從英特爾所揭露的技術(shù)資料可看出,F(xiàn)overos本身就是一種3D IC技術(shù),透過硅穿孔(Through-Silicon Via, TSV)技術(shù)與微凸塊(micro-bumps)搭配,把不同的邏輯芯片堆疊起來。
其架構(gòu)概念就是在一塊基礎(chǔ)的運(yùn)算微芯片(compute chiplet)上,以TSV加上微凸塊的方式,堆疊其他的運(yùn)算晶粒(die)和微芯片(chiplets),例如GPU和記憶體,甚至是RF元件等,最后再把整個結(jié)構(gòu)打包封裝。
而英特爾目前所使用的制程已達(dá)到10納米,預(yù)計也可以順利推進(jìn)至7納米,也此透過此3D封裝技術(shù),將可在單一芯片中達(dá)成絕佳的運(yùn)算效能,并持續(xù)推進(jìn)摩爾定律。
英特爾更特別把此技術(shù)稱為「臉貼臉(Face-to-Face)」的封裝,強(qiáng)調(diào)它芯片對芯片封裝的特點(diǎn)。而要達(dá)成此技術(shù),TSV與微凸塊(μbumps)的先進(jìn)制程技術(shù)就是關(guān)鍵,尤其是凸塊接點(diǎn)的間距(pitch)僅有約36微米(micron),如何透過優(yōu)異的打線流程來達(dá)成,就非常考驗英特爾的生產(chǎn)技術(shù)了。
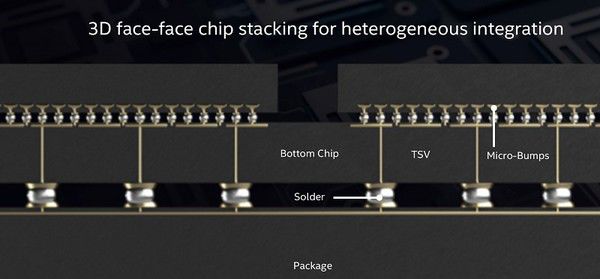
圖六: Foveros的TSV與微凸塊疊合示意(source: intel)
但是英特爾也指出,F(xiàn)overos技術(shù)仍存在三個挑戰(zhàn),分別為散熱、供電、以及良率。由于多芯片的堆疊,勢必會大幅加大熱源密度;而上下層邏輯芯片的供電性能也會受到挑戰(zhàn);而如何克服上述的問題,并在合理的成本內(nèi)進(jìn)行量產(chǎn)供貨,則是最后的一道關(guān)卡。
依照英特爾先前發(fā)布的時程,「Lakefield」處理器應(yīng)該會在今年稍晚推出,但由于英特爾沒有在COMPUTEX更新此一產(chǎn)品的進(jìn)度,是否能順利推出仍有待觀察。
-
英特爾
+關(guān)注
關(guān)注
61文章
10177瀏覽量
174038 -
邏輯芯片
+關(guān)注
關(guān)注
1文章
157瀏覽量
31229
原文標(biāo)題:其他「小鋼炮」都一邊玩去吧
文章出處:【微信號:eda365wx,微信公眾號:EDA365電子論壇】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
日月光最新推出FOCoS-Bridge TSV技術(shù)
電機(jī)系統(tǒng)節(jié)能關(guān)鍵技術(shù)及展望
TSV以及博世工藝介紹

TSV硅通孔填充材料
基于TSV的3D-IC關(guān)鍵集成技術(shù)

芯片先進(jìn)封裝硅通孔(TSV)技術(shù)說明

成功量產(chǎn)!德明利實現(xiàn)SATA SSD存儲控制芯片關(guān)鍵IP和技術(shù)平臺全自研

成功量產(chǎn)!德明利實現(xiàn)SATA SSD存儲控制芯片關(guān)鍵IP和技術(shù)平臺全自研

TSV三維堆疊芯片的可靠性問題
怎樣讀懂ADC的技術(shù)手冊,哪些參數(shù)比較關(guān)鍵?
先進(jìn)封裝中的TSV/硅通孔技術(shù)介紹

先進(jìn)封裝中互連工藝凸塊、RDL、TSV、混合鍵合的新進(jìn)展

一文了解硅通孔(TSV)及玻璃通孔(TGV)技術(shù)






 TSV與μbumps技術(shù)是量產(chǎn)關(guān)鍵
TSV與μbumps技術(shù)是量產(chǎn)關(guān)鍵












評論