PoP,譯為“堆疊封裝”,主要特征是在芯片上安裝芯片。目前見到的安裝結(jié)構(gòu)主要為兩類,即“球——焊盤”和“球——球”結(jié)構(gòu)。一般PoP為兩層,通常頂層封裝是小中心距的球柵陣列(FBGA)存儲(chǔ)器,而底層封裝是包含某種類型的邏輯器件或ASIC處理器。
(1)節(jié)約板面面積,有效改善了電性能。
(2)相對(duì)于裸芯片安裝,省去了昂貴芯片測試問題并為手持設(shè)備制造商提供了更好的設(shè)計(jì)選擇,可以把存儲(chǔ)器和邏輯芯片相互匹配地安裝起來——即使是來自不同制造商的產(chǎn)品。
(3)頂層封裝的安裝工藝控制要求比較高,特別是“球——球”結(jié)構(gòu)的 PoP,同時(shí),維修也比較困難,大多數(shù)情況下拆卸下來的芯片基本不能再次利用。
工藝的核心是頂層封裝的沾焊劑或焊膏工藝以及再流焊接時(shí)的封裝變形控制問題。
1)沾焊劑或焊膏
頂層封裝的安裝通常采用焊球沾焊劑或焊膏的工藝,焊劑工藝相對(duì)而言應(yīng)用更普遍一些。
沾焊劑與沾焊膏哪種更好?這主要取決于PoP的安裝結(jié)構(gòu)。一般而言,“球——焊盤”結(jié)構(gòu),更傾向于采用沾焊劑工藝,“球——球”結(jié)構(gòu),則更傾向于采用粘焊膏工藝。
2)變形控制
由于上下芯片的受熱狀態(tài)不同,導(dǎo)致再流焊接過程中上下封裝的翹曲方向不同,而且翹曲的大小與芯片的尺寸有關(guān)。
-
芯片
+關(guān)注
關(guān)注
459文章
52350瀏覽量
438627 -
存儲(chǔ)器
+關(guān)注
關(guān)注
38文章
7643瀏覽量
166830 -
封裝
+關(guān)注
關(guān)注
128文章
8618瀏覽量
145121
發(fā)布評(píng)論請先 登錄
半導(dǎo)體封裝工藝流程的主要步驟






 堆疊封裝的安裝工藝流程與核心技術(shù)介紹
堆疊封裝的安裝工藝流程與核心技術(shù)介紹

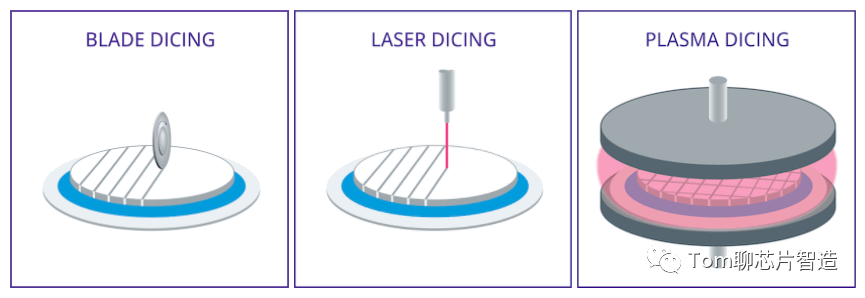












評(píng)論