MEMS(MicroElectro Mechanical Systems)全稱為微機(jī)電系統(tǒng),是指用新型加工技術(shù)形成的微型器件或者系統(tǒng),這個(gè)系統(tǒng)可以將微傳感器、微機(jī)構(gòu)、信號(hào)處理及控制電路、微執(zhí)行器,直至接口、通信以及電源均集成于一體。MEMS技術(shù)的發(fā)展來(lái)源于IC(Integrated Circuit)技術(shù),即集成電路技術(shù),是多學(xué)科交叉融合的產(chǎn)物,因此在繼承了集成電路技術(shù)中的成熟部分的基礎(chǔ)上,也將多種學(xué)科技術(shù)的發(fā)展成果集成于一體。MEMS并非傳統(tǒng)機(jī)械系統(tǒng)在宏觀尺度上的微縮,而是一種新型智能化、集成化的系統(tǒng)。因此近年來(lái),世界各國(guó)都開始重視MEMS技術(shù)的發(fā)展,并大力支持其產(chǎn)業(yè)化的研究。目前國(guó)外已經(jīng)研制并開發(fā)出許多MEMS傳感器,如壓力傳感器、加速度計(jì)等。并且壓力傳感器、微加速度計(jì)等已經(jīng)應(yīng)用于各種行業(yè),比傳統(tǒng)產(chǎn)品更具有競(jìng)爭(zhēng)力。
MEMS產(chǎn)業(yè)化、商品化的關(guān)鍵是將其從測(cè)試階段推廣到產(chǎn)品階段,其中最后一步的關(guān)鍵流程就是封裝。封裝的功能是實(shí)現(xiàn)芯片與環(huán)境之間的有機(jī)交互與隔離,從而在保證芯片功能實(shí)現(xiàn)的情況下,起到保護(hù)芯片,提高可靠性的作用。很多MEMS器件沒(méi)有實(shí)現(xiàn)產(chǎn)品化成功投入市場(chǎng)的原因就是沒(méi)有有效解決MEMS芯片的封裝問(wèn)題。因此,MEMS器件的封裝是把基于MEMS的系統(tǒng)方案推向市場(chǎng)的關(guān)鍵步驟,也是MEMS設(shè)計(jì)與制造中的一個(gè)關(guān)鍵因素。在MEMS封裝技術(shù)中,陽(yáng)極鍵合技術(shù)是最為常見(jiàn)的幾種技術(shù)之一,從MEMS發(fā)展以來(lái)一直在體型MEMS結(jié)構(gòu)中得到了廣泛的應(yīng)用。
1969年,美國(guó)的Wallis和Pomerantz兩位研究人員首次提出了陽(yáng)極鍵合技術(shù),其鍵合方法如圖1所示。陽(yáng)極鍵合目前在硅片與玻璃鍵合中得到了較為廣泛的應(yīng)用,技術(shù)發(fā)展相對(duì)較為成熟。其基本原理如圖2所示。除了硅片與玻璃,陽(yáng)極鍵合技術(shù)還廣泛應(yīng)用于金屬與玻璃、半導(dǎo)體與合金、半導(dǎo)體與玻璃間的鍵合,且所需環(huán)境溫度相對(duì)較低(200~500 ℃)。憑借其優(yōu)點(diǎn),陽(yáng)極鍵合技術(shù)廣泛應(yīng)用于MEMS器件的制備過(guò)程中,如激光器、微干涉儀、壓力傳感器以及SOI結(jié)構(gòu)制作等。
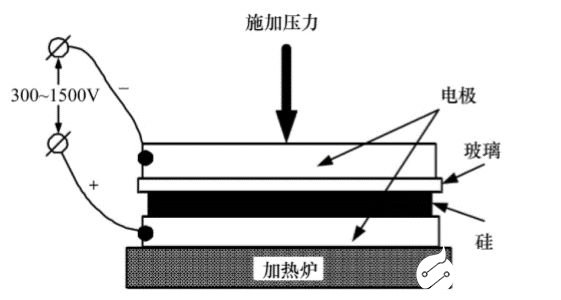
圖1 陽(yáng)極鍵合示意圖

圖2 陽(yáng)極鍵合基本原理
1 鍵合前表面預(yù)處理研究
在進(jìn)行陽(yáng)極鍵合前,需要對(duì)晶片表面進(jìn)行預(yù)處理。晶片的表面粗糙度會(huì)嚴(yán)重影響鍵合效果甚至?xí)?dǎo)致無(wú)法鍵合。陽(yáng)極鍵合技術(shù)對(duì)鍵合晶片表面的要求一般為粗糙度小于10 nm,不平整度小于10 μm。晶片表面光潔度是陽(yáng)極鍵合的另一項(xiàng)重要指標(biāo)。因此為滿足晶片表面光潔度要求,需要在超凈間完成鍵合操作,并且要對(duì)晶片進(jìn)行較為嚴(yán)格的表面清洗工序。有相關(guān)研究得到如下結(jié)論:如果將兩片厚度為425 μm的硅片在室溫下進(jìn)行鍵合時(shí),即使表面只有一個(gè)直徑為1 μm的污染物,這個(gè)污染物將造成的未鍵合區(qū)域直徑會(huì)達(dá)到4.4 mm。可見(jiàn)表面顆粒物的存在會(huì)大大影響鍵合的成功率和可靠性。除此以外,通過(guò)Helvoort等的研究發(fā)現(xiàn):在陽(yáng)極鍵合的過(guò)程中,可動(dòng)陽(yáng)離子主要是鈉離子(Na+),而如鉀離子(K+)等一些移動(dòng)能力更弱的陽(yáng)離子,會(huì)在靠近耗盡層與玻璃體交界處附近進(jìn)行堆積,如圖3所示,從而在鍵合界面形成靜電吸引力,這也是鍵合界面過(guò)渡區(qū)形成的關(guān)鍵。因此為了產(chǎn)生足夠的靜電吸引力,需要待鍵合晶片表面足夠光潔平整。Anthony研究了表面粗糙度及表面顆粒對(duì)陽(yáng)極鍵合的影響,并且在研究中發(fā)現(xiàn):靜電力隨著粗糙度的增加會(huì)迅速減少,當(dāng)粗糙度達(dá)到一定程度時(shí),鍵合將無(wú)法完成。
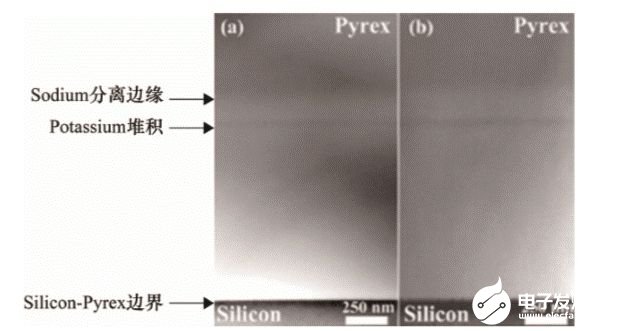
圖3 Pryex-Si界面過(guò)渡區(qū)TEM顯微圖
因此,為了增加鍵合可靠性,在進(jìn)行陽(yáng)極鍵合程序之前,研究人員均會(huì)采用一些方法對(duì)硅片或者玻璃片進(jìn)行預(yù)處理,以增加鍵合界面的光潔平整度,盡可能減小表面污染物對(duì)鍵合的影響,同時(shí)能夠使鍵合界面間形成最大靜電吸引力。除此之外,對(duì)鍵合表面進(jìn)行一定的活化處理還可以提高表面張力并獲得較高的表面能,從而可以得到更好的鍵合效果和質(zhì)量。陽(yáng)極鍵合在表面親水化處理流程中,常采用濕化學(xué)法表面活化和干法表面活化兩類流程。干法表面活化方法主要包括等離子活化和氬氣濺射氧化法,濕化學(xué)法主要是利用一些特定的化學(xué)藥劑對(duì)晶片表面進(jìn)行預(yù)先處理,以提高晶片表面活性。常用的濕化學(xué)活法的化學(xué)試劑如下:H2O2、HF、H2SO4、HNO3等。
1.1 濕化學(xué)法處理
近年來(lái),國(guó)內(nèi)外眾多研究人員均對(duì)陽(yáng)極鍵合前鍵合表面處理方法及工藝進(jìn)行了研究。姚明秋等對(duì)低溫陽(yáng)極鍵合特性進(jìn)行了研究。他們分別研究了硅片在親水、疏水和表面未處理3種不同處理方式下對(duì)鍵合的影響。在250 ℃的鍵合溫度及600 V的電壓下鍵合后發(fā)現(xiàn),經(jīng)過(guò)親水處理的實(shí)驗(yàn)組鍵合效果最好,這主要是由于親水處理后,硅片表面的氫基含量增多,參與鍵合生成SiO2的反應(yīng)離子多,在鍵合的過(guò)程中發(fā)生了反應(yīng)(1)和反應(yīng)(2),與此同時(shí),羥基之間的分子力會(huì)增加硅-玻璃之間的結(jié)合力,而疏水處理后硅片表面基本只發(fā)生反應(yīng)(1),因此經(jīng)過(guò)親水處理的硅片陽(yáng)極鍵合效果更好。
Si+O-Si→Si-O-Si(1)
Si-OH+OH-Si→Si-O-Si+H2O(2)
王多笑等在陽(yáng)極鍵合前分別用RCA1(NH4OH:H2O2:H2O=1:1:5)溶液和RCA2(HCl:H2O2:H2O=1:1:6)溶液對(duì)硅片鍵合表面進(jìn)行了非常嚴(yán)格的濕化學(xué)活化表面預(yù)處理,在250 ℃較低的鍵合溫度下成功完成了硅-玻璃的鍵合,其未鍵合率小于0.5 %,鍵合強(qiáng)度大于15 MPa。李星等為了克服陽(yáng)極鍵合試驗(yàn)時(shí)硅片和玻璃片的鍵合困難,提高硅片表面活性和鍵合質(zhì)量,在陽(yáng)極鍵合的表面預(yù)處理工藝中引進(jìn)UV光對(duì)硅片進(jìn)行活化并對(duì)其工藝參數(shù)和效果進(jìn)行評(píng)估。鍵合結(jié)果評(píng)估表明,經(jīng)過(guò)4 min活化后的硅片,其表面親水角最小,也就是這個(gè)時(shí)候的硅片表面活性最好,有助于提高鍵合質(zhì)量。
1.2 干法表面活化方法
近年來(lái),低溫等離子體方法是比較常見(jiàn)的干法表面活化方法,其原理是采用等離子轟擊晶片表面,提高晶片表面能,使晶片表面具有更高的吸附能力,更易鍵合。常見(jiàn)的等離子體產(chǎn)生的氣體主要有以下幾種:O2、NH3、N2等。圖4為混合等離子體陽(yáng)極鍵合裝置示意圖。
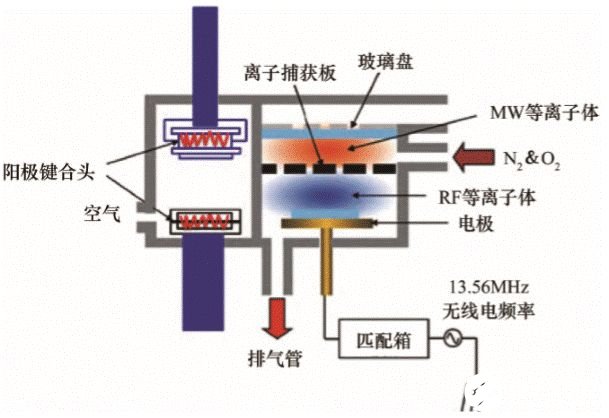
圖4 混合等離子體陽(yáng)極鍵合裝置示意圖
Kowal等將待鍵合樣品放在充滿氧氣的氣體環(huán)境中,通過(guò)放電產(chǎn)生等離子體并對(duì)待鍵合表面進(jìn)行改性,然后在200 ℃的溫度下退火1 h,成功完成了鍵合。他們對(duì)等離子體處理裝置進(jìn)行了改良設(shè)計(jì),降低了等離子體對(duì)界面的不良影響。
Howlader等采用復(fù)合陽(yáng)極鍵合設(shè)備對(duì)硅-玻璃進(jìn)行了鍵合。其表面預(yù)處理過(guò)程可以分為兩個(gè)步驟:①引入氧等離子體清除晶片表面雜質(zhì),并且在表面形成大量懸掛鍵,增強(qiáng)晶片的表面能;②引入氮等離子體進(jìn)一步加強(qiáng)表面活性。通過(guò)這種方式在200 ℃下成功實(shí)現(xiàn)了高質(zhì)量玻璃-鍺陽(yáng)極鍵合。
Howlader等在之后的研究中發(fā)現(xiàn),在等離子體激活鍵合和常規(guī)陽(yáng)極鍵合的鍵合界面處均有空洞存在,但200 ℃鍵合溫度下的混合等離子體陽(yáng)極鍵合界面處(Hybrid Plasma bonding, HPB)卻未發(fā)現(xiàn)空洞,且鍵合強(qiáng)度高達(dá)30 MPa。
綜合近年來(lái)對(duì)陽(yáng)極鍵合過(guò)程中鍵合前表面預(yù)處理的研究發(fā)現(xiàn):隨著陽(yáng)極鍵合工藝及技術(shù)的發(fā)展,近年來(lái)許多的研究都集中于在鍵合前采取一定的預(yù)處理手段,使得鍵合界面具有更多的親水基來(lái)增加硅-玻璃表面結(jié)合力,除此之外還有一些研究專注于采用一定的方法使鍵合表面的活性增強(qiáng),進(jìn)而增加鍵合力,如激光照射法、等離子體清洗法等。這在MEMS封裝中具有重要意義,但是這些處理方法工藝相對(duì)復(fù)雜,成本較高,需要專用的化學(xué)試劑和設(shè)備。
2 鍵合工藝研究
在陽(yáng)極鍵合的過(guò)程中,合適的鍵合工藝是實(shí)現(xiàn)鍵合的關(guān)鍵因素。在鍵合過(guò)程中,為了增加鍵合強(qiáng)度,一般會(huì)增加鍵合溫度或者鍵合壓力。當(dāng)鍵合溫度增加時(shí),鈉離子的擴(kuò)散更加厲害,導(dǎo)致擴(kuò)散層的寬度更寬,鍵合強(qiáng)度也隨之增加。當(dāng)鍵合壓力增加時(shí),硅片和玻璃之間的靜電結(jié)合力會(huì)隨著兩級(jí)的電壓增大而越來(lái)越大,界面間的結(jié)合會(huì)越來(lái)越緊密。然而在MEMS制造過(guò)程中,過(guò)高的溫度不僅會(huì)對(duì)元器件造成傷害甚至導(dǎo)致其失效,還會(huì)因?yàn)楣韬筒A煞N材料的熱匹配系數(shù)不同導(dǎo)致鍵合后產(chǎn)生較高殘余應(yīng)力,影響器件的抗疲勞性能。而高電壓則會(huì)影響器件的電極或電路。另一方面,過(guò)低的鍵合溫度和鍵合電壓則會(huì)影響鍵合質(zhì)量,甚至不能達(dá)到鍵合效果。因此,為了更好地實(shí)現(xiàn)陽(yáng)極鍵合、提高鍵合質(zhì)量,對(duì)陽(yáng)極鍵合工藝的研究非常有必要。近年來(lái),國(guó)內(nèi)外學(xué)者也對(duì)陽(yáng)極鍵合工藝進(jìn)行了較為廣泛的研究。影響陽(yáng)極鍵合質(zhì)量的主要工藝參數(shù)除了鍵合電壓外,還有鍵合溫度、鍵合方法以及鍵合環(huán)境等。
明小祥通過(guò)基于激光拉曼光譜的方法,設(shè)計(jì)了正交試驗(yàn),研究了溫度、電壓、時(shí)間對(duì)陽(yáng)極鍵合過(guò)程中硅-玻璃界面處應(yīng)力的影響。研究結(jié)果表明:在800~1200 V鍵合壓力的范圍內(nèi),隨著電壓的增加,鍵合界面應(yīng)力先增加后減小,在300~380 ℃的鍵合溫度范圍內(nèi),鍵合界面應(yīng)力隨著溫度的升高一直減小,在5~15 min的鍵合時(shí)間范圍內(nèi),隨著鍵合時(shí)間的逐漸增加,鍵合界面應(yīng)力先增加后減小。另外,他還研制了小型的原位陽(yáng)極鍵合裝置。其結(jié)果表明,在400 ℃,-1000 V,1 atm的鍵合條件下,鍵合界面附近的硅晶片上會(huì)形成80 MPa的拉應(yīng)力。
Choi等研究發(fā)現(xiàn),硅-玻璃表面經(jīng)過(guò)氧等離子體處理后會(huì)發(fā)生活化。經(jīng)過(guò)氧等離子體處理之后,即使未施加電壓,玻璃和硅仍然可以發(fā)生鍵合,但是鍵合強(qiáng)度較低;而在240 ℃的環(huán)境條件下施加了250 V電壓后,硅與玻璃間的鍵合強(qiáng)度可以得到大幅度提高。
Joyce等采用了一種全新的陽(yáng)極鍵合技術(shù),他們?cè)谘芯恐邪l(fā)現(xiàn)適當(dāng)增大外加電壓可以縮短鍵合時(shí)間。與二氧化硅和玻璃鍵合相比,硅片和玻璃的鍵合所需時(shí)間更短、電壓更低。
Joyce等研究了同一鍵合溫度下硅-玻璃鍵合過(guò)程中鍵合電壓對(duì)鍵合電流的影響,結(jié)果表明,隨著鍵合電壓的增加,鍵合時(shí)間逐漸減小,而鍵合過(guò)程中的峰值電流逐漸增加。近年來(lái),Joyce通過(guò)修正加熱板和陰極,在低溫陽(yáng)極鍵合的條件下實(shí)現(xiàn)了硅-玻璃的完好鍵合,這使陽(yáng)極鍵合溫度下降到了280 ℃。采用掃描電子顯微鏡對(duì)不同鍵合溫度下的鍵合界面進(jìn)行分析,不同鍵合溫度下鍵合界面均為良好,沒(méi)有裂紋、空洞等缺陷出現(xiàn)。
秦會(huì)峰等研究了脈沖電壓對(duì)硅-玻璃陽(yáng)極鍵合質(zhì)量的影響。首先采用脈沖電壓對(duì)硅-玻璃進(jìn)行了壓機(jī)鍵合試驗(yàn)。結(jié)果表明:采用脈沖電壓能有效縮短硅-玻璃陽(yáng)極鍵合時(shí)間,并能適當(dāng)降低鍵合溫度。通過(guò)拉伸試驗(yàn)表明鍵合強(qiáng)度能夠達(dá)到預(yù)定要求。采用掃描電鏡對(duì)鍵合界面進(jìn)行分析,在硅-玻璃鍵合界面發(fā)現(xiàn)了較明顯的中間過(guò)渡層。分析認(rèn)為,這是由于在鍵合過(guò)程中,脈沖電壓會(huì)產(chǎn)生一定的脈沖電場(chǎng)力,這對(duì)玻璃Na+耗盡層中的O2-向界面遷移擴(kuò)散起到了反復(fù)驅(qū)動(dòng)的作用,促使O2-向陰極表面遷移,增加了界面鍵合效率,從而縮短了硅-玻璃陽(yáng)極鍵合的時(shí)間,并降低了鍵合溫度,從而促進(jìn)了過(guò)度層的形成。
關(guān)榮峰分別在大氣環(huán)境和真空環(huán)境中(真空度)對(duì)硅-玻璃進(jìn)行了靜電鍵合。采用三維云紋干涉儀對(duì)鍵合前后硅片局部進(jìn)行了測(cè)量,如圖5所示,發(fā)現(xiàn)兩種環(huán)境下的鍵合都取得了較好的效果,但是真空環(huán)境下的鍵合效果要優(yōu)于大氣環(huán)境下的鍵合效果。從圖中可以看出,真空環(huán)境下的鍵合具有更加對(duì)稱的三維云紋干涉圖,這說(shuō)明鍵合的變形量更小,也就是鍵合應(yīng)力更小。最后對(duì)鍵合式樣的強(qiáng)度進(jìn)行了測(cè)試,發(fā)現(xiàn)真空條件下鍵合強(qiáng)度可以達(dá)到10 MPa。除此之外,他們還選擇壓力芯片對(duì)硅-玻璃真空微型密封腔靜電鍵合工藝進(jìn)行了研究。圖6、圖7是鍵合結(jié)構(gòu)示意圖。鍵合的硅芯片結(jié)構(gòu)尺寸為:2.5 mm×2.5 mm×0.5 mm,鍵合工藝參數(shù)分別為:鍵合溫度350 ℃,鍵合真空度為1×10-3 Pa,鍵合壓力小于0.1 MPa,鍵合時(shí)間8 min,鍵合峰值電流8 mA。對(duì)鍵合式樣進(jìn)行強(qiáng)度測(cè)試后發(fā)現(xiàn)其鍵合強(qiáng)度達(dá)到了14 MPa。
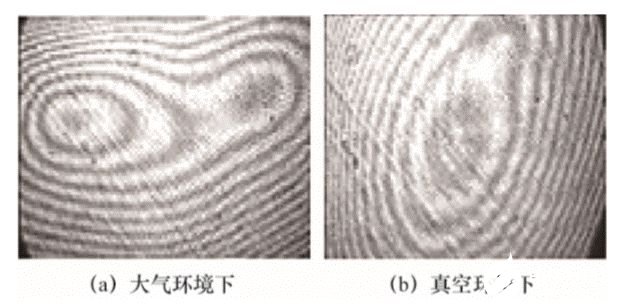
圖5 三維云紋測(cè)試結(jié)果
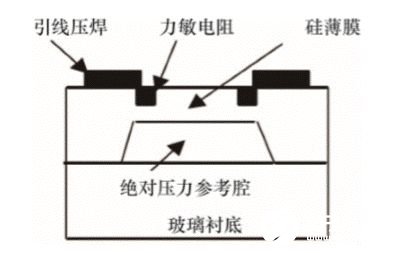
圖6 硅-玻璃鍵合結(jié)構(gòu)示意圖
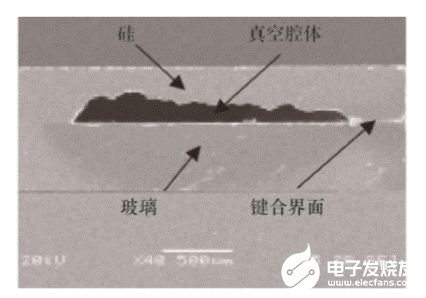
圖7 硅-玻璃鍵合腔體結(jié)構(gòu)圖
吳登峰等采用線陰極的快速陽(yáng)極鍵合方法對(duì)硅-玻璃進(jìn)行了鍵合。他們分別采用了平板陰極、點(diǎn)陰極和十字線陰極方式進(jìn)行了鍵合,最后對(duì)鍵合式樣進(jìn)行了拉伸試驗(yàn)。結(jié)果表明:十字線陰極鍵合樣品的鍵合強(qiáng)度達(dá)到16.7 MPa,數(shù)碼顯微鏡并沒(méi)有在十字線陰極鍵合樣品中發(fā)現(xiàn)明顯的空氣空洞。
張延凱等對(duì)兩電極多層陽(yáng)極鍵合實(shí)驗(yàn)進(jìn)行了研究。他們采用了一次電極反接對(duì)多層樣片進(jìn)行了陽(yáng)極鍵合,并且采用實(shí)驗(yàn)手段以玻璃-硅-玻璃三層鍵合結(jié)構(gòu)為對(duì)象對(duì)其進(jìn)行了研究。結(jié)果表明:多余的玻璃對(duì)第一次鍵合過(guò)程的電流特性沒(méi)有過(guò)大的影響,而第一次鍵合的玻璃對(duì)第二次鍵合電流產(chǎn)生了較為顯著的影響,電流出現(xiàn)了無(wú)規(guī)律的突變。同時(shí),在第二次鍵合時(shí),第一次鍵合的玻璃在鍵合面上會(huì)出現(xiàn)黃褐色斑點(diǎn),這主要是由于鈉元素積聚而產(chǎn)生的。對(duì)鍵合后的樣件進(jìn)行了強(qiáng)度實(shí)驗(yàn),結(jié)果表明:第二次鍵合過(guò)程會(huì)在第一次鍵合面形成反向電壓,這會(huì)減弱鍵合的強(qiáng)度。
李星等采用激光輔助陽(yáng)極鍵合的方法對(duì)硅-玻璃進(jìn)行了鍵合試驗(yàn),成功地實(shí)現(xiàn)了硅與玻璃在低功率下局部的完好鍵合。他們采用UV光對(duì)硅片表面進(jìn)行活化照射,采用掃描電鏡對(duì)鍵合界面的微觀結(jié)構(gòu)進(jìn)行分析,如圖8所示。從圖中可以看出,在硅-玻璃鍵合界面有明顯的過(guò)渡層生成,通過(guò)能譜儀測(cè)試分析可知,激光在鍵合層的致熱溫度和界面的強(qiáng)電場(chǎng)導(dǎo)致玻璃層中的O2-向鍵合界面遷移擴(kuò)散,并與硅發(fā)生氧化反應(yīng),從而形成中間過(guò)渡層,促進(jìn)鍵合。
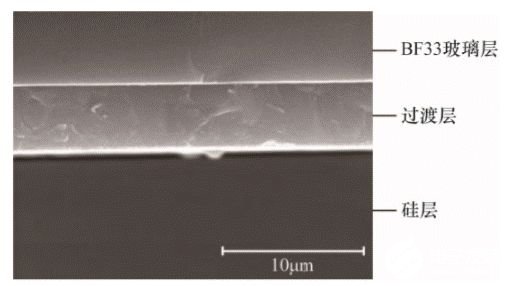
圖8 鍵合界面局部放大SEM照片
在一定范圍內(nèi),靜電引力會(huì)隨著溫度的升高而增大。鍵合晶片內(nèi)的離子遷移速率會(huì)隨著鍵合電壓的升高而增大,使得陽(yáng)極鍵合速率也隨之提高。目前,針對(duì)陽(yáng)極鍵合工藝的研究相對(duì)較多,且大多數(shù)都集中于鍵合工藝對(duì)鍵合質(zhì)量的影響。對(duì)于MEMS封裝來(lái)說(shuō),鍵合工藝更加重要,不但要考慮單個(gè)器件的鍵合質(zhì)量,還要考慮每個(gè)器件的封裝鍵合是否會(huì)對(duì)其他器件本身或者其他器件的鍵合界面造成影響。整體來(lái)說(shuō),在MEMS封裝中,在保證鍵合質(zhì)量的前提下,鍵合溫度及鍵合電壓越低越好,這樣對(duì)其他器件的影響就越小。尤其是近年來(lái),越來(lái)越多的科研工作者均對(duì)低溫鍵合工藝及其機(jī)理進(jìn)行了研究。
3 展望
陽(yáng)極鍵合在MEMS封裝中占據(jù)著重要地位。在鍵合前對(duì)鍵合表面進(jìn)行預(yù)處理不僅可以提高鍵合質(zhì)量,還可以適當(dāng)降低鍵合溫度,從而降低對(duì)溫度敏感器件的損傷,降低高溫造成的殘余熱應(yīng)力,這在MEMS封裝中具有重要意義。但是這些處理方法工藝相對(duì)復(fù)雜,成本較高,因此,對(duì)于陽(yáng)極鍵合前鍵合表面預(yù)處理的研究還有一定的潛力和必要性。鍵合工藝是陽(yáng)極鍵合的核心環(huán)節(jié),尤其在MEMS中,對(duì)鍵合工藝提出了更高的要求。低溫鍵合是陽(yáng)極鍵合的重要研究方向。實(shí)現(xiàn)低溫鍵合甚至常溫鍵合,對(duì)MEMS來(lái)說(shuō)具有重大的意義。隨著MEMS技術(shù)的發(fā)展逐漸趨于成熟,勢(shì)必會(huì)對(duì)陽(yáng)極鍵合提出更高的要求和挑戰(zhàn)。如果能夠解決陽(yáng)極鍵合中所涉及的預(yù)處理、鍵合工藝等問(wèn)題,將為MEMS的設(shè)計(jì)和應(yīng)用提供更廣闊的選擇自由度,有助于推動(dòng)MEMS技術(shù)的進(jìn)一步發(fā)展。
責(zé)任編輯:pj
-
壓力傳感器
+關(guān)注
關(guān)注
35文章
2323瀏覽量
180062 -
微機(jī)電系統(tǒng)
+關(guān)注
關(guān)注
2文章
136瀏覽量
24157 -
MEMS器件
+關(guān)注
關(guān)注
2文章
47瀏覽量
13131
發(fā)布評(píng)論請(qǐng)先 登錄
提高鍵合晶圓 TTV 質(zhì)量的方法

倒裝芯片鍵合技術(shù)的特點(diǎn)和實(shí)現(xiàn)過(guò)程

SC1249廣泛應(yīng)用于電子測(cè)試和測(cè)量系統(tǒng),替代ADI AD9208

揭秘Au-Sn共晶鍵合:MEMS封裝的高效解決方案

微流控芯片鍵合技術(shù)
微流控芯片的熱鍵合和表面改性鍵合的工藝區(qū)別
晶圓鍵合技術(shù)的類型有哪些
探秘MEMS封裝中的封帽“黑科技”

金絲鍵合強(qiáng)度測(cè)試儀試驗(yàn)方法:鍵合拉脫、引線拉力、鍵合剪切力






 陽(yáng)極鍵合技術(shù)廣泛應(yīng)用于MEMS器件的制備過(guò)程中
陽(yáng)極鍵合技術(shù)廣泛應(yīng)用于MEMS器件的制備過(guò)程中
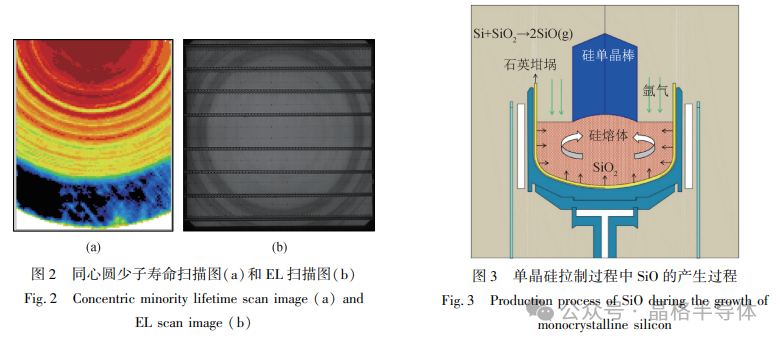














評(píng)論