傳統(tǒng)刀片切割(劃片)原理——撞擊
機(jī)械切割(劃片)是機(jī)械力直接作用于晶圓表面,在晶體內(nèi)部產(chǎn)生應(yīng)力操作,容易產(chǎn)生晶圓崩邊及晶片破損。
由于刀片具有一定的厚度,由此刀具的切割(劃片)線寬較大。鉆石鋸片切割(劃片)能夠達(dá)到的最小切割線寬度一般在25-35μm之間。
刀具切割(劃片)采用的是機(jī)械力的作用方式,因而刀具切割(劃片)具有一定的局限性。對(duì)于厚度在100μm以下的晶圓,用刀具進(jìn)行切割(劃片)極易導(dǎo)致晶圓破碎。
刀片切割(劃片)速度為8-10mm/s,切割速度較慢。且切割不同的晶圓片,需要更換不同的刀具。
旋轉(zhuǎn)砂輪式切割需要刀片冷卻水和切割水,均為去離子水(DI純水)
切割刀片需要頻繁更換,后期運(yùn)行成本較高。
新型激光切割
激光切割(切片)屬于無接觸式加工,不會(huì)對(duì)晶圓產(chǎn)生機(jī)械應(yīng)力的作用,對(duì)晶圓操作較小。
由于激光在聚焦上的優(yōu)點(diǎn),聚焦點(diǎn)可小到亞微米級(jí),從而對(duì)晶圓的微處理更具有優(yōu)越性,可以進(jìn)行小部件加工;即使在不高的脈沖能量水平下,也能得到較高的能量密度,有效地對(duì)材料進(jìn)行加工。
大多數(shù)材料吸收激光直接將硅材料汽化,形成溝道,從而實(shí)現(xiàn)切割的目的。因?yàn)楣獍咝。軐?shí)現(xiàn)最低限度的碳化影響。
激光切割采用的高光束質(zhì)量的光纖激光器對(duì)芯片的電性影響也較小,可提供更高的切割成品率。
激光切割速度更快。
激光可以切割厚度較薄的晶圓,可用于對(duì)不同厚度的晶圓進(jìn)行切割。
激光可切割一些較復(fù)雜的晶圓芯片,如六邊形管芯等。
激光切割也不需要用到去離子水,也不存在刀具磨損的問題,可以實(shí)現(xiàn)24小時(shí)不間斷作業(yè)。
激光有很好的兼容性,用激光切割,對(duì)不同的晶圓片可以實(shí)現(xiàn)更好的兼容性和通用性。
P.S.:OFweek君不是技術(shù)出身,現(xiàn)學(xué)現(xiàn)賣的這種概括文章,對(duì)于產(chǎn)業(yè)中的各種基礎(chǔ)概念無法做到非常準(zhǔn)確的描述。若讀者朋友們對(duì)于文章內(nèi)容準(zhǔn)確性有異議,歡迎添加OFweek君微信(hepinggui2010)告知。若相關(guān)內(nèi)容能形成完整的文章,OFweek君也可以署名文章投稿的形式,將相應(yīng)內(nèi)容發(fā)表在OFweek旗下各個(gè)內(nèi)容平臺(tái)上。感謝大家的支持!
-
晶圓
+關(guān)注
關(guān)注
53文章
5154瀏覽量
129729 -
激光切割
+關(guān)注
關(guān)注
3文章
226瀏覽量
13277
發(fā)布評(píng)論請(qǐng)先 登錄
淺切多道切割工藝對(duì)晶圓 TTV 厚度均勻性的提升機(jī)制與參數(shù)優(yōu)化

晶圓切割振動(dòng)監(jiān)測(cè)系統(tǒng)與進(jìn)給參數(shù)的協(xié)同優(yōu)化模型

超薄晶圓切割:振動(dòng)控制與厚度均勻性保障

晶圓切割中振動(dòng) - 應(yīng)力耦合效應(yīng)對(duì)厚度均勻性的影響及抑制方法

基于多物理場(chǎng)耦合的晶圓切割振動(dòng)控制與厚度均勻性提升

陶瓷基板激光切割設(shè)備的核心特點(diǎn)

用于切割晶圓 TTV 控制的硅棒安裝機(jī)構(gòu)

晶圓切割的定義和功能
晶硅切割液潤濕劑用哪種類型?
晶圓切割機(jī)在氧化鋯材料高精度劃切中的應(yīng)用
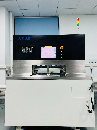
怎么制備半導(dǎo)體晶圓片切割刃料?

CNC切割與傳統(tǒng)切割的區(qū)別
晶圓切割技術(shù)知識(shí)大全






 晶圓傳統(tǒng)刀片切割與新型激光切割的對(duì)比
晶圓傳統(tǒng)刀片切割與新型激光切割的對(duì)比


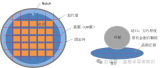










評(píng)論