超越摩爾,三星的異構(gòu)集成之路
在近期舉辦的2021年SamsungFoundry論壇上,三星透露了2/3nm制程工藝的新進展,并公開發(fā)布了全新的17nm工藝。三星市場戰(zhàn)略副總裁MoonSoo Kang也面向產(chǎn)業(yè)合作伙伴,公布了三星在異構(gòu)集成上的計劃,如何為摩爾定律再度添加一個“維度”。
 ?
?
旗艦GPU與移動芯片的面積變化對比 / 三星
幾十年間,半導體產(chǎn)業(yè)一直在不懈地推動摩爾定律,以更先進的制程做到更多的晶體管數(shù)目,這就是我們常說的“延續(xù)摩爾”方案,也是當前計算與電路領(lǐng)域持續(xù)創(chuàng)新最大的推動力。
盡管摩爾定律的延續(xù),芯片面積仍在擴大,比如一直在追求算力的GPU,已經(jīng)快要逼近光罩尺寸的限度了。再加上晶體管數(shù)目的增加,使得芯片設(shè)計成本和生產(chǎn)成本無休止地增加。在不少人看來,單靠“延續(xù)摩爾”不再是一個技術(shù)與成本上可持續(xù)的方案。
與此同時,更多的功能與特性集成在單個芯片上,卻又沒有單個制程可以滿足所有不同功能的需求,比如模擬、射頻、高壓等,即便可以滿足也無法達到優(yōu)秀的性能與成本平衡。“延續(xù)摩爾”的方案在這類挑戰(zhàn)面前束手無策,因此才出現(xiàn)了異構(gòu)集成這種“擴展摩爾”的方案。通過兩種方案的互補,共同做到“超越摩爾”。
Chiplet:降低成本提高良率的救星
隨著單個芯片加入更多特性,即便摩爾定律延續(xù)下去,其芯片面積仍在增加,為所有不同功能的設(shè)計區(qū)塊使用同一個制程節(jié)點成了抵消的選擇,好在如今有了Chiplet這一救星的出現(xiàn)。將一大塊裸片分成較小的chiplet,并為每個chiplet使用最優(yōu)的制程,可以顯著提高整個芯片的良率,同時減少生產(chǎn)成本。例如某些特定的接口IP并不會因為采用先進制程而獲得面積或性能上的優(yōu)化,對這些IP使用成熟制程和專用定制制程,可以做到更低的成本以及更優(yōu)的性能。
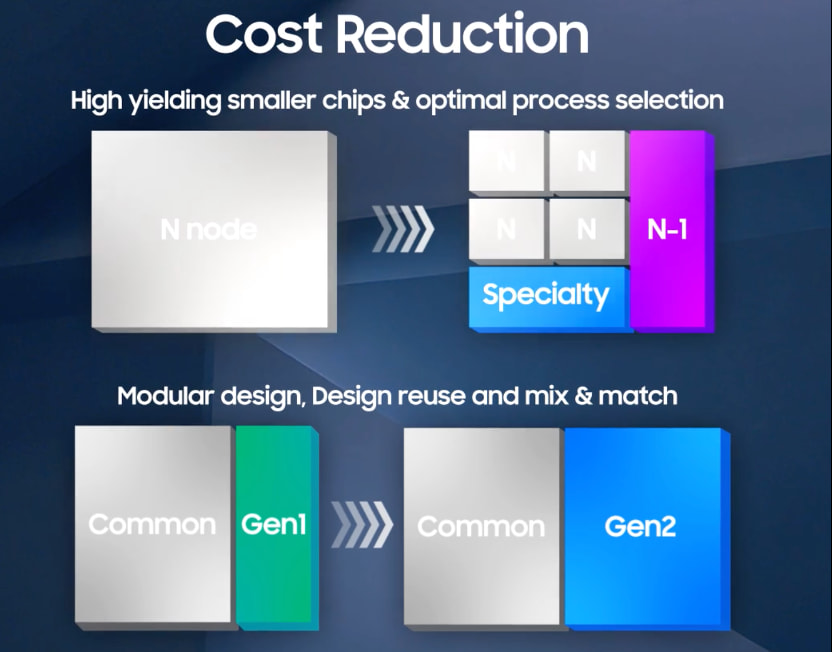 ?
?
Chiplet方案 / 三星
另一個可行方案就是模組化的設(shè)計與制造,也就是重復(fù)使用相同的組件chiplet。不少IP模組都可以作為chiplet重復(fù)使用,只有芯片的其他部分需要重新設(shè)計和生產(chǎn),此舉顯著減少了設(shè)計、開發(fā)與生產(chǎn)的成本,芯片廠商可以借此更快實現(xiàn)產(chǎn)品迭代。
X-Cube:垂直3D集成
異構(gòu)集成不只是為了成本和良率考慮,也能進一步提升芯片性能。傳統(tǒng)的2D設(shè)計中,信號路徑有幾毫米長。而在3D集成下,芯片的堆疊可以將信號路徑減少至幾微米,大大改進了芯片延遲。除此之外,3D集成中更出色的內(nèi)聯(lián)間距可以實現(xiàn)更高的帶寬,進一步提高芯片性能。
早在2014年,三星就首次實現(xiàn)了將寬IO內(nèi)存與移動應(yīng)用處理器的3D堆疊,也就是三星的Widcon技術(shù)。隨后,3D芯片堆疊技術(shù)繼續(xù)發(fā)展,誕生了一系列HBM內(nèi)存產(chǎn)品。HBM就是由DRAM與邏輯堆疊,并由微凸塊和TSV相連而成的。也正是因為3D堆疊技術(shù),三星得以開發(fā)出了3層的CMOS圖像傳感器,由圖像傳感器、邏輯與DRAM三種不同的裸片堆疊在一起而成。
2020年,三星推出了X-Cube技術(shù),這項技術(shù)使得兩個邏輯單元裸片可以垂直堆疊在一起,形成一個單獨的3D芯片,由微凸塊與TSV連接。X-Cube分為兩種形式,兩個裸片由微凸塊連接或是直接銅鍵合。
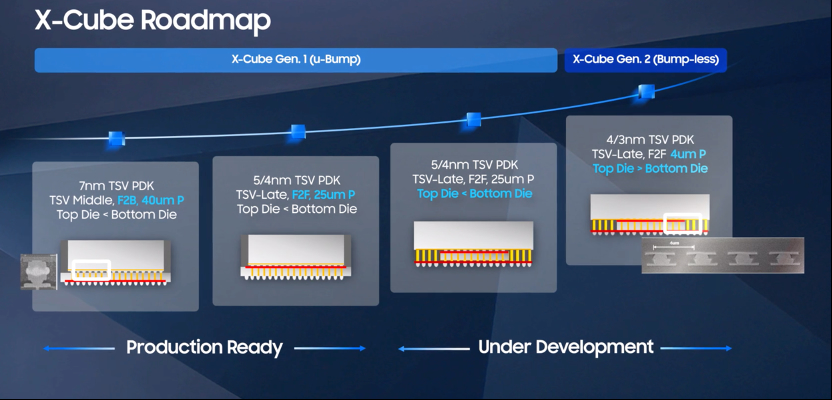 ?
?
X-Cube路線圖 / 三星
第一代X-Cube技術(shù)(u-Bump)主要依靠微凸塊連接,三星已經(jīng)發(fā)布了針對7nm邏輯制程的TSV PDK,采用F2B結(jié)構(gòu),凸塊間距為40um。面向4/5nm的TSV PDK也已經(jīng)發(fā)布,改用F2F的結(jié)構(gòu),凸塊間距降低至25um。尚在開發(fā)中的第二代X-Cube技術(shù)(Bump-less)則采用了直接銅鍵合技術(shù),間距降低至4um。
值得一提的是,英特爾的Foveros3D堆疊技術(shù)路線與三星X-Cube大致相同。第一代Foveros的凸塊間距在36um至50um之間,而下一代FoverosOmni技術(shù)同樣可以做到25um的凸塊間距。尚在開發(fā)的Foveros Direct也采用了直接銅鍵合的方式,宣稱凸塊間距降低至10um以下。
過去的X-Cube架構(gòu)中,底部裸片的面積要大于頂部裸片,然而為了更好了滿足客戶對芯片分區(qū)和散熱等不同要求,三星也將在后續(xù)提供頂部裸片大于底部裸片的結(jié)構(gòu)。目前三星已經(jīng)完成了3D堆疊SRAM的驗證,在7nm的制程下,可以做到48.6GB/s的帶寬,以及7.2ns的讀取延遲與2.6ns的寫入延遲。
除此之外,三星還提供了一項差異化技術(shù),ISC(集成堆疊電容)。這一電容應(yīng)用了已經(jīng)在三星DRAM產(chǎn)品中獲得驗證的硅電容結(jié)構(gòu)、材料和工藝,具有1100nF/mm2的電容密度,可以有效提高電源完整性。三星的ISC還提供了多種不同的配置,比如分立型、硅中介層型和多晶圓堆疊型,以滿足客戶不同的結(jié)構(gòu)需求,ISC預(yù)計將在2022年進入量產(chǎn)階段。
I-Cube:橫向2.5D組合
另一方面,為了從橫向組合芯片,三星開發(fā)了所謂的2.5D技術(shù)I-Cube,將邏輯單元與多個HBM集成在同一硅中介層上。目前三星已經(jīng)成功實現(xiàn)了一個邏輯裸片+兩個HBM的I-Cube2量產(chǎn),成品之一就是百度的昆侖AI芯片。百度的昆侖AI芯片不僅使用了三星的14nm制程,也運用了三星的I-CUBE 2技術(shù)。
I-Cube使用了預(yù)篩選的技術(shù),在封裝的中間階段進行運算測試,從而提高良率。該技術(shù)還采用了無封膠的結(jié)構(gòu),做到更好的散熱性能,據(jù)三星強調(diào),與傳統(tǒng)的2.5D方案相比,I-Cube的散熱效率高上4.5%。此外,與其他代工廠商相比,三星的I-Cube技術(shù)還有一些優(yōu)勢,比如與三星內(nèi)存合作,率先用上最新的內(nèi)存方案
 ?
?
I-Cube4示意圖 / 三星
目前三星已經(jīng)在計劃集成4HBM3模組的I-Cube4量產(chǎn)工作,而6 HBM的I-Cube6也已經(jīng)做好量產(chǎn)準備,前者預(yù)計2022年進入大批量產(chǎn)階段。三星更是準備了兩個邏輯裸片+8個HBM的I-Cube8方案,目前尚處于開發(fā)階段,預(yù)計2022年末將正式上線。
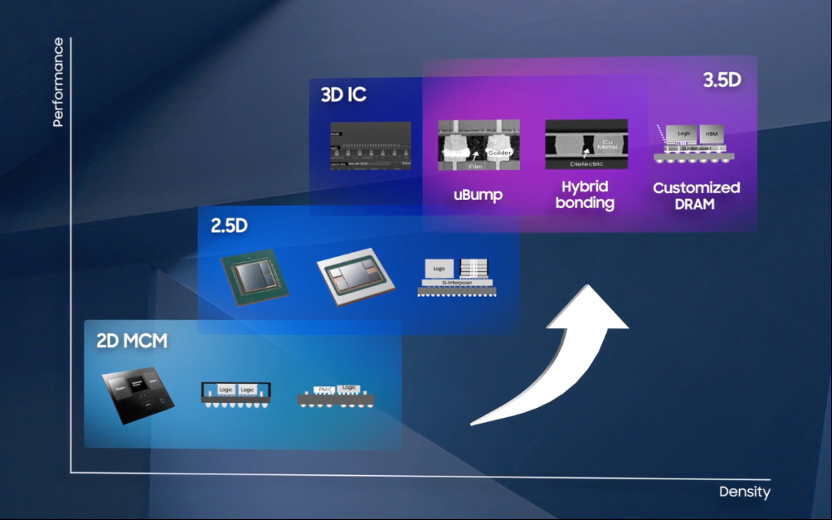 ?
?
2D至3.5D的封裝方案 / 三星
除了2D、2.5D與3D的IC技術(shù)之外,三星還在開發(fā)全新的3.5D封裝技術(shù),這種系統(tǒng)級封裝內(nèi)還將加入堆疊的定制DRAM或SRAM裸片,實現(xiàn)更高的性能與密度。
小結(jié)
在開發(fā)2.5D/3D集成的多芯片或多Chiplet系統(tǒng)級芯片時,設(shè)計者往往還會遇到在傳統(tǒng)單芯片設(shè)計上罕見的技術(shù)障礙,比如多出來的接口IP或潛在的功耗增加。這時候,三星、臺積電和剛進入IDM 2.0的英特爾等代工廠商還會提供異構(gòu)設(shè)計的方法和工具,幫助設(shè)計者克服這些挑戰(zhàn)。在異構(gòu)集成的大勢之下,代工廠也將提供更多的服務(wù)模式,增加封裝、測試以及一站式的設(shè)計服務(wù)。
在近期舉辦的2021年SamsungFoundry論壇上,三星透露了2/3nm制程工藝的新進展,并公開發(fā)布了全新的17nm工藝。三星市場戰(zhàn)略副總裁MoonSoo Kang也面向產(chǎn)業(yè)合作伙伴,公布了三星在異構(gòu)集成上的計劃,如何為摩爾定律再度添加一個“維度”。
 ?
?旗艦GPU與移動芯片的面積變化對比 / 三星
幾十年間,半導體產(chǎn)業(yè)一直在不懈地推動摩爾定律,以更先進的制程做到更多的晶體管數(shù)目,這就是我們常說的“延續(xù)摩爾”方案,也是當前計算與電路領(lǐng)域持續(xù)創(chuàng)新最大的推動力。
盡管摩爾定律的延續(xù),芯片面積仍在擴大,比如一直在追求算力的GPU,已經(jīng)快要逼近光罩尺寸的限度了。再加上晶體管數(shù)目的增加,使得芯片設(shè)計成本和生產(chǎn)成本無休止地增加。在不少人看來,單靠“延續(xù)摩爾”不再是一個技術(shù)與成本上可持續(xù)的方案。
與此同時,更多的功能與特性集成在單個芯片上,卻又沒有單個制程可以滿足所有不同功能的需求,比如模擬、射頻、高壓等,即便可以滿足也無法達到優(yōu)秀的性能與成本平衡。“延續(xù)摩爾”的方案在這類挑戰(zhàn)面前束手無策,因此才出現(xiàn)了異構(gòu)集成這種“擴展摩爾”的方案。通過兩種方案的互補,共同做到“超越摩爾”。
Chiplet:降低成本提高良率的救星
隨著單個芯片加入更多特性,即便摩爾定律延續(xù)下去,其芯片面積仍在增加,為所有不同功能的設(shè)計區(qū)塊使用同一個制程節(jié)點成了抵消的選擇,好在如今有了Chiplet這一救星的出現(xiàn)。將一大塊裸片分成較小的chiplet,并為每個chiplet使用最優(yōu)的制程,可以顯著提高整個芯片的良率,同時減少生產(chǎn)成本。例如某些特定的接口IP并不會因為采用先進制程而獲得面積或性能上的優(yōu)化,對這些IP使用成熟制程和專用定制制程,可以做到更低的成本以及更優(yōu)的性能。
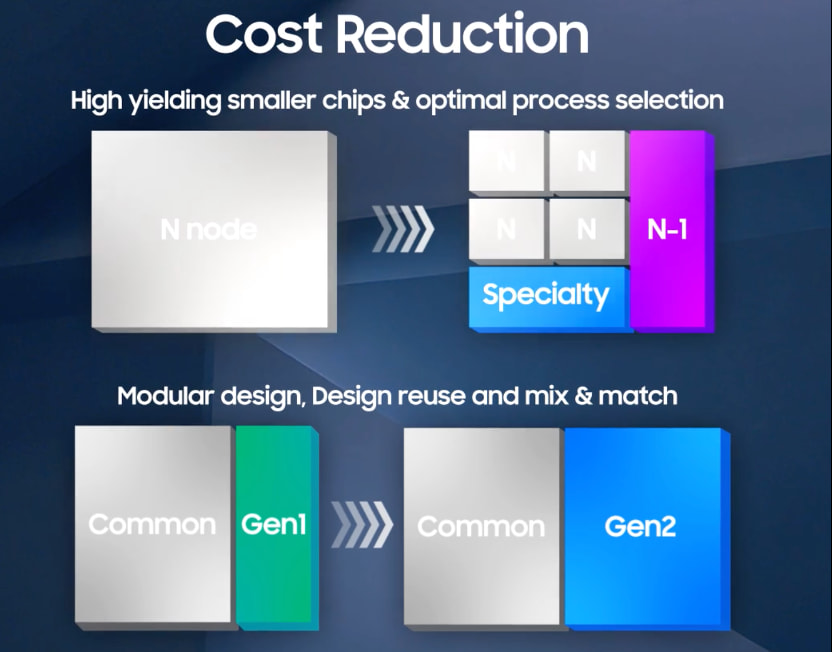 ?
?Chiplet方案 / 三星
另一個可行方案就是模組化的設(shè)計與制造,也就是重復(fù)使用相同的組件chiplet。不少IP模組都可以作為chiplet重復(fù)使用,只有芯片的其他部分需要重新設(shè)計和生產(chǎn),此舉顯著減少了設(shè)計、開發(fā)與生產(chǎn)的成本,芯片廠商可以借此更快實現(xiàn)產(chǎn)品迭代。
X-Cube:垂直3D集成
異構(gòu)集成不只是為了成本和良率考慮,也能進一步提升芯片性能。傳統(tǒng)的2D設(shè)計中,信號路徑有幾毫米長。而在3D集成下,芯片的堆疊可以將信號路徑減少至幾微米,大大改進了芯片延遲。除此之外,3D集成中更出色的內(nèi)聯(lián)間距可以實現(xiàn)更高的帶寬,進一步提高芯片性能。
早在2014年,三星就首次實現(xiàn)了將寬IO內(nèi)存與移動應(yīng)用處理器的3D堆疊,也就是三星的Widcon技術(shù)。隨后,3D芯片堆疊技術(shù)繼續(xù)發(fā)展,誕生了一系列HBM內(nèi)存產(chǎn)品。HBM就是由DRAM與邏輯堆疊,并由微凸塊和TSV相連而成的。也正是因為3D堆疊技術(shù),三星得以開發(fā)出了3層的CMOS圖像傳感器,由圖像傳感器、邏輯與DRAM三種不同的裸片堆疊在一起而成。
2020年,三星推出了X-Cube技術(shù),這項技術(shù)使得兩個邏輯單元裸片可以垂直堆疊在一起,形成一個單獨的3D芯片,由微凸塊與TSV連接。X-Cube分為兩種形式,兩個裸片由微凸塊連接或是直接銅鍵合。
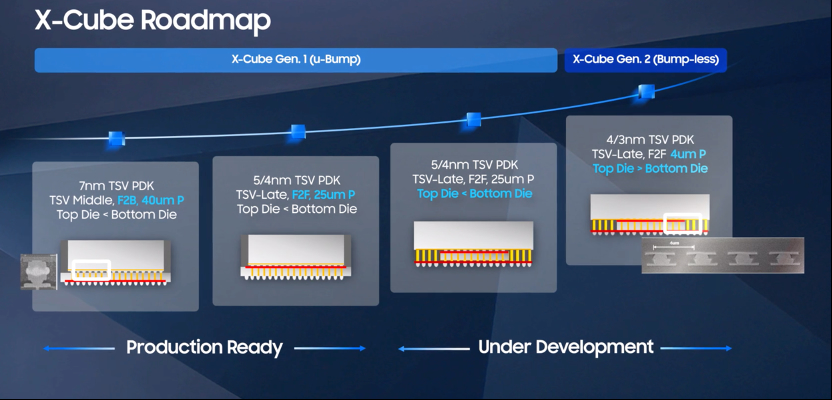 ?
?X-Cube路線圖 / 三星
第一代X-Cube技術(shù)(u-Bump)主要依靠微凸塊連接,三星已經(jīng)發(fā)布了針對7nm邏輯制程的TSV PDK,采用F2B結(jié)構(gòu),凸塊間距為40um。面向4/5nm的TSV PDK也已經(jīng)發(fā)布,改用F2F的結(jié)構(gòu),凸塊間距降低至25um。尚在開發(fā)中的第二代X-Cube技術(shù)(Bump-less)則采用了直接銅鍵合技術(shù),間距降低至4um。
值得一提的是,英特爾的Foveros3D堆疊技術(shù)路線與三星X-Cube大致相同。第一代Foveros的凸塊間距在36um至50um之間,而下一代FoverosOmni技術(shù)同樣可以做到25um的凸塊間距。尚在開發(fā)的Foveros Direct也采用了直接銅鍵合的方式,宣稱凸塊間距降低至10um以下。
過去的X-Cube架構(gòu)中,底部裸片的面積要大于頂部裸片,然而為了更好了滿足客戶對芯片分區(qū)和散熱等不同要求,三星也將在后續(xù)提供頂部裸片大于底部裸片的結(jié)構(gòu)。目前三星已經(jīng)完成了3D堆疊SRAM的驗證,在7nm的制程下,可以做到48.6GB/s的帶寬,以及7.2ns的讀取延遲與2.6ns的寫入延遲。
除此之外,三星還提供了一項差異化技術(shù),ISC(集成堆疊電容)。這一電容應(yīng)用了已經(jīng)在三星DRAM產(chǎn)品中獲得驗證的硅電容結(jié)構(gòu)、材料和工藝,具有1100nF/mm2的電容密度,可以有效提高電源完整性。三星的ISC還提供了多種不同的配置,比如分立型、硅中介層型和多晶圓堆疊型,以滿足客戶不同的結(jié)構(gòu)需求,ISC預(yù)計將在2022年進入量產(chǎn)階段。
I-Cube:橫向2.5D組合
另一方面,為了從橫向組合芯片,三星開發(fā)了所謂的2.5D技術(shù)I-Cube,將邏輯單元與多個HBM集成在同一硅中介層上。目前三星已經(jīng)成功實現(xiàn)了一個邏輯裸片+兩個HBM的I-Cube2量產(chǎn),成品之一就是百度的昆侖AI芯片。百度的昆侖AI芯片不僅使用了三星的14nm制程,也運用了三星的I-CUBE 2技術(shù)。
I-Cube使用了預(yù)篩選的技術(shù),在封裝的中間階段進行運算測試,從而提高良率。該技術(shù)還采用了無封膠的結(jié)構(gòu),做到更好的散熱性能,據(jù)三星強調(diào),與傳統(tǒng)的2.5D方案相比,I-Cube的散熱效率高上4.5%。此外,與其他代工廠商相比,三星的I-Cube技術(shù)還有一些優(yōu)勢,比如與三星內(nèi)存合作,率先用上最新的內(nèi)存方案
 ?
?I-Cube4示意圖 / 三星
目前三星已經(jīng)在計劃集成4HBM3模組的I-Cube4量產(chǎn)工作,而6 HBM的I-Cube6也已經(jīng)做好量產(chǎn)準備,前者預(yù)計2022年進入大批量產(chǎn)階段。三星更是準備了兩個邏輯裸片+8個HBM的I-Cube8方案,目前尚處于開發(fā)階段,預(yù)計2022年末將正式上線。
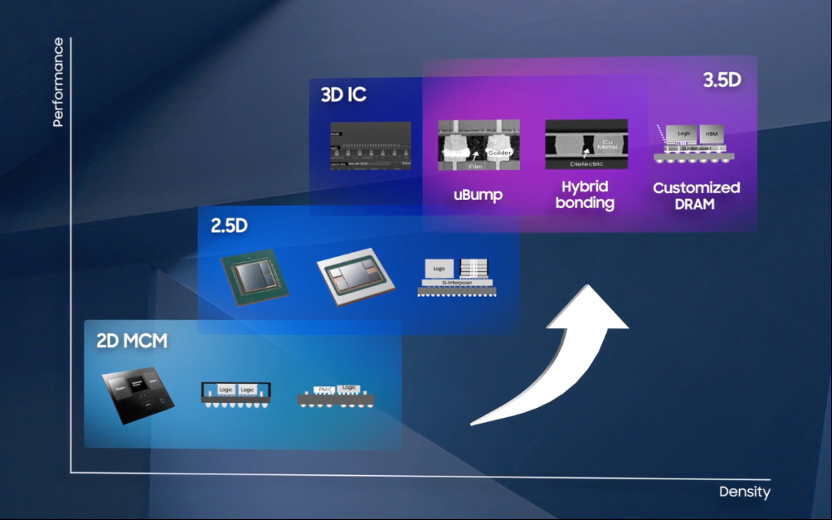 ?
?2D至3.5D的封裝方案 / 三星
除了2D、2.5D與3D的IC技術(shù)之外,三星還在開發(fā)全新的3.5D封裝技術(shù),這種系統(tǒng)級封裝內(nèi)還將加入堆疊的定制DRAM或SRAM裸片,實現(xiàn)更高的性能與密度。
小結(jié)
在開發(fā)2.5D/3D集成的多芯片或多Chiplet系統(tǒng)級芯片時,設(shè)計者往往還會遇到在傳統(tǒng)單芯片設(shè)計上罕見的技術(shù)障礙,比如多出來的接口IP或潛在的功耗增加。這時候,三星、臺積電和剛進入IDM 2.0的英特爾等代工廠商還會提供異構(gòu)設(shè)計的方法和工具,幫助設(shè)計者克服這些挑戰(zhàn)。在異構(gòu)集成的大勢之下,代工廠也將提供更多的服務(wù)模式,增加封裝、測試以及一站式的設(shè)計服務(wù)。
聲明:本文內(nèi)容及配圖由入駐作者撰寫或者入駐合作網(wǎng)站授權(quán)轉(zhuǎn)載。文章觀點僅代表作者本人,不代表電子發(fā)燒友網(wǎng)立場。文章及其配圖僅供工程師學習之用,如有內(nèi)容侵權(quán)或者其他違規(guī)問題,請聯(lián)系本站處理。
舉報投訴
-
三星電子
+關(guān)注
關(guān)注
34文章
15885瀏覽量
182173 -
異構(gòu)
+關(guān)注
關(guān)注
0文章
44瀏覽量
13326 -
異構(gòu)集成
+關(guān)注
關(guān)注
0文章
36瀏覽量
2052
發(fā)布評論請先 登錄
相關(guān)推薦
熱點推薦
三星存儲,開始反擊!
電子發(fā)燒友網(wǎng)報道(文/黃山明)近日,三星電子公布了其第三季度財報,顯示該公司芯片季度營業(yè)利潤達3.86萬億韓元,遠低于上一季度的6.45萬億韓元,環(huán)比爆降近40%。顯然,這一輪業(yè)績的爆降與三星此前

回收三星S21指紋排線 適用于三星系列指紋模組
深圳帝歐電子回收三星S21指紋排線,收購適用于三星S21指紋模組。回收三星指紋排線,收購三星指紋排線,全國高價回收三星指紋排線,專業(yè)求購指紋
發(fā)表于 05-19 10:05
三星在4nm邏輯芯片上實現(xiàn)40%以上的測試良率
三星電子在 HBM3 時期遭遇了重大挫折,將 70% 的 HBM 內(nèi)存市場份額拱手送給主要競爭對手 SK 海力士,更是近年來首度讓出了第一大 DRAM 原廠的寶座。這迫使三星在 HBM4 上采用
發(fā)表于 04-18 10:52
三星辟謠晶圓廠暫停中國業(yè)務(wù)
對于網(wǎng)絡(luò)謠言三星晶圓代工暫停所有中國業(yè)務(wù),三星下場辟謠。三星半導體在官方公眾號發(fā)文辟謠稱““三星晶圓代工暫停與中國部分公司新項目合作”的說法屬誤傳,
下一代FOPLP基板,三星續(xù)用塑料,臺積青睞玻璃
近期Digitimes報道指出,在下一代扇出型面板級封裝(FOPLP)解決方案所使用的材料方面,三星和臺積電走上了一條明顯的分歧之路。 據(jù)《電子時報》報道,三星堅持使用塑料,而臺積電則在探索用于
三星芯片代工新掌門:先進與成熟制程并重
據(jù)韓媒報道,三星電子設(shè)備解決方案部新任foundry業(yè)務(wù)總裁兼總經(jīng)理韓真晚(Han Jinman),在近期致員工的內(nèi)部信中明確提出了三星代工部門的發(fā)展策略。 韓真晚強調(diào),三星代工部門要實現(xiàn)先進
異構(gòu)集成封裝類型詳解
隨著摩爾定律的放緩,半導體行業(yè)越來越多地采用芯片設(shè)計和異構(gòu)集成封裝來繼續(xù)推動性能的提高。這種方法是將大型硅芯片分割成多個較小的芯片,分別進行設(shè)計、制造和優(yōu)化,然后再集成到單個封裝中。

選擇三星電容時需要參考哪些?
如今,市場越來越大,電容的品牌居多,諸多的品牌為了能夠呈現(xiàn)出更為清晰明了的內(nèi)容,因此會有相關(guān)的規(guī)格書介紹。三星電容作為電容行業(yè)的佼佼者,自然是備受關(guān)注的焦點,并吸引了各個廠家的關(guān)注,尤其是對于選購
三星電容的標簽標識怎么識別?
三星電容的標簽標識識別,主要可以從以下幾個方面進行: 一、編帶粘膠顏色 特征描述:三星電容的編帶粘膠顏色統(tǒng)一為白色和一小截藍色。這種特定的顏色組合是三星電容的一個重要特征,有助于快速識別。 注意事項
三星電子公布2024年異構(gòu)集成路線圖,LP Wide I/O移動內(nèi)存即將面世
7月17日,三星電子公布了其雄心勃勃的2024年異構(gòu)集成路線圖,其中一項關(guān)鍵研發(fā)成果引發(fā)了業(yè)界廣泛關(guān)注——一款名為LP Wide I/O的創(chuàng)新型移動內(nèi)存即將面世。這款內(nèi)存不僅預(yù)示著存儲技術(shù)的又一次

三星半導體部門第二季度銷售額或超越臺積電
在全球半導體行業(yè)風起云涌的浪潮中,三星電子再次成為焦點。據(jù)最新預(yù)測,2024年第二季度,三星電子的半導體部門營收有望近兩年來首次超越臺積電,這一潛在的歷史性跨越不僅標志著半導體市場競爭格局的深刻變化,也預(yù)示著行業(yè)內(nèi)部力量對比的新
三星芯片復(fù)興之路:半導體業(yè)務(wù)飆升與HBM挑戰(zhàn)并存
在科技行業(yè)的浩瀚星空中,三星電子無疑是一顆璀璨的星辰。近期,這家科技巨頭憑借其半導體業(yè)務(wù)的顯著改善,實現(xiàn)了利潤的飆升,再次向世人展示了其強大的市場影響力和技術(shù)實力。然而,在光鮮亮麗的背后,三星電子也面臨著不小的挑戰(zhàn),尤其是在高帶寬內(nèi)存(HBM)這一關(guān)鍵領(lǐng)域,其業(yè)務(wù)表現(xiàn)仍顯
三星計劃2025年推出AI集成家電,與蘋果角逐智能生態(tài)市場
三星電子,這家全球知名的電子產(chǎn)品制造商,正積極布局其家電業(yè)務(wù)的未來。據(jù)行業(yè)內(nèi)部消息透露,三星的家電部門正致力于開發(fā)集成大型語言模型(LLMs)的家電產(chǎn)品,并計劃在2025年正式發(fā)布這一系列創(chuàng)新產(chǎn)品。





 超越摩爾,三星的異構(gòu)集成之路
超越摩爾,三星的異構(gòu)集成之路












評論