從智能手機(jī)到汽車,消費者希望將更多功能集成到更小的產(chǎn)品中。為順應(yīng)這一趨勢,TI已針對封裝技術(shù)進(jìn)行了優(yōu)化,包括用于子系統(tǒng)控制和電源時序的負(fù)載開關(guān)。封裝技術(shù)的創(chuàng)新可以提高功率密度,即在每個印刷電路板上設(shè)置更多的器件和功能。
晶圓芯片級封裝(WCSP)
現(xiàn)如今尺寸最小的負(fù)載開關(guān)都使用晶圓芯片級封裝(WCSP)。圖1為具四引腳的WCSP封裝器件。
WCSP封裝技術(shù)通過將焊球連接于硅片底部來盡可能地減小占用空間,這使得該技術(shù)在載流和封裝面積方面更具競爭力。由于WCSP技術(shù)最小化了物理尺寸,連接輸入和輸出引腳的焊球數(shù)量有限,也就限制了負(fù)載開關(guān)可以支持的最大電流。
采用絲焊技術(shù)的塑料封裝
高電流或制造工藝要求嚴(yán)苛的應(yīng)用(如工業(yè)PC)中需要使用塑料封裝。圖2為采用絲焊技術(shù)的塑料封裝。
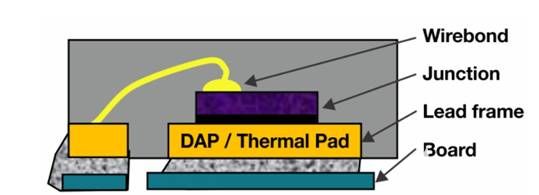
圖2. 標(biāo)準(zhǔn)絲焊方形扁平無引腳封裝
QFN或SON(小外形無引腳)封裝技術(shù)通過絲焊技術(shù)將硅片與引腳進(jìn)行連接,這使得更高的電流能夠從輸入端流向輸出端,同時為器件提供良好的散熱性。絲焊塑料封裝需要為接合線本身提供很大的空間,甚至比硅片本身占有的封裝空間還要大。接合線還會增加電源路徑的電阻,從而增加負(fù)載開關(guān)的總導(dǎo)通電阻。因此需要在更大尺寸和更高的功率支持之間進(jìn)行權(quán)衡。
塑料HotRod封裝
雖然WCSP封裝和接合線封裝都有各自的優(yōu)缺點,但TI的HotRod QFN負(fù)載開關(guān)卻兼具兩種封裝技術(shù)的優(yōu)勢。圖3為HotRod封裝的結(jié)構(gòu)示意圖。
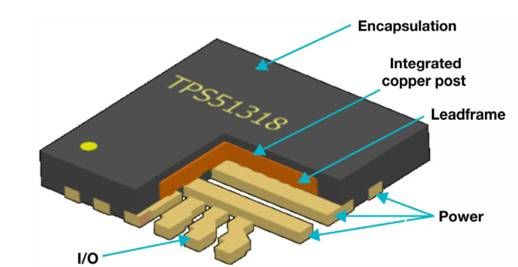
圖3. TI HotRod QFN封裝結(jié)構(gòu)及其與硅片的連接
這些無引線塑料封裝使用銅柱將硅片與封裝進(jìn)行連接,由于比接合線占用的面積更少,因此可以最大限度地減小封裝尺寸。這些銅柱可以支持大電流,引入電源路徑的電阻較小,且允許高達(dá) 6 A 的電流通過單個引腳。
表1為TPS22964C WCSP,TPS22975 SON和TPS22992 HotRod三種封裝優(yōu)勢的對比。

表1. 各負(fù)載開關(guān)解決方案的對比
雖然TPS22975 SON封裝器件支持6A的電流,但需要引入支持該電流水平的輸入和輸出引腳,這也就限制了功率良好和可調(diào)上升時間等方面的性能。接合線還會增加導(dǎo)通電阻,限制最大電流。
采用WCSP封裝的負(fù)載開關(guān)是三種解決方案中尺寸最小的,但有限的引腳數(shù)量限制了其更多功能的實現(xiàn)和可支持的最大電流。
總結(jié)
TPS22992負(fù)載開關(guān)結(jié)合了WSCP和SON的優(yōu)勢,兼具小尺寸和高電流等特點。TI的TPS22992 和TPS22998負(fù)載開關(guān)通過HotRod封裝來解決小型化的問題,同時支持高電流、低導(dǎo)通電阻等特性。
-
封裝技術(shù)
+關(guān)注
關(guān)注
12文章
576瀏覽量
68498 -
系統(tǒng)控制
+關(guān)注
關(guān)注
0文章
34瀏覽量
16392 -
功率密度
+關(guān)注
關(guān)注
0文章
92瀏覽量
17097
發(fā)布評論請先 登錄
新能源汽車高功率密度電驅(qū)動系統(tǒng)關(guān)鍵技術(shù)趨勢

功率密度> 100W/in3,TI新款電源管理芯片賦能現(xiàn)代數(shù)據(jù)中心建設(shè)

法拉電容具有高能量密度和高功率密度的特點,廣泛應(yīng)用于以下領(lǐng)域

瑞豐光電推出金剛石基超大功率密度封裝
芯干線科技出席高功率密度GaN數(shù)字電源技術(shù)交流會
如何使用耦合電感器提高DC-DC應(yīng)用中的功率密度?

PD快充芯片U8608凸顯高功率密度優(yōu)勢

源鉗位反激控制器(UCC28780)其在提高功率密度方面的優(yōu)勢

揭秘超高功率密度LED器件中的星技術(shù)
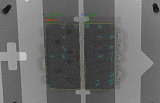
使用有源鉗位反激式控制器(UCC28780)增大功率密度

高功率密度降壓轉(zhuǎn)換器的熱性能優(yōu)化應(yīng)用報告

如何通過創(chuàng)新封裝技術(shù)提升功率器件性能
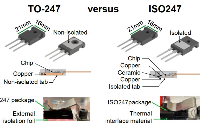





 TI創(chuàng)新性封裝如何提高功率密度
TI創(chuàng)新性封裝如何提高功率密度










評論