本文作者:Guozhi XuCadence公司 DSG Product Validation Group
Cadence Integrity 3D-IC 平臺(tái)是業(yè)界首個(gè)全面的整體 3D-IC 設(shè)計(jì)規(guī)劃、實(shí)現(xiàn)和分析平臺(tái),以全系統(tǒng)的視角,對芯片的性能、功耗和面積 (PPA) 進(jìn)行系統(tǒng)驅(qū)動(dòng)的優(yōu)化,并對 3D-IC 應(yīng)用的中介層、封裝和印刷電路板進(jìn)行協(xié)同設(shè)計(jì)。
近幾年,隨著摩爾定律的失效,集成電路的設(shè)計(jì)發(fā)展逐漸從傳統(tǒng)的二維平面轉(zhuǎn)向立體,人們獲得了三維帶來的諸多優(yōu)勢,比如:更短的引線、更低的功耗、更高的性能和帶寬、更小的封裝尺寸、以及更好的良率,但同時(shí)三維設(shè)計(jì)也帶來了新的挑戰(zhàn):例如設(shè)計(jì)的聚合與管理、額外的系統(tǒng)級驗(yàn)證等。
過去行業(yè)中的解決方案多借助于點(diǎn)工具搭建的流程,裸片和裸片、裸片和封裝之間的設(shè)計(jì)缺少聯(lián)系,無法進(jìn)行早期的探索和獲得反饋。為了使集成后的系統(tǒng)仍能滿足設(shè)計(jì)要求,必須過度設(shè)計(jì)以留下余量,造成性能受限并且成本高昂。
Cadence 在 2021 年推出的 Integrity 3D-IC 平臺(tái),正是為了應(yīng)對這些挑戰(zhàn)而設(shè)計(jì)。
Cadence Integrity 3D-IC 平臺(tái)集成了 3D 設(shè)計(jì)規(guī)劃與物理實(shí)現(xiàn),能夠支持系統(tǒng)級的早期和簽核分析,全面完整地助力設(shè)計(jì)者實(shí)現(xiàn)由系統(tǒng)來驅(qū)動(dòng)的 PPA 目標(biāo)。
3D-IC的流程包括從系統(tǒng)級規(guī)劃,到單個(gè)芯片物理實(shí)現(xiàn),再到系統(tǒng)級分析和驗(yàn)證。
今天我們主要介紹:
Cadence Integrity 3D-IC 系統(tǒng)級規(guī)劃
1.系統(tǒng)級規(guī)劃和優(yōu)化
2.系統(tǒng)連接性檢查
3.Integrity 3D-IC 與系統(tǒng)分析工具的融合
1. 系統(tǒng)級規(guī)劃和優(yōu)化
芯片的堆疊
Feedthrough 的插入
Bump 的規(guī)劃與優(yōu)化
3D 圖形界面
在傳統(tǒng)的 3D-IC 設(shè)計(jì)當(dāng)中,系統(tǒng)級規(guī)劃通常是通過人工規(guī)劃來實(shí)現(xiàn)的。這使得系統(tǒng)級的更新需要比較長的迭代周期。Integrity 3D-IC 系統(tǒng)級規(guī)劃工具可自動(dòng)高效地實(shí)現(xiàn)芯片的堆疊、feedthrough 的插入、Bump 的規(guī)劃和優(yōu)化等功能。工具可以實(shí)時(shí)顯示每個(gè)操作的結(jié)果,讓用戶對于設(shè)計(jì)的結(jié)果一目了然。
與此同時(shí),TCL 命令的引入讓用戶可以像使用數(shù)字后端工具一樣,通過腳本來進(jìn)行系統(tǒng)設(shè)計(jì)和定制自動(dòng)化流程。這也是 Integrity 3D-IC 平臺(tái)最為突出的特點(diǎn)之一。
芯片的堆疊:
在 Integrity 3D-IC 當(dāng)中,用戶可以在圖形界面上或者 TCL 命令輕松地更改芯片的擺布和堆疊。Integrity 3D-IC 支持所有的堆疊方式,包括 Face-to-Face, Face-to-Back, Back-to-Back 和 Back-to-Face。堆疊方式更新的結(jié)果也能夠?qū)崟r(shí)顯示在圖形界面上。


Feedthrough 的插入:
系統(tǒng)的輸入輸出通常存在于封裝上,上層芯片輸入輸出信號有時(shí)候需要穿過下層芯片,而并不與下層芯片發(fā)生數(shù)據(jù)交換,這樣的路徑我們稱為 feedthrough。比如在下圖所示的系統(tǒng)中,bottom_die 當(dāng)中的路徑A起到了連接 top_die 和封裝 PKG 的作用。這樣的路徑就是 feedthrough :

然而,feedthrough 路徑可能并沒有被插入到下層芯片的邏輯網(wǎng)表當(dāng)中。比如上圖所示路徑A,就可能直接由 PKG 的端口連接到 top_die 的端口。Integrity 3D-IC 提供了自動(dòng)插入 feedthrough 的功能。
在下圖當(dāng)中,我們列出了一些比較常見的 feedthrough 的插入:

Bump 的規(guī)劃與優(yōu)化:
Bump 的規(guī)劃和芯片當(dāng)中的功能模塊密切相關(guān)。如果 Bump 距離功能模塊的輸入輸出太遠(yuǎn),會(huì)對時(shí)序產(chǎn)生不好的影響。Integrity 3D-IC 可以快速地完成基于芯片功能模塊的 Bump 規(guī)劃。用戶可以分區(qū)域指定 Bump pattern(包括Bump cell,Bump pitch,stagger等),從而可以對不同的 power domain 或 IP block 區(qū)域創(chuàng)建不同的 Bump,如下圖所示:
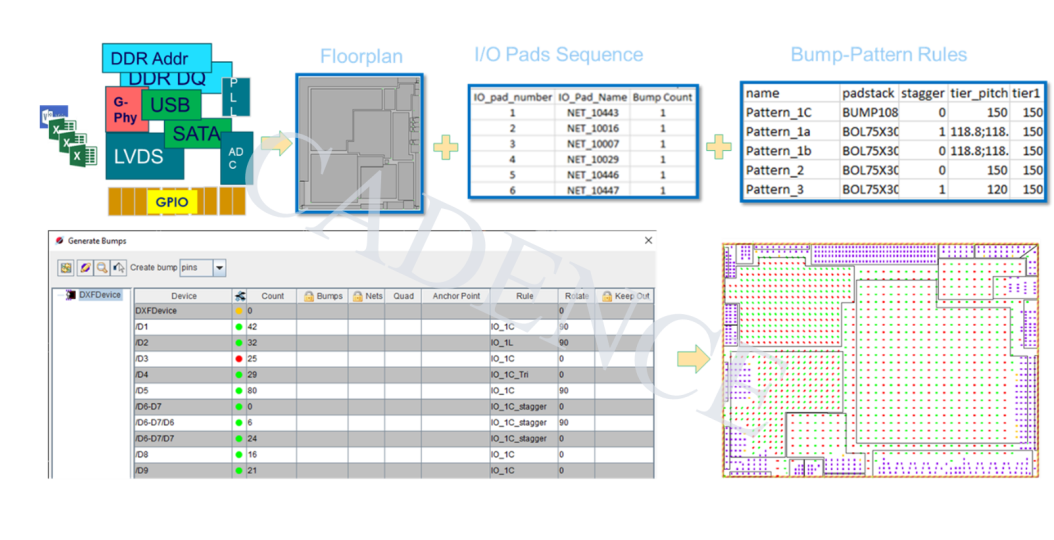
Bump 規(guī)劃完成之后,需要檢查 Bump 之間的連接關(guān)系有沒有交叉的部分。如果發(fā)生交叉,對后續(xù)的 Bump 繞線有比較大的影響。我們最好能夠在系統(tǒng)級規(guī)劃的階段解決交叉的問題,避免繞線完成之后再進(jìn)行迭代。
Integrity 3D-IC 提供了一種自動(dòng)解決連接交叉的方案:
將比較關(guān)鍵的 Bump 端固定,對另一端進(jìn)行自動(dòng)優(yōu)化。經(jīng)過優(yōu)化,達(dá)到 Bump 連接交叉比較少的狀態(tài),從而讓后續(xù) Bump 繞線變得更加容易。

3D圖形界面:
芯片設(shè)計(jì)進(jìn)入三維之后,連接關(guān)系也從平面走向立體。Integrity 3D-IC 推出了三維圖形界面,讓 3D-IC 設(shè)計(jì)更加直觀具體。
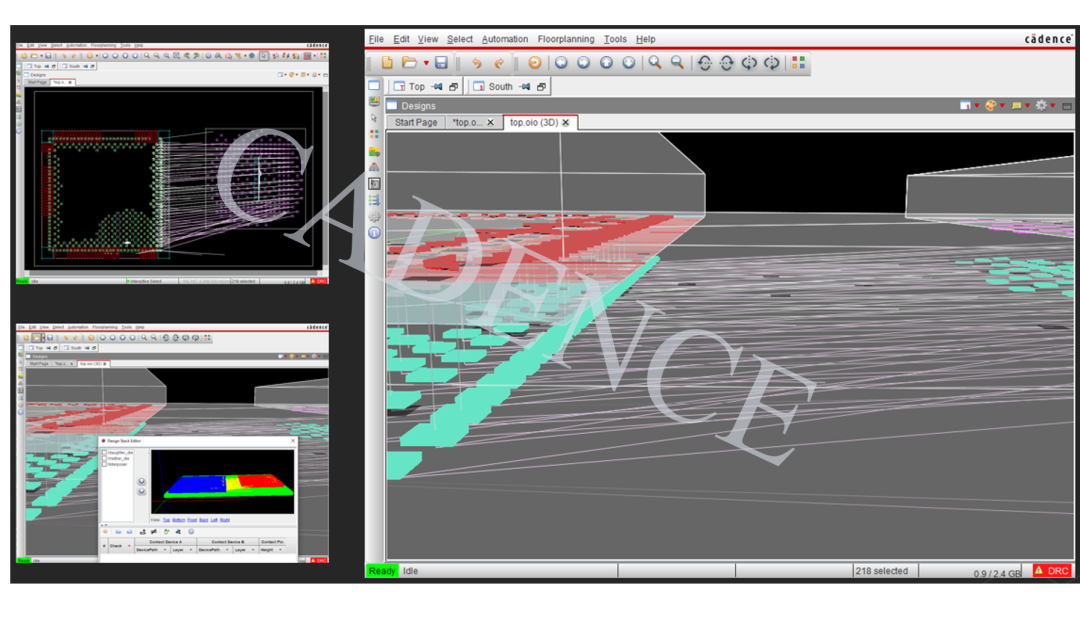

2.系統(tǒng)連接性檢查
芯片間接口連接性實(shí)時(shí)自動(dòng)檢查
系統(tǒng)連接關(guān)系圖
在 3D-IC 設(shè)計(jì)中,芯片間接口連接性是非常關(guān)鍵的,會(huì)直接影響最后的 LVS 核簽。Integrity 3D-IC 提供了自動(dòng)檢查和手動(dòng)檢查兩種方式。
芯片間接口連接性實(shí)時(shí)自動(dòng)檢查:
Integrity 3D-IC 提供了實(shí)時(shí)自動(dòng)檢查的功能,用來檢查做完 Bump 規(guī)劃和優(yōu)化之后,Bump 的物理連接關(guān)系是不是和邏輯連接關(guān)系一致。這個(gè)檢查是實(shí)時(shí)的,不需要通過LVS簽核工具來進(jìn)行迭代。
如果有懸空的 Bump、Bump offset、不正確的 Bump 物理連接等問題都會(huì)被報(bào)出來。用戶可以在早期解決這些問題,從而避免在物理實(shí)現(xiàn)做完之后才通過 LVS 核簽工具發(fā)現(xiàn)這些問題,增加迭代的周期。這個(gè)檢查有一點(diǎn)類似于 Innovus 當(dāng)中的 connectivity check。

系統(tǒng)連接關(guān)系圖:
在系統(tǒng)連接性檢查當(dāng)中,用戶如果想對某一條路徑的連接性進(jìn)行 debug,可以使用 Integrity 3D-IC 的系統(tǒng)連接關(guān)系圖。這個(gè)圖可以將特定路徑的全部系統(tǒng)連接關(guān)系顯示出來。用戶可以基于結(jié)果進(jìn)行調(diào)試。

3.
Integrity 3D-IC
與系統(tǒng)分析工具的融合

在做完系統(tǒng)級規(guī)劃之后,我們希望能夠直接進(jìn)入物理實(shí)現(xiàn)工具做芯片物理實(shí)現(xiàn),或者進(jìn)入分析和驗(yàn)證工具做早期系統(tǒng)分析驗(yàn)證。
Integrity 3D-IC 和 Cadence 的數(shù)字后端工具 Innovus、模擬版圖工具 Virtuoso、封裝設(shè)計(jì)工具 Allegro 工具等都實(shí)現(xiàn)了不同程度的集成。不同工具之間可以實(shí)現(xiàn)數(shù)據(jù)的無損交換和設(shè)計(jì)環(huán)境的自由切換。
Integrity 3D-IC 也提供了和部分常用 Cadence 分析工具的接口,包括熱分析工具 Celsius、功耗分析工具 Voltus、靜態(tài)時(shí)序分析工具 Tempus、物理驗(yàn)證工具 Pegasus。工具提供了 Flow Manager 的圖形界面,來方便用戶方便地使用各種分析驗(yàn)證工具,而不受制于分析驗(yàn)證工具使用經(jīng)驗(yàn)這部分內(nèi)容我們后續(xù)會(huì)做具體詳細(xì)的介紹,這里就不再贅述。
至此,我們簡單地介紹了 Integrity 3D-IC 系統(tǒng)級規(guī)劃平臺(tái)的特點(diǎn),包括系統(tǒng)級規(guī)劃和優(yōu)化、系統(tǒng)連接性檢查、Integrity 3D-IC 與其他工具的融合。希望 Integrity 3D-IC 能夠方便越來越多工程師的系統(tǒng)設(shè)計(jì),加速優(yōu)秀的芯片產(chǎn)品落地,推動(dòng)后摩爾時(shí)代的發(fā)展。
Integrity 3D-IC 介紹:
Cadence Integrity 3D-IC 平臺(tái)提供了一個(gè)高效的解決方案,用于部署 3D 設(shè)計(jì)和分析流程,以實(shí)現(xiàn)強(qiáng)大的硅堆疊設(shè)計(jì)。該平臺(tái)是 Cadence 數(shù)字和簽核產(chǎn)品組合的一部分,支持 Cadence 公司的智能系統(tǒng)設(shè)計(jì)戰(zhàn)略(Intelligent System Design) ,旨在實(shí)現(xiàn)系統(tǒng)驅(qū)動(dòng)的卓越 SoC 芯片設(shè)計(jì)。
關(guān)于 Cadence
Cadence 在計(jì)算軟件領(lǐng)域擁有超過 30 年的專業(yè)經(jīng)驗(yàn),是電子系統(tǒng)設(shè)計(jì)產(chǎn)業(yè)的關(guān)鍵領(lǐng)導(dǎo)者。基于公司的智能系統(tǒng)設(shè)計(jì)戰(zhàn)略,Cadence 致力于提供軟件、硬件和 IP 產(chǎn)品,助力電子設(shè)計(jì)概念成為現(xiàn)實(shí)。Cadence 的客戶遍布全球,皆為最具創(chuàng)新能力的企業(yè),他們向超大規(guī)模計(jì)算、5G 通訊、汽車、移動(dòng)、航空、消費(fèi)電子、工業(yè)和醫(yī)療等最具活力的應(yīng)用市場交付從芯片、電路板到完整系統(tǒng)的卓越電子產(chǎn)品。Cadence 已連續(xù)八年名列美國財(cái)富雜志評選的 100 家最適合工作的公司。如需了解更多信息,請?jiān)L問公司網(wǎng)站 cadence.com。
2022 Cadence Design Systems, Inc. 版權(quán)所有。在全球范圍保留所有權(quán)利。Cadence、Cadence 徽標(biāo)和 www.cadence.com/go/trademarks 中列出的其他 Cadence 標(biāo)志均為 Cadence Design Systems, Inc. 的商標(biāo)或注冊商標(biāo)。所有其他標(biāo)識均為其各自所有者的資產(chǎn)。
-
集成電路
+關(guān)注
關(guān)注
5420文章
11975瀏覽量
367443 -
IC設(shè)計(jì)
+關(guān)注
關(guān)注
38文章
1351瀏覽量
105344 -
封裝
+關(guān)注
關(guān)注
128文章
8568瀏覽量
144924 -
Cadence
+關(guān)注
關(guān)注
67文章
966瀏覽量
143941 -
3DIC
+關(guān)注
關(guān)注
3文章
86瀏覽量
19708
原文標(biāo)題:3D-IC 設(shè)計(jì)之如何實(shí)現(xiàn)高效的系統(tǒng)級規(guī)劃
文章出處:【微信號:gh_fca7f1c2678a,微信公眾號:Cadence楷登】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
Cadence攜手TSMC開發(fā)3D IC設(shè)計(jì)基礎(chǔ)架構(gòu)
如何建立正確的3D-IC設(shè)計(jì)實(shí)現(xiàn)流程和實(shí)現(xiàn)項(xiàng)目高效管理的挑戰(zhàn)
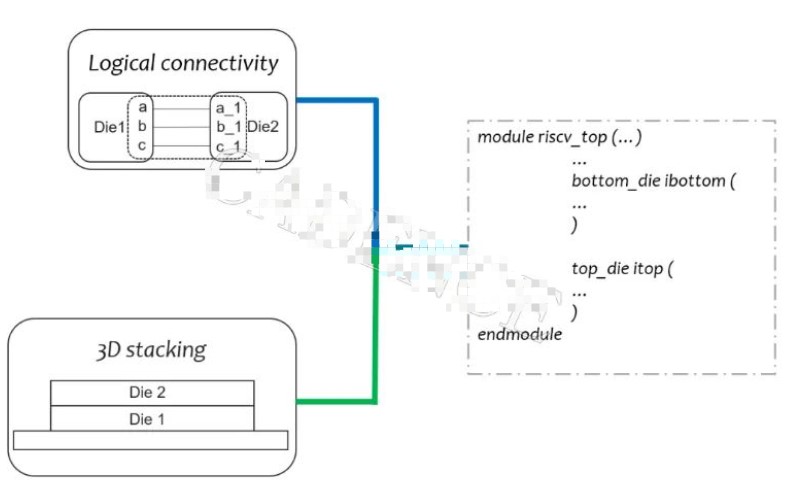
Cadence推出Clarity 3D場求解器,擁有近乎無限的處理能力
Cadence 憑借突破性的 Integrity 3D-IC 平臺(tái)加速系統(tǒng)創(chuàng)新
TSMC 和 Cadence 合作開發(fā)3D-IC參考流程以實(shí)現(xiàn)真正的3D堆疊
Cadence Integrity 3D-IC平臺(tái)?支持TSMC 3DFabric技術(shù),推進(jìn)多Chiplet設(shè)計(jì)
Cadence Integrity 3D-IC平臺(tái)進(jìn)行工藝認(rèn)證
Cadence Clarity 3D Solver 2022版本發(fā)布 電磁設(shè)計(jì)同步分析功能提高效率
Integrity?3D-IC平臺(tái)助力設(shè)計(jì)者實(shí)現(xiàn)驅(qū)動(dòng)PPA目標(biāo)

3D IC制造技術(shù)已成主流,異構(gòu)3D IC還有待進(jìn)步
Cadence Integrity 3D-IC Platform榮膺“年度EDA/IP/軟件產(chǎn)品”
7.2小時(shí)完成868個(gè)HBM封裝端口——Cadence Clarity 3D Solver仿真案例詳解
產(chǎn)品資訊 | 3D-IC 設(shè)計(jì)之自底向上實(shí)現(xiàn)流程與高效數(shù)據(jù)管理

Cadence 擴(kuò)大了與 Samsung Foundry 的合作,依托 Integrity 3D-IC平臺(tái)提供獨(dú)具優(yōu)勢的參考流程
系統(tǒng)分析大講堂:Clarity 3D Solver 課程新內(nèi)容






 Cadence分析 3D IC設(shè)計(jì)如何實(shí)現(xiàn)高效的系統(tǒng)級規(guī)劃
Cadence分析 3D IC設(shè)計(jì)如何實(shí)現(xiàn)高效的系統(tǒng)級規(guī)劃










評論