當 GaNHEMT在較大漏極偏壓下工作時,溝道電場特別是柵極漏側電場峰產生的熱電子會發射大量縱向光學(LO)聲子對晶格升溫,LO聲子可以被其他電子重吸收,或者退化為橫向光學(TO)聲子和聲學聲子,其中只有聲學聲子將溝道內的熱量傳輸到襯底,從而實現溝道的散熱,但是這個過程大約需要350fs,遠大于熱電子激發LO聲子的時間(約10fs),又由于GaN本身的強離子性,光學聲子的群速度接近零,故大量的縱向光學聲子在溝道內集聚,成為散熱的障礙,從而導致器件載流子遷移率降低,漏電流在飽和區會隨著漏源電壓的升高而下降,這種現象稱為“自熱效應”。自熱效應不僅導致 GaN HEMT微波功率輸出能力降低,還會影響器件的可靠性。因此從提高模型的預測精度和指導器件設計優化、提高可靠性的考慮出發,器件熱電模型都是GaN HEMT大功率器件必須考慮的重要問題。本文將從器件件熱產生機理和物理模型出發,分析毫米波GaN器件熱電效應,為建立適合熱電等效電路模型拓撲提供重要的理論依據。
針對熱效應機理和熱電模型,我們將著重考慮熱導率和飽和速率隨晶格溫度的變化。由于熱電效應最直接的外部反映是就是直流I-V特性,因此這里主要模擬GaN HEMT器件的直流特性曲線。通過編寫 Silvaco程序來模擬 GaN HEMT器件的特性曲線,再與實驗曲線作對比,獲得準確的模型參數。
圖1為利用上述方法建立的包含熱電效應的 GaN HEMT物理模型,仿真和實測結果比較表明該方法建立的物理模型具有較高精度,能準確反映器件的自熱效應。

圖1 包含自熱效應的物理模型I-V仿真和實測結果比較
圖2為利用該模型在考慮自熱效應和不考慮自熱效應的情況下模型仿真結果對比。可以看出在考慮自熱效應和不考慮自熱效應兩種情況下漏電流的差異明顯,原因是如果不考慮自熱效應,則認為溝道溫度是定值,而實際上當漏源電壓升高時,耗散功率變大,異質結溫度升高,電子遷移率減小,引起飽和漏源電流下降。

圖2 考慮自熱效應和不考慮自熱效應的物理模型仿真結果對比
為進一步分析器件內部溫度分布,基于Silvaco中建立的物理模型可以對不同材料和不同器件結構的GaN HEMT進行熱分析。圖3為利用GaN HEMT物理模型對藍寶石襯底(左)和SiC襯底(右) GaN HEMT的熱分布仿真,可見,在相同功耗下,SiC襯底的HEMT內部溫度遠低于以藍寶石為襯底的HEMT的內部溫度,自熱效應相應也不如后者明顯,能更大限度發揮GaN的材料優勢。該分析結果與實際器件測試結果吻合,充分證明了該方法的可行性。
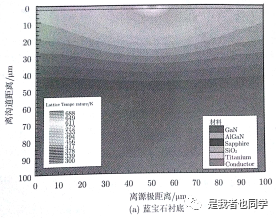
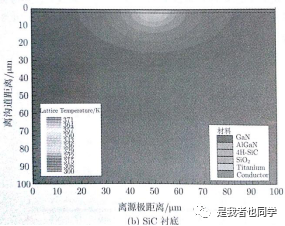
圖3 GaNHEMT內部熱分布
可見通過建立包含熱電效應的GaN HEMT器件物理可以有效分析器件熱電效應和器件背部熱分布,從而可更好地指導熱電等效電路建模和器件結構設計。
利用上述方法,建立包含自然效應的0.15μm柵長GaN HEMT器件物理模型,得到器件的直流I-V特性曲線和內部溫度分布,分析器件結構對溝道溫度分布的影響。仿真分析的單指器件結構如圖4所示,包括80μm的SiC襯底、2μm的GaN緩沖層、1nm的AlN插入層和20nm的AlGaN勢壘層(Al摩爾組分為0.26),SiN鈍化層厚度為100nm。器件的柵長為0.15μm,柵源距離為1μm,柵漏距離為2μm,漏源歐姆接觸電阻設置為0.26?·mm。
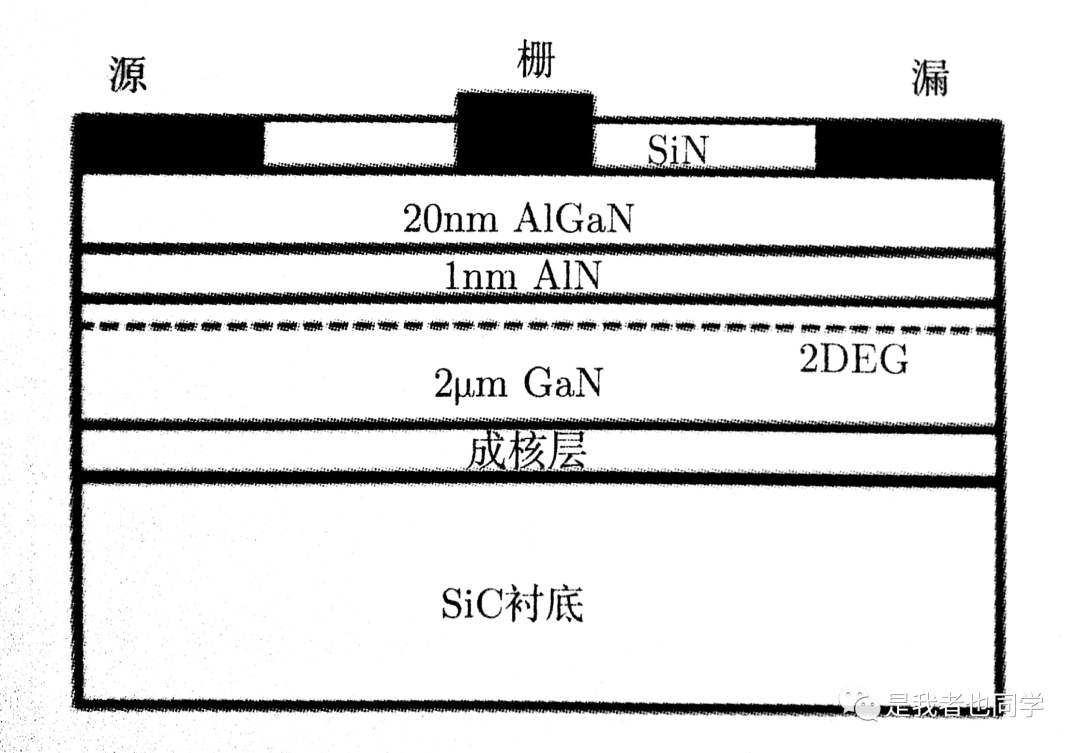
圖4 0.15μm柵長 GaNHEMT器件結構示意圖
GaNHEMT器件的直流仿真包括Ids-Vds特性曲線、Ids-Vgs特性曲線和gm-Vgs特性曲線。圖5為器件的Ids-Vds曲線,其中實線為不考慮自熱效應的Ids-Vds特性曲線,方塊為考慮器件自熱效應的lds-Vds特性曲線。仿真時器件的柵源電壓從1V變化到-4V,步長為-1V。從圖5中可以看出,當柵壓為-4V時,器件處于截止狀態。

圖5 器件Ids-Vds特性曲線
從Ids-Vds曲線圖可以看到,隨著漏源電壓的增大,考慮自熱效應的直流Ids-Vds曲線和不考慮自熱效應的Ids-Vds。曲線相比,漏源電流有明顯的下降。這是由考慮自熱效應時,器件的溝道溫度隨著漏壓的增大而升高導致溝道載流子遷移率的下降所造成的。同時也注意到,隨著柵源電壓的增大,漏源電流下降的幅度也增大。圖6為漏源電壓Vds=14V時不同柵壓下器件溝道溫度峰值的分布曲線,可以看出,當柵壓增加時,溝道溫度急劇上升。在對GaN HEMT器件進行降額設計時,應控制器件的柵壓處于合適的范圍內,從而達到對器件溝道峰值結溫的控制,增加其可靠性。
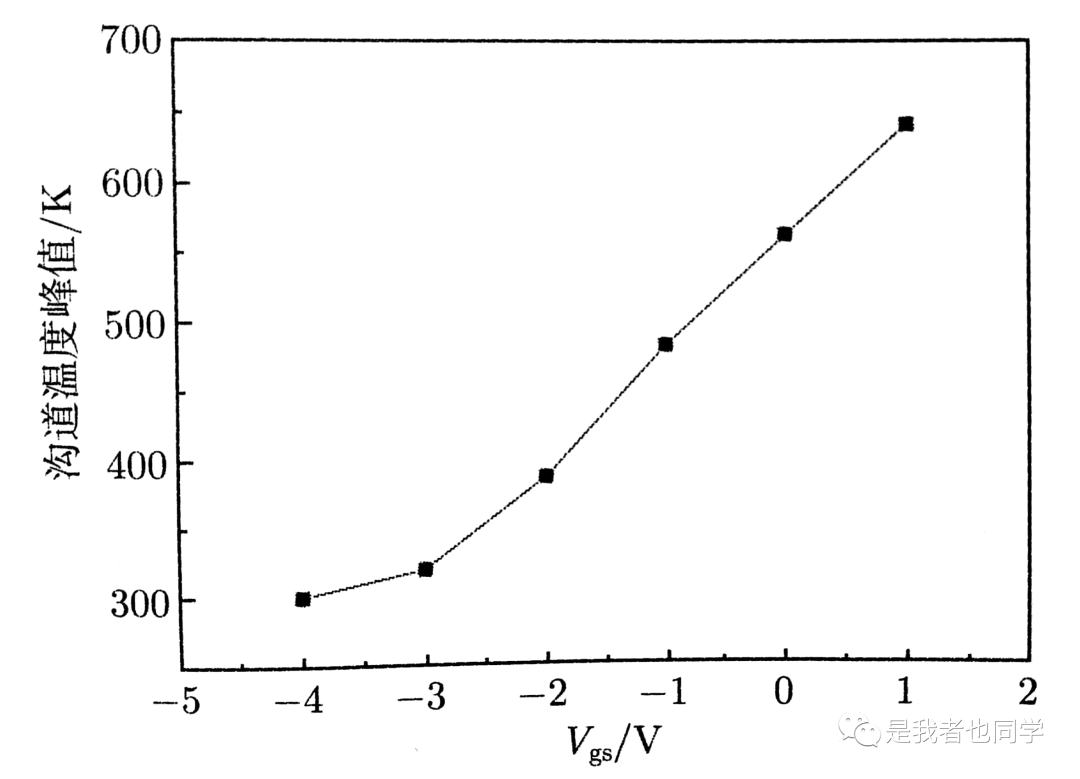
圖6 不同柵壓下器件溝道溫度峰值
器件的lds-Vgs和gm-Vgs曲線如圖7所示。其中,實線為Ids-Vds特性曲線,方塊為 gm-Vgs特性曲線。方塊為gm-Vgs特性曲線。從圖7中可以看出,器件的閾值電壓為-3.5V,與圖6的分析一致,器件在柵壓為-2V時獲得最大跨導325mS/mm。

圖7 器件的lds-Vds和gm-Vgs特性曲線
柵壓為0V,漏壓為15V時器件溝道溫度和電場分布曲線如圖8所示。
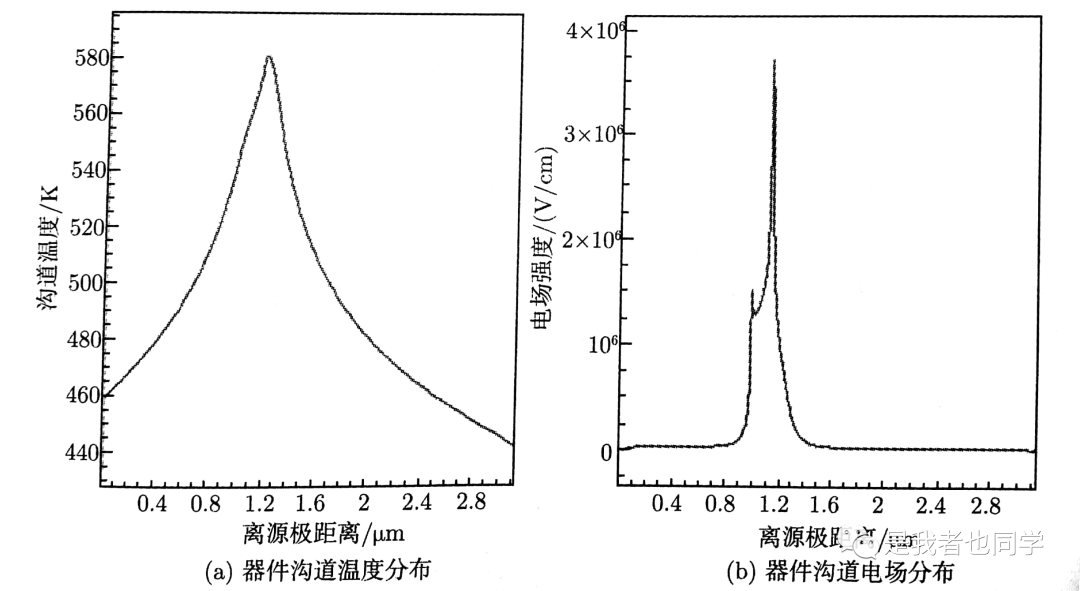
圖8 器件溝道溫度和電場分布曲線
從圖8可以看出,熱源主要集中于柵極底部,靠近漏極一側,與強電場區域相對應。此時器件的溝道由于受到強電場的加速以及聲子間、聲子與電子間、聲子與雜質原子間的散射等,載流子與晶格間發生能量交換,局部晶格的溫度迅速升高,而晶格溫度的升高又引起載流子散射幾率的增大,如此循環、惡化使該區域的溫度急劇升高,這就解釋了器件的熱生成機制,同時也確定了熱生成區域。器件結構參數對溝道溫度的影響如下。
1)柵源距離對溝道溫度的影響
仿真時固定器件的柵漏距離為2μm,柵源距離從1μm變化到2μm。仿真得到的器件溝道峰值溫度及漏源電流隨柵源距離變化的曲線如圖9所示。從圖中可以看出,隨著柵源距離的減小,溝道溫度上升,但漏源電流也隨之增大。說明隨著柵源距離的減小,溝道溫度上升對漏源電流的影響小于距離減小的影響。
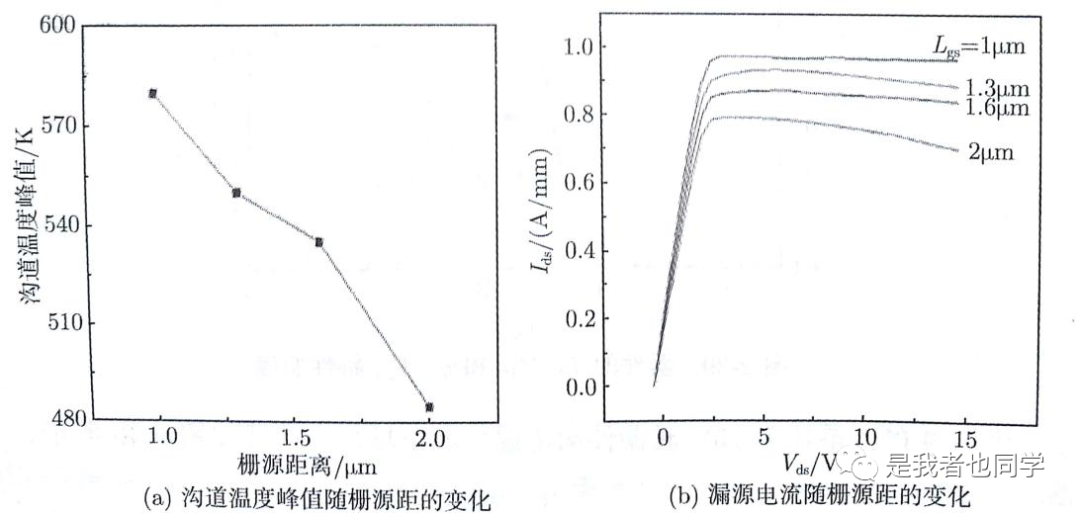
圖9 不同柵源距器件溝道溫度峰值和漏源電流曲線
2)柵漏距離對溝道溫度的影響
固定器件的柵源距離為1μm,柵漏距離從1μm變化到3μm,步長為0.5μm。仿真得到的器件溝道峰值溫度及漏源電流隨柵漏距離變化的曲線如圖10所示。從圖中可以看出,隨著柵漏距離的減小,溝道溫度有所上升,漏源電流也有一定幅度的增大。對比圖9,柵漏距離對溝道溫度和源漏電流的影響不是很大。
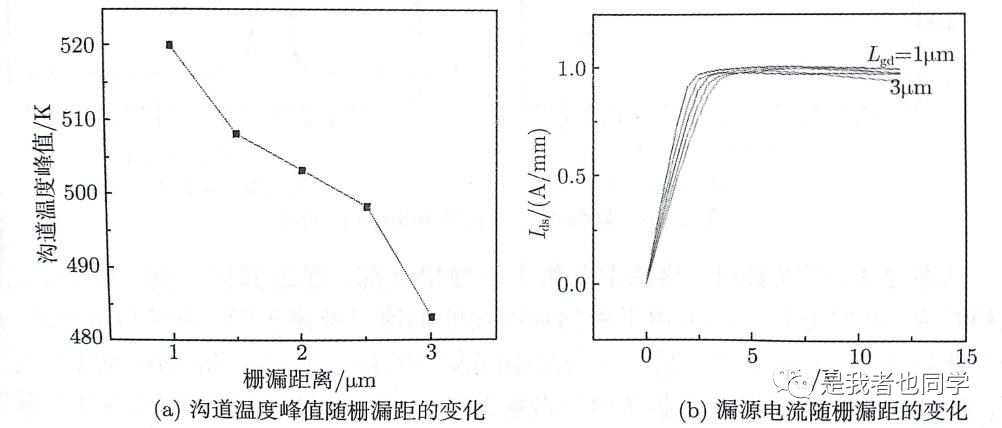
圖10 不同柵漏距器件溝道溫度峰值和漏源電流曲線
3)柵指對溝道溫度的影響
圖11為單指、雙指、四指和八指器件溝道溫度分布曲線,仿真時柵源電壓為0V,柵漏電壓為15V,處于飽和工作狀態。可以看出,熱點出現在柵指處,且中間柵指溫度高于邊緣柵指溫度,說明中間柵指承受的熱耗散功率高于邊緣柵指。設計器件時,可以通過增大中間柵指間的距離來降低中間溝道溫度的峰值。

圖11 不同柵指器件溝道溫度分布曲線
GaN HEMT工作時的溫度分布如圖12所示,可以看出自熱導致熱量主要集中于溝道中靠近漏極一側的柵極邊緣,這主要是由于此處的電場強度最大。

圖12 GaN HEMT紅外成像(IR)熱分布圖
溫度升高引起電子遷移率降低,低場電子遷移率隨電子濃度和溫度的變化可以用如下公式表示:

如圖13所示,隨著溫度的升高,電子遷移率逐漸下降,由電流公式可知,相應的漏極電流也會減小,從而降低了器件的輸出功率大小。因此,自熱效應是制約微波毫米波 GaN HEMT功率性能的重要因素。

圖13 GaNHEMT電子遷移率隨電子濃度及溫度的變化
審核編輯 :李倩
-
功率器件
+關注
關注
42文章
1923瀏覽量
92313 -
熱導率
+關注
關注
0文章
44瀏覽量
9417
原文標題:GaN-HEMT器件自熱效應
文章出處:【微信號:是我者也同學,微信公眾號:是我者也同學】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
毫米波雷達信號的傳輸特性
毫米波雷達的基頻和調制技術 毫米波雷達在機器人導航中的應用
毫米波雷達與超聲波雷達的區別
毫米波雷達技術優勢分析 毫米波雷達在安防監控中的應用
毫米波雷達工作原理 毫米波雷達應用領域
物聯網中的高分辨率精確距離測量方案_毫米波雷達
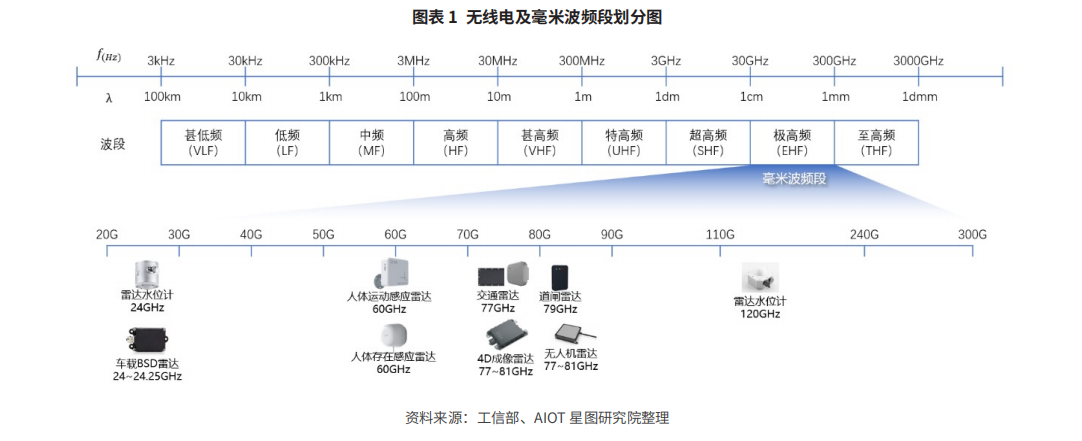
什么是毫米波雷達?毫米波雷達模組選型

毫米波雷達是聲波還是電磁波
毫米波雷達與多普勒雷達區別是什么
簡述毫米波雷達的結構、原理和特點
毫米波雷達具有哪些特點和優勢
毫米波應用5G手機低介電絕緣透波散熱膜






 分析毫米波GaN器件熱電效應
分析毫米波GaN器件熱電效應











評論