現(xiàn)如今在使用的陶瓷基板或底座通常基于銀印刷、直接鍵合銅陶瓷DBC或LTCC低溫共燒陶瓷、HTCC高溫共燒陶瓷技術(shù)。
1、由于絲網(wǎng)印刷工藝的限制,Ag印刷、LTCC和HTCC基板的分辨率和導(dǎo)電材料厚度較差,較差的分辨率使這些材料難以用于高密度和倒裝芯片器件設(shè)計,并且相關(guān)的更薄的導(dǎo)電材料(通常<20um)限制了設(shè)計的額定功率。
2、DBC目前廣泛應(yīng)用于電源電路設(shè)計,但由于覆銅工藝要求,需要300um以上的銅層厚度。任何較低銅厚度的設(shè)計都應(yīng)該進(jìn)行額外昂貴的研磨。此外,DBC材料難以提供給多層走線設(shè)計。
為了高功率和高器件密度應(yīng)用提供具有多層陶瓷基板的解決方案。此外,還要考慮材料特性,金屬/陶瓷的附著力,以下是開發(fā)所需的材料特性:
1、低電阻材料:銅;
2、厚度超過3盎司的厚跡線材料;
3、用于TSV電鍍(鉆孔AI2O3/AIN基板)或非收縮LTCC材料的高導(dǎo)熱性和穩(wěn)定性陶瓷;
4、高金屬跡線分辨率,線寬和間距僅為50um;
5、良好的金屬/陶瓷粘合均勻性和強(qiáng)度要求,金屬/陶瓷之間的空隙<1%;粘合強(qiáng)度>2kg/2*2mm;
金屬痕跡電鍍:針對微量金屬的高分辨率和更低材料電阻的要求,我們引入了電鑄直接鍍銅DPC技術(shù)。
使用鈦?zhàn)鳛殂~和陶瓷之間的組合/緩沖層將第一層銅濺射在陶瓷基板上,以提供良好的粘合強(qiáng)度和穩(wěn)定性。第二種銅是通過電鑄工藝制成的,以將其厚度增加到3到5盎司。(100um~150um)金屬跡線電鍍的關(guān)鍵技術(shù)是濺射層的材料控制和電鍍過程中第二銅層的應(yīng)力釋放。
多層陶瓷基板:對于雙層設(shè)計,我們使用帶有導(dǎo)電通孔設(shè)計的燒結(jié)AI2O3或者AIN陶瓷基板,通孔由激光鉆孔制成。正面和背面的導(dǎo)電通過以下電鍍工藝連接。
該工藝的關(guān)鍵技術(shù)是過孔的穩(wěn)定性,我們必須確保高溫激光鉆孔過程中的通孔清潔、雜質(zhì)去除和材料變化得到很好的控制。
對于三層以上的設(shè)計,使用不收縮的LTCC。不收縮的LTCC的尺寸失配可以控制在100um以內(nèi),比普通的LTCC/HTCC好很多,通過后續(xù)DPC工藝的修正,可以將金屬跡線的公差控制在<30um。該工藝的關(guān)鍵技術(shù)是不收縮的LTCC技術(shù)和DPC金屬在LTCC材料上的附著力。
【文章來源:展至科技】
審核編輯 黃昊宇
-
陶瓷基板
+關(guān)注
關(guān)注
5文章
235瀏覽量
11769
發(fā)布評論請先 登錄
LTCC材料技術(shù)解析,多層集成與高頻適配的電子封裝基石
引領(lǐng)產(chǎn)業(yè)變革的先鋒陶瓷材料

為什么選擇DPC覆銅陶瓷基板?
陶瓷基板五大工藝技術(shù)深度剖析:DPC、AMB、DBC、HTCC與LTCC的卓越表現(xiàn)

DPC、AMB、DBC覆銅陶瓷基板技術(shù)對比與應(yīng)用選擇

氮化鋁陶瓷基板:高性能電子封裝材料解析
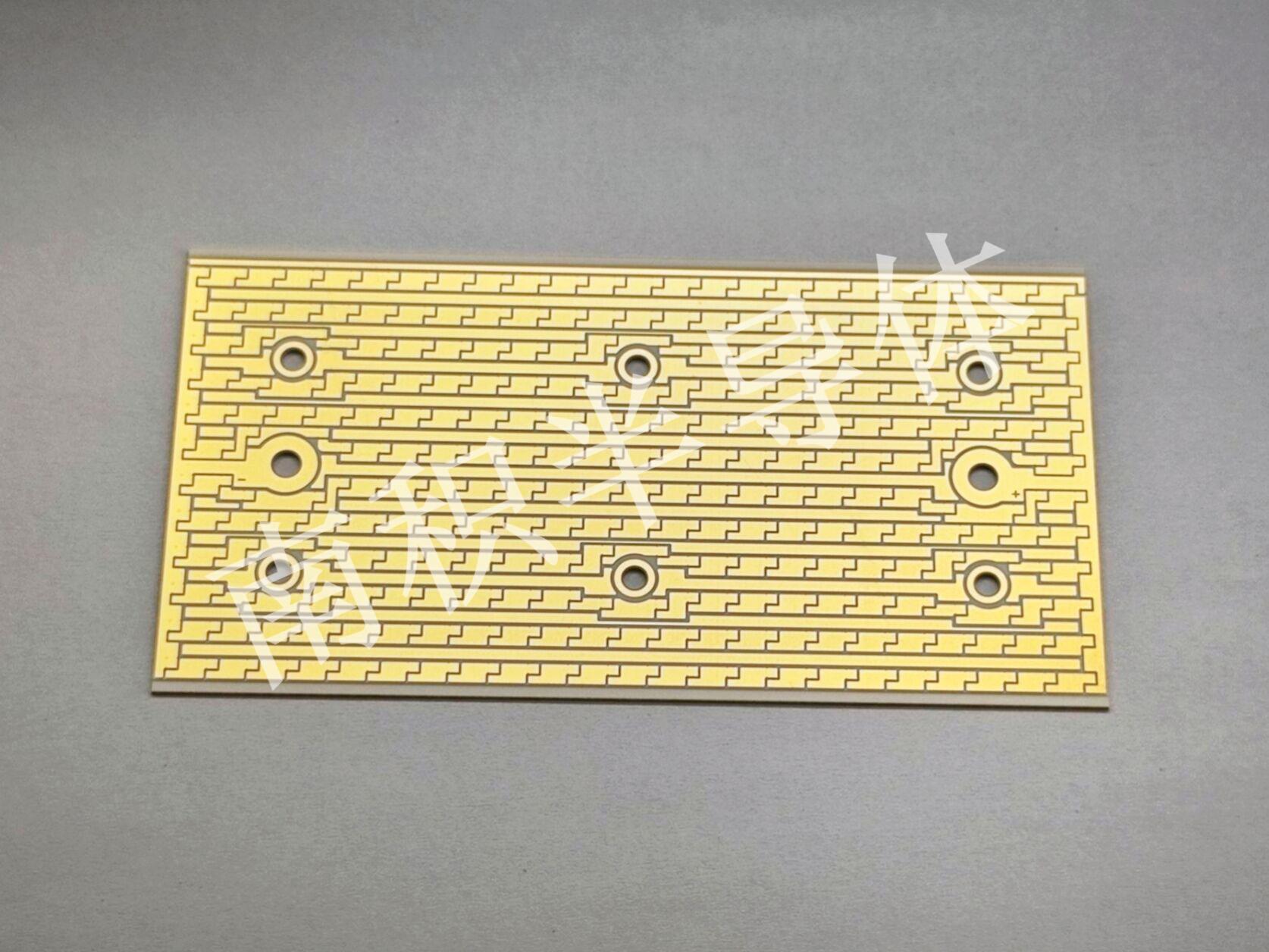
DOH技術(shù)工藝方案解決陶瓷基板DBC散熱挑戰(zhàn)問題

為何陶瓷能導(dǎo)熱卻不導(dǎo)電
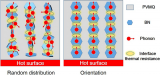
陶瓷電容的密度與什么有關(guān)?
金融界:萬年芯申請預(yù)置焊接合金材料的陶瓷基板專利

村田貼片電容用陶瓷材料的物理常數(shù)
光纜有哪些方面用到陶瓷材料
高功率器件設(shè)備散熱用陶瓷基板 | 晟鵬耐高溫高導(dǎo)熱絕緣片

高導(dǎo)熱陶瓷基板,提升性能必備
陶瓷基板技術(shù)PK:DBC vs DPC,你站哪一邊?






 低溫共燒陶瓷基板上的直接鍍銅DPC陶瓷材料
低溫共燒陶瓷基板上的直接鍍銅DPC陶瓷材料










評論