·成功克服面板翹曲,打造業(yè)界最大生產(chǎn)面積700mm x 700mm
·生產(chǎn)設(shè)備已出貨全球知名半導(dǎo)體制造商進行試產(chǎn)
·板級封裝為芯片整合注入新生產(chǎn)模式;也為中國芯片產(chǎn)品自主化注入新契機
活躍于全球并具有廣泛技術(shù)組合的高科技設(shè)備制造商Manz 集團,掌握全球半導(dǎo)體先進封裝趨勢,加速開發(fā)新一代專利垂直電鍍生產(chǎn)設(shè)備并無縫整合濕法化學(xué)工藝設(shè)備、自動化設(shè)備,以優(yōu)異的設(shè)備制程經(jīng)驗以及機電整合能力, 打造新一代板級封裝中的細微銅重布線路層(RDL)生產(chǎn)線,生產(chǎn)面積達業(yè)界最大基板尺寸700mm x 700mm,創(chuàng)下板級封裝生產(chǎn)效率的新里程碑!
板級封裝是兼具大產(chǎn)能及成本優(yōu)勢的新技術(shù), Manz是板級封裝RDL工藝的市場領(lǐng)跑者之一,從研發(fā)515mm x 510mm面板開始,再演進至600mm x 600 mm,今年成功克服面板翹曲而打造700mmx700mm的業(yè)界最大面板生產(chǎn)尺寸。目前,Manz生產(chǎn)設(shè)備已出貨全球知名半導(dǎo)體制造商,應(yīng)用于車載與射頻芯片的封裝量產(chǎn),展現(xiàn)了新技術(shù)的實力!

Manz新一代板級封裝 RDL生產(chǎn)線不僅僅提升生產(chǎn)效率,同時也兼顧成本及產(chǎn)品性能。該生產(chǎn)線以大面積電鍍制作精密的RDL層銅線路,克服電鍍與圖案化均勻度、分辨率與高度電氣連接性的挑戰(zhàn),涵蓋傳統(tǒng)強項濕法化學(xué)工藝的洗凈、顯影、蝕刻、剝膜與關(guān)鍵電鍍銅設(shè)備,同時實現(xiàn)全線的自動化生產(chǎn)。此外,Manz還積極整合材料商、上下游設(shè)備商,為客戶提供完整的RDL生產(chǎn)設(shè)備及工藝規(guī)劃服務(wù),從自動化、材料使用與環(huán)保多維度協(xié)助客戶打造高效生產(chǎn)解決方案并優(yōu)化制程良率及降低制造成本。
創(chuàng)新無治具板級電鍍系統(tǒng),兼顧大面積與高均勻度之應(yīng)用需求
在大面積板級封裝生產(chǎn)時,要達成高均勻線路重分布層的實踐,電鍍設(shè)備是關(guān)鍵。Manz創(chuàng)新杯式垂直電鍍系統(tǒng)設(shè)計,不需笨重密封的陰極治具,多分區(qū)陽極設(shè)計,能達成高均勻性電鍍。
高精度自動化移載系統(tǒng),達成自動化生產(chǎn)
搭配無治具基板之高精度移載與上下板技術(shù),開發(fā)新移載架構(gòu),取代機械手臂,以縮小系統(tǒng)占地面積。并結(jié)合真空吸盤設(shè)計,無損基板且避免斷電掉板之生產(chǎn)問題。
板級封裝技術(shù) ━━車規(guī)級芯片中功率半導(dǎo)體、傳感器及通信芯片最佳生產(chǎn)解決方案之一
全球芯片應(yīng)用端在發(fā)生變化,消費性電子產(chǎn)品如智能手機、 PC 、 NB 等供需緊張情形趨緩,取而代之的是5G、物聯(lián)網(wǎng)、車用電子對芯片的需求成為持續(xù)驅(qū)動芯片生產(chǎn)的主要動能。相關(guān)機構(gòu)預(yù)測,到2026年時,車用芯片市場占有率及年增長率將雙雙提升。
中國電動汽車發(fā)展迅速,2021年純電車產(chǎn)量已占全球的50%,但功率半導(dǎo)體、傳感器及通信芯片等主要車用芯片的國產(chǎn)化率卻不及12%。要快速發(fā)展國內(nèi)車規(guī)芯片,先進封裝技術(shù)是一條可靠的技術(shù)路徑。
眾多先進封裝技術(shù)之中,板級封裝技術(shù)因具備大產(chǎn)能且更具成本優(yōu)勢,是目前高速成長功率、傳感器、通信等車規(guī)級/芯片生產(chǎn)的最佳解決方案。未來,隨著政策繼續(xù)力挺半導(dǎo)體產(chǎn)業(yè),電動車持續(xù)帶動車規(guī)級芯片市場需求,車規(guī)級芯片國產(chǎn)化進程有望加速,將促進板級封裝技術(shù)同步發(fā)展。

Manz亞智科技與國內(nèi)產(chǎn)業(yè)鏈進行過多次深入合作,涵蓋產(chǎn)、學(xué)、研,旨在有效推進國內(nèi)板級封裝的建設(shè)。Manz集團亞洲區(qū)總經(jīng)理林峻生先生表示:“我們將繼續(xù)發(fā)揮自身在技術(shù)和市場方面的積累,通過整合,積極推動板級封裝實現(xiàn)產(chǎn)業(yè)化落地,全方位推進國內(nèi)在先進封裝的發(fā)展,為整個產(chǎn)業(yè)生態(tài)的建設(shè)貢獻出更多的力量。”
政府在政策層面上給予先進封裝諸多的支持,各地十四五規(guī)劃都將發(fā)展先進封裝列入其中,以不斷增強產(chǎn)業(yè)國際競爭力、創(chuàng)新力及技術(shù)力。林峻生先生指出:“為了給予客戶全方位的技術(shù)工藝與服務(wù),迎接這一波板級封裝的快速成長,我們在上下游制程工藝及設(shè)備的整合、材料使用皆與供應(yīng)鏈保持密切合作,藉由凝聚供應(yīng)鏈共同目標(biāo),提供給客戶更創(chuàng)新的板級封裝制程工藝技術(shù),為客戶打造高效生產(chǎn)解決方案的同時優(yōu)化制程良率及降低制造成本。我們提供以市場為導(dǎo)向的板級封裝RDL一站式整體解決方案,打造共榮共贏的供應(yīng)鏈生態(tài)。”
·生產(chǎn)設(shè)備已出貨全球知名半導(dǎo)體制造商進行試產(chǎn)
·板級封裝為芯片整合注入新生產(chǎn)模式;也為中國芯片產(chǎn)品自主化注入新契機
活躍于全球并具有廣泛技術(shù)組合的高科技設(shè)備制造商Manz 集團,掌握全球半導(dǎo)體先進封裝趨勢,加速開發(fā)新一代專利垂直電鍍生產(chǎn)設(shè)備并無縫整合濕法化學(xué)工藝設(shè)備、自動化設(shè)備,以優(yōu)異的設(shè)備制程經(jīng)驗以及機電整合能力, 打造新一代板級封裝中的細微銅重布線路層(RDL)生產(chǎn)線,生產(chǎn)面積達業(yè)界最大基板尺寸700mm x 700mm,創(chuàng)下板級封裝生產(chǎn)效率的新里程碑!
板級封裝是兼具大產(chǎn)能及成本優(yōu)勢的新技術(shù), Manz是板級封裝RDL工藝的市場領(lǐng)跑者之一,從研發(fā)515mm x 510mm面板開始,再演進至600mm x 600 mm,今年成功克服面板翹曲而打造700mmx700mm的業(yè)界最大面板生產(chǎn)尺寸。目前,Manz生產(chǎn)設(shè)備已出貨全球知名半導(dǎo)體制造商,應(yīng)用于車載與射頻芯片的封裝量產(chǎn),展現(xiàn)了新技術(shù)的實力!

▲由Manz新一代板級封裝RDL自動化生產(chǎn)線試生產(chǎn)的產(chǎn)品。
Manz新一代板級封裝 RDL生產(chǎn)線不僅僅提升生產(chǎn)效率,同時也兼顧成本及產(chǎn)品性能。該生產(chǎn)線以大面積電鍍制作精密的RDL層銅線路,克服電鍍與圖案化均勻度、分辨率與高度電氣連接性的挑戰(zhàn),涵蓋傳統(tǒng)強項濕法化學(xué)工藝的洗凈、顯影、蝕刻、剝膜與關(guān)鍵電鍍銅設(shè)備,同時實現(xiàn)全線的自動化生產(chǎn)。此外,Manz還積極整合材料商、上下游設(shè)備商,為客戶提供完整的RDL生產(chǎn)設(shè)備及工藝規(guī)劃服務(wù),從自動化、材料使用與環(huán)保多維度協(xié)助客戶打造高效生產(chǎn)解決方案并優(yōu)化制程良率及降低制造成本。
創(chuàng)新無治具板級電鍍系統(tǒng),兼顧大面積與高均勻度之應(yīng)用需求
在大面積板級封裝生產(chǎn)時,要達成高均勻線路重分布層的實踐,電鍍設(shè)備是關(guān)鍵。Manz創(chuàng)新杯式垂直電鍍系統(tǒng)設(shè)計,不需笨重密封的陰極治具,多分區(qū)陽極設(shè)計,能達成高均勻性電鍍。
高精度自動化移載系統(tǒng),達成自動化生產(chǎn)
搭配無治具基板之高精度移載與上下板技術(shù),開發(fā)新移載架構(gòu),取代機械手臂,以縮小系統(tǒng)占地面積。并結(jié)合真空吸盤設(shè)計,無損基板且避免斷電掉板之生產(chǎn)問題。
板級封裝技術(shù) ━━車規(guī)級芯片中功率半導(dǎo)體、傳感器及通信芯片最佳生產(chǎn)解決方案之一
全球芯片應(yīng)用端在發(fā)生變化,消費性電子產(chǎn)品如智能手機、 PC 、 NB 等供需緊張情形趨緩,取而代之的是5G、物聯(lián)網(wǎng)、車用電子對芯片的需求成為持續(xù)驅(qū)動芯片生產(chǎn)的主要動能。相關(guān)機構(gòu)預(yù)測,到2026年時,車用芯片市場占有率及年增長率將雙雙提升。
中國電動汽車發(fā)展迅速,2021年純電車產(chǎn)量已占全球的50%,但功率半導(dǎo)體、傳感器及通信芯片等主要車用芯片的國產(chǎn)化率卻不及12%。要快速發(fā)展國內(nèi)車規(guī)芯片,先進封裝技術(shù)是一條可靠的技術(shù)路徑。
眾多先進封裝技術(shù)之中,板級封裝技術(shù)因具備大產(chǎn)能且更具成本優(yōu)勢,是目前高速成長功率、傳感器、通信等車規(guī)級/芯片生產(chǎn)的最佳解決方案。未來,隨著政策繼續(xù)力挺半導(dǎo)體產(chǎn)業(yè),電動車持續(xù)帶動車規(guī)級芯片市場需求,車規(guī)級芯片國產(chǎn)化進程有望加速,將促進板級封裝技術(shù)同步發(fā)展。

Manz集團亞洲區(qū)總經(jīng)理 林峻生先生展示以Manz新一代板級封裝 RDL自動化生產(chǎn)線所試生產(chǎn)的產(chǎn)品。
Manz亞智科技與國內(nèi)產(chǎn)業(yè)鏈進行過多次深入合作,涵蓋產(chǎn)、學(xué)、研,旨在有效推進國內(nèi)板級封裝的建設(shè)。Manz集團亞洲區(qū)總經(jīng)理林峻生先生表示:“我們將繼續(xù)發(fā)揮自身在技術(shù)和市場方面的積累,通過整合,積極推動板級封裝實現(xiàn)產(chǎn)業(yè)化落地,全方位推進國內(nèi)在先進封裝的發(fā)展,為整個產(chǎn)業(yè)生態(tài)的建設(shè)貢獻出更多的力量。”
政府在政策層面上給予先進封裝諸多的支持,各地十四五規(guī)劃都將發(fā)展先進封裝列入其中,以不斷增強產(chǎn)業(yè)國際競爭力、創(chuàng)新力及技術(shù)力。林峻生先生指出:“為了給予客戶全方位的技術(shù)工藝與服務(wù),迎接這一波板級封裝的快速成長,我們在上下游制程工藝及設(shè)備的整合、材料使用皆與供應(yīng)鏈保持密切合作,藉由凝聚供應(yīng)鏈共同目標(biāo),提供給客戶更創(chuàng)新的板級封裝制程工藝技術(shù),為客戶打造高效生產(chǎn)解決方案的同時優(yōu)化制程良率及降低制造成本。我們提供以市場為導(dǎo)向的板級封裝RDL一站式整體解決方案,打造共榮共贏的供應(yīng)鏈生態(tài)。”
聲明:本文內(nèi)容及配圖由入駐作者撰寫或者入駐合作網(wǎng)站授權(quán)轉(zhuǎn)載。文章觀點僅代表作者本人,不代表電子發(fā)燒友網(wǎng)立場。文章及其配圖僅供工程師學(xué)習(xí)之用,如有內(nèi)容侵權(quán)或者其他違規(guī)問題,請聯(lián)系本站處理。
舉報投訴
-
pcb
+關(guān)注
關(guān)注
4361文章
23453瀏覽量
408078 -
Manz
+關(guān)注
關(guān)注
0文章
17瀏覽量
8433
發(fā)布評論請先 登錄
相關(guān)推薦
熱點推薦
什么是晶圓級扇出封裝技術(shù)
晶圓級扇出封裝(FO-WLP)通過環(huán)氧樹脂模塑料(EMC)擴展芯片有效面積,突破了扇入型封裝的I/O密度限制,但其技術(shù)復(fù)雜度呈指數(shù)

什么是晶圓級扇入封裝技術(shù)
在微電子行業(yè)飛速發(fā)展的背景下,封裝技術(shù)已成為連接芯片創(chuàng)新與系統(tǒng)應(yīng)用的核心紐帶。其核心價值不僅體現(xiàn)于物理防護與電氣/光學(xué)互聯(lián)等基礎(chǔ)功能,更在于應(yīng)對多元化市場需求的適應(yīng)性突破,本文著力介紹晶圓級

中微公司ICP雙反應(yīng)臺刻蝕機Primo Twin-Star取得新突破
近日,中微半導(dǎo)體設(shè)備(上海)股份有限公司(以下簡稱“中微公司”,股票代碼“688012.SH”)宣布通過不斷提升反應(yīng)臺之間氣體控制的精度, ICP雙反應(yīng)臺刻蝕機Primo Twin-Star 又取得新的突破,反應(yīng)臺之間的刻蝕精度已達到0.2A(

工業(yè)4.0革命利器!明遠智睿SSD2351核心板:低成本+高算力,破解產(chǎn)線智能化難題
行業(yè)痛點:傳統(tǒng)工業(yè)設(shè)備智能化改造面臨三大瓶頸——算力不足導(dǎo)致實時性差、接口資源有限難以擴展多設(shè)備、進口方案成本高昂且供貨不穩(wěn)定。
核心板方案價值:
明遠智睿SSD2351核心板基于SigmaStar
發(fā)表于 03-21 14:22
簽約頂級封裝廠,普萊信巨量轉(zhuǎn)移技術(shù)掀起晶圓級封裝和板級封裝的技術(shù)革命
經(jīng)過半年的測試,普萊信智能和某頂級封裝廠就其巨量轉(zhuǎn)移式板級封裝設(shè)備(FOPLP)設(shè)備XBonder Pro達成戰(zhàn)略合作協(xié)議,這將是巨量轉(zhuǎn)移技術(shù)在IC

SL3062:60V 輸入寬電壓降壓恒壓電源芯片,完美替換 TPS54362
高效穩(wěn)定的電源設(shè)計!
SL3062 核心優(yōu)勢:
寬輸入電壓范圍: 6V 至 60V 的寬輸入電壓范圍,輕松應(yīng)對各種復(fù)雜供電環(huán)境。
高效穩(wěn)定輸出: 最大 1.5A 輸出電流,效率高達 90% 以上
發(fā)表于 02-20 17:30
嵌入式板級封裝在高壓應(yīng)用中的新挑戰(zhàn)—微區(qū)缺陷造成的局部放電
嵌入式板級封裝汽車電驅(qū)系統(tǒng)正在朝著更高電壓(1200V)、更高集成度不斷發(fā)展。高集成度特別是“嵌入式板級
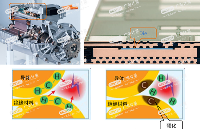
Manz集團成功交付多尺寸板級封裝RDL量產(chǎn)線
。公司成功向多家國際大廠交付了包括300mm、510mm、600mm及700mm等不同尺寸的板級封裝RDL量產(chǎn)線。這些量產(chǎn)線覆蓋了洗凈、顯影、蝕刻、剝膜、電鍍及自動化設(shè)備等關(guān)鍵環(huán)節(jié),為半導(dǎo)體封
Manz亞智科技RDL制程打造CoPoS板級封裝路線,滿足FOPLP/TGV應(yīng)用于下一代AI需求
結(jié)合有機材料與玻璃基板應(yīng)用,盡顯產(chǎn)能優(yōu)勢。 ?Manz亞智科技板級RDL制程設(shè)備,實現(xiàn)高密度與窄線寬線距的芯片封裝。 【2024 年12月4

Manz亞智科技RDL制程打造CoPoS板級封裝路線, 滿足FOPLP/TGV應(yīng)用于下一代AI需求
有機材料與玻璃基板應(yīng)用,盡顯產(chǎn)能優(yōu)勢。 Manz亞智科技板級RDL制程設(shè)備,實現(xiàn)高密度與窄線寬線距的芯片封裝。 ? 【2024 年12月4日
發(fā)表于 12-04 14:33
?283次閱讀

海外HTTP安全挑戰(zhàn)與應(yīng)對策略
海外HTTP安全挑戰(zhàn)與應(yīng)對策略是確保跨國網(wǎng)絡(luò)通信穩(wěn)定、安全的關(guān)鍵。
Manz亞智科技RDL設(shè)備切入五家大廠
近日,設(shè)備制造業(yè)的佼佼者Manz亞智科技宣布了在人工智能芯片與半導(dǎo)體先進封裝領(lǐng)域的重大突破。該公司已成功將近10條先進的重布線層(RDL)生產(chǎn)
使用SiC技術(shù)應(yīng)對能源基礎(chǔ)設(shè)施的挑戰(zhàn)
本文簡要回顧了與經(jīng)典的硅 (Si) 方案相比,SiC技術(shù)是如何提高效率和可靠性并降低成本的。然后在介紹 onsemi 的幾個實際案例之前,先探討了 SiC 的封裝和系統(tǒng)集成選項,并展示了設(shè)計人員該如何最好地應(yīng)用它們來優(yōu)化 SiC 功率 MOSFET 和柵極驅(qū)動器性能,以

扇入型和扇出型晶圓級封裝的區(qū)別
晶圓級封裝是一種先進的半導(dǎo)體封裝技術(shù),被廣泛應(yīng)用在存儲器、傳感器、電源管理等對尺寸和成本要求較高的領(lǐng)域中。在這些領(lǐng)域中,這種技術(shù)能夠滿足現(xiàn)代對電子設(shè)備的小型化、多功能、低
臺積電開始探索面板級封裝,但三星更早?
電子發(fā)燒友網(wǎng)報道(文/周凱揚)當(dāng)下限制AI芯片大量供應(yīng)的因素,除了HBM產(chǎn)能受限外,也有先進封裝產(chǎn)能不足的問題,尤其是臺積電的CoWoS。為了應(yīng)對AI芯片需求激增的現(xiàn)狀,不少供應(yīng)商都在
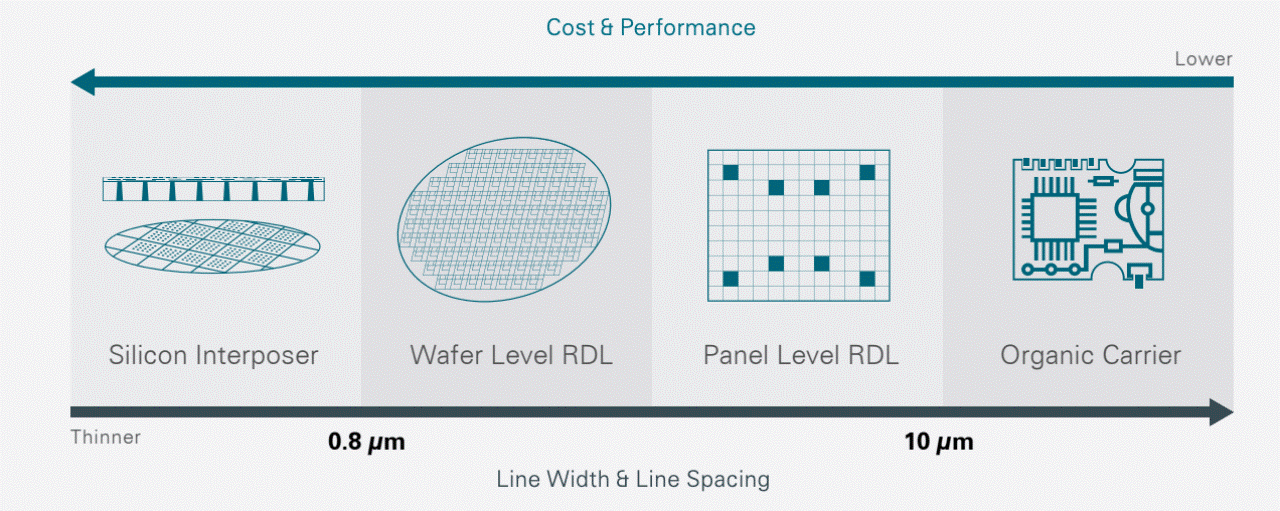





 Manz亞智科技板級封裝突破業(yè)界最大生產(chǎn)面積 完美應(yīng)對產(chǎn)能、成本雙挑戰(zhàn)
Manz亞智科技板級封裝突破業(yè)界最大生產(chǎn)面積 完美應(yīng)對產(chǎn)能、成本雙挑戰(zhàn)











評論