文章來源:學(xué)習(xí)那些事
原文作者:小陳婆婆
本文介紹了晶圓級(jí)扇入封裝相關(guān)原理。
晶圓級(jí)扇入封裝
在微電子行業(yè)飛速發(fā)展的背景下,封裝技術(shù)已成為連接芯片創(chuàng)新與系統(tǒng)應(yīng)用的核心紐帶。其核心價(jià)值不僅體現(xiàn)于物理防護(hù)與電氣/光學(xué)互聯(lián)等基礎(chǔ)功能,更在于應(yīng)對(duì)多元化市場(chǎng)需求的適應(yīng)性突破,本文著力介紹晶圓級(jí)扇入封裝,分述如下。
晶圓級(jí)封裝的發(fā)展
晶圓級(jí)扇入封裝技術(shù)
晶圓級(jí)封裝的發(fā)展
隨著移動(dòng)計(jì)算、高性能計(jì)算(HPC)及人工智能/機(jī)器學(xué)習(xí)(AI/ML)領(lǐng)域的爆發(fā)式增長,傳統(tǒng)封裝方案正面臨雙重革命性挑戰(zhàn):內(nèi)部維度上,系統(tǒng)級(jí)芯片(SoC)需在有限空間內(nèi)實(shí)現(xiàn)晶體管密度與存儲(chǔ)容量的指數(shù)級(jí)擴(kuò)展。
外部維度上,移動(dòng)終端與HPC系統(tǒng)對(duì)性能、能效、散熱及微型化提出了近乎苛刻的要求。這驅(qū)動(dòng)著行業(yè)探索從單芯片封裝向異構(gòu)系統(tǒng)集成躍遷。
晶圓級(jí)封裝(WLP)與晶圓級(jí)系統(tǒng)集成(WLSI)技術(shù)在此背景下脫穎而出。依托晶圓級(jí)工藝的規(guī)模化優(yōu)勢(shì),WLSI平臺(tái)通過低成本、超薄化與高集成度的解決方案,重新定義了系統(tǒng)級(jí)整合的邊界。
其技術(shù)突破集中體現(xiàn)為兩大方向:其一,深度摩爾定律(More Moore)路徑下,通過先進(jìn)封裝實(shí)現(xiàn)邏輯芯片的晶體管密度持續(xù)微縮;其二,超越摩爾定律(More than Moore)路徑中,將CMOS芯片與非硅基功能單元(如傳感器、光電器件)異構(gòu)集成,構(gòu)建單器件級(jí)多功能系統(tǒng)。這一模式轉(zhuǎn)變已催生出集成扇出(InFO)等標(biāo)志性技術(shù),成為移動(dòng)計(jì)算領(lǐng)域的主流方案,并逐步向HPC場(chǎng)景延伸。
晶圓級(jí)扇入封裝技術(shù)
晶圓級(jí)封裝(WLP)作為先進(jìn)封裝技術(shù)的核心分支,通過直接在晶圓上完成封裝工藝,實(shí)現(xiàn)了系統(tǒng)微型化與成本優(yōu)化的雙重突破。

其技術(shù)體系包含扇入型(Fan-In)與扇出型(Fan-Out)兩大變體,本文僅聚焦扇入型WLP的技術(shù)特征與工程實(shí)踐。
封裝結(jié)構(gòu)與工藝流程
扇入型WLP采用"芯片級(jí)封裝"架構(gòu),所有BGA焊球直接布局于硅芯片有效投影面積內(nèi),無需額外基板或轉(zhuǎn)接板。典型工藝流程包含四步:
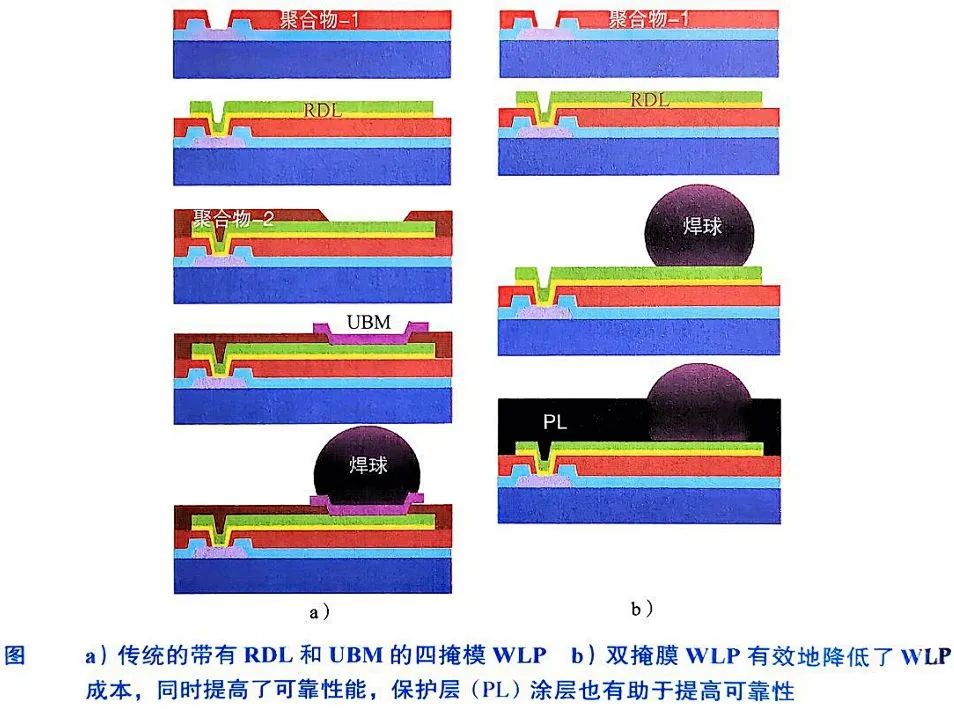
鈍化保護(hù)與RDL布線:在完成晶圓表面鈍化后,通過物理氣相沉積(PVD)制備鈦/銅種子層,電鍍銅形成再布線層(RDL),實(shí)現(xiàn)芯片I/O端口從密集焊盤區(qū)向封裝表面的扇入擴(kuò)展;
介電層成型:采用聚酰亞胺(PI)或聚雙苯并惡唑(PBO)等光敏聚合物構(gòu)建介電層,經(jīng)光刻工藝形成互連通孔與布線溝槽;
UBM制備:通過電鍍或化學(xué)鍍工藝沉積凸點(diǎn)下金屬化層(UBM),常用材料包括銅、鎳或ENEPIG合金,形成與BGA焊球的冶金結(jié)合界面;
焊球植入與切割:在晶圓級(jí)完成BGA焊球植球后,進(jìn)行晶圓切割獲得單顆封裝器件。
該工藝流程的精簡(jiǎn)性賦予扇入型WLP三大優(yōu)勢(shì):封裝體尺寸與芯片尺寸1:1等比、工藝步驟較傳統(tǒng)封裝減少40%-60%、制造周期縮短至2-3天。
關(guān)鍵材料與結(jié)構(gòu)優(yōu)化
介電層設(shè)計(jì):通過調(diào)節(jié)聚合物厚度(通常5-20μm)平衡機(jī)械緩沖與工藝精度。較厚介電層可緩解硅-PCB間熱膨脹系數(shù)失配(CTE mismatch)引發(fā)的熱應(yīng)力,但會(huì)增加光刻通孔成型難度;
RDL層級(jí)擴(kuò)展:?jiǎn)螌鱼~布線可滿足常規(guī)需求,雙層RDL結(jié)構(gòu)通過增加銅厚(≥5μm)提升機(jī)械可靠性,使芯片適用尺寸擴(kuò)展至10mm×10mm級(jí)別;
UBM成本管控:銅基UBM方案較傳統(tǒng)鎳/金體系成本降低30%-50%,但需優(yōu)化掩模數(shù)量(通常2-4層)以平衡工藝復(fù)雜度與良率。
可靠性挑戰(zhàn)與突破路徑
熱循環(huán)測(cè)試表明,硅-PCB界面CTE差異(硅4.3ppm/K vs. PCB 17ppm/K)導(dǎo)致的剪切應(yīng)力是主要失效機(jī)理,具體表現(xiàn)為:
尺寸效應(yīng):芯片邊長超過8mm時(shí),BGA焊球疲勞壽命呈指數(shù)下降;
應(yīng)力緩解方案:通過三維結(jié)構(gòu)優(yōu)化實(shí)現(xiàn)應(yīng)力分散:
增加封裝體高度(BGA球高≥0.3mm)提升中性點(diǎn)距離(DNP);
采用柔性聚合物材料(模量<2GPa)構(gòu)建可變形緩沖層;
優(yōu)化UBM焊盤形貌(圓形/環(huán)形設(shè)計(jì))改善應(yīng)力分布。
大尺寸芯片封裝實(shí)現(xiàn)
工程實(shí)踐證實(shí),通過協(xié)同優(yōu)化材料體系與結(jié)構(gòu)設(shè)計(jì),可實(shí)現(xiàn)邊長達(dá)25.4mm(1英寸)的大尺寸扇入型WLP。
關(guān)鍵技術(shù)包括:
復(fù)合緩沖結(jié)構(gòu):采用"介電層/RDL/UBM"三層復(fù)合緩沖,將熱循環(huán)壽命提升至1000次以上;
焊球強(qiáng)化技術(shù):通過頸部聚合物包覆(Underfill Encapsulation)使焊球抗剪強(qiáng)度提升40%;
制造良率管控:在6mm×6mm以下尺寸可保持99%以上良率,8mm×8mm器件需引入缺陷檢測(cè)與激光修復(fù)工藝。
當(dāng)前行業(yè)實(shí)踐顯示,扇入型WLP在消費(fèi)電子領(lǐng)域形成標(biāo)準(zhǔn)化方案,而10mm×10mm以上尺寸則需權(quán)衡工藝成本與可靠性裕度,這推動(dòng)了扇出型WLP在高性能計(jì)算領(lǐng)域的迭代發(fā)展。
-
芯片
+關(guān)注
關(guān)注
459文章
52217瀏覽量
436525 -
晶圓
+關(guān)注
關(guān)注
52文章
5125瀏覽量
129188 -
封裝
+關(guān)注
關(guān)注
128文章
8535瀏覽量
144832
原文標(biāo)題:晶圓級(jí)扇入封裝
文章出處:【微信號(hào):bdtdsj,微信公眾號(hào):中科院半導(dǎo)體所】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
HRP晶圓級(jí)先進(jìn)封裝替代傳統(tǒng)封裝技術(shù)研究(HRP晶圓級(jí)先進(jìn)封裝芯片)

什么是晶圓級(jí)封裝?
晶圓級(jí)封裝產(chǎn)業(yè)(WLP),晶圓級(jí)封裝產(chǎn)業(yè)(WLP)是什么意思
WLCSP/扇入封裝技術(shù)和市場(chǎng)動(dòng)態(tài)






 什么是晶圓級(jí)扇入封裝技術(shù)
什么是晶圓級(jí)扇入封裝技術(shù)















評(píng)論