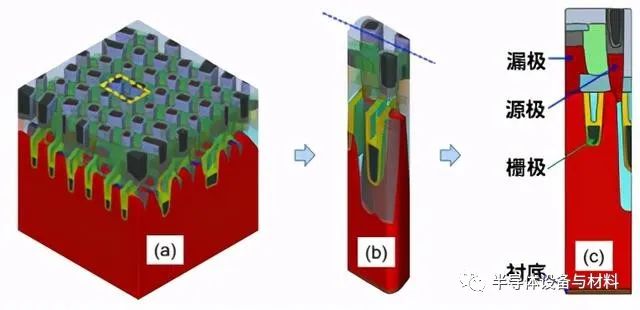
2006
Development of New TiN/ZrO2/Al2O3/ZrO2/TiN Capacitors Extendable to 45nm Generation DRAMs Replacing HfO2 based Dielectrics IEDM
從單層HfO薄膜過渡到堆疊結(jié)構(gòu),第一次提出ZAZ的結(jié)構(gòu),并在45nm工藝節(jié)點(diǎn)進(jìn)行了可靠性驗(yàn)證。為DRAM電容介質(zhì)提出了全新的研究方向。
通過控制溫度來控制晶相,將非晶AlO、T相ZrO制作為新型介質(zhì)薄膜。因?yàn)橹饕暙I(xiàn)點(diǎn)是EOT很低的新型薄膜,通過三個(gè)I_V曲線描述漏電性能,XRD表明晶相,C_V測(cè)算K值得到優(yōu)越性能。最后還通過“浴缸圖”、良率比較圖等大數(shù)據(jù)證明其可靠性。
Tetragonal Phase Stabilization by Doping as an Enabler of Thermally Stable HfO2 based MIM and MIS Capacitors for sub 50nm Deep Trench DRAM IEDM
首次表明,通過四價(jià)(Si)和三價(jià)(Y,Gd)摻雜劑控制HfO2的結(jié)晶相,可以穩(wěn)定其四方相,顯著提高電容等效厚度(EOT)。(溝槽電容)、45nm工藝節(jié)點(diǎn)。
2007
Carbon / high-k Trench Capacitor for the 40nm DRAM Generation VLSI
奇夢(mèng)達(dá)、trench,碳作高k電容電極、隔離層。40nm
韋博分布——龍老師擅長。
可以看作新思路。
2008
Al-Doped TiO2 Films with Ultralow Leakage Currents for Next Generation DRAM Capacitors ADVANCED MATERIALS
Al摻雜TiO2超低漏電流薄膜。內(nèi)有XSP測(cè)試,有原理解釋。可作為Si摻參考。
0.5 nm EOT low leakage ALD SrTiO3 on TiN MIM capacitors for DRAM applications IEDM
本文首次記錄了在TiN底電極上用低溫(250攝氏度)ALD沉積STO,通過改善其前驅(qū)材料和工藝,得到了低漏電的薄膜。
通過工藝設(shè)置Si-rich、Ti-rich、標(biāo)準(zhǔn)三種薄膜,得出Si-最佳的結(jié)果。還摸索出最佳退火溫度。工藝創(chuàng)新,讓最有潛力的材料可與便宜的TiN電極共同生長。對(duì)后續(xù)STO應(yīng)用在DRAM中貢獻(xiàn)很大。
2009
Scalability of TiN/HfAlO/TiN MIM DRAM Capacitor to 0.7-nm-EOT and Beyond IEDM
通過各個(gè)角度驗(yàn)證了HfO的優(yōu)越性(然而現(xiàn)在主流并不用),主要是理論推導(dǎo),teff-K、qφB0-K等。大量理論+少許實(shí)驗(yàn),結(jié)論存疑,但能自洽。
2010
Enabling 3X nm DRAM: Record low leakage 0.4 nm EOT MIM capacitors with novel stack engineering IEDM
30nm,新型stackDRAM。本文運(yùn)用了超薄Ru氧化工藝,在TIN上加了一層thin Ru改善了性能。主要是提出了不同的堆疊方式,各種材料的堆疊結(jié)構(gòu)開始發(fā)展。
Recent Innovations in DRAM Manufacturing IEEE
4x節(jié)點(diǎn)開始上市,通過采用雙層電容器、高k介質(zhì)和提高源/漏等技術(shù)實(shí)現(xiàn)。
是一篇綜述類文章,與電容關(guān)系不大,但可縱觀產(chǎn)業(yè)。
Capacitors with an Equivalent Oxide Thickness of < 0.5 nm for Nanoscale Electronic Semiconductor Memory ADVANCED MATERIALS
新前驅(qū)體在TiN電極上形成了薄、均勻、密度更高的Ru和RuO層。金紅石結(jié)構(gòu)的tio2和al摻雜的tio2薄膜由于在二元氧化物中具有極高的介電常數(shù),可能會(huì)填補(bǔ)ZAZ和srtio3 MIM電容器之間的空隙,其中都需RuO作為底電極。
還有一些對(duì)電極的工藝改良,可以一看。
Structure and property changes of ZrO2/Al2O3/ZrO2 laminate induced by low-temperature NH3 annealing applicable to metal–insulator–metal capacitor Thin Soild Films
對(duì)ZAZ進(jìn)行480℃低溫NH3退火。N確實(shí)可以加入到介質(zhì)層板中,導(dǎo)致ZrO2層中出現(xiàn)四方向立方的相變和小晶粒。N化可減少雜質(zhì),改善形貌。
對(duì)ZAZ的工藝改進(jìn),可以研究下機(jī)理。
Theoretical Screening of Candidate Materials for DRAM Capacitors and Experimental Demonstration of a Cubic-Hafnia MIM Capacitor TED
采用TiN電極的立方HfO2是一種很有前途的DRAM候選材料。插入AlO層改善漏電。漏電機(jī)制由氧空位決定。
從漏電出發(fā)拉踩STO,提出相同EOT最小的漏電由HfO提供,在此基礎(chǔ)上制備了al摻雜HfO2和TiN的MIM電容器。分析可借鑒。
A Novel Cylinder-Type MIM Capacitor in Porous Low-k Film (CAPL) for Embedded DRAM with Advanced CMOS Logics IEDM
CAPL,感覺是集成領(lǐng)域的,目前參考價(jià)值不大。
2011
Towards 1X DRAM: Improved leakage 0.4 nm EOT STO-based MIMcap and explanation of leakage reduction mechanism showing further potential VLSI
對(duì)0.4nmEOT的STO MIM 進(jìn)行了改進(jìn),主要為了減少漏電,采用一種Ru/RuOx/TiOx/Sr-rich STO/TiN的結(jié)構(gòu)。并得到結(jié)論,漏電是由STO中的氧空位缺陷引起的,RuO可以在結(jié)晶過程中改善消除甚至逆轉(zhuǎn)電極附近的氧空位缺陷。
各種J-V圖,能帶原理分析圖。
Advanced capacitor dielectrics: towards 2x nm DRAM IEEE
介紹富Sr (Sr/(Sr + Ti) ~ 62%)鈦酸鍶(STO)、金紅石型TiO2等高級(jí)電容介質(zhì)的介電常數(shù)均大于60的電學(xué)特性數(shù)據(jù)。
另提出了一種基于平面金屬-絕緣體-金屬(MIM)系統(tǒng)的實(shí)用電容模型。偏綜述類
A High-Performance, High-Density 28nm eDRAM Technology with High-K/Metal-Gate IEDM
高K金屬柵用于eDRAM,HKMG CMOS兼容(低熱低充電過程)高k MIM電容,具有極低泄漏。研究T的,關(guān)聯(lián)不大可以了解。
Improved EOT and leakage current for metal–insulator–metal capacitor stacks with rutile TiO2 Microelectronic Engineering
以RuO2/Ru為底電極,金紅石TiO2為介質(zhì),TiN為上電極形成的MIMCAP結(jié)構(gòu)。在TiO2原子層沉積(ALD)過程中,需要臭氧(O3)作為氧化劑,以獲得金紅石相(介電常數(shù)> 80),而用H2O得到銳鈦礦型TiO2(介電常數(shù)40)。
2012
Reliability of SrRuO3/SrTiO3/SrRuO3 Stacks for DRAM Applications EDL
SrRuO3/SrTiO3/SrRuO3棧在DRAM應(yīng)用中的可靠性研究,對(duì)比CET,電流與時(shí)間關(guān)系等,可靠性方面不失為高校研究的好方向。
The structural andelectrical characterization of a HfErOx dielectric for MIM capacitor DRAM applications Microelectronic Engineering
新材料HfErOx。稀土元素?fù)诫sHfO2可以降低金屬絕緣體硅(MIS)電容器[8]的漏電流,提高k值(Er摻雜濃度大概為15%)。
TEM表征、XRD確認(rèn)、C-V、J-V性能分析,CET對(duì)比。值得研究。
2013
The Novel Stress Simulation Method for Contemporary DRAM Capacitor Arrays IEEE
富鍶鈦酸鍶和金紅石氧化鈦薄膜的陷阱輔助泄漏中提取了有效電子隧穿質(zhì)量,并與由假想能帶結(jié)構(gòu)第原理計(jì)算得到的理論值進(jìn)行了比較。討論了薄膜的最佳取向和化學(xué)計(jì)量學(xué)對(duì)隧道的影響。偏理論,可仔細(xì)研究。
Considerations for further scaling of metal– insulator–metal DRAM capacitors JVST
2014
Low leakage Ru-strontium titanate-Ru metal-insulator-metal capacitors for sub-20 nm technology node in dynamic random access memory APL
Ru/STO/Ru堆棧,通過控制Sr/Ti比和晶粒尺寸,采用非均相TiO2/STO基納米層疊沉積和兩步結(jié)晶退火,實(shí)現(xiàn)了MIMCAPs等效氧化層厚度、漏電流密度(Jg)和STO物理厚度的降尺度。
多步退火。
Leakage Control in 0.4-nm EOT Ru/SrTiOx/Ru Metal-Insulator-Metal Capacitors: Process Implications EDL
Ru/SrTiOx/Ru泄漏控制:工藝影響。上電極材料和沉積技術(shù)以及沉積后退火是控制上電極負(fù)偏壓和正偏壓泄漏的關(guān)鍵參數(shù)。沒什么出眾數(shù)據(jù)(?
2015
Sub-0.5 nm Equivalent Oxide Thickness Scaling for Si-Doped Zr1?xHfxO2 Thin Film without Using Noble Metal Electrode ACS
Si摻雜的ZHO體系分析!與研究方向高度重合!Si摻雜有助于穩(wěn)定四方向,提高k值。
XRD驗(yàn)證表征、確定結(jié)構(gòu),Z與H比例改變,探究最佳。Hf的含量對(duì)器件k值也有很大的影響。注意本文表征解釋部分。
20nm DRAM: A new beginning of another revolution IEDM
提出了蜂窩結(jié)構(gòu)(HCS)和空氣間隔技術(shù)。估計(jì)都是產(chǎn)業(yè)界在用的技術(shù)。主張不使用***生產(chǎn)。前言部分站在產(chǎn)業(yè)角度縱觀,值得一讀。
2016
Nonvolatile Random Access Memory and Energy Storage Based on Antiferroelectric Like Hysteresis in ZrO2 ADVANCED MATERIALS
反鐵電隨機(jī)存取存儲(chǔ)器的概念證明,講NRAM中ZrO的應(yīng)用,注重極化角度,目前關(guān)系不大。
Conduction barrier offset engineering for DRAM capacitor scaling Solid-State Electronics
IPE檢測(cè),與漏電有關(guān)。描述ZAZ層的制作過程,給出詳細(xì)的泄漏特性描述,表征結(jié)果和參數(shù)提取方法。
Low leakage ZrO2 based capacitors for sub 20 nm dynamic random access memory technology nodes JAP
將ZAZ層間材料由Al2O3改為SrO和頂部電極材料由TiN改為Pt。這兩種方法結(jié)合得到的電容等效厚度值為0.47 。可以參考吧。
Extraction of the Defect Distributions in DRAM Capacitor Using I–V and C–V Sensitivity Maps EDL
利用I-V和C-V靈敏度圖提取DRAM電容中的缺陷分布。靈敏圖??
2017
Novel Approach for the Reduction of Leakage Current Characteristics of 20 nm DRAM Capacitors With ZrO2–Based High-k Dielectrics EDL
可通過去除電容外部雜質(zhì)硼和氫,減少電容器形成后的熱量預(yù)算,消除泄漏電流的退化,而不改變電容器的結(jié)構(gòu)或材料。
提出了三種降低電容器漏電流退化的方法。
Investigation of ultrathin Pt/ZrO2eAl2O3eZrO2/TiN DRAM capacitors Schottky barrier height by internal photoemission spectroscopy Current Applied Physics
內(nèi)發(fā)射光譜法研究超薄Pt/ZrO2eAl2O3eZrO2/TiN DRAM電容器的肖特基勢(shì)壘高度,Pt/ZAZ/TiN疊層中Pt/ZAZ和ZAZ/TiN界面的SBH分別為2.77 eV和2.18 eV。上電極/氧化物和下電極/氧化物界面的SBH差異與Pt和TiN的功函數(shù)差異以及給定介質(zhì)的亞隙缺陷態(tài)特征(密度和能量)有關(guān)。結(jié)合器件級(jí)的IPE實(shí)驗(yàn)分析和薄膜級(jí)的紫外光電子能譜和光譜橢偏分析,提出了帶結(jié)構(gòu)模型。
Doped Hf0.5Zr0.5O2 for high efficiency integrated supercapacitors APL
我們將10 nm厚的Hf0.5Zr0.5O2 (HZO)二元薄膜摻雜Al或Si (Al或Si摻雜HZO)。添加的摻雜劑提供了從鐵電特性到反鐵電特性的明顯轉(zhuǎn)變。
與課題關(guān)系密切。
2018
High-performance (EOT<0.4nm, Jg~10-7A/cm2) ALD-deposited RuSrTiO3 stack for next generations DRAM pillar capacitor IEDM
RuSrTiO3新型堆棧結(jié)構(gòu),數(shù)據(jù)圖好看值得借鑒。
EDS測(cè)成分?
1-T Capacitorless DRAM Using Laterally Bandgap Engineered Si-Si:C Heterostructure Bipolar I-MOS for Improved Sensing Margin and Retention Time IEEE
New Method for Reduction of the Capacitor Leakage Failure Rate Without Changing the Capacitor Structure or Materials in DRAM Mass Production TED
新方法降漏電(與2017類似)。減少B雜質(zhì)。雜質(zhì)運(yùn)用原子探針層析技術(shù)測(cè)量。
電介質(zhì)泄漏失效測(cè)試、電阻失效測(cè)試、可靠性結(jié)果也能通過。(20nm)
Simultaneous improvement of the dielectric constant and leakage currents of ZrO2 dielectrics by incorporating a highly valent Ta5+ element? JMC
ZrO2電介質(zhì)加入高價(jià)Ta5+元素,由于Zr被Ta取代和VO的降低而引起的原子排列的變化增強(qiáng)了立方相的結(jié)晶度,使ZrO2薄膜的摩爾體積減小。
2019
Controlling the Electrical Characteristics of ZrO2/Al2O3/ ZrO2 Capacitors by Adopting a Ru Top Electrode Grown via Atomic Layer Deposition PSS
采用原子層沉積法生長Ru頂電極控制ZrO2/Al2O3/ ZrO2電容器的電特性。為應(yīng)對(duì)ZAZ厚度減小后漏電的增加,將TE從TiN換成Ru。工藝詳細(xì)。
Scaling the Equivalent Oxide Thickness by Employing a TiO2 Thin Film on a ZrO2–Al2O3-Based Dielectric for Further Scaling of Dynamic Random Access Memory PSS
新型結(jié)構(gòu)ZAT,比傳統(tǒng)ZAZ性能好。C-V、J-V都有進(jìn)步。
Recent advances in the understanding of high-k dielectric materials deposited by atomic layer deposition for dynamic random-access memory capacitor applications JMR
就談?wù)摵徒ㄗh。電容材料方面的綜述!!
A Sensitivity Map-Based Approach to Profile Defects in MIM Capacitors From I–V, C–V, and G–V Measurements TED
又是基于I-V、C-V、J-V方面的靈敏度圖。
Influence of Etch Profiles on the Leakage Current and Capacitance of 3-D DRAM Storage Capacitors ISSN
刻蝕輪廓對(duì)三維DRAM存儲(chǔ)電容器漏電流和電容的影響。仿真!可以仔細(xì)瞅瞅。
Trap-Assisted DRAM Row Hammer Effect EDL
Hammer效應(yīng)。仿真!單電荷阱的三維TCAD模擬,我們發(fā)現(xiàn)了DRAM滾錘效應(yīng)機(jī)理的直接證據(jù)。結(jié)果與之前報(bào)道的實(shí)驗(yàn)結(jié)果吻合良好。
Dielectric Enhancement of Atomic Layer-Deposited Al2O3/ZrO2/Al2O3 MIM Capacitors by Microwave Annealing NRL
ZAZ微波退火。1400 W、5 min的微波退火條件下,ZrO2的介電常數(shù)提高到41.9(提高了40%),襯底溫度低于400℃,與線工藝的后端兼容。
2020
Double-Gate Junctionless 1T DRAM With Physical Barriers for Retention Improvement TED
雙門無結(jié)1T DRAM與物理屏障的保留改進(jìn)。對(duì)T的改善。
High-kHfxZr1-xO2 Ferroelectric Insulator by Utilizing High Pressure Anneal TED
HZO結(jié)構(gòu),高壓退火。還有Z與H比例調(diào)節(jié)。
Anti-ferroelectric HfxZr1-xO2 Capacitors for High-density 3-D Embedded-DRAM IEDM
高密度三維嵌入式dram用反鐵電HfxZr1-xO2電容器。P-V圖的。
2021
105× Endurance Improvement of FE-HZO by an Innovative Rejuvenation Method for 1z Node NV-DRAM Applications VLSI
可靠性。鐵電原理解釋的透徹,亮點(diǎn)在于Pr的再生方法。
審核編輯 :李倩
-
電容器
+關(guān)注
關(guān)注
64文章
6256瀏覽量
100239 -
電容
+關(guān)注
關(guān)注
100文章
6091瀏覽量
150995 -
DRAM
+關(guān)注
關(guān)注
40文章
2326瀏覽量
183868
發(fā)布評(píng)論請(qǐng)先 登錄
相關(guān)推薦
藍(lán)牙技術(shù)的發(fā)展歷程和工作原理
納微半導(dǎo)體亮相2024亞洲電源技術(shù)發(fā)展論壇
LP-SCADA的發(fā)展歷程和應(yīng)用行業(yè)?
直流高壓電源技術(shù)發(fā)展淺析
開關(guān)電源的最新技術(shù)發(fā)展趨勢(shì)
CNC技術(shù)發(fā)展趨勢(shì)與前景
智能駕駛技術(shù)發(fā)展趨勢(shì)
直徑測(cè)量工具的發(fā)展歷程
藍(lán)牙模塊技術(shù)發(fā)展歷程,連接未來,智享生活

NAND閃存的發(fā)展歷程
無線充電技術(shù)發(fā)展趨勢(shì)
TCXO發(fā)展歷程簡述

AI大模型的發(fā)展歷程和應(yīng)用前景
巖土工程中的振弦采集儀技術(shù)發(fā)展與前景展望





 DRAM的電容技術(shù)發(fā)展歷程
DRAM的電容技術(shù)發(fā)展歷程










評(píng)論