在筆者看來,市場對新興存儲器并不友善,盡管人們?nèi)匀幌M鎯?nèi)計算(copute in memory)能夠重振基于電阻、相變和其他特性的新型存儲器。
不過,這并沒有阻止存儲器的研發(fā),當前的新興存儲器領(lǐng)域的大部分研究現(xiàn)在都集中在鐵電存儲器(ferroelectric memories)上,如IEDM內(nèi)存分委會約有三分之一的研究人員從事FeRAM研發(fā)。其中鋯酸鉿 (HZO:hafnium zirconate) 和其他材料的極化(正或負)可以通過施加電壓來控制。
存儲技術(shù)委員會主席兼首爾國立大學(xué)教授 Sang Bum Kim 在 IEDM會議上也指出,F(xiàn)eRAM 比 DRAM 慢,但比 NAND 快。而且它們真的很小。不過,他們還有很多材料問題需要解決,其循環(huán)耐力和保持力(cycling endurance and retention)仍然沒有達到應(yīng)有的水平。
從IEDM的統(tǒng)計數(shù)據(jù)看來,中國的FeRAM研究已經(jīng)達到了一相當高的水平。例如,來自北京大學(xué)的一個研究小組考慮了一個棘手的問題,那就是如何在 HZO 晶體中保持正斜方相(orthorhombic phase),這是鐵電效應(yīng)所需的相。“我們系統(tǒng)地表征了 La 摻雜 HfO2 器件中出色的鐵電性。觀察到超過 38 nm 的大單晶斜方晶相。實現(xiàn)了超快速和高可靠性的偏振切換。”中國研究人員在報告說。
如何在鐵電材料中保持O-phase這一挑戰(zhàn)促使英特爾創(chuàng)建了一個復(fù)雜的模型,該模型著眼于電場循環(huán)過程中的相變。英特爾表示:“擁有一個可以描述所有這些階段的統(tǒng)一理論框架對于更好地理解場循環(huán)過程中的潛在物理機制以及探索基于氧化鉿薄膜(hafnia-based thin films)的混合階段的設(shè)備設(shè)計非常重要。”
中國團隊的新型存儲器研究
正如前文所說,中國北京大學(xué)團隊在IEDM 2022上發(fā)布了一些研究進展。北京大學(xué)集成電路學(xué)院也撰文分享了其在新型存儲器及可靠性研。需要強調(diào)一下,本章節(jié)內(nèi)的主要內(nèi)容都是引自北京大學(xué)集成電路學(xué)院的新聞稿,僅供讀者學(xué)習,其內(nèi)容版權(quán)歸北京大學(xué)所有。
DRAM作為存儲器市場的主力軍,傳統(tǒng)的1T1C結(jié)構(gòu)在10nm節(jié)點附近面臨巨大的瓶頸。后道兼容的寬禁帶氧化物半導(dǎo)體基2T0C DRAM,具有極低的關(guān)態(tài)漏電流,熱預(yù)算低,與硅基后道工藝兼容,可以在數(shù)據(jù)保持時間、功耗與密度上實現(xiàn)突破。然后,氧化物半導(dǎo)體特殊的滲流輸運機制導(dǎo)致了其高閾值電壓與高開態(tài)電流不可兼得,從而需要負保持電壓來實現(xiàn)高數(shù)據(jù)保持時間,并且寫入速度也遠低于當前主流水平。
針對上述問題,吳燕慶研究員、黃如院士團隊對基于寬禁帶氧化物半導(dǎo)體IGZO的晶體管載流子遷移率與源漏接觸進行優(yōu)化,實現(xiàn)了閾值電壓在100 pA*W/L的標準下大于1.2V,同時輸出電流在過驅(qū)動電壓為1V下達到24 mA/mm,柵壓為0時的關(guān)態(tài)電流在常溫和85℃下均小于10-19A/mm。2T0C DRAM單元成功實現(xiàn)了10 ns的超快寫入速度,以及室溫斷電情況下數(shù)據(jù)保持時間大于10ks和85℃下保持時間大于7ks,分別為之前同類工作的10倍與100倍。此外,通過調(diào)節(jié)寫入管的字線和位線電壓,成功在常溫和85℃下實現(xiàn)了具有超高區(qū)分度和線性度的3-bit存儲,并可通過電壓協(xié)同調(diào)節(jié)進一步擴展存儲容量。該工作展示了寬禁帶氧化物半導(dǎo)體在三維集成的大容量、高密度、非易失DRAM方向應(yīng)用的潛力。
氧化鉿基薄膜鐵電材料由于其與硅基工藝的兼容性,近年來受到廣泛的關(guān)注和研究。如何通過摻雜適合的元素以制備出具有優(yōu)異鐵電性的薄膜材料,是鉿基鐵電材料的重要問題。此外,如何在ns量級脈沖下獲得足夠的極化翻轉(zhuǎn)量也是實現(xiàn)高速非易失存儲的關(guān)鍵。針對以上問題,吳燕慶研究員、黃如院士團隊提出了通過鑭元素摻雜氧化鉿薄膜提升鐵電性的方法,系統(tǒng)研究了其鐵電回滯特性以及翻轉(zhuǎn)特性。實驗表征到超過38nm的大尺寸正交鐵電相(O相)單晶,在5ns脈沖下實現(xiàn)了文獻中最高的超過60mC/cm2的極化翻轉(zhuǎn)量,實現(xiàn)了1.3×104A/cm2的最高翻轉(zhuǎn)電流。提出了新的反映翻轉(zhuǎn)特性的參數(shù)-翻轉(zhuǎn)電導(dǎo)G,并測量到了最高的1.03×104S/cm2的翻轉(zhuǎn)電導(dǎo)。
鉿基鐵電晶體管(FeFET),由于其與CMOS工藝兼容性好、可微縮性強和低功耗等優(yōu)勢,在嵌入式和存儲級內(nèi)存等存儲器應(yīng)用領(lǐng)域具有廣泛的前景。針對鉿基FeFET耐久性低(<106)的問題,唐克超研究員、黃如院士課題組從硅溝道FeFET的器件原理出發(fā),提出了鐵電層-中間層協(xié)同優(yōu)化的耐久性改善新方法;結(jié)合第一性原理計算的理論預(yù)測,選取了Al:HfO2鐵電層和Al2O3中間層的材料組合,具有較低的電荷俘獲密度和較長的俘獲時間常數(shù),利于耐久性的提升。優(yōu)化后器件的耐久性超過5×109,超過通常報道的FeFET耐久性三個數(shù)量級以上,并具有10年以上的保持特性。研究成果對高耐久性的硅溝道FeFET提供了重要指導(dǎo)。
針對FeFET寫后讀延遲和循環(huán)操作中存儲窗口退化機理不清晰的問題,王潤聲教授、黃如院士課題組與合作者首次對不同應(yīng)力條件下器件中缺陷的物理性質(zhì)進行了全面的實驗研究。通過eMSM、DMP和RTN等先進表征方法,發(fā)現(xiàn)寫后讀延遲和存儲窗口退化的可靠性根源分別來自兩種不同的缺陷,并揭示了它們在循環(huán)電應(yīng)力下的動力學(xué)行為變化,為厘清FeFET的缺陷物理本質(zhì)、改善器件可靠性提供了重要的依據(jù)。
四層鐵電容器堆棧
根據(jù) Intel 在最近的技術(shù)會議上也發(fā)表了相關(guān)論文,很明顯,Intel 正在緊追 FeRAM,以此作為提供快速、密集、嵌入式 L4 緩存的一種方式。在 IEDM 2022 上,英特爾研究員 Shriram Shivaraman 發(fā)表了題為“Hafnia-Based FeRAM: A Path Toward Ultra-High Density for Next-Generation High-Speed Embedded Memory”的受邀論文。該演示文稿描述了創(chuàng)建具有四層 FeRAM 電容器堆疊層的嵌入式存儲器的能力,這表明堆疊電容器可以實現(xiàn)與傳統(tǒng) AFE(anti ferroelectric)溝槽電容器相同的行為,并且架構(gòu)變化不會影響 AFE 電容器的結(jié)晶和電氣特性。
負責 imec 鐵電項目的 imec研究員 Jan Van Houdt 則對此持謹慎態(tài)度。當被問及(正交)O-phase是否難以在 HZO 中保持時,Van Houdt 說:“我們?nèi)栽谂?yōu)化材料。
他接著指出,我們絕對希望擁有一種在加工過程中穩(wěn)定的材料,一種在使用壽命結(jié)束前保持相同相組成的材料,雖然我們現(xiàn)在還沒有。但它將是一種動態(tài)材料,隨溫度而變化,隨循環(huán)而變化。如果我們在設(shè)備上做一些壓力測試,它就會改變。這是一個不便的事實,我們不能完全控制材料的成分。與 DRAM 電容器中的常規(guī)電介質(zhì)或其他控制非常好的材料完全不同。
Van Houdt 說,一個樂觀的事實是原子級沉積 (ALD) 與鋯酸鉿 (HZO) 薄膜配合得很好。“有了鋯酸鉿,我們就有了 ALD,這讓 imec 看到了希望。我想我們會成功的。但以何種形式,這仍在爭論中。有一件事是肯定的,不再只是學(xué)術(shù)界在研究這個了。它已經(jīng)轉(zhuǎn)向業(yè)界。” 圖 1 顯示了 HZO 設(shè)備中的相數(shù)或極化可能性。

正如IL(interfacial)層在 CMOS 邏輯中起著至關(guān)重要的作用一樣,imec 研究人員在 IEDM 2022 上展示了界面工程( interfacial engineering)工作,研究了 IL 種子(seed)層和覆蓋(cap)層如何“顯著改善”基于 La 摻雜 HZO 的鐵電電容器,包括鐵電響應(yīng)和剩余極化 (PR:remnant polarization)。
imec 團隊在具有 TiN 頂部和底部電極的BL( bilayer) 和/或TL (trilayer) 配置中創(chuàng)建了 1 nm TiO2seed層和/或 2nm Nb2O5cap層。“我們展示了 Nb2O5cap 如何通過在 HZO 中注入氧氣來促進從((anti-FE)四方相(tetragonal)到(FE)正交相(orthorhombic phase)的轉(zhuǎn)變,并發(fā)現(xiàn) TiO2seed層有利于改善 HZO 內(nèi)部的晶粒取向,從而帶來更高的 2PR 和減少的喚醒。最后,根據(jù)所使用的 Hf 和 Zr 的前體( precursors),我們展示了兩種 trilayer器件的耐久性高達 1011次循環(huán),其在1.8 MV/cm能獲得約為30μC/cm2的2PR。在3 MV/cm的時候,歷經(jīng) 3x106的循環(huán)以后,更是獲得了一個創(chuàng)紀錄的66.5μC/cm2的2PR。”Van Houdt 說。
imec 團隊成員 J. Bizin davyi 表示,Bilayer 和trilayer堆疊可以成功組合以提高鐵電性,同時仍具有出色的耐用性。
從IGZO 氧化物半導(dǎo)體受益
有趣的是,日本研究人員在 IEDM 上展示了將 FeRAM 電容器與基于銦鎵鋅氧化物 (IGZO) 的氧化物半導(dǎo)體制成的控制設(shè)備相結(jié)合的工作,IGZO 是會議上的另一個熱門話題。Semiconductor Energy Laboratory Co., Ltd.(日本厚木)描述了一種使用氧化物半導(dǎo)體場效應(yīng)晶體管 (OSFET) 和鐵電電容器的 FeRAM,“利用 OSFET 的高擊穿電壓,即使柵極長度成比例 ” 。這家以研發(fā)為導(dǎo)向的公司報告稱,其 FeRAM 具有前所未有的尺寸——0.06μm2,實現(xiàn)了 10 ns 的寫入時間,在 85°C 下的保留時間為 1,000 分鐘或更長時間。在2.5V的工作電壓,它更是展現(xiàn)出了108的耐受循環(huán)。
“這種內(nèi)存具有較高的運行速度、非易失性以及較高的重復(fù)寫入耐久性,因此將成為未來新興內(nèi)存的候選者,”SEL在其論文中寫道。
新加坡國立大學(xué)的一篇論文還在 BEOL 兼容的非易失性開關(guān)中結(jié)合了 IGZO 器件和鐵電 HZO 電容器,這是一種 FPGA 類型的器件,NUS 團隊稱之為 MemTransistor(圖 2)。Soitec聲稱首次展示了與 BEOL 兼容的“3D Fin-Gate 氧化物半導(dǎo)體 Fe-FET。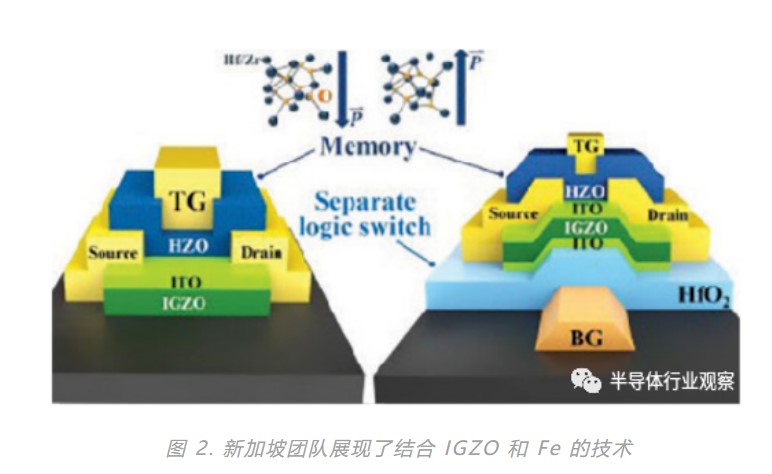
三星追逐MRAM
除了鐵電存儲器外,MRAM 在 IEDM 2022 上也受到關(guān)注,三星在兩個背靠背的演示中詳細介紹了其 MRAM 進展。J.H. Park 詳細介紹了三星在 STT-MRAM 方面的大量工作,他說,與 SRAM 相比,STT-MRAM 在速度、尺寸和耐用性方面具有許多優(yōu)勢。”
在接下來的演講中,T.Y. Lee 描述了“用于非易失性 RAM 應(yīng)用的世界上最節(jié)能的 MRAM 技術(shù)”。將磁隧道結(jié) (MTJ) 縮小到 14 納米 FinFET 節(jié)點,可使面積縮小 33%,讀取時間加快 2.6 倍(圖 3)。“MRAM 具有用作低泄漏工作存儲器的良好潛力,”Lee 說。
三星的研究人員聲稱,他們開發(fā)的這個產(chǎn)品是有史以來最小、最節(jié)能的非易失性隨機存取存儲器。
該團隊采用了該公司的 28 納米嵌入式 MRAM,并將磁性隧道結(jié)擴展到 14 納米 FinFET 邏輯工藝。論文摘要涉及該團隊生產(chǎn)的獨立存儲器,其寫入能量要求為每位 25pJ,以每秒 54MB 的數(shù)據(jù)速率進行讀取的有源功率要求為 14mW,寫入的有源功率要求為 27mW。循環(huán)是1014個周期,當縮放到 16Mbit 設(shè)備時,芯片將占用 30 平方毫米。
按照三星所說,該研究的目標之一是證明嵌入式 MRAM 作為緩存存儲器適用于依賴大型數(shù)據(jù)集和分析的應(yīng)用程序(例如邊緣 AI)的適用性。
審核編輯:劉清
-
DRAM
+關(guān)注
關(guān)注
40文章
2351瀏覽量
185824 -
存儲器
+關(guān)注
關(guān)注
38文章
7654瀏覽量
167766 -
CMOS工藝
+關(guān)注
關(guān)注
1文章
59瀏覽量
15960 -
IEDM
+關(guān)注
關(guān)注
0文章
5瀏覽量
11431 -
驅(qū)動電壓
+關(guān)注
關(guān)注
0文章
95瀏覽量
13753
原文標題:IEDM 2022上的新型存儲
文章出處:【微信號:光刻人的世界,微信公眾號:光刻人的世界】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
AI驅(qū)動新型存儲器技術(shù),國內(nèi)新興存儲企業(yè)進階






 IEDM 2022上的新型存儲器簡介
IEDM 2022上的新型存儲器簡介











評論