4月17日-19日,第25屆中國集成電路制造年會暨供應(yīng)鏈創(chuàng)新發(fā)展大會于廣州舉辦。長電科技董事、首席執(zhí)行長鄭力發(fā)表了以《高性能封裝承載集成電路成品制造技術(shù)持續(xù)創(chuàng)新》為主題的演講。
鄭力稱,未來集成電路產(chǎn)業(yè)向前發(fā)展,需要依靠應(yīng)用進(jìn)行驅(qū)動。對于封測行業(yè)也是這樣,將在應(yīng)用的驅(qū)動下向產(chǎn)業(yè)提供的解決方案,來引領(lǐng)集成電路產(chǎn)業(yè)在遇到技術(shù)或是成本瓶頸時繼續(xù)向前發(fā)展。封測產(chǎn)業(yè)作為集成電路的后道制造環(huán)節(jié),在集成電路的前道制造和應(yīng)用中確實起到了承前啟后的關(guān)鍵作用,將伴隨著摩爾定律繼續(xù)向前發(fā)展。
高性能封裝成為集成電路制造核心環(huán)節(jié)之一
作為全球領(lǐng)先的集成電路制造和技術(shù)服務(wù)提供商,長電科技多年前就提出從“封測”到“芯片成品制造”的升級,帶動行業(yè)重新定義封裝測試的產(chǎn)業(yè)鏈價值。
在本次大會上,長電科技再次提出了高性能封裝的概念,并認(rèn)為高性能封裝是未來集成電路制造的核心環(huán)節(jié)之一,將重塑集成電路產(chǎn)業(yè)鏈。
對于高性能封裝的定義,鄭力表示,業(yè)內(nèi)一般將封裝產(chǎn)業(yè)分為傳統(tǒng)封裝階段和先進(jìn)封裝階段,但時至今日先進(jìn)封裝的定義逐漸模糊。
“高性能封裝的一個核心關(guān)鍵詞就是異質(zhì)異構(gòu)集成。異質(zhì)異構(gòu)集成的發(fā)展對未來集成電路封裝測試步入高性能起到了關(guān)鍵性的作用,也為集成電路產(chǎn)業(yè)發(fā)展提供新空間。”
高性能計算芯片發(fā)展需要基于異質(zhì)異構(gòu)集成的高性能封裝。同時,Die-to-Die 2.5D/3D封裝是邏輯、模擬射頻、功率、光、傳感器等小芯片形成異質(zhì)集成的重要途徑。同時,SIP技術(shù)發(fā)展至今已經(jīng)形成了更高密度,更高帶寬的連接,從國際學(xué)術(shù)上來看,高密度SIP技術(shù)也是異質(zhì)異構(gòu)集成的重要路徑。
1965年4月19日,戈登·摩爾(Gordon Moore)在一篇主題為“讓集成電路填滿更多元件”的論文中首次預(yù)言,集成電路上可容納的晶體管數(shù)目大約會以每年增加一倍的速率增長。1975年,摩爾又將其修正為“每兩年翻一番”。這就是著名的就是“摩爾定律”。
鄭力表示,事實上,摩爾先生在上述文章中不僅提到了“摩爾定律”,還預(yù)測了可以用小芯片封裝組成大系統(tǒng)的芯片架構(gòu),繼續(xù)推動集成電路技術(shù)向前發(fā)展。也就是說,基于微系統(tǒng)集成的高性能封裝原本就是“摩爾定律”的重要內(nèi)容。
在過去的50余年,傳統(tǒng)的摩爾定律以晶體管微縮技術(shù)推動了集成電路性能的不斷提升,但隨著晶體管微縮技術(shù)遇到瓶頸,以2.5D/3D chiplet封裝、高密度SiP為代表的高性能異質(zhì)異構(gòu)集成正在成為集成電路未來創(chuàng)新的發(fā)展方向之一。
“未來集成電路高性能的持續(xù)演進(jìn)更依賴于微系統(tǒng)集成技術(shù)。”鄭力表示,以前的封裝技術(shù)更多考慮的是熱性能、力學(xué)性能等,但高性能的封裝技術(shù)將從系統(tǒng)層面優(yōu)化產(chǎn)品性能、功耗、尺寸、成本、可靠性、開發(fā)周期、上市時間。
應(yīng)用技術(shù)創(chuàng)新成就高性能封裝技術(shù)
鄭力表示,從行業(yè)發(fā)展來看,“封裝”一詞已經(jīng)不再適合當(dāng)前集成電路后道制造的特點。高性能封裝不僅僅是一個封和裝的過程,更重要的是“集”和“連”的過程。因此,基于高帶寬互聯(lián)的高密度集成是高性能封裝的核心特征之一。
高性能封裝的另一個特征在于芯片—封裝功能融合。鄭力表示,由于高性能封裝的出現(xiàn),芯片成品制造環(huán)節(jié)已經(jīng)與IC設(shè)計和晶圓制造環(huán)節(jié)密不可分,融為一體了。協(xié)同設(shè)計是高性能封裝的必由之路。
鄭力提出,DTCO通過器件微縮工藝和設(shè)計協(xié)同實現(xiàn)半導(dǎo)體集成電路性能的增長,在設(shè)計和生產(chǎn)制造之間成為了一個非常重要的開發(fā)路徑。但是隨著高性能封裝技術(shù)的發(fā)展,業(yè)內(nèi)又提出來了一個更為重要的設(shè)計開發(fā)路徑——STCO(系統(tǒng)、技術(shù)協(xié)同優(yōu)化)。
據(jù)了解,STCO是通過系統(tǒng)層面進(jìn)行功能分割再集成,以先進(jìn)高性能封裝為載體,通過芯片、封裝、系統(tǒng)協(xié)同優(yōu)化實現(xiàn)半導(dǎo)體集成電路性能的增長。
除設(shè)計協(xié)同外,鄭力還指出,高性能封裝需要更高效、更可靠的自動化生產(chǎn)設(shè)備和更高精密度的材料來支撐,高性能封裝技術(shù)向前發(fā)展,不僅需要與設(shè)計、制造、應(yīng)用相互協(xié)同,更需要上游材料、設(shè)備廠商的參與,這也給集成電路產(chǎn)業(yè)鏈提供了絕佳地向前發(fā)展機會。
“應(yīng)用將驅(qū)動高性能封裝技術(shù)的發(fā)展,而最早驅(qū)動的,毫無疑問是高性能計算。”鄭力表示,實際上,無論是自動駕駛、邊緣計算,還是工業(yè)自動化、智能化發(fā)展,都在驅(qū)動著高性能封裝的技術(shù),和集成電路產(chǎn)業(yè)的向前發(fā)展。
舉例來看,移動設(shè)備推動了SIP技術(shù)的發(fā)展,當(dāng)SIP技術(shù)成熟后又廣泛應(yīng)用于工控、邊緣計算等更多市場領(lǐng)域。
此外,光電合封(CPO)原來主要用于光通信的領(lǐng)域,但隨著高性能計算的發(fā)展,光纜的連接已經(jīng)無法滿足帶寬和速度需求。業(yè)內(nèi)客戶開始采用光電合封的形式,極大地優(yōu)化了芯片和芯片之間進(jìn)行互聯(lián)的帶寬和算力。隨著AI向前發(fā)展,光電合封也會成為高性能封裝技術(shù)中一個非常重要的形式。
最后,鄭力強調(diào),Chiplet架構(gòu)下的2.5D/3D封裝和高密度SiP封裝是摩爾定律向前發(fā)展的必經(jīng)之路,也將成為下一代先進(jìn)封裝技術(shù)的必備項和必選項。STCO系統(tǒng)技術(shù)協(xié)同優(yōu)化模式是芯片開發(fā)的核心從器件集成走向微系統(tǒng)集成的分水嶺。
審核編輯 :李倩
-
集成電路
+關(guān)注
關(guān)注
5415文章
11852瀏覽量
366081 -
封裝
+關(guān)注
關(guān)注
128文章
8352瀏覽量
144385 -
產(chǎn)業(yè)鏈
+關(guān)注
關(guān)注
3文章
1354瀏覽量
26138
原文標(biāo)題:長電科技CEO鄭力:高性能封裝將重塑集成電路產(chǎn)業(yè)鏈
文章出處:【微信號:actSMTC,微信公眾號:actSMTC】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
相關(guān)推薦
從“卡脖子”到自主創(chuàng)新,中國封裝材料產(chǎn)業(yè)鏈深度解析
FPGA+AI王炸組合如何重塑未來世界:看看DeepSeek東方神秘力量如何預(yù)測......
集成電路封裝的發(fā)展歷程

喆塔科技與國家級創(chuàng)新中心共建高性能集成電路數(shù)智化聯(lián)合工程中心
高性能集成電路應(yīng)用 集成電路封裝技術(shù)分析
58大新質(zhì)生產(chǎn)力產(chǎn)業(yè)鏈圖譜

行芯亮相2024上海新質(zhì)生產(chǎn)力集成電路產(chǎn)教融合大會
國內(nèi)半導(dǎo)體封裝測試企業(yè)盤點,長電華潤微萬年芯在列

第十六屆集成電路封測產(chǎn)業(yè)鏈創(chuàng)新發(fā)展論壇在蘇州開幕

集成電路的封裝形式介紹
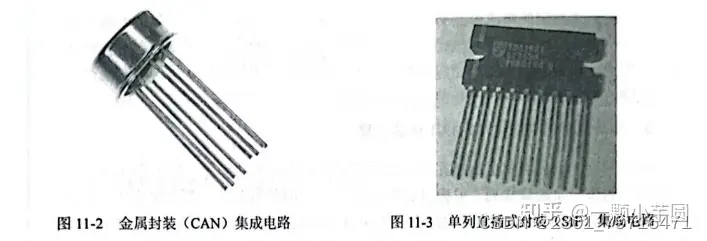





 長電科技CEO鄭力:高性能封裝將重塑集成電路產(chǎn)業(yè)鏈
長電科技CEO鄭力:高性能封裝將重塑集成電路產(chǎn)業(yè)鏈










評論