當(dāng)前紅外熱成像行業(yè)內(nèi)非制冷紅外探測(cè)器的封裝工藝主要有金屬封裝、陶瓷封裝、晶圓級(jí)封裝三種形式。
金屬封裝是業(yè)內(nèi)最早的封裝形式。 金屬封裝非制冷紅外探測(cè)器制作工藝上,首先對(duì)讀出電路的晶圓片進(jìn)行加工,在讀出電路預(yù)留的接口處進(jìn)行MEMS微橋結(jié)構(gòu)的生長(zhǎng),隨后進(jìn)行劃片,將整個(gè)晶圓片上的探測(cè)器芯片切割成獨(dú)立的單元,然后將每個(gè)單元與金屬管殼、TEC、吸氣劑以及紅外保護(hù)窗口等部件在特殊環(huán)境下進(jìn)行結(jié)合,完成真空封裝和相關(guān)測(cè)試。金屬封裝紅外探測(cè)器的成像更穩(wěn)定,環(huán)境適應(yīng)性強(qiáng),可靠性好,但其零部件材料昂貴,制造成本較高,特殊用途使用較多。
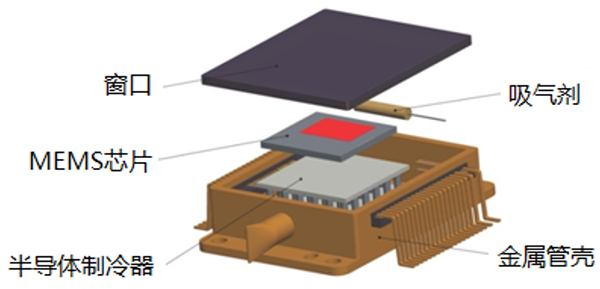
陶瓷紅外探測(cè)器封裝工藝過(guò)程與金屬封裝類似,是較為成熟的一種紅外探測(cè)器封裝技術(shù),相比金屬封裝探測(cè)器其封裝后的體積和重量會(huì)有較大程度減輕。原材料成本和制造成本上都比傳統(tǒng)的金屬管殼封裝有所降低,適合大批量電子元器件的生產(chǎn)。陶瓷管殼封裝技術(shù)的發(fā)展得益于目前讀出電路性能的提升,以及日趨完善的無(wú)TEC技術(shù),省去TEC可以減小對(duì)封裝管殼體積的要求并降低成本,更為民品的專用市場(chǎng)所青睞,但是仍然無(wú)法滿足智能家居以及消費(fèi)電子等新興領(lǐng)域的應(yīng)用需求。
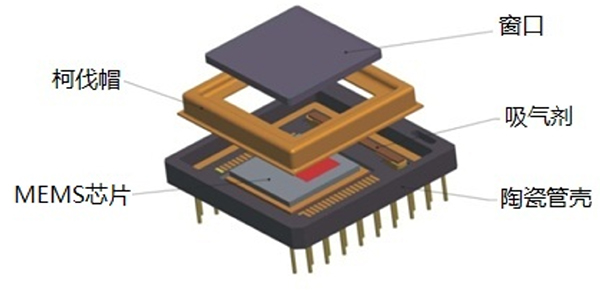
晶圓級(jí)封裝是近幾年才日趨成熟的一種封裝形式,其封裝難度最高,工藝最為復(fù)雜,需要制造與微測(cè)輻射熱計(jì)晶圓相對(duì)應(yīng)的另一片硅窗晶圓,微測(cè)輻射熱計(jì)晶圓與硅窗晶圓通過(guò)精密對(duì)位,紅外探測(cè)器芯片與硅窗一一對(duì)準(zhǔn),在真空腔體內(nèi)通過(guò)焊料環(huán)焊接在一起,最后再裂片成為一個(gè)個(gè)真空密閉的晶圓級(jí)紅外探測(cè)器。從工藝上來(lái)講,晶圓級(jí)紅外探測(cè)器可以做到體積更小,效率更高,產(chǎn)量更高,成本更低,可以用在軍品、民品,也可以廣泛應(yīng)用于消費(fèi)品領(lǐng)域,讓紅外熱成像技術(shù)走入尋常百姓家成為可能。

-
紅外探測(cè)器
+關(guān)注
關(guān)注
5文章
298瀏覽量
18527
發(fā)布評(píng)論請(qǐng)先 登錄
紅外探測(cè)器晶圓級(jí)、陶瓷級(jí)和金屬級(jí)三種封裝形式有什么區(qū)別?

深入探索:晶圓級(jí)封裝Bump工藝的關(guān)鍵點(diǎn)

不同類型金屬探測(cè)器比較
如何提高金屬探測(cè)器探測(cè)率
金屬探測(cè)器配件及其效果
金屬探測(cè)器使用技巧 水下金屬探測(cè)器使用方法
被動(dòng)紅外探測(cè)器接線方法
被動(dòng)紅外探測(cè)器與主動(dòng)紅外探測(cè)器的原理比較
被動(dòng)紅外探測(cè)器和主動(dòng)紅外探測(cè)器的區(qū)別
優(yōu)可測(cè)白光干涉儀助力紅外探測(cè)行業(yè)發(fā)展——晶圓襯底檢測(cè)

金屬探測(cè)器電路圖 帶Arduino的金屬探測(cè)器設(shè)計(jì)






 紅外探測(cè)器金屬、陶瓷和晶圓級(jí)封裝工藝對(duì)比
紅外探測(cè)器金屬、陶瓷和晶圓級(jí)封裝工藝對(duì)比



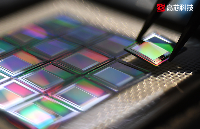










評(píng)論