高速光模塊主板BGA芯片底填膠點膠應用由漢思化學提供
客戶公司是研究、開發、生產、銷售計算機網絡設備及零部件、通訊設備及零部件并提供技術服務。其中通訊設備用到我公司的底部填充膠水。
客戶產品是通訊設備光模塊
用膠部位:光模塊主板BGA芯片需要點底填膠。
用膠目的:
光模塊主板BGA芯片底部需要點膠填充,將焊點密封保護起來。使BGA 封裝具備更高的機械可靠性。
客戶目前對膠水要求有兩個:
1、固化速度快,小于10min,制程控制要求
2、高固含量,低VOC揮發,揮發物會造成光路異常。
漢思化學推薦用膠:
經過漢思化學工作人員和客戶詳細溝通對接,推薦了底部填充膠HS710給客戶測試。
聲明:本文內容及配圖由入駐作者撰寫或者入駐合作網站授權轉載。文章觀點僅代表作者本人,不代表電子發燒友網立場。文章及其配圖僅供工程師學習之用,如有內容侵權或者其他違規問題,請聯系本站處理。
舉報投訴
-
芯片
+關注
關注
459文章
52091瀏覽量
435441 -
BGA
+關注
關注
5文章
564瀏覽量
48106 -
光模塊
+關注
關注
80文章
1370瀏覽量
59990
發布評論請先 登錄
相關推薦
熱點推薦
勻膠機轉速對微流控芯片精度的影響
微流控芯片制造過程中,勻膠是關鍵步驟之一,而勻膠機轉速會在多個方面對微流控芯片的精度產生影響: 對光刻膠厚度的影響 勻
芯片封裝膠underfill底部填充膠點膠工藝基本操作流程
一、烘烤烘烤,主要是為了確保主板的干燥。實施底部填充膠之前,如果主板不干燥,容易在填充后有小氣泡產生,在最后的固化環節,氣泡就會發生爆炸,從而影響焊盤與PCB之間的粘結性,也有可能導致焊錫球與焊盤






 高速光模塊主板BGA芯片底填膠點膠應用
高速光模塊主板BGA芯片底填膠點膠應用



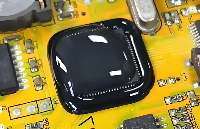

















評論