封裝作為半導(dǎo)體產(chǎn)業(yè)核心一環(huán),主要目的為保護芯片。半導(dǎo)體封裝測試處于晶圓制造過程中的后段部分,在芯片制造完后,將晶圓進行封裝測試,將通過測試的晶圓按需求及功能加工得到芯片,屬于整個IC 產(chǎn)業(yè)鏈中技術(shù)后段的環(huán)節(jié),封裝的四大目的為保護芯片、 支撐芯片及外形、將芯片的電極和外界的電路連通、增強導(dǎo)熱性能作用,實現(xiàn)規(guī)格標(biāo)準(zhǔn)化且便于將芯片的I/O端口連接到部件級(系統(tǒng)級)的印制電路板(PCB)、玻璃基板等材料上,以實現(xiàn)電路連接,確保電路正常工作。
早在2023年年初,SEMI(國際半導(dǎo)體產(chǎn)業(yè)協(xié)會)與TechSearch International就共同發(fā)表了全球半導(dǎo)體封裝材料市場前景報告(Global Semiconductor Packaging Materials Outlook),預(yù)測全球半導(dǎo)體封裝材料市場將追隨晶片產(chǎn)業(yè)增長的步伐:市場營收將從2019年的176億美元一舉上升至2024年的208億美元,復(fù)合年增長率(CAGR)達(dá)3.4%。無獨有偶,近日,TECHCET也發(fā)布了針對半導(dǎo)體封裝材料市場的最新展望,預(yù)計2022年半導(dǎo)體封裝材料市場總體規(guī)模約為261億美元,到2027年將有望達(dá)到300億美元。
鑒于整個半導(dǎo)體行業(yè)的預(yù)期放緩,封裝材料預(yù)計將下降約0.6%,但2023年下半年就有望復(fù)蘇,2024年的增長將使當(dāng)年的收入增加5%。

TECHCET表示,從2020年開始,封裝材料經(jīng)歷了強勁的出貨和收入增長。終端市場需求的變化,加上緊張的供應(yīng)鏈和物流限制,使整個供應(yīng)鏈的材料價格上漲。此外,許多材料部門在可用生產(chǎn)能力方面受到限制。由于受到成本上升的擠壓,許多供應(yīng)商限制了與產(chǎn)能相關(guān)的投資。供應(yīng)鏈和物流限制了供應(yīng)商擴大產(chǎn)能的速度。
封裝材料價格上漲的趨勢完全扭轉(zhuǎn)了十多年來的降價趨勢,這在很大程度上是由于設(shè)備制造商和OSAT的壓力。“降低成本”成為限制材料供應(yīng)商產(chǎn)能投資的口頭禪。這些需求驅(qū)動的價格上漲推動了2020年封裝材料收入增長超過15%,2021增長超過20%。只要原材料和能源成本繼續(xù)維持在高位,供應(yīng)商在產(chǎn)能擴張計劃中保持謹(jǐn)慎,目前的價格預(yù)計將保持不變。
有業(yè)內(nèi)人士認(rèn)為,驅(qū)動這波半導(dǎo)體產(chǎn)業(yè)成長,主要得益于各種新科技帶動,包括大數(shù)據(jù)、高性能運算(HPC)、人工智能(AI)、邊緣計算、前端存取存儲器、5G基礎(chǔ)設(shè)施的擴建、5G智能手機的采用、電動車使用率增長和汽車安全性增強功能等。
此外,晶圓級封裝、倒裝芯片封裝和包括系統(tǒng)級集成在內(nèi)的異構(gòu)集成,是新材料領(lǐng)域發(fā)展的主要驅(qū)動力。對于晶圓級封裝,最大的應(yīng)用仍然是移動電子,其他的應(yīng)用場景也在快速增長,像是汽車領(lǐng)域。倒裝芯片互連在高性能計算、高頻通信和其他應(yīng)用中的增長仍然強勁,銅柱互連技術(shù)的使用越來越多。
-
芯片
+關(guān)注
關(guān)注
460文章
52520瀏覽量
441079 -
芯片封裝
+關(guān)注
關(guān)注
11文章
578瀏覽量
31467
發(fā)布評論請先 登錄
全球半導(dǎo)體市場持續(xù)增長 2025年5月銷售額達(dá)590億美元

安世半導(dǎo)體Nexperia 2024年財報:營收20.6億美元,市場份額從2023年的8.9%提升至9.7%
全球化合物半導(dǎo)體市場預(yù)計到2030年將達(dá)250億美元!

2024年半導(dǎo)體銷售超6200億美元,AI和存儲成增長密碼

2024年全球半導(dǎo)體銷售額突破6000億美元
2025年全球半導(dǎo)體市場將增至7050億美元
TECHCET預(yù)測,半導(dǎo)體材料市場預(yù)計將在2028年增長至840億美元

AI Server市場持續(xù)擴張,2025年產(chǎn)值有望逼近3000億美元
預(yù)計2025年全球半導(dǎo)體封裝材料市場規(guī)模達(dá)260億美元
全球半導(dǎo)體市場回暖:預(yù)計2024年市場規(guī)模將達(dá)6000億美元
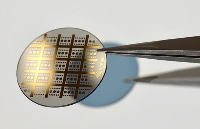
SEMI報告:未來三年全球半導(dǎo)體行業(yè)計劃在300mm晶圓廠設(shè)備上投資4000億美元






 半導(dǎo)體封裝材料市場:2024年或升至208億,2027年有望達(dá)300億美元
半導(dǎo)體封裝材料市場:2024年或升至208億,2027年有望達(dá)300億美元












評論