文章來源“先進制程貼近物理極限,算力需求Chiplet迎來黃金發展期(精華)”,研究機構IBS 統計對比16nm至3nm 的單位數量的晶體管成本指出,隨著制程工藝的推進,單位數量的晶體管成本的下降幅度在急劇降低。比如從 16nm 到 10nm,每10億顆晶體管的成本降低了23.5%,而從5nm到3nm成本僅下降了 4%。 隨著先進制程持續推進,單位晶體管所需要付出的成本降低的速度正在持續放緩,即意味著摩爾定律正在放緩。Chiplet 誕生背景是在摩爾定律放緩。
1、Chiplet 在成本、良率、設計靈活性等方面優勢明顯
Chiplet俗稱“芯粒”或“小芯片組”,通過將原來集成于同一 SoC 中的各個元件分拆,獨立 為多個具特定功能的 Chiplet,分開制造后再通過先進封裝技術將彼此互聯,最終集成封裝 為一個系統芯片。 由于Chiplet芯粒可以獨立設計和組裝,因此制造商可以根據自己的需要來選擇不同類型、不同規格和不同供應商的芯粒進行組合,很大程度上提高了芯片設計的靈活性和可定制化程度;并且制造商可以依賴于預定好的芯片工具箱來設計新產品,縮短芯片的上市時間。同時,Chiplet技術可以將大型 7nm 設計的成本降低高達 25%;在 5nm 及以下的情況下,節省的成本更大。
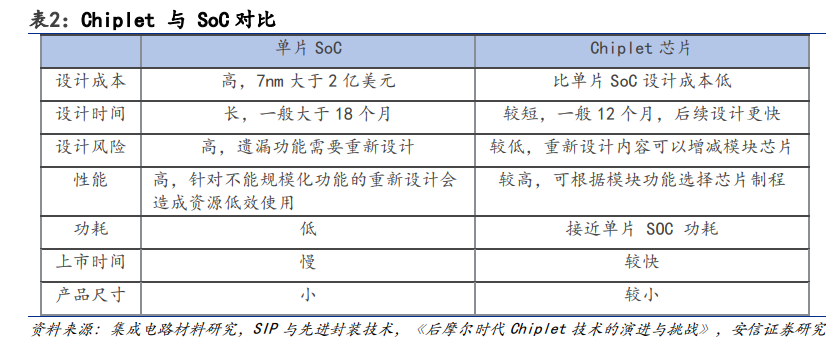
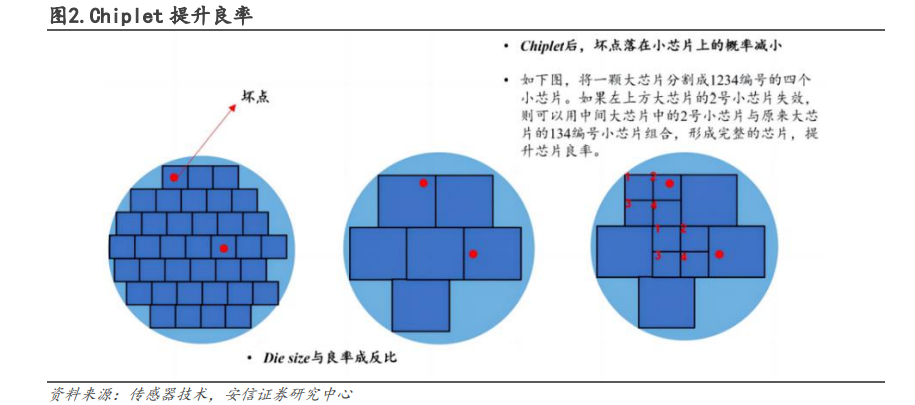
Chiplet 技術被視為“異構”技術的焦點,也是當下最被企業所認可的新型技術之一。2022年 3 月,英特爾、AMD、Arm、高通、三星、臺積電、日月光、Google Cloud、Meta、微軟等全球領先的芯片廠商共同成立了 UCIe 聯盟,旨在建立統一的 die-to-die 互聯標準,促進Chiplet 模式的應用發展,目前聯盟成員已有超過 80 家半導體企業,越來越多的企業開始研發 Chiplet 相關產品。
2、Chiplet市場規模快速成長
根據 Gartner 數據統計,基于 Chiplet 的半導體器件銷售收入在 2020 年僅為 33 億美元,2022 年已超過 100 億美元,預計 2023 年將超過 250 億美元,2024 年將達到 505 億美元,復合年增長率高達 98%。超過 30%的 SiP 封裝將使用芯粒(Chiplet)來優化成本、性能和上市時間。

MPU占據Chiplet 大部分應用應用場景,Omdia 預測 2024 年用于 MPU 的 Chiplet 約占Chiplet 總市場規模的 43%。 隨著 Chiplet 技術的發展,Chiplet 產業鏈各環節逐漸完善,即由 Chiplet 系統級設計、EDA/IP、芯粒(核心、非核心、IO Die、Base Die)、制造、封測組成的完整 Chiplet 生態鏈。

Chiplet產業鏈主鏈有四大環節,包括芯粒、芯片設計、封裝生產和系統應用,支撐環節包括芯粒生產、設計平臺、EDA 工具、封裝基板、封測設備等領域。
3、IC 制造及封測廠加碼布局Chiple
目前全球封裝技術主要由臺積電、三星、Intel 等公司主導,主要是 2.5D 和 3D 封裝。2.5D 封裝技術已非常成熟,廣泛應用于 FPGA、CPU、GPU 等芯片,目前是 Chiplet 架構產品主要的封裝解決方案。3D 封裝能夠幫助實現 3D IC,即晶粒間的堆疊和高密度互連,可以提供更為靈活的設計選擇。但 3D 封裝的技術難度更高,目前主要有英特爾和臺積電掌握 3D 封裝技術并商用。臺積電比三星、英特爾更早采用 Chiplet 的封裝方式。
1)、臺積電3DFabric封裝技術
臺積電推出了3D Fabric,搭載了完備的3D硅堆棧(3D Silicon Stacking)和先進的封裝技術。3DFabric 是由臺積電前端 3D 硅堆棧技術 TSMC SoIC 系統整合的芯片,由基板晶圓上封裝(Chip on Wafer on Substrate, CoWoS)與整合型扇出(Integrated Fan-Out, InFO)的后端 3D 導線連接技術所組成,能夠為客戶提供整合異質小芯片(Chiplet)的彈性解決方案。該項技術先后被用于賽靈思的 FPGA、英偉達的 GPU 以及 AMD 的 CPU。
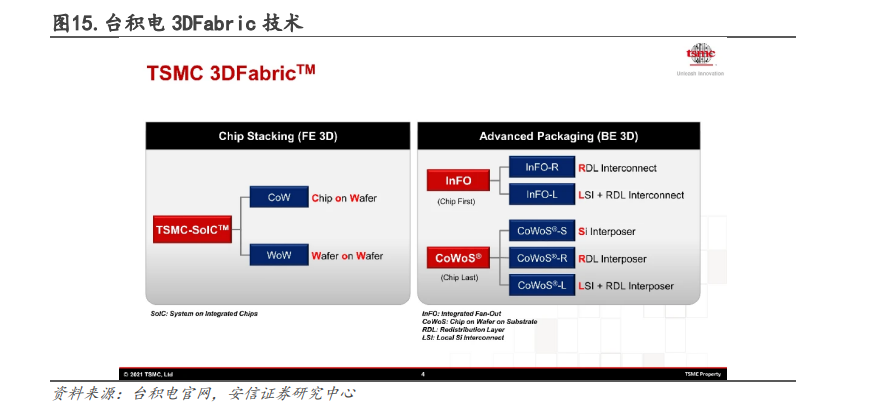
2)、Intel2.5D封裝技術EMIB
Intel主導的 2.5D 封裝技術為 EMIB,使用多個嵌入式包含多個路由層的橋接芯片,同時內嵌至封裝基板,達到高效和高密度的封裝。由于不再使用 interposer 作為中間介質,可以去掉原有連接至 interposer 所需要的 TSV,以及由于 interposer 尺寸所帶來的封裝尺寸的限制,可以獲得更好的靈活性和更高的集成度。 相較于 MCM 和 CoWoS 技術,EMIB 技術獲得更高的集成度和制造良率。英特爾對各種先進封裝產品組合 (如 Foveros、EMIB 和 Co-EMIB) 的投資是實施公司新領導層所公布的 IDM2.0 戰略的關鍵。
3)、三星X Cube 3D封裝技術
三星也在積極投資先進的封裝技術,以滿足 HPC 應用在異質芯片整合的快速發展。2020 年 8 月,三星公布了 X Cube 3D 封裝技術。在芯片互連方面,使用成熟的硅通孔 TSV 工藝。目前X Cube 能把 SRAM 芯片堆疊在三星生產的 7nm EUV 工藝的邏輯芯片上,在更易于擴展 SRAM 容量的同時也縮短了信號連接距離,提升了數據傳輸的速度。此后發布的 I-Cube 可以將一個或多個邏輯Die 和多個 HBM die 水平放置在硅中介層,進行異構集成。
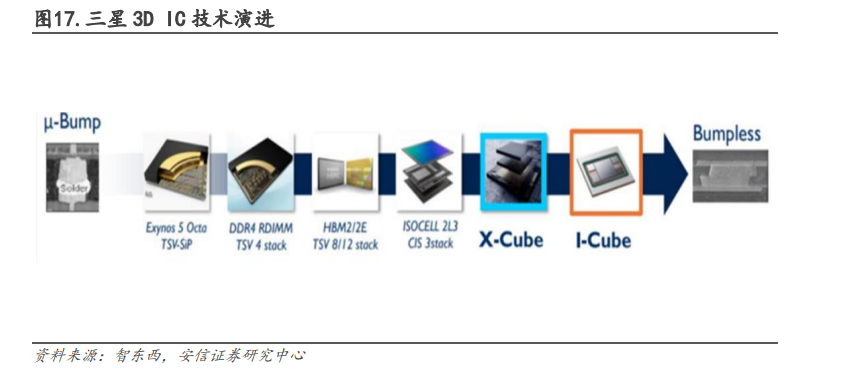
4)、日月光FOCoS先進封裝技術
日月光憑借在FOCoS先進封裝技術的布局,是目前在封測代工廠中唯一擁有超高密度扇出解決方案的供應商。日月光的 FOCoS提供了一種用于實現小芯片集成的硅橋技術,稱為 FOCoSB(橋),它利用帶有路由層的微小硅片作為小芯片之間的封裝內互連,例如圖形計算芯片(GPU)和高帶寬內存(HBM)。硅橋嵌入在扇出 RDL 層中,是一種可以不使用硅中介層的 2.5D 封裝方案。與使用硅中介層的 2.5D 封裝相比,FOCoS-B 的優勢在于只需要將兩個小芯片連接在一起的區域使用硅片,可大幅降低成本。
5)、長電科技2.5D TSV-less封裝技術
長電科技推出的面向Chiplet小芯片的高密度多維異構集成技術平臺 XDFOI可實現 TSV-less 技術,達到性能和成本的雙重優勢,重點應用領域為高性能運算如 FPGA、5G、自動駕駛、智能醫療等。 XDFOI是一種以 2.5D TSV-less 為基本技術平臺的封裝技術,在線寬/線距可達到 2μm/2μm 的同時,還可以實現多層布線層,以及 2D/2.5D 和 3D 多種異構封裝,能夠提供小芯片(Chiplet)及異構封裝的系統封裝解決方案。目前長電先進 XDFOI 2.5D 試驗線已建設完成,并進入穩定量產階段,同步實現國際客戶 4nm 節點多芯片系統集成封裝產品出貨。
-
封裝技術
+關注
關注
12文章
576瀏覽量
68492 -
半導體器件
+關注
關注
12文章
777瀏覽量
32857 -
chiplet
+關注
關注
6文章
453瀏覽量
12914 -
先進封裝
+關注
關注
2文章
465瀏覽量
549
原文標題:百家爭鳴:Chiplet先進封裝技術哪家強?
文章出處:【微信號:架構師技術聯盟,微信公眾號:架構師技術聯盟】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
高算力AI芯片主張“超越摩爾”,Chiplet與先進封裝技術迎百家爭鳴時代

百家爭鳴 智能物聯網應用未來如何發展
5G全新空口技術的挑戰
六款主流電子電路仿真軟件介紹
半導體產業進入三強鼎立時代
MWC國產手機百家爭鳴 魅族下午5點亮底牌
半自動駕駛技術“百家爭鳴”

國內AI芯片百家爭鳴_如何抗衡全球技術寡頭
工業機器人市場百家爭鳴,未來前景良好
智能汽車產業的風口已經形成 智能車載系統百家爭鳴

國內物聯網:“百花齊放,百家爭鳴”
多款5G集成手機芯片發布,產品百家爭鳴,技術優勢最強集成
先進封裝Chiplet的優缺點與應用場景

政策助高端醫械補齊短板,Medtec創新活動促品牌“百家爭鳴”






 百家爭鳴:Chiplet先進封裝技術哪家強?
百家爭鳴:Chiplet先進封裝技術哪家強?










評論