·高電鍍銅均勻性及電流密度,提高產(chǎn)能與良率,助力車用半導(dǎo)體芯片生產(chǎn)
·協(xié)同制程開發(fā)、設(shè)備制造、生產(chǎn)調(diào)試到售后服務(wù)規(guī)劃,實(shí)現(xiàn)具可靠性的板級封裝FOPLP整廠解決方案
作為一家活躍于全球并具有廣泛技術(shù)組合的高科技設(shè)備制造商Manz 集團(tuán),繼打造業(yè)界最大700 x 700 mm生產(chǎn)面積的FOPLP封裝技術(shù) RDL生產(chǎn)線,為芯片制造商提供產(chǎn)能與成本優(yōu)勢后,持續(xù)投入開發(fā)關(guān)鍵電鍍設(shè)備,并于近日在兩大重點(diǎn)技術(shù)的攻關(guān)上取得重大突破:
一是鍍銅厚度達(dá)100 μm以上,讓芯片封裝朝著體積輕薄化的演進(jìn)下仍能使組件具有良好的導(dǎo)電性、電性功能與散熱性;
二是開發(fā)大于5 ASD的高電鍍電流密度規(guī)格,快速增加鍍銅的速度,有效提升整體產(chǎn)能。
此次技術(shù)突破為需求激增的高電性、高散熱性車載芯片提供了最佳生產(chǎn)解決方案,并助力芯片制造商攫取高速成長的車用半導(dǎo)體商機(jī)。這也是Manz 集團(tuán)繼打造業(yè)界最大700 x 700 mm生產(chǎn)面積的FOPLP封裝技術(shù) RDL生產(chǎn)線,為芯片制造商提供產(chǎn)能與成本優(yōu)勢后,在關(guān)鍵技術(shù)領(lǐng)域取得的又一新突破。
根據(jù)Prismark的報(bào)告,2022年全球半導(dǎo)體市場雖然遭遇市場亂流,但是車用半導(dǎo)體無畏于COVID疫情肆虐、高通脹與能源價格高漲的現(xiàn)實(shí),強(qiáng)勢展現(xiàn)了2022到2027期間的復(fù)合年均增長率(CAGR)的預(yù)估,自動輔助駕駛(ADAS)增長高達(dá)13%,而電力系統(tǒng)增長則更高到18%,雙雙創(chuàng)下2位數(shù)的高增長率,成為半導(dǎo)體產(chǎn)業(yè)強(qiáng)力的增長引擎。為了掌握車用芯片市場的高成長良機(jī),車用IDM大廠、OSAT、IC載板與PCB大廠積極尋求具備成本效益的高功能互連(Interconnect) 技術(shù),以滿足兼顧細(xì)線化導(dǎo)線與高散熱薄形化封裝需求的創(chuàng)新設(shè)計(jì),F(xiàn)OPLP技術(shù)可免除IC載板的使用,成為車用芯片商與供應(yīng)鏈的首選。
Manz亞智科技亞洲區(qū)總經(jīng)理林峻生表示:“「車用芯片制造商在應(yīng)用FOPLP封裝技術(shù)面對電源芯片與模塊的銅導(dǎo)線制程挑戰(zhàn)時,較高電流密度電鍍銅的高均勻性可進(jìn)一步將產(chǎn)能及良率推升,也可提升電動車系統(tǒng)功率組件效能,強(qiáng)化電動車?yán)m(xù)航能力并降低環(huán)境污染,履行企業(yè)社會責(zé)任。”」而國內(nèi)新能源車市場近期面對「降本增效」,車用芯片制造商正面臨利潤下降與設(shè)計(jì)周期壓縮的挑戰(zhàn)。林峻生指出:“「Manz FOPLP封裝技術(shù)已達(dá)700 x 700 mm生產(chǎn)面積,將生產(chǎn)面積使用率提升到95 % ,可望為車用芯片制造商提高生產(chǎn)效率同時降低成本。除了制程技術(shù)開發(fā)及設(shè)備制造外,Manz亞智科技全方位的服務(wù)還涵蓋以自動化整合上下游設(shè)備整廠生產(chǎn)設(shè)備線,協(xié)助客戶生產(chǎn)設(shè)備調(diào)試乃至量產(chǎn)后的售后服務(wù)規(guī)劃,一站式完整服務(wù),幫助國內(nèi)芯片制造商以高速建造生產(chǎn)線, 同時有效降低成本。”」
打造700 x 700 mm業(yè)界最大生產(chǎn)面積的面板級封裝RDL生產(chǎn)線
Manz憑借長久在濕法化學(xué)制程、電鍍、自動化、量測與檢測等制程解決方案應(yīng)用于不同領(lǐng)域所累績的核心技術(shù),以自動化技術(shù)串聯(lián)整線設(shè)備,打造業(yè)界第一條700 x 700 mm最大生產(chǎn)面積的FOPLP封裝RDL生產(chǎn)線,并已進(jìn)入量產(chǎn)驗(yàn)證階段,由于RDL制程占整體FOPLP封裝超過三分之一的成本,其中至關(guān)重要的設(shè)備即為電鍍設(shè)備,Manz的解決方案在RDL導(dǎo)線層良率與整體面積利用率,顯現(xiàn)強(qiáng)大的競爭優(yōu)勢,大幅降低封裝制程的成本,目前已經(jīng)與國際IDM大廠合作組裝一條驗(yàn)證生產(chǎn)線,積極進(jìn)入生產(chǎn)驗(yàn)證與機(jī)臺參數(shù)調(diào)校流程,緊鑼密鼓準(zhǔn)備迎接接續(xù)的量產(chǎn)訂單。
全方位服務(wù)打造整廠解決方案,建立高獲利FOPLP封裝的商業(yè)模式
除了設(shè)備建造外,Manz與客戶合作密切,協(xié)同開發(fā)制程,并打造整合上下游設(shè)備整廠生產(chǎn)設(shè)備線,形成整廠解決方案(Total Fab Solution);以最佳制程參數(shù)調(diào)校的能力,協(xié)助IDM、OSAT與半導(dǎo)體代工廠建立完整芯片封裝生產(chǎn)線,打造有利的FOPLP商業(yè)模式,并進(jìn)而提升客戶在半導(dǎo)體產(chǎn)業(yè)鏈的地位,增加半導(dǎo)體產(chǎn)品的競爭力。
FOPLP封裝大舉提升制程精細(xì)度,助長電源管理組件效能
FOPLP封裝的RDL技術(shù)滿足高密度互連所構(gòu)成的復(fù)雜布線規(guī)格,解決多芯片與越來越小的組件緊密整合時所需要的更多互連層,透過精密金屬連接降低電阻值以提高電氣性能。由于電動車市場高速起飛,SiC與IGBT等第三類半導(dǎo)體與高功率、大電流應(yīng)用的車用芯片大行其道。為了滿足大量的電源控制芯片的暢旺需求,Manz的RDL制程解決方案實(shí)現(xiàn)精細(xì)的圖形線路與復(fù)雜的薄膜層的制造與管控,提供最小5μm /5μm的線寬與線距的制程規(guī)格,讓半導(dǎo)體供應(yīng)鏈從容面對高密度封裝的技術(shù)挑戰(zhàn)。
高電鍍銅均勻性,提高產(chǎn)能與良率,協(xié)助客戶達(dá)成節(jié)能減廢的ESG目標(biāo)
電鍍設(shè)備是RDL制程中至關(guān)重要的環(huán)節(jié),Manz電鍍設(shè)備除了結(jié)合自有前、后段濕制程提供優(yōu)異的整合方案之外,還能實(shí)現(xiàn)整面電鍍銅之均勻性達(dá)92%的高標(biāo)準(zhǔn),鍍銅厚度可以做到100 μm以上的規(guī)格,讓組件密度提升與封裝架構(gòu)薄型化,以具有優(yōu)良的電性與散熱性,使用大于5 ASD的高電鍍電流密度規(guī)格,快速增加鍍銅的速度與提升整體產(chǎn)能,采用無治具垂直電鍍系統(tǒng)及自動移載系統(tǒng),駕馭700 x 700 mm基板的行進(jìn)與移動,有效搭配化學(xué)物分析、銅粉添加及化學(xué)液添加等模塊,有效掌握化學(xué)品管理與維持節(jié)能減廢的優(yōu)化安排,協(xié)助客戶達(dá)成ESG目標(biāo)。
Manz亞智科技瞄準(zhǔn)全球車用芯片近年激增需求,期望在板級封裝FOPLP制程設(shè)備的突破,滿足客戶進(jìn)行RDL制程研發(fā)與產(chǎn)能最佳化規(guī)劃,保持階段性的技術(shù)發(fā)展與產(chǎn)能擴(kuò)張所需的彈性配置,成為半導(dǎo)體市場不可或缺的競爭優(yōu)勢。同時,擴(kuò)大規(guī)模量產(chǎn)與成本的優(yōu)勢,凝聚成為一個重要的技術(shù)領(lǐng)域,加速FOPLP市場化與商品化的快速成長,以此打造半導(dǎo)體新應(yīng)用的發(fā)展契機(jī)
我們歡迎您于SEMICON China 2023展會期間蒞臨Manz展位,了解Manz創(chuàng)新板級封裝 RDL生產(chǎn)設(shè)備解決方案。
Manz與您相約SEMICON China 2023,上海新國際博覽中心
│ 日期:06.29 ~ 07.01
│ 參觀時間:09:00~17:00
│ 展位位置:E1館 #1477
關(guān)于Manz集團(tuán)
創(chuàng)新設(shè)備成就明日生產(chǎn)力 —— ENGINEERING TOMORROW'S PRODUCTION
Manz 集團(tuán)是一家活躍于全球的高科技生產(chǎn)設(shè)備制造商。超過三十年的生產(chǎn)設(shè)備制造經(jīng)驗(yàn),集團(tuán)核心技術(shù)涵蓋自動化、濕法化學(xué)制程、檢測系統(tǒng)、激光加工和噴墨打印;憑借著核心技術(shù),專注于開發(fā)和設(shè)計(jì)創(chuàng)新且高效的半導(dǎo)體面板級封裝、顯示器、IC載板、鋰電池以及電池CCS組件等生產(chǎn)設(shè)備,從用于實(shí)驗(yàn)室生產(chǎn)或試生產(chǎn)和小量生產(chǎn)的定制單機(jī)、標(biāo)準(zhǔn)化模塊設(shè)備和系統(tǒng)生產(chǎn)線,甚至到量產(chǎn)線的整廠生產(chǎn)設(shè)備解決方案——應(yīng)用于電子產(chǎn)品、汽車和電動車和醫(yī)療等市場的生產(chǎn)設(shè)備解決方案。
Manz集團(tuán)成立于 1987 年,自 2006 年起在法蘭克福證券交易所上市。全球約 1,500 名員工位于德國、斯洛伐克、匈牙利、意大利、中國大陸和臺灣進(jìn)行開發(fā)和生產(chǎn);美國和印度也設(shè)有銷售和客戶服務(wù)子公司。2022財(cái)年集團(tuán)的收入約為 2.50 億歐元。
審核編輯 黃宇
-
芯片
+關(guān)注
關(guān)注
459文章
51996瀏覽量
434358 -
半導(dǎo)體
+關(guān)注
關(guān)注
335文章
28414瀏覽量
230732 -
封裝
+關(guān)注
關(guān)注
128文章
8399瀏覽量
144565
發(fā)布評論請先 登錄
芯片封裝中的FOPLP工藝介紹
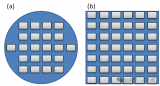
下一代FOPLP基板,三星續(xù)用塑料,臺積青睞玻璃
三星與臺積電在FOPLP材料上產(chǎn)生分歧
Manz集團(tuán)成功交付多尺寸板級封裝RDL量產(chǎn)線
先進(jìn)封裝技術(shù)-7扇出型板級封裝(FOPLP)

Manz亞智科技RDL制程打造CoPoS板級封裝路線,滿足FOPLP/TGV應(yīng)用于下一代AI需求

Manz亞智科技RDL制程打造CoPoS板級封裝路線, 滿足FOPLP/TGV應(yīng)用于下一代AI需求

整合為王,先進(jìn)封裝「面板化」!臺積電、日月光、群創(chuàng)搶攻FOPLP,如何重塑封裝新格局?

Manz亞智科技RDL設(shè)備切入五家大廠
AI芯片先進(jìn)封裝供應(yīng)緊張,臺企加速布局FOPLP技術(shù)
日月光FOPLP扇出型面板級封裝將于2025年二季度小規(guī)模出貨
臺積電布局FOPLP技術(shù),推動芯片封裝新變革
FOPLP技術(shù)受AMD與英偉達(dá)推動,預(yù)計(jì)2027-2028年量產(chǎn)
大廠群創(chuàng)華麗轉(zhuǎn)型全球最大尺寸FOPLP廠!先進(jìn)封裝如此火熱,友達(dá)為何不跟進(jìn)?






 Manz亞智科技FOPLP封裝技術(shù)再突破
Manz亞智科技FOPLP封裝技術(shù)再突破










評論