掃描電鏡-電子通道襯度成像技術(SEM-ECCI)是一種在掃描電鏡下直接表征晶體材料內部缺陷的技術。SEM-ECCI技術的發展在缺陷表征領域替代了一部分透射電鏡(TEM)的功能,相對透射電鏡分析而言,提供了更高通量、更快效率的分析解決方案,也更具有統計意義。
由于其高效的成像效率、簡單且非破壞性的制樣流程,此技術近年來在金屬材料、化合物半導體等領域得到了很大的發展,也受到了越來越多的關注。
接下來,為您展示的是研究人員們利用蔡司場發射掃描電鏡的ECCI技術取得的成果。
異質外延生長的GaN/AlGaN薄膜材料在光子、電力電子及微波射頻器件中具有廣泛應用。隨著GaN器件的微型化,其薄膜材料中位錯缺陷的類型、面密度及分布情況嚴重限制了器件的性能及可靠性。如何在不破壞薄膜材料的前提下,精確表征GaN、GaN/AlGaN異質結中的位錯缺陷仍具有較大的挑戰。
中科院蘇州納米所研究員樊士釗等基于蔡司場發射掃描電鏡通道襯度成像技術(ECCI)成功分析出刃位錯、螺位錯及混合位錯的面密度,并首次在GaN/AlGaN異質結中觀測到位錯半環及位錯滑移現象。
研究人員利用蔡司場發射掃描電鏡獲取GaN薄膜材料的菊池花樣(圖1)。通過系統分析菊池晶帶與垂直晶面、傾斜晶面的對應關系,精準選取布拉格衍射條件并用于位錯通道襯度成像。

▲ (a)GaN薄膜的菊池花樣及由電子束衍射的運動學理論計算得出的(b)垂直晶面和(c)傾斜晶面的菊池晶帶分布圖
通過對比同一區域的位錯在不同雙束衍射條件下的襯度演化規律,將消光判據與位錯襯度分布方向判據相結合,實現了對位錯伯氏矢量的判定(圖2)。另外,通過分析基于電子通道襯度技術直接獲得的位錯類型占比與基于X射線衍射方法間接獲得的位錯類型占比,確定電子通道襯度成像技術在分析混合位錯方面的獨特優勢。

▲ 圖2.同一區域GaN薄膜在不同雙束衍射條件下的通道襯度成像及位錯類型判定
最后,利用電子通道襯度成像技術直接測試GaN/AlGaN異質結界面,首次觀測到位錯半環,并發現大量混合位錯在界面處的彎曲形成失配位錯(圖3)。通過分析位錯彎曲的晶向,判明界面存在位錯滑移現象,為GaN器件的失效機制拓展了新的研究方向。
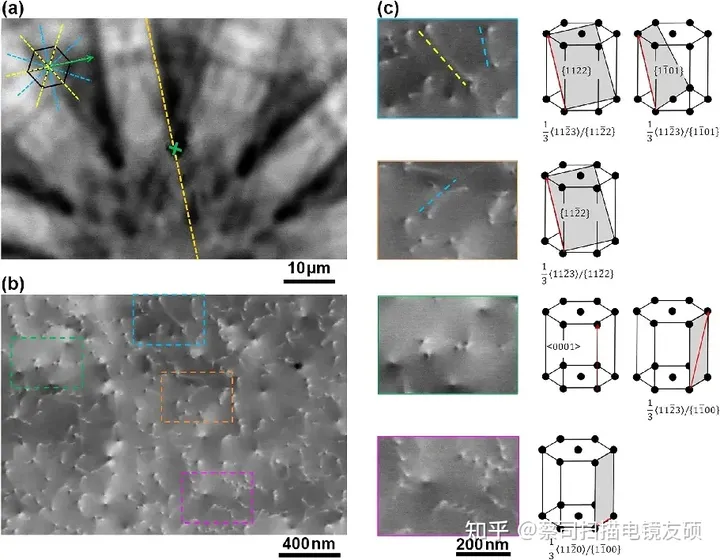
▲ 圖3. GaN/AlGaN異質結的通道襯度成像及位錯滑移體系的判定
審核編輯 黃宇
-
半導體
+關注
關注
335文章
28703瀏覽量
234323 -
成像技術
+關注
關注
4文章
303瀏覽量
31769 -
GaN
+關注
關注
19文章
2186瀏覽量
76342 -
電鏡
+關注
關注
0文章
97瀏覽量
9575
發布評論請先 登錄
掃描電鏡日常操作流程的詳細說明
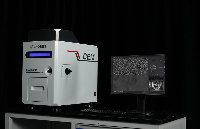
SEM是掃描電鏡嗎?

材料的哪些性質會影響掃描電鏡下的成像效果
掃描電鏡有哪些作用?

CEM3000系列臺式掃描電鏡在金屬材料分析中的應用

掃描電鏡與氬離子拋光技術在樣品成分分析的作用

場發射掃描電鏡(FESEM)與常規掃描電鏡(SEM):技術對比及優勢分析
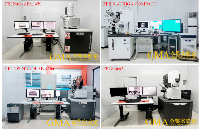
臺式掃描電鏡:微觀尺度形貌觀測和分析利器
掃描電鏡是用來測什么的
這些因素影響蔡司顯微鏡掃描電鏡的價格

蔡司X射線顯微鏡和掃描電鏡檢測燃料電池材料
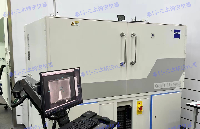





 蔡司掃描電鏡在半導體領域的應用成果
蔡司掃描電鏡在半導體領域的應用成果













評論