散包裝SD NAND的使用注意事項
1、若購買散包裝,請務必上線前120℃烘烤8小時。
2、若物料沒有全部使用,剩余部分請務必存放于氮氣柜或抽真空保存,再次上線前請務必120℃烘烤8小時。
MK-米客方德 SD NAND封裝示意圖:
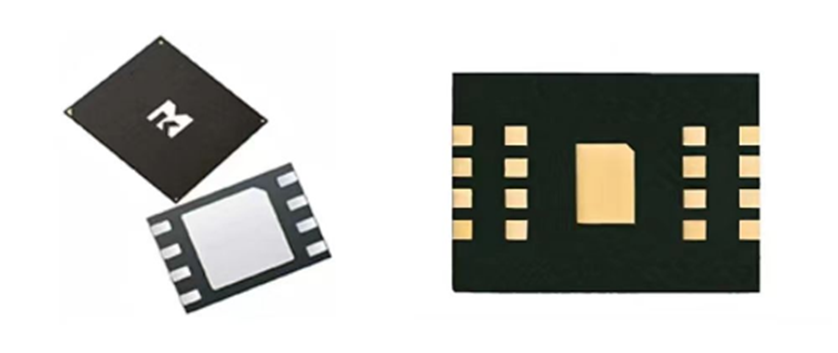
貼片溫度和貼裝順序
1、峰值溫度請務必控制到250℃以內,且此峰值溫度下,時間不能超過10秒。
2、若PCB有A/B面,存儲器件請最后貼裝。
芯片內部
不同廠家的芯片內部結構是不一樣的,例如MK-米客方德家的芯片內部是PCB基板的
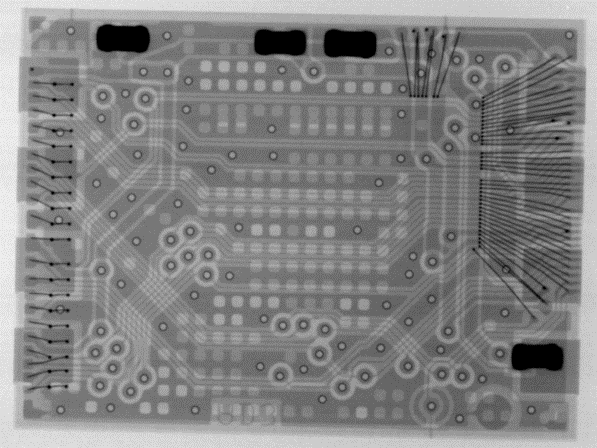
eMMC/SD NAND內部有使用Flash + Flash控制器 +數顆電容,內部線路較為復雜,所以必須使用PCB封裝基板,若回流焊前受潮,容易發生分層,使產品發生不穩定的因素。
1、SOP/TSOP/WSON封裝的襯底使用的材質是金屬框架,其擁有更好的散熱性、結實耐操,成本低,但不適用于內部的復雜走線。
2、LGA/ BGA封裝的襯底使用的是PCB,適用于復雜的布線,可以讓芯片尺寸更小巧,但散熱性和結實度稍遜色,成本也會更高。
另外,eMMC/SD NAND內部有使用Flash + Flash控制器 +數顆電容,內部線路較為復雜,若回流焊前受潮,容易發生分層,使產品發生不穩定的因素。
焊接
LGA封裝焊接比較又難度,有條件的盡可能選擇液體錫膏和加熱臺,沒有加熱臺的可以用風槍,風槍溫度盡量不要超過350℃
解焊:盡可能選擇加熱臺,若必須使用風槍,建議風槍溫度控制在350℃,30秒以內,
樣品風槍測試
關于這個風槍焊接我們做一個多種樣品對比測試,測試結果如下

從結果可以大概推斷出,當風槍焊接溫度超過350°,芯片的不良率會直線上升,
回流焊
sd nand回流焊的最高溫度不能超過245°±5°,回流焊溫度在250°之下是完全沒有問題的。回流焊的參數設置還需要根據焊錫的熔點和板子的其他元器件回流焊參數來設置,
下面是回流焊的曲線和一些參數,
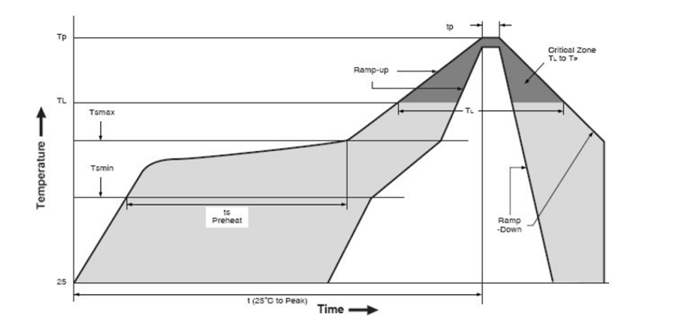
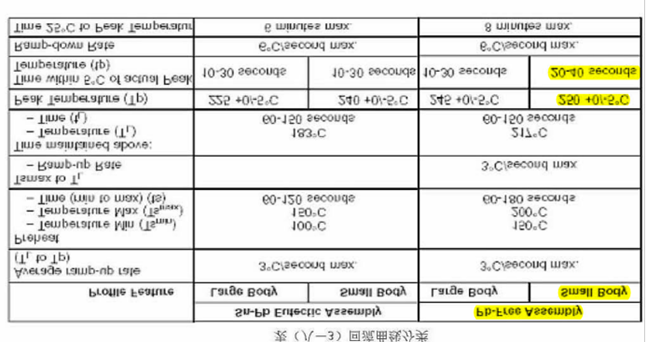
-
NAND
+關注
關注
16文章
1719瀏覽量
137949 -
SD
+關注
關注
1文章
167瀏覽量
34391 -
TF卡
+關注
關注
2文章
88瀏覽量
12578
發布評論請先 登錄





 SD NAND使用注意事項和焊接/解焊溫度
SD NAND使用注意事項和焊接/解焊溫度





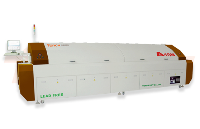











評論