近期不少客戶朋友咨詢博仕檢測工程師,關于芯片橫截面采用FIB切片分析的制樣品的問題,這篇文章分享給大家,希望能幫到大家。
聚焦離子束技術(FIB)原理:
聚焦離子束(FIB)系統利用鎵離子源和雙透鏡聚焦柱,用強烈的聚焦離子束轟擊標本表面,以進行精密材料去除、沉積和高分辨率成像。簡單來說是聚合了FIB處理樣品和SEM觀察成相的功能。其中FIB是將Ga元素離子化成Ga+,然后利用電場加速,再利用靜電透鏡聚焦將高能量的Ga+打到指定點從而達到處理樣品的功能。
(PS大多數商用FIB都用Ga源,也有部分具有He和Ne等離子源)
聚焦離子束FIB切片截面分析過程:
FIB技術可以精確地在器件的特定微區進行截面觀測,形成高分辨的清晰圖像,并且對所加工的材料沒有限制,同時可以邊刻蝕邊利用SEM實時觀察樣品,截面分析是FIB最常見的應用。這種刻蝕斷面定位精度極高,在整個制樣過程中樣品所受應力很小,制作的斷面因此也具有很好的完整性。這種應用在微電子領域具體運用場合主要有:定點觀測芯片的內部結構;失效樣品分析燒毀的具體位置并定位至外延層;分析光發射定位熱點的截面結構缺陷。
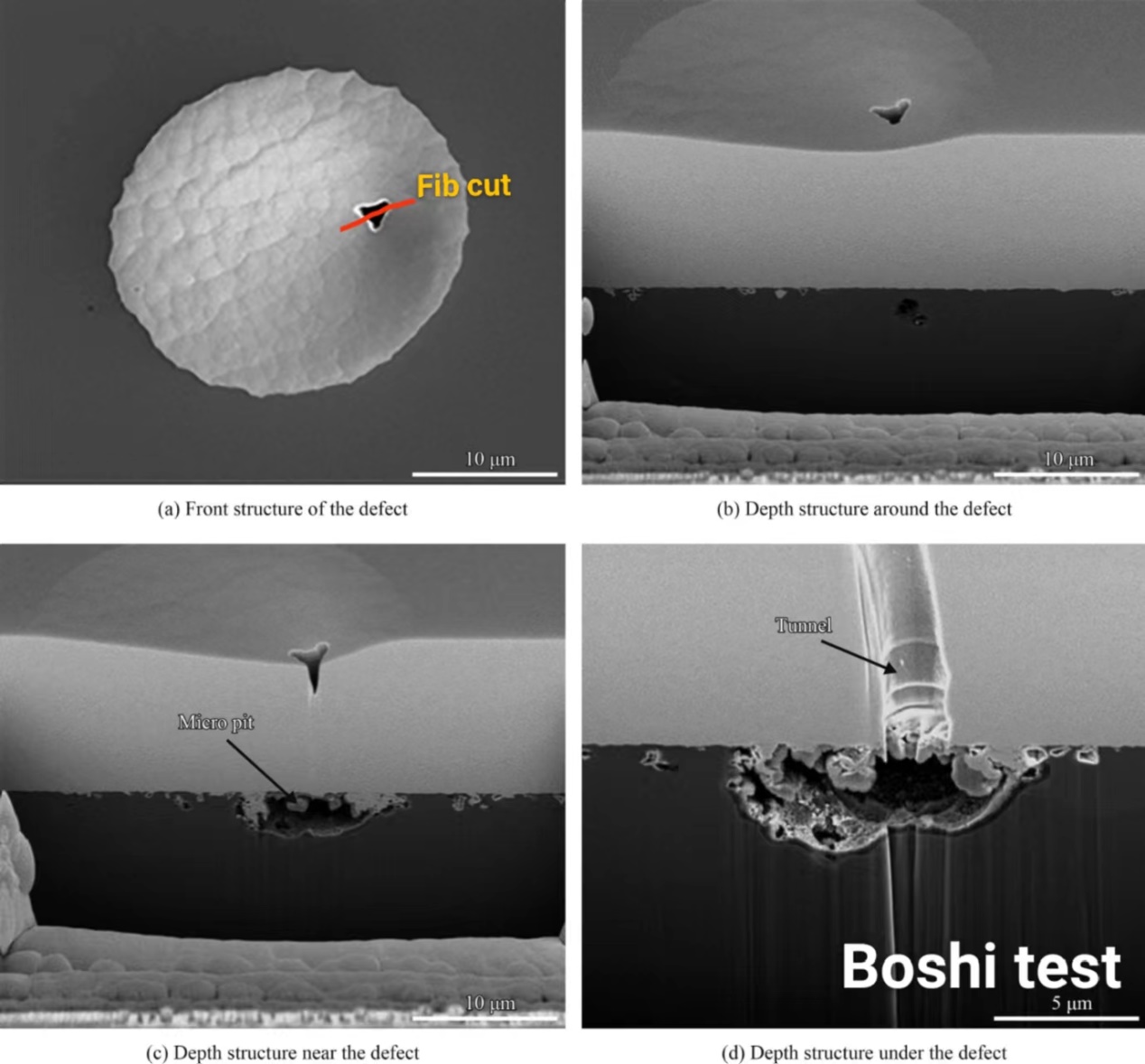
聚焦離子束-掃描電子顯微鏡雙束系統 FIB-SEM應用
聚焦離子束-掃描電鏡雙束系統主要用于表面二次電子形貌觀察、能譜面掃描、樣品截面觀察、微小樣品標記以及TEM超薄片樣品的制備。
FIB-SEM測試:
線路板PCB電路斷裂位置,利用SEM觀察銅箔金相。

FIB切割PCB電路截面分析
FIB切割PCB電路截面分析
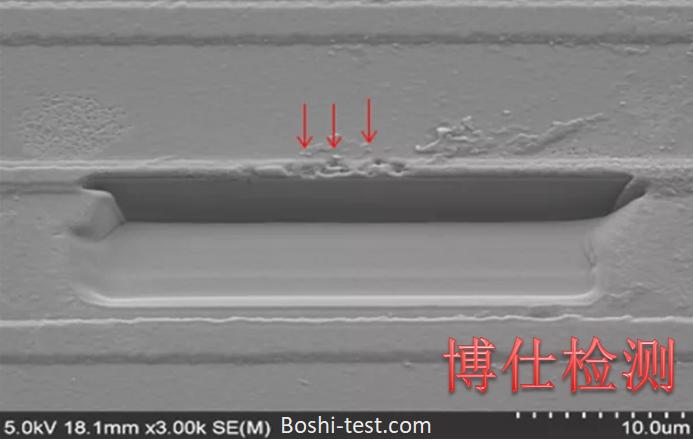
微米級芯片樣品缺陷FIB-SEM截面測試
半導體芯片橫截面分析 -FIB-SEM EDS 測試

審核編輯 黃宇
-
pcb
+關注
關注
4357文章
23438瀏覽量
407175 -
微電子
+關注
關注
18文章
399瀏覽量
41733 -
fib
+關注
關注
1文章
94瀏覽量
11339 -
掃描電鏡
+關注
關注
0文章
110瀏覽量
9348
發布評論請先 登錄
聚焦離子束系統的結構、工作原理及聚焦離子束雙束系統
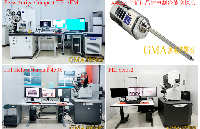





 雙束聚焦離子束FIBSEM在微電子技術中的應用
雙束聚焦離子束FIBSEM在微電子技術中的應用

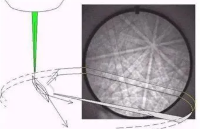
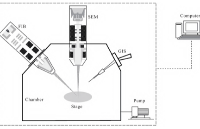


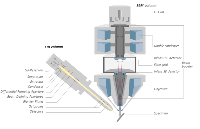
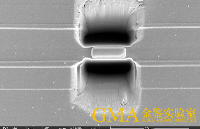



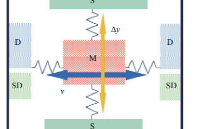

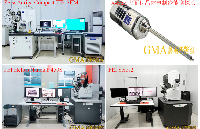











評論