什么是失效分析?
失效分析(FA)是根據失效模式和現象,通過分析和驗證,模擬重現失效的現象,找出失效的原因,挖掘出失效的機理的活動。
一、集成電路為什么要做失效分析?
1、失效分析是要找出失效原因,采取有效措施,使同類失效事故不再重復發生,可避免極大的經濟損失和人員傷亡;
2、促進科學技術的發展;
3、促進產品質量和安全可靠性提升;
4、失效分析為制定或修改技術標準提供依據;
5、失效分析也是仲裁失效事故、開展技術保險業務及對外貿易中索賠的重要依據。
二、失效分析流程?

圖1:失效分析流程
三、常見的失效分析方法樣品準備及注意事項:
集成電路常用失效分析方法有X-RAY,SAT,IV,Decap,EMMI,FIB,SEM,EDX,Probe,OM,RIE等,因為失效分析設備昂貴,大部分需求單位配不了或配不齊需要的設備,因此借用外力,使用對外開放的資源,來完成自己的分析也是一種很好的選擇。各種分析項目測試時需要準備的信息有哪些呢?
(一)超聲波掃描顯微鏡(SAT):
含義:超聲波掃描顯微鏡(SAT)是一種利用超聲波為傳播媒介的無損檢測設備。通過發射高頻超聲波傳遞到樣品內部,在經過兩種不同材質之間界面時,由于不同材質的聲阻抗不同,對聲波的吸收和反射程度的不同,進而采集的反射或者穿透的超聲波能量信息或者相位信息的變化來檢查樣品內部出現的分層、裂縫或者空洞等缺陷。
檢測內容:
1.材料內部的雜質顆粒、夾雜物、沉淀物
2.內部裂紋
3.分層缺陷
4.空洞、氣泡、空隙等
樣品準備及注意事項:
SAT是一種常用的無損檢測分析方法。樣品需要在去離子水中測試,對樣品密封性,平整性有要求,適合塑封集成電路表面平整的樣品,不適合陶瓷封裝金屬封裝集成電路。以SONIX設備為例,樣品尺寸需要在20CM以內。SAT有不同的探頭選擇,比如15MHz,35MHz,75MHz,110MHz,230MHz。探頭頻率越高掃描精度越高,相應的掃描時間越長,穿透率越差。探頭頻率越低掃描精度越差,頻率低探頭穿透力大,掃描更深,更快。這項測試基本都是按機時計費的,影響機時的因素主要是掃描精度和掃描面積。用戶可以根據樣品情況和掃描要求在精度,深度方面做取舍。
(二)X射線(X-Ray):
含義:X-Ray是利用陰極射線管產生高能量電子與金屬靶撞擊,在撞擊過程中,因電子突然減速,其損失的動能會以X-Ray形式放出。而對于樣品無法以外觀方式觀測的位置,利用X-Ray穿透不同密度物質后其光強度的變化,產生的對比效果可形成影像,即可顯示出待測物的內部結構,進而可在不破壞待測物的情況下觀察待測物內部有問題的區域。
檢測內容:
1.觀測DIP、SOP、QFP、QFN、BGA、Flipchip等不同封裝的半導體、電阻、電容等電子元器件以及小型PCB印刷電路板
2.觀測器件內部芯片大小、數量、疊die、綁線情況
3.觀測芯片crack、點膠不均、斷線、搭線、內部氣泡等封裝缺陷,以及焊錫球冷焊、虛焊等焊接缺陷
樣品準備及注意事項:
X-RAY寫清樣品尺寸,數量,材質。尺寸需要在50cm以內,尺寸越小可以掃描的精度越高,以YXLON為例樣品最佳精度能達到1um,X-RAY主要是基于密度差成像,密度大的可以看到,密度小的直接穿透,適合觀察低密度包裹高密的的樣品,比如塑封樣品看金線,需要提醒一點密度小的可能就看不到了,比如集成電路鋁綁線在x-ray下幾乎看不到,TO封裝的粗鋁線能稍微看到一點影子。
(三)IV自動曲線量測儀(IV):
IV驗證及量測半導體電子組件的電性、參數及特性。比如電壓-電流。
檢測內容:
1.Open/Short Test
2.I/V Curve Analysis
3.Idd Measuring
4.Powered Leakage(漏電)Test
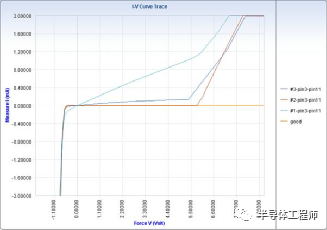
圖5:IV測試效果圖
樣品準備及注意事項:
寫清管腳數量,封裝形式,加電方式,電壓電流要求及限制范圍。實驗人員需要提前確認搭建適合的分析環境,確認是否有適合的scoket。測試時做好靜電防護。
(四)開封(decap):
含義:Decap即開封,也稱開蓋,開帽,指給完整封裝的IC做局部腐蝕,使得IC可以暴露出來,同時保持芯片功能的完整無損,保持 die,bond pads,bond wires乃至lead-frame不受損傷,為下一步芯片失效分析實驗做準備,方便觀察或做其他測試(如FIB,EMMI), Decap后功能正常。
檢測內容:
1.IC開封(正面/背面) QFP, QFN, SOT,TO, DIP,BGA,COB等
2.樣品減薄(陶瓷,金屬除外)
3.激光打標
4.芯片開封(正面/背面)
5.IC蝕刻,塑封體去除
樣品準備及注意事項:
寫清樣品尺寸,數量,封裝形式,綁線材質,開封要求。decap后做什么。若集成電路在pcb板上,最好提前拆下,pcb板子面較大有突起,會影響對芯片的防護,
(五)微光顯微鏡(EMMI):
含義:EMMI主要偵測IC內部所放出光子。在IC元件中,EHP(Electron Hole Pairs)Recombination會放出光子(Photon)。如在P-N結加偏壓,此時N阱的電子很容易擴散到P阱,而P的空穴也容易擴散至N,然后與P端的空穴(或N端的電子)做EHP Recombination。
檢測內容:
1.P-N接面漏電;P-N接面崩潰
2.飽和區晶體管的熱電子
3.氧化層漏電流產生的光子激發
4.Latch up、Gate Oxide Defect、Junction Leakage、
Hot Carriers Effect、ESD等問題
樣品準備及注意事項:
EMMI寫清樣品加電方式,電壓電流要求和限制條件,是否是裸die,是否已經開封,特殊要求等,EMMI是加電測試,可以連接各種源表,確認加電要求,若實驗室沒有適合的源表,可以自帶,避免做無用功。
EMMI可以捕捉波長范圍在900-1600nm波段的近紅外光。多用來定位集成電路pn結電流異常。需要特別注意的是,因為集成電路金屬層會遮擋光子,一般建議樣品背面Decap后做EMMI。
(六)聚焦離子束顯微鏡(FIB):
含義:FIB是將液態金屬離子源產生的離子束經過離子槍加速,聚焦后照射于樣品表面產生二次電子信號取得電子像,此功能與SEM(掃描電子顯微鏡)相似,或用強電流離子束對表面原子進行剝離,以完成微、納米級表面形貌加工。
檢測內容:
1.芯片電路修改和布局驗證
2.Cross-Section截面分析
3.Probing Pad
4.定點切割
樣品準備及注意事項:
FIB寫清樣品尺寸,材質,導電性是否良好,若尺寸較大需要事先裁剪。一般樣品臺1-3cm左右,太大的樣品放不進去,也影響定位,導電性好的樣品分析較快,導電性不好的,需要輔助措施才能較好的分析。比如表面噴金,貼導電膠,切點觀察的,標清切點要求。切線連線寫清方案,發GDS文件。
(七)形貌觀測(SEM):
含義:
SEM可直接利用樣品表面材料的物質性能進行微觀成像。具有景深大,倍率高優勢,放大倍率能到幾十萬倍,可以看到nm精度。
檢測內容:
1.材料表面形貌分析,微區形貌觀察
2.材料形狀、大小、表面、斷面、粒徑分布分析
3.薄膜樣品表面形貌觀察、薄膜粗糙度及膜厚分析
4.納米尺寸量測及標示
樣品準備及注意事項:
寫清樣品尺寸,材質,導電性是否良好,若尺寸較大需要事先裁剪。一般樣品臺1-3cm左右,太大的樣品放不進去,也影響定位,導電性好的樣品分析較快,導電性不好的,需要輔助噴金或導電膠分析。
(八)成分分析(EDX):
含義:
EDX是借助于分析試樣發出的元素特征X含義:射線波長和強度實現的,根據不同元素特征X射線波長的不同來測定試樣所含的元素。通過對比不同元素譜線的強度可以測定試樣中元素的含量。通常EDX結合電子顯微鏡(SEM)使用,可以對樣品進行微區成分分析。
檢測內容:
1.微區成分定性分析
2.元素成分及大概比例

圖10:EDX測試效果圖
樣品準備及注意事項:
EDX寫清樣品尺寸,材質,EDX是定性分析,能看到樣品的材質和大概比例,適合金屬元素分析。
(九)探針臺(Probe):
含義:
探針臺主要應用于半導體行業、光電行業。針對集成電路以及封裝的測試。廣泛應用于復雜、高速器件的精密電氣測量的研發,旨在確保質量及可靠性,并縮減研發時間和器件制造工藝的成本。
檢測內容:
1.微小連接點信號引出
2.失效分析失效確認
3.FIB電路修改后電學特性確認
4.晶圓可靠性驗證
樣品準備及注意事項:
寫清樣品測試環境要求,需要搭配什么源表,使用什么探針,一般有硬針和軟針,軟針較細,不易對樣品造成二次損傷。硬針成本低,Probe測試有耗材費。
(十)顯微鏡分析(OM):
含義:
可用來進行器件外觀及失效部位的表面形狀,尺寸,結構,缺陷等觀察。
檢測內容:
1.樣品外觀、形貌檢測
2.制備樣片的金相顯微分析
3.各種缺陷的查找
4.晶體管點焊、檢查
樣品準備及注意事項:
寫清樣品情況,對放大倍率要求。OM屬于表面觀察,看不到內部情況。
(十一)離子蝕刻(RIE):
含義:RIE是干蝕刻的一種,這種蝕刻的原理是,當在平板電極之間施加10~100MHZ的高頻電壓(RF,radio frequency)時會產生數百微米厚的離子層(ion sheath),在其中放入試樣,離子高速撞擊試樣而完成化學反應蝕刻,此即為RIE(Reactive Ion Etching)。
檢測內容:
1.用于對使用氟基化學的材料進行各向同性和各向異性蝕刻,其中包括碳、環氧樹脂、石墨、銦、鉬、氮氧化物、光阻劑、聚酰亞胺、石英、硅、氧化物、氮化物、鉭、氮化鉭、氮化鈦、鎢鈦以及鎢
2.器件表面圖形的刻蝕
樣品準備及注意事項:
寫清樣品材質,需要看到的區域。
注釋:
EDX:X射線能譜(Energy Dispersive X-ray spectroscopy,EDX)作為元素分析方法之一,用于材料微區元素種類與含量分析。
審核編輯:劉清
-
集成電路
+關注
關注
5420文章
11971瀏覽量
367382 -
SEM
+關注
關注
0文章
257瀏覽量
14805 -
失效分析
+關注
關注
18文章
229瀏覽量
66892 -
SAT
+關注
關注
0文章
7瀏覽量
6469 -
QFP封裝
+關注
關注
0文章
14瀏覽量
6207
原文標題:集成電路失效分析概述
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導體所】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
什么是失效分析?失效分析原理是什么?
失效分析方法---PCB失效分析
芯片失效分析含義,失效分析方法
芯片失效分析步驟
集成電路失效分析新技術

集成電路失效分析
淺談失效分析—失效分析流程






 集成電路為什么要做失效分析?失效分析流程?
集成電路為什么要做失效分析?失效分析流程?













評論