離子注入工藝是對高能離子進(jìn)行分析、聚焦與調(diào)節(jié)后,以一種特定的掃描模式,將其均勻地注入芯片上。在離子注入的過程中,溫度是PN結(jié)成型的重要參數(shù),注入溫度對增強(qiáng)擴(kuò)散和晶格缺陷的影響很大。對于碲鎘汞的離子注入工藝而言,由于碲鎘汞的特殊性,注入?yún)^(qū)原子的擴(kuò)散過程不僅僅出現(xiàn)在熱處理工藝中。如果注入工藝本身溫度較高,那么原子的擴(kuò)散過程在注入中就會(huì)發(fā)生。碲鎘汞離子注入工藝本身就能直接形成較好的n?n?p結(jié)。因此,注入溫度很大程度上影響著注入?yún)^(qū)的實(shí)際尺寸和有效結(jié)深。離子注入技術(shù)中碲鎘汞芯片的溫度控制具有重要研究價(jià)值。
據(jù)麥姆斯咨詢報(bào)道,近期,華北光電技術(shù)研究所的科研團(tuán)隊(duì)在《紅外》期刊上發(fā)表了以“碲鎘汞離子注入溫度研究”為主題的文章。該文章第一作者為何斌助理工程師,主要從事碲鎘汞紅外探測器的研究工作。
本文從離子注入工藝的溫度控制出發(fā),研究了離子注入工藝中的束流、注入能量、接觸面粗糙度等因素對溫控的影響,并結(jié)合器件的I-V曲線,探究了碲鎘汞紅外探測器工藝中注入溫度的影響。
實(shí)驗(yàn)
如圖1(a)所示,將溫度試紙貼在芯片上,表征離子注入過程中芯片表面的實(shí)際溫度。采用半導(dǎo)體參數(shù)測試儀采集器件的I-V特性曲線。
如圖1(b)所示,采用液相外延工藝在CdZnTe襯底材料上生長HgCdTe外延層;使用磁控濺射設(shè)備在HgCdTe表面上生長CdTe及ZnS復(fù)合鈍化膜層;基于離子注入技術(shù),通過注入高能B離子,在HgCdTe上形成PN結(jié);利用干法刻蝕技術(shù)在碲鎘汞表面上刻蝕出電極接觸孔,并用離子束沉積設(shè)備引出電極,完成器件的制備。
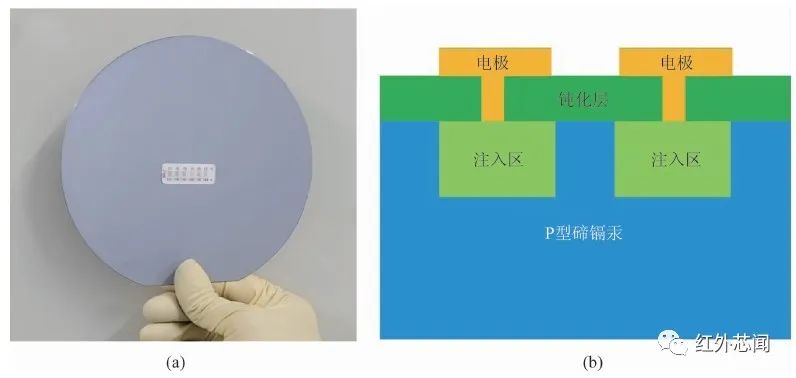
圖1 (a)離子注入溫度測試圖;(b)器件結(jié)構(gòu)圖
實(shí)驗(yàn)結(jié)果與討論
注入能量與束流對芯片溫度的影響
在離子注入過程中,注入能量是指注入離子攜帶的總能量,束流是指單位時(shí)間、單位面積內(nèi)注入離子的數(shù)量。一般來說,注入能量與束流越高,芯片表面的熱效應(yīng)越大。如圖2所示,當(dāng)采用高能離子轟擊芯片表面時(shí),雖然芯片與硅片背面有冷卻系統(tǒng),但由于光刻膠的導(dǎo)熱性差,巨大的熱效應(yīng)依然會(huì)導(dǎo)致芯片表面有一定溫升,引起芯片的實(shí)際溫度與設(shè)定溫度不一致。
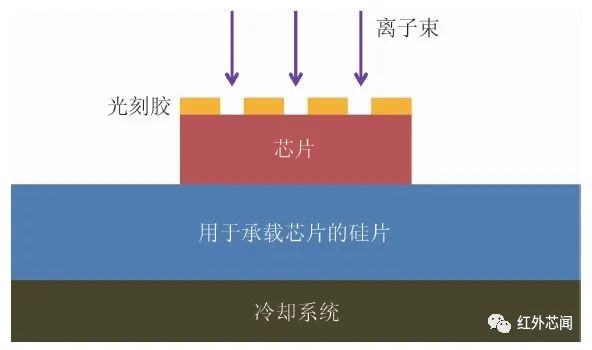
圖2 離子注入工藝的模型圖
圖3所示為采用不同的離子注入?yún)?shù)時(shí),在0℃與20℃冷卻溫度下,芯片表面溫度與注入能量、束流的關(guān)系曲線。在圖3(a)中,樣品背面采用循環(huán)水實(shí)現(xiàn)0℃控溫。當(dāng)恒定注入能量分別為150 keV、200 keV、250 keV和300keV時(shí),芯片表面溫度隨著注入束流的增大而升高。在小束流30~60 μA范圍內(nèi),溫度變化整體上較為緩慢;在束流60~120 μA范圍內(nèi),芯片表面溫度與注入束流幾乎成正比;當(dāng)束流大于120 μA時(shí),芯片表面溫度開始陡增。
對比圖3(a)中注入能量分別為150 keV、200 keV、250 keV和300 keV時(shí)的溫度-束流曲線,可以發(fā)現(xiàn)注入能量增大也會(huì)增加芯片表面溫度。當(dāng)束流處于30~60 μA且注入能量從150 keV增至300 keV時(shí),芯片溫度升高10℃;當(dāng)束流處于60~130 μA且注入能量從150 keV增至300 keV時(shí),芯片溫度升高5~19℃左右。
在圖3(b)中,樣品背面采用循環(huán)水實(shí)現(xiàn)20℃控溫,芯片表面溫度隨注入能量及束流的變化關(guān)系與圖2(a)極相似。當(dāng)恒定注入能量為150 keV、200 keV、250 keV、300 keV且束流處于30~60 μA時(shí),溫度可控制在一個(gè)理想的范圍內(nèi);若繼續(xù)增大束流,芯片表面溫度與注入束流成正比,并逐漸開始失控。若恒定束流,芯片表面溫度也隨注入能量的增大而上升;注入能量從150 keV增至300 keV時(shí),芯片溫度升高6~14℃左右。
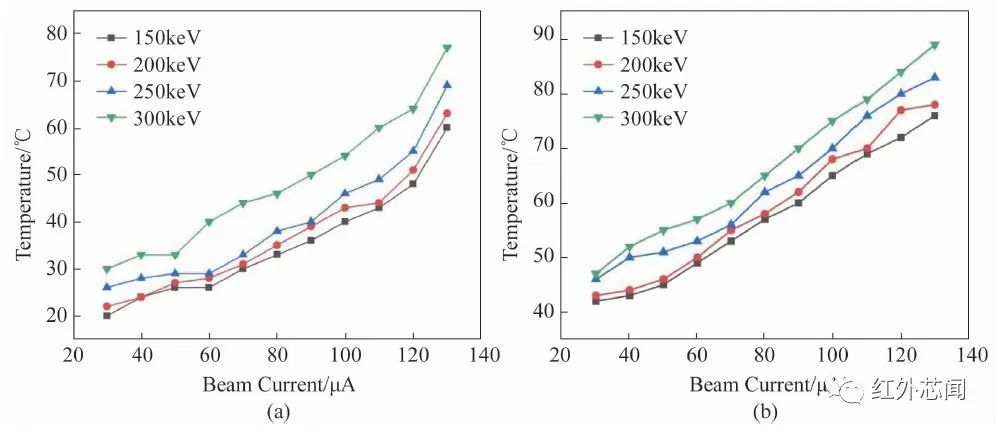
圖3 芯片表面溫度與注入能量、束流的關(guān)系曲線:(a) 0℃控溫;(b) 20℃控溫
試驗(yàn)結(jié)果表明,在離子注入工藝中束流與能量對芯片表面溫度的影響較大,過大的束流與能量都會(huì)讓芯片表面溫度失控。在實(shí)際工藝參數(shù)的選擇中,注入能量決定了離子的注入深度,通常不會(huì)輕易變動(dòng)。我們可以選擇一個(gè)較低的注入束流以及背面冷卻溫度,以盡量降低芯片表面溫度(保證低于光刻膠的耐受溫度),從而提高工藝過程的成品率。
接觸面粗糙度對芯片溫度的影響
如圖4所示,實(shí)際工藝中存在個(gè)別芯片背面較差、承載芯片的硅片在多次注入后稍粗糙等情況。為了探究不同導(dǎo)熱接觸面對離子注入工藝的影響程度,本文選擇背面粗糙度不同的芯片,觀察離子注入后的光刻掩膜圖案。

圖4 芯片與硅片接觸面的模型圖
如圖5所示,對于背面粗糙度不同的芯片A與B,采用相同的工藝參數(shù),試驗(yàn)結(jié)束后光刻掩膜的形貌差距較大。結(jié)果表明,圖5(a)中芯片A背面整體高度較為均勻,背面光滑;圖5(b)中,在離子注入后,芯片A表面光刻掩膜正常,并未有光刻膠變形等現(xiàn)象。然而,圖5(c)中芯片B背面整體高度相差極大(最大達(dá)5 μm),芯片背面呈現(xiàn)較多的小坑,較為粗糙;圖5(d)中,在離子注入后,芯片B表面光刻膠嚴(yán)重變形甚至裂開,造成光刻掩膜失效。從傳熱學(xué)上看,在芯片和硅片導(dǎo)熱系數(shù)不變時(shí),芯片面型差與硅片粗糙將減小傳熱面,引起芯片溫度極度失控。
在離子注入工藝中,需要對芯片和硅片的接觸面加以重視。在芯片背面,我們可以采用磨拋工藝來降低粗糙度,并采用表面光滑的硅片承載芯片。一個(gè)好的接觸表面有利于增大換熱面積,降低區(qū)域溫度升幅,保證光刻掩膜不變形,提高工藝過程的穩(wěn)定性。

圖5 基于相同的工藝參數(shù),試驗(yàn)結(jié)束后光刻掩膜的形貌:(a)芯片A的背面;(b)芯片A在離子注入后的光刻掩膜形狀;(c)芯片B的背面;(d)芯片B在離子注入后的光刻掩膜形狀
離子注入溫度對碲鎘汞紅外探測器的影響
研究器件在很大程度上是研究漏電流與器件加工工藝的關(guān)系。為了探究離子注入溫度對碲鎘汞紅外探測器的影響,將同一片碲鎘汞材料劃開。圖6(a)與圖6(b)所示分別是注入溫度為0℃與85℃時(shí)的I-V曲線。
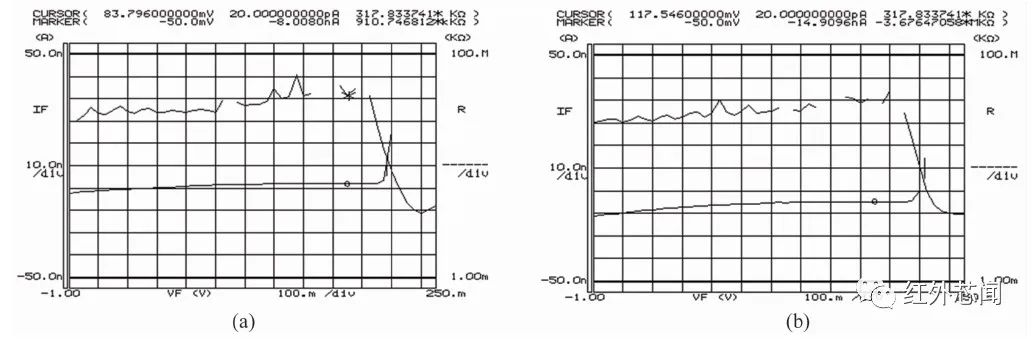
圖6 (a)注入溫度為0℃時(shí)的I-V曲線;(b)注入溫度為85℃時(shí)的I-V曲線
對比圖6(a)與圖6(b)的第四象限可知,當(dāng)反向電壓為50 mV時(shí),注入溫度為 0℃的碲鎘汞光敏元的反向電流為8 nA,注入溫度為85℃的碲鎘汞光敏元的反向電流為14.9 nA。在I-V曲線的第一象限內(nèi),注入溫度為0℃的碲鎘汞光敏元的開啟電壓為83.7 mV,注入溫度為85℃的碲鎘汞光敏元的開啟電壓為117.5mV對于相同的離子注入劑量及束流等條件,離子注入溫度較高的碲鎘汞芯片表現(xiàn)出更大的反向電流和開啟電壓。
根據(jù)圖6(a)與圖6(b)的開啟電壓與反向電流信息,可以發(fā)現(xiàn)注入溫度越高,實(shí)際的注入?yún)^(qū)面積越大。一般認(rèn)為碲鎘汞B離子注入依靠損傷成結(jié),其有效結(jié)深往往比注入深度延長1~3 μm左右。當(dāng)B離子注入到碲鎘汞芯片時(shí),與內(nèi)部晶格原子發(fā)生連續(xù)撞擊,造成大量的晶格損傷,表現(xiàn)出Hg-Te鍵斷裂,大量間隙Hg原子形成N型層。當(dāng)注入溫度較高時(shí),我們認(rèn)為注入?yún)^(qū)Hg原子的擴(kuò)散過程在注入中就會(huì)發(fā)生,大量的間隙Hg原子發(fā)生橫向擴(kuò)散,增大了PN結(jié)的面積。
對比圖6(a)與圖6(b)的反向電流與平坦電壓信息可知,注入溫度較高的PN結(jié)的反向漏電更易增加。這很可能是因?yàn)樽⑷霚囟容^高,原子晶格處于較高的能量狀態(tài),在被注入離子破壞后,容易得到較多的射程端缺陷和離子注入損傷。這些離子注入帶來的晶格損傷在后續(xù)的退火工藝中無法完全消除,使得少子壽命降低,引入了較大的漏電流。若從光敏元的性能考慮,為了保證注入?yún)^(qū)的實(shí)際面積與設(shè)計(jì)面積接近,并避免較多的晶格損傷,我們應(yīng)該盡量選擇一個(gè)較低的注入溫度。
結(jié)束語
本文研究了離子注入工藝中束流、注入能量、接觸面粗糙度等因素對注入溫度的影響,并結(jié)合器件的I-V曲線,探究了碲鎘汞紅外探測器工藝中注入溫度的影響。實(shí)驗(yàn)結(jié)果表明,束流、注入能量、冷卻溫度以及接觸面對于控制芯片溫度具有重要作用。為了保證注入溫度低于光刻膠的耐受溫度,提高工藝過程的成品率,我們可以選擇較低的注入束流和冷卻溫度;同時(shí)在芯片背面,可以采用磨拋工藝來降低粗糙度,并選用表面光滑的硅片來優(yōu)化導(dǎo)熱面。從光敏元的I-V曲線分析,較低的注入溫度有利于減小PN結(jié)的暗電流,阻止注入?yún)^(qū)面積的橫向擴(kuò)散,從而提高碲鎘汞紅外探測器的整體性能。后續(xù)將重點(diǎn)研究注入溫度對碲鎘汞的熱擴(kuò)散作用,并結(jié)合透射電鏡和I-V曲線等手段對注入機(jī)理作進(jìn)一步解釋。
編輯:黃飛
-
芯片
+關(guān)注
關(guān)注
459文章
52252瀏覽量
436861 -
探測器
+關(guān)注
關(guān)注
14文章
2699瀏覽量
74150 -
紅外探測器
+關(guān)注
關(guān)注
5文章
298瀏覽量
18505 -
離子注入
+關(guān)注
關(guān)注
5文章
34瀏覽量
10479
原文標(biāo)題:碲鎘汞離子注入溫度研究
文章出處:【微信號:MEMSensor,微信公眾號:MEMS】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
用MCT材料和CdTe /ZnS雙層鈍化工藝制備碲鎘汞中波探測器的研究成果
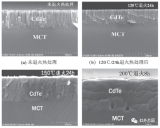
基于分子束外延的短/中波雙色碲鎘汞材料及器件的最新研究進(jìn)展
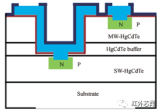
碲鎘汞P-on-N紅外探測器的器件結(jié)構(gòu)設(shè)計(jì)
集成碲鎘汞長波320×256偏振探測器的設(shè)計(jì)
昆明物理研究所在長波p-on-n碲鎘汞紅外焦平面器件方面的研究進(jìn)展
高工作溫度p-on-n中波碲鎘汞紅外焦平面器件研究
碲鎘汞APD焦平面技術(shù)研究
探討碲鎘汞線性雪崩焦平面器件評價(jià)及其應(yīng)用
中波紅外碲鎘汞室溫探測器激光輻照飽和特性的仿真
昆明物理研究所碲鎘汞紅外探測器研究進(jìn)展






 探討碲鎘汞紅外探測器工藝中注入溫度的影響
探討碲鎘汞紅外探測器工藝中注入溫度的影響




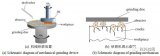










評論