前面的文章中講到了SOI襯底,見之前文章:
什么是SOI襯底?
但是,在刻蝕SOI襯底時,通常會發生一種凹槽效應,導致刻蝕的形貌與預想的有很大出入。那么什么是凹槽效應?什么原因引起的?怎么抑制這種異常效應呢?
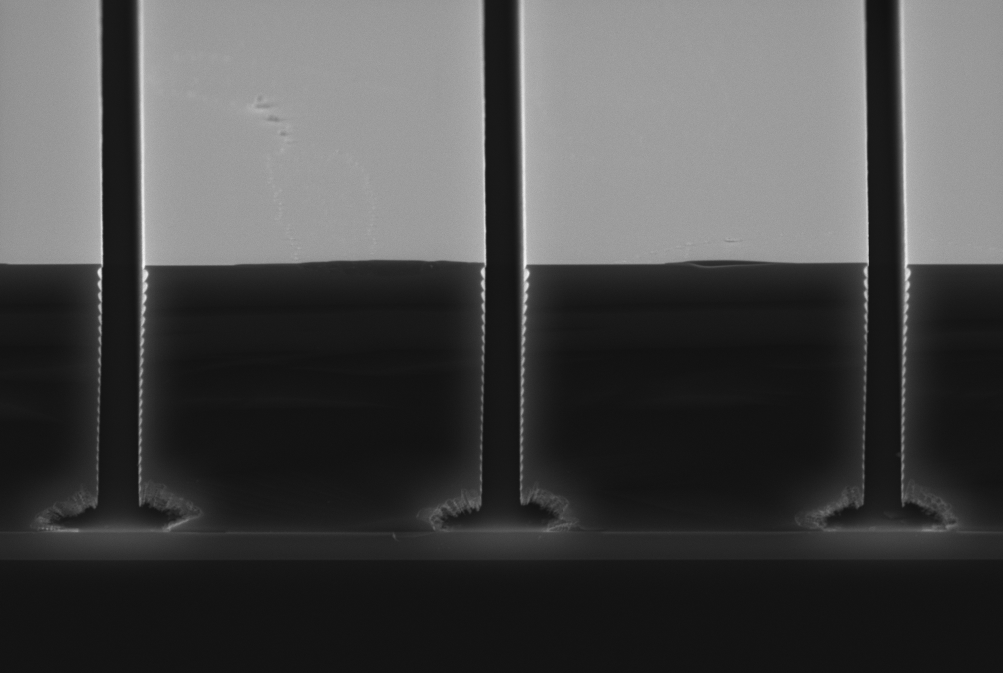
什么是凹槽效應?
凹槽效應,英文名稱notching effect,又可以叫做缺口效應。指的是在多層結構的干法刻蝕過程中,會在某一層的邊緣形成不希望出現的凹槽,影響整個芯片的性能。"Notching Effect" 并不是SOI襯底的專屬,它是一個廣泛存在于多層材料刻蝕過程中的現象。本文以SOI襯度刻蝕為例,來解釋這一現象。
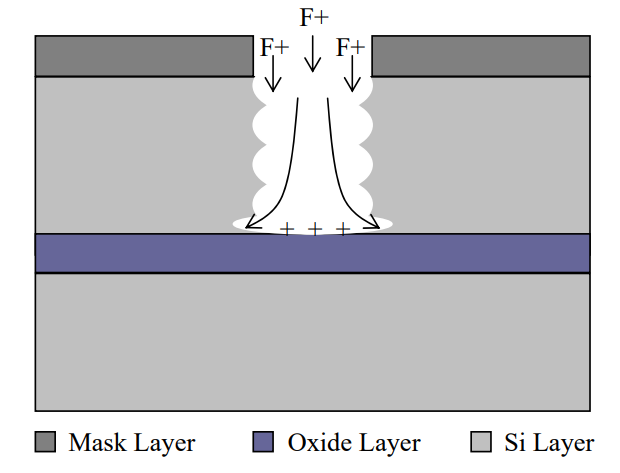
SOI襯底的中間有一層氧化硅,上下均為硅單晶。理論上,干法刻蝕過程在遇到氧化硅層時應當自動停止,即氧化硅作為一個刻蝕終止層。但是,實際過程中,在刻蝕到二氧化硅層后,刻蝕并沒有完全停止。刻蝕在二氧化硅層的表面繼續進行,形成橫向的刻蝕,造成了凹槽效應。
凹槽效應的形成機理
由于氧化硅層本身的絕緣特性,離子電荷會在氧化硅上大量積聚。在氧化硅層表面積累的正電荷形成一個局部電場。這個電場會改變進入材料的離子軌跡,使其沿著硅氧化層的表面橫向刻蝕,在多層材料的交界處,由于離子的橫向刻蝕,形成一個不期望的缺口。

如何減弱凹槽效應?
上面我們已經了解到凹槽效應主要來源于絕緣層電荷的積累,那么我們抑制凹槽效應的一大思路便是及時導散掉積累的電荷,不讓氧化硅表面有過多的電荷聚集。圍繞著這個思路,我們可以從以下幾個當面入手:
1,設計時做好考慮
在設計階段就需要考慮到凹槽效應的可能性,預留出相應空間,避免高深寬比的結構,防止負載效應加深凹槽效應,負載效應見前文:
干法刻蝕的負載效應是什么?
2,優化工藝參數
通過改變刻蝕參數(電源頻率、刻蝕氣體種類和流量等)來找到一個更優化的刻蝕條件,以減輕凹槽效應。例如,在其他條件不變的情況下,采用低頻率產生的凹槽效應就遠遠小于高頻率產生的凹槽效應。如下圖:
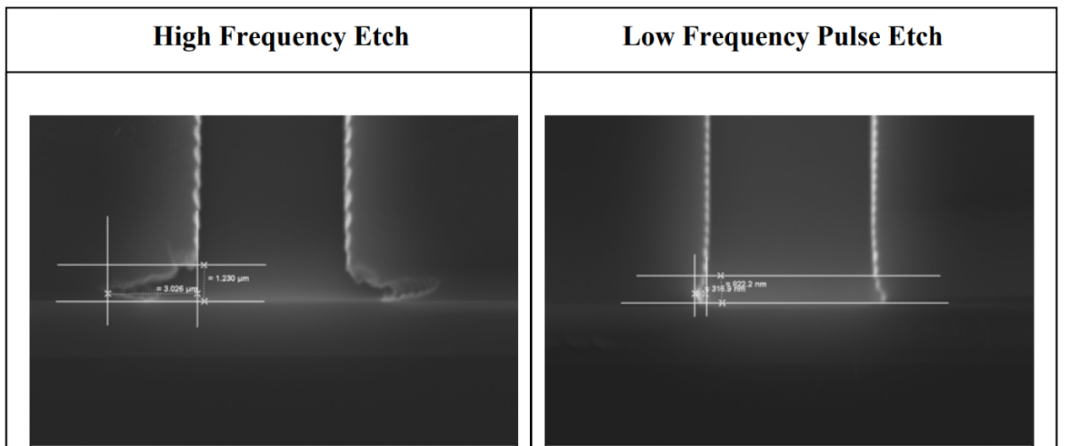
3,分步刻蝕
在剛開始階段,使用高刻蝕速率的參數來移除大部分材料。當刻蝕接近目標層時,減小刻蝕速率、減小RF功率或增加保護氣體的流量,以減小Notching Effect。
分步刻蝕適合優化在單一參數設置下可能出現的問題,有利于解決復雜結構中的刻蝕問題。
審核編輯:湯梓紅
-
芯片
+關注
關注
459文章
51927瀏覽量
433755 -
SOI
+關注
關注
4文章
75瀏覽量
17861 -
刻蝕
+關注
關注
2文章
198瀏覽量
13289
原文標題:【光電集成】什么是干法刻蝕的凹槽效應?
文章出處:【微信號:今日光電,微信公眾號:今日光電】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
相關推薦
干法刻蝕常用設備的原理及結構

釋放MEMS機械結構的干法刻蝕技術
【轉帖】干法刻蝕的優點和過程
釋放MEMS機械結構的干法刻蝕技術
兩種基本的刻蝕工藝:干法刻蝕和濕法腐蝕
GaN材料干法刻蝕工藝在器件工藝中有著廣泛的應用

干法刻蝕之鋁刻蝕的介紹,它的原理是怎樣的

干法刻蝕工藝介紹
干法刻蝕和清洗(Dry Etch and Cleaning)
干法刻蝕工藝的不同參數
晶圓表面溫度對干法刻蝕的影響

干法刻蝕側壁彎曲的原因及解決方法






 什么是干法刻蝕的凹槽效應?凹槽效應的形成機理和抑制方法
什么是干法刻蝕的凹槽效應?凹槽效應的形成機理和抑制方法












評論