作者:Jens Wallmann
工業(yè)和汽車開關轉換器和電機驅動器都需要體積小、效率高、電氣噪聲低的金屬氧化物硅場效應晶體管 (MOSFET)。雙 MOSFET 方法有助于滿足這些要求。
設計精良的雙 MOSFET 將兩個 MOSFET 置于在一個封裝內,減小了在印刷電路板 (PCB) 上的占用空間,降低了寄生電感并通過改善散熱性能,取消了體積龐大、成本高昂的散熱器。這類器件可在數(shù)百千赫茲 (kHz) 頻率下進行無干擾開關操作,在很寬的溫度范圍內穩(wěn)定工作,而且漏電流很低。然而,設計人員必須了解這類器件的工作特性,才能充分認識其優(yōu)勢。
本文以 [Nexperia] 的雙 MOSFET 為例進行介紹,并說明設計人員如何使用這類器件來應對堅固耐用、效率高和空間受限型設計的挑戰(zhàn)。本文討論電路優(yōu)化和 PCB 設計方法,并提供熱電仿真和損耗分析的技巧。
高開關速度下效率更高
雙 MOSFET 適合許多汽車 (AEC-Q101) 和工業(yè)應用,包括 DC/DC 開關轉換器、電機逆變器和電磁閥控制器。這些應用可在開關對和半橋拓撲結構以及其他配置中使用雙 MOSFET。
Nexperia [LFPAK56D]系列是值得一提的雙 MOSFET 器件。該系列器件采用了 Nexperia 的銅夾技術,具有超強的電流能力、低封裝阻抗和高可靠性(圖 1,右)。這些實心銅夾改善了從半導體基板通過焊接點到 PCB 的散熱性能,使約 30% 的總熱量通過源引腳消散。大銅截面還能降低阻性功率耗散,并通過減少寄生線路電感來抑制瞬時振蕩。
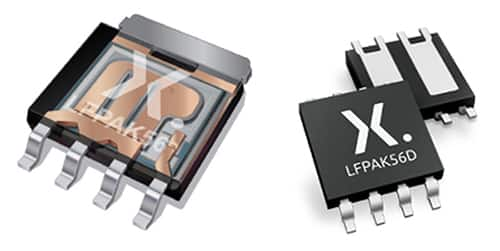 圖 1:LFPAK56D 封裝(右)集成了兩個獨立的 MOSFET,并使用與 [LFPAK56]單 MOSFET 封裝(左)類似的銅夾結構。(圖片來源:Nexperia)
圖 1:LFPAK56D 封裝(右)集成了兩個獨立的 MOSFET,并使用與 [LFPAK56]單 MOSFET 封裝(左)類似的銅夾結構。(圖片來源:Nexperia)
與大多數(shù)用于高壓開關轉換器的部件一樣,LFPAK56D 采用了超結技術。這種設計減小了漏源極“導通”電阻 (R DS(開) )和柵漏極電荷 (Q GD ) 參數(shù),從而最大限度地減少了功率損耗。在同一基板上運行兩個 MOSFET,可進一步降低漏源極電阻。
正如超結 MOSFET 一樣,LFPAK56D 系列具有很強的雪崩事件抵抗能力,并具有很寬的安全工作區(qū) (SOA)。例如,[PSMN029-100HLX]TrenchMOS 器件中的每個 100 V MOSFET 都具有 29 mΩ R DS(開) ,可處理 68 W 功率,并能夠能通過高達 30 A 的電流。
LFPAK56D 系列還采用了 [NXP] 的 SchottkyPlus 技術,以減少尖峰和漏電流。例如,[PSMN014-40HLDX] 的 R DS(開) 典型值通常為 11.4 mΩ,且漏源極漏電流極低,僅為 10 nA。
要充分發(fā)揮 MOSFET 的大電流優(yōu)勢,印刷電路板的設計必須能散發(fā)高熱量并確保電氣連接穩(wěn)定可靠。多層印刷電路板具有足夠多的過孔和大而粗的銅導體軌跡,可確保高散熱性能。
避免出現(xiàn)熱擊穿
雖然完全接通的功率 MOSFET 具有熱穩(wěn)定性,但當漏電流 (I D ) 較低時,就會有熱擊穿風險。在這種工作狀態(tài)下,局部發(fā)熱往往會降低柵源極的閾值電壓 (V GS(次) ),這意味著器件更容易導通。這就造成了一種正反饋情況,更多的電流會導致發(fā)熱更多、V GS(次) 更低。
圖 2 顯示了恒定漏源極電壓 (V DS ) 下的這種效應。隨著 VGS的增大,會出現(xiàn)一個稱為零溫度系數(shù) (ZTC) 的臨界 I D 。大于該電流時,存在負反饋并具有熱穩(wěn)定性(藍色區(qū)域);小于該電流時,閾值壓降會占主導地位,造成可導致熱擊穿的熱不穩(wěn)定工作點(紅色區(qū)域)。
 圖 2:低于 ZTC 點時,MOSFET 會因熱效應導致 V~GS ~下降(紅色區(qū)域)而進入熱擊穿狀態(tài)。(圖片來源:Nexperia)
圖 2:低于 ZTC 點時,MOSFET 會因熱效應導致 V~GS ~下降(紅色區(qū)域)而進入熱擊穿狀態(tài)。(圖片來源:Nexperia)
這種效應降低了低電流和高漏源極電壓下的 SOA。對于具有陡峭 dV/dt 斜坡的快速開關操作來說,這并不是一個大問題。然而,隨著開關操作持續(xù)時間的增加,例如為了減少電磁干擾,出現(xiàn)熱不穩(wěn)定性的可能性增大,并存在潛在危險。
降低高頻開關損耗
為快速開關應用選擇超結 MOSFET 時,低 QGD至關重要,因為該參數(shù)會顯著降低開關損耗。
當漏極、柵極和源極之間同時出現(xiàn)顯著的電壓和電流變化時,開關操作過程中就會出現(xiàn)高功率損耗。較低的 QGD會導致出現(xiàn)較短的米勒平臺 (Miller Plateau)(圖 3,左側),從而導致陡峭的開關斜率 (dV ds /dt),最終降低開關導通期間的動態(tài)能量損耗(圖 3,右側藍色區(qū)域)。
 圖 3:較短的米勒平臺(左側)意味著陡峭的開關斜率,從而導致較低的動態(tài)損耗(右側的藍色區(qū)域)。V
圖 3:較短的米勒平臺(左側)意味著陡峭的開關斜率,從而導致較低的動態(tài)損耗(右側的藍色區(qū)域)。V全科醫(yī)生是米勒平臺的柵源電壓;VTH是柵極閾值電壓;IDS是漏源電流。(圖片來源:[Vishay])
抑制雪崩能量并保護 MOSFET
在電機驅動應用中,定子線圈關斷時,坍縮磁場會維持電流流動,從而在 MOSFET 上產生疊加在電源電壓 (V DD ) 上的高感應電壓。然而,MOSFET 體二極管的反向擊穿電壓 (V BR ) 會限制該高電壓。在所謂的雪崩效應中,MOSFET 將流出的磁能轉換為雪崩能量 (E DS ),直至線圈電流降至零。這會使半導體晶體迅速過熱。
圖 4 所示為帶有 MOSFET 開關的簡單線圈控制,以及單次雪崩事件發(fā)生前、發(fā)生期間(時間窗口 t AL )和發(fā)生后的時間信號。如果雪崩能量耗散量 (E DS(AL)S ) 過高,由此產生的熱量將損壞半導體結構。
 圖 4:MOSFET 在單次雪崩事件之前、期間 (t
圖 4:MOSFET 在單次雪崩事件之前、期間 (t AL ) 和之后的時序信號。(圖片來源:Nexperia)
LFPAK56D MOSFET 采用了堅固耐用的設計。根據Nexperia 實驗室測試結果,該器件可承受數(shù)十億次雪崩事件而不會損壞。考慮到最大雪崩能量,線圈驅動器級可以不使用額外的續(xù)流或鉗位二極管,只使用這些MOSFET 的雪崩工作。
電熱的在線仿真
要提高系統(tǒng)效率,僅靠簡單的品質因數(shù) (FOM),如 RDSxQGD產品是不夠的。相反,設計人員需要進行更精確的損耗分析,具體包括考慮以下原因造成的 MOSFET 損耗:
- 導通傳導性
- 導通和關斷損耗
- 輸出電容的充放電
- 體二極管的連續(xù)性和開關損耗
- 柵極電容的充電和放電
為了最大限度地降低總損耗,設計人員必須了解 MOSFET 參數(shù)與工作環(huán)境之間的關系。為此,Nexperia 為 MOSFET 建立了精密的電熱模型。這些模型結合了電氣和熱性能,并可反映 MOSFET 的所有重要特性。開發(fā)人員可使用 [PartQuest Explore]在線仿真器,或將 SPICE 和 VHDL-AMS 格式的模型導入其所選擇的仿真平臺。
在撰寫報告時,僅提供 LFPAK56D MOSFET 的電氣型號。因此,下面的熱仿真示例涉及不同類型的 MOSFET,即 [BUK7S1R0-40H]。
[IAN50012 的功率 MOSFET 電熱模型]互動實驗對 BUK7S1R0-40H MOSFET 在接通 36.25 A 負載電流后的三種發(fā)熱情況進行了仿真。圖 5 左側所示為三種仿真設置。
 圖 5:所示為使用 PartQuest Explore 在線仿真器對 MOSFET 進行的電熱仿真。(圖片來源:Nexperia)
圖 5:所示為使用 PartQuest Explore 在線仿真器對 MOSFET 進行的電熱仿真。(圖片來源:Nexperia)
在上部“t j _no_self_heating”(無自發(fā)熱)情況下,接線端和安裝底座直接與 0°C 環(huán)境溫度 (T 和 ) 相耦合,且無熱阻 (R th )。在中間的“t j _self_heating”(自發(fā)熱)情況下,芯片通過 Rth-j耦合,且 Tj升約 0.4°C。下部所示為安裝底座 (mb),通過帶有散熱片的六層 FR4 電路板的 Rth_mb與環(huán)境溫度耦合。T MB (綠色)上升至 3.9°C,T j (紅色)上升至 4.3°C。
審核編輯 黃宇
-
MOSFET
+關注
關注
150文章
8416瀏覽量
219274 -
印刷電路板
+關注
關注
4文章
841瀏覽量
35935 -
電機驅動
+關注
關注
60文章
1299瀏覽量
87653 -
開關轉換器
+關注
關注
0文章
50瀏覽量
13799
發(fā)布評論請先 登錄
使用寬帶隙技術最大限度地提高高壓轉換器的功率密度

功率MOSFET技術提升系統(tǒng)效率和功率密度
權衡功率密度與效率的方法
集成MOSFET如何提升功率密度
借助高能效GaN轉換器,提高充電器和適配器設計的功率密度
借助高能效GaN轉換器,提高充電器和適配器設計的功率密度
高功率密度的解決方案
超低抖動時鐘發(fā)生器和分配器最大限度地提高數(shù)據轉換器的信噪比

直播預告|直流快速充電系統(tǒng):通過 LLC 變壓器驅動最大限度提高功率密度

高功率密度降壓轉換器的熱性能優(yōu)化應用報告






 利用雙 MOSFET 最大限度地提高開關轉換器應用的功率密度和性能
利用雙 MOSFET 最大限度地提高開關轉換器應用的功率密度和性能












評論