隨著Chat GPT的火爆,整個AI硬件市場迎來了奇點,除了GPU之外,HBM存儲也進入了爆發(fā)式的增長,根據(jù)TrendForce,2022年全球HBM容量約為1.8億GB,2023年增長約60%達到2.9億GB,2024年將再增長30%。如果以HBM每GB售價20美元測算,2022年全球HBM市場規(guī)模約為36.3億美元,預(yù)計至2026年市場規(guī)模將達127.4億美元,對應(yīng)CAGR約37%。

然而,全球的HBM生產(chǎn)基本壟斷在SK海力士,三星及美光的手中,其中SK海力士在HBM市場擁有最大的市場份額,它是占據(jù)AI GPU市場80%份額的Nvidia的HBM3內(nèi)存唯一供應(yīng)商,并于3月份開始量產(chǎn)最新一代HBM3E。美光和三星等競爭供應(yīng)商正在開發(fā)自己的 HBM產(chǎn)品,以阻止SK海力士主導(dǎo)市場。在整個市場中,中國廠商基本完全缺位。
同時,由于美國BIS 2022年針對高算力芯片的規(guī)則3A090管控指標(biāo)較高,英偉達等廠商通過降低芯片互聯(lián)速率方式對中國持續(xù)供應(yīng),同時,美國商務(wù)部認(rèn)為中國企業(yè)通過海外子公司或者其他海外渠道,規(guī)避許可證相關(guān)規(guī)定獲取先進計算芯片。2023年新規(guī)修改了3A090芯片及相關(guān)物項的技術(shù)指標(biāo),擴大了針對高算力芯片的許可證要求及直接產(chǎn)品原則的適用范圍,并增加了先進計算最終用途管控。在美國的制裁和管控下,無論是先進的GPU,HBM產(chǎn)品,還是制造AI芯片和HBM的先進封裝設(shè)備,都基本斷絕了對中國的供給。
芯片和存儲的制造,是卡在中國AI產(chǎn)業(yè)脖子上最緊的鐵鏈,其中最關(guān)鍵的設(shè)備,除了光刻機之外,在整個AI芯片和HBM的制造工藝中,2.5D或者3D先進封裝,芯片堆疊的先進工藝和設(shè)備是其核心之一,無論海力士,三星還是美光,現(xiàn)階段采用的均是TCB工藝,其中,海力士采用TCB MR-MUF, 三星及美光主要以TCB NCF技術(shù),但是隨著HBM的發(fā)展,隨著HBM4的到來,堆疊層數(shù)從8層到16層,IO間距持續(xù)縮小到10微米左右的,TCB工藝也向著Fluxless演進。
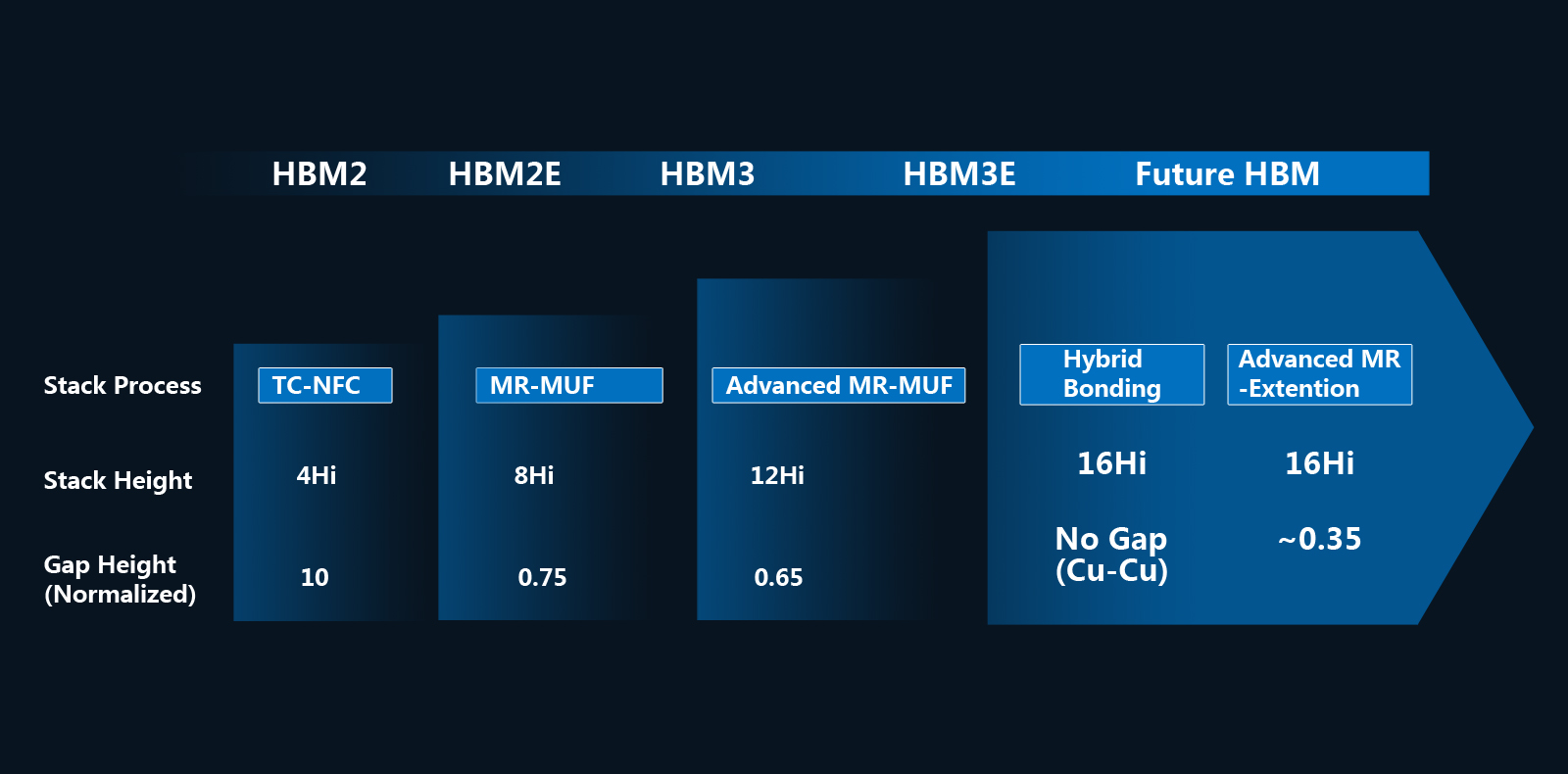
在過去數(shù)年,普萊信智能一直和相關(guān)客戶緊密配合,進行TCB工藝和整機的研發(fā),攻克并構(gòu)建了自己的納米級運動控制平臺,超高速的溫度升降系統(tǒng),自動調(diào)平系統(tǒng)及甲酸還原系統(tǒng)。在此基礎(chǔ)上,普萊信智能構(gòu)建完成Loong系列TC Bonder技術(shù)平臺,并針對AI芯片,HBM等不同產(chǎn)品的需求,推出Loong WS及Loong F系列產(chǎn)品。

其中Loong WS可以兼容C2W及C2S封裝形式,最高精度為±1um, 做到和國外最先進產(chǎn)品同一水準(zhǔn),可以支持TCB NCF, TCB MR-MUF等工藝。

Loong F為下一代的HBM3E和HBM技術(shù)準(zhǔn)備的Fluxless工藝設(shè)備,在Loong WS平臺基礎(chǔ)上增加了甲酸還原系統(tǒng),消除了Flux在整個堆疊工藝中帶來的不良,可以直接進行coper-coper的鍵合,支持最小IO pitch在15微米,在未來HBM4堆疊層數(shù)增加和IO激增的情況下,Loong F將會是最具性價比的解決方案。
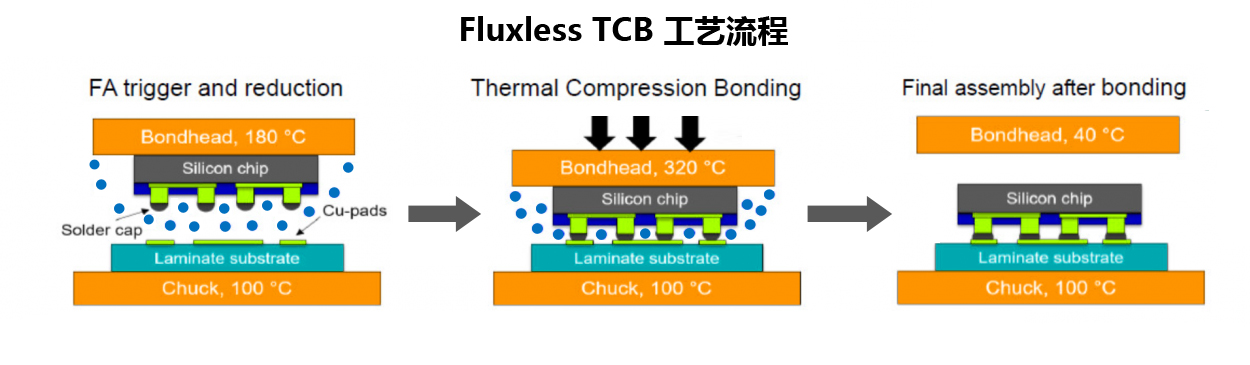
相信隨著中國半導(dǎo)體技術(shù)的進步和普萊信智能Loong系列TCB設(shè)備的推出和量產(chǎn),國產(chǎn)廠商在AI芯片和HBM產(chǎn)品的研發(fā)和制造上,將在不遠的將來引來爆發(fā)點。
審核編輯 黃宇
-
芯片
+關(guān)注
關(guān)注
459文章
52343瀏覽量
438466 -
封裝
+關(guān)注
關(guān)注
128文章
8614瀏覽量
145090 -
AI
+關(guān)注
關(guān)注
88文章
34733瀏覽量
276818 -
HBM
+關(guān)注
關(guān)注
1文章
409瀏覽量
15165
發(fā)布評論請先 登錄
普萊信Clip Bond封裝整線設(shè)備,獲功率半導(dǎo)體國際巨頭海外工廠訂單
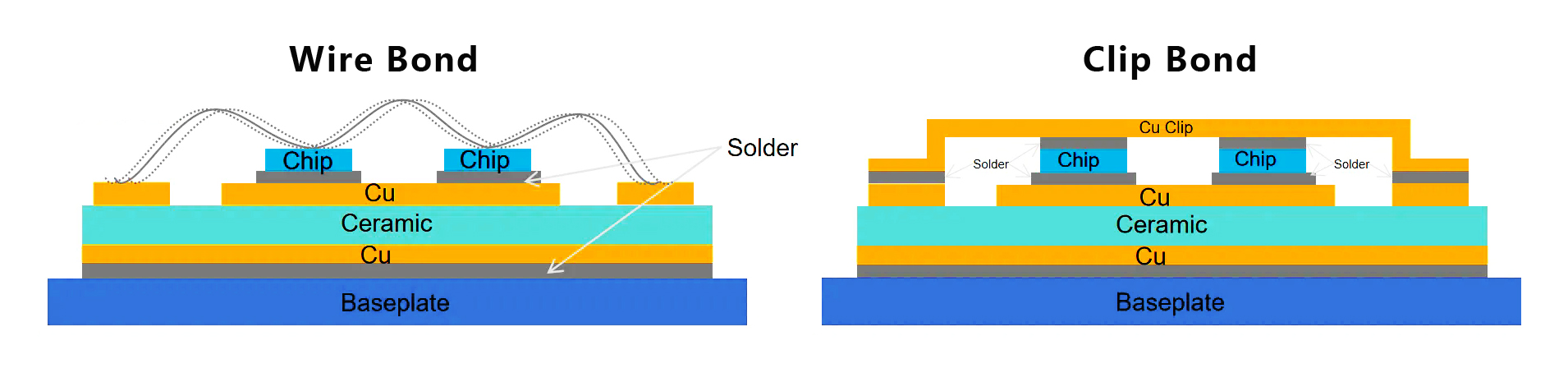
芯馳科技重磅發(fā)布最新一代AI座艙芯片X10
國產(chǎn)AI芯片破局:國產(chǎn)TCB設(shè)備首次完成CoWoS封裝工藝測試
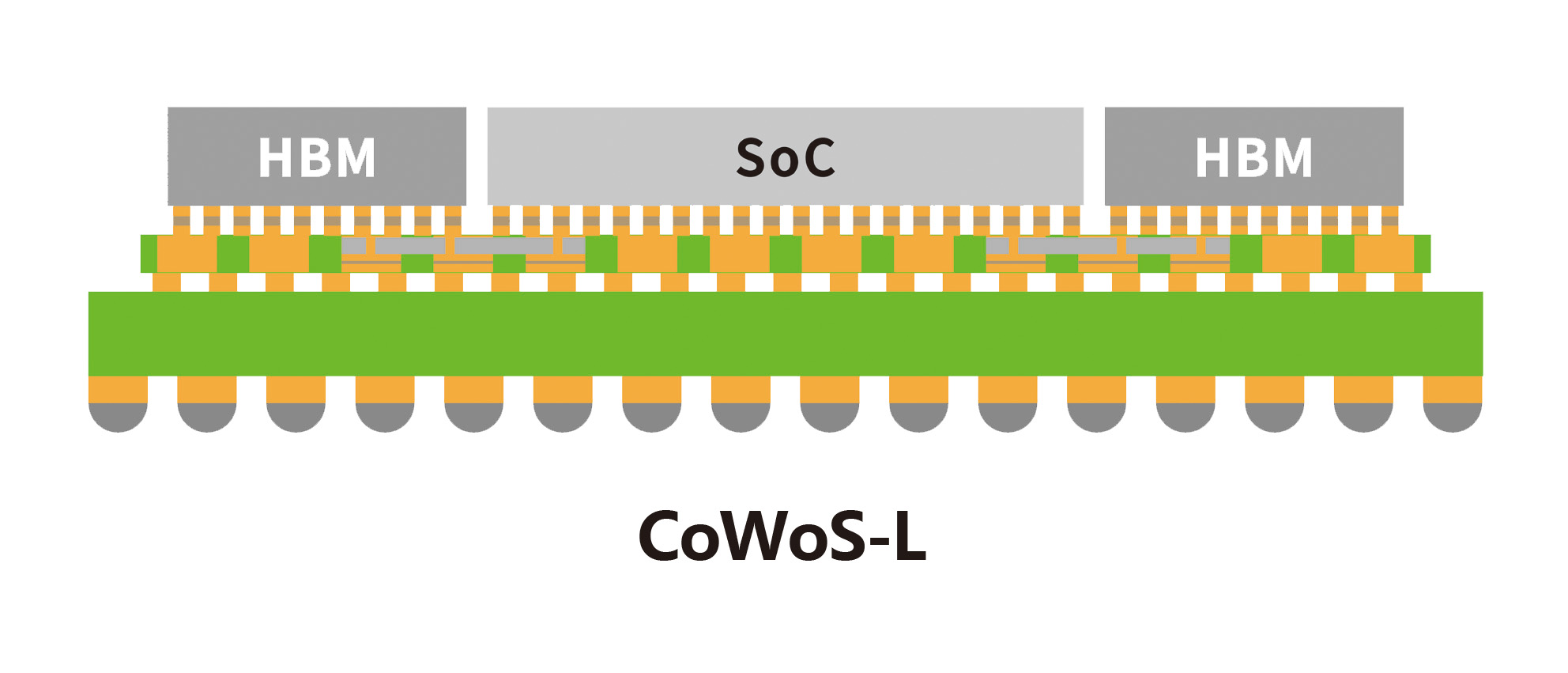
如何通俗理解芯片封裝設(shè)計

簽約頂級封裝廠,普萊信巨量轉(zhuǎn)移技術(shù)掀起晶圓級封裝和板級封裝的技術(shù)革命



中美貿(mào)易戰(zhàn),國產(chǎn)芯片發(fā)展艱難,先進封裝助力中國芯突圍!#芯片封裝 #先進封裝 #華芯邦 #
美光新加坡HBM內(nèi)存封裝工廠破土動工
先進封裝技術(shù)-19 HBM與3D封裝仿真

TCB熱壓鍵合:打造高性能半導(dǎo)體封裝的秘訣

先進封裝的重要設(shè)備有哪些

AI網(wǎng)絡(luò)物理層底座: 大算力芯片先進封裝技術(shù)
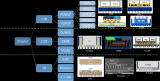





 劍指HBM及AI芯片,普萊信重磅發(fā)布Loong系列TCB先進封裝設(shè)備
劍指HBM及AI芯片,普萊信重磅發(fā)布Loong系列TCB先進封裝設(shè)備

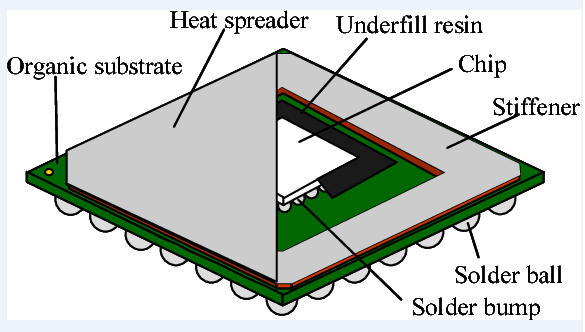










評論