DeepSeek的突破性進展,讓中國在AI產業領域似乎迅速縮小了和美國的差距,然而整個國產大模型的運行仍高度依賴英偉達的芯片支持。盡管國產GPU設計能力迅速提升,但隨著臺積電對中國大陸的供應限制,高端GPU的國產化制造成為中國AI產業發展的關鍵挑戰,尤其是CoWoS先進封裝制程的自主化尤為緊迫,目前中國大陸產能極少,且完全依賴進口設備,這一瓶頸嚴重制約著國產AI發展進程。在此背景下,普萊信智能開發的Loong系列TCB設備,通過與客戶的緊密合作,率先完成了國產AI芯片的CoWoS-L測試打樣,實現了國產TCB設備在AI芯片CoWoS封裝領域的首次突破。
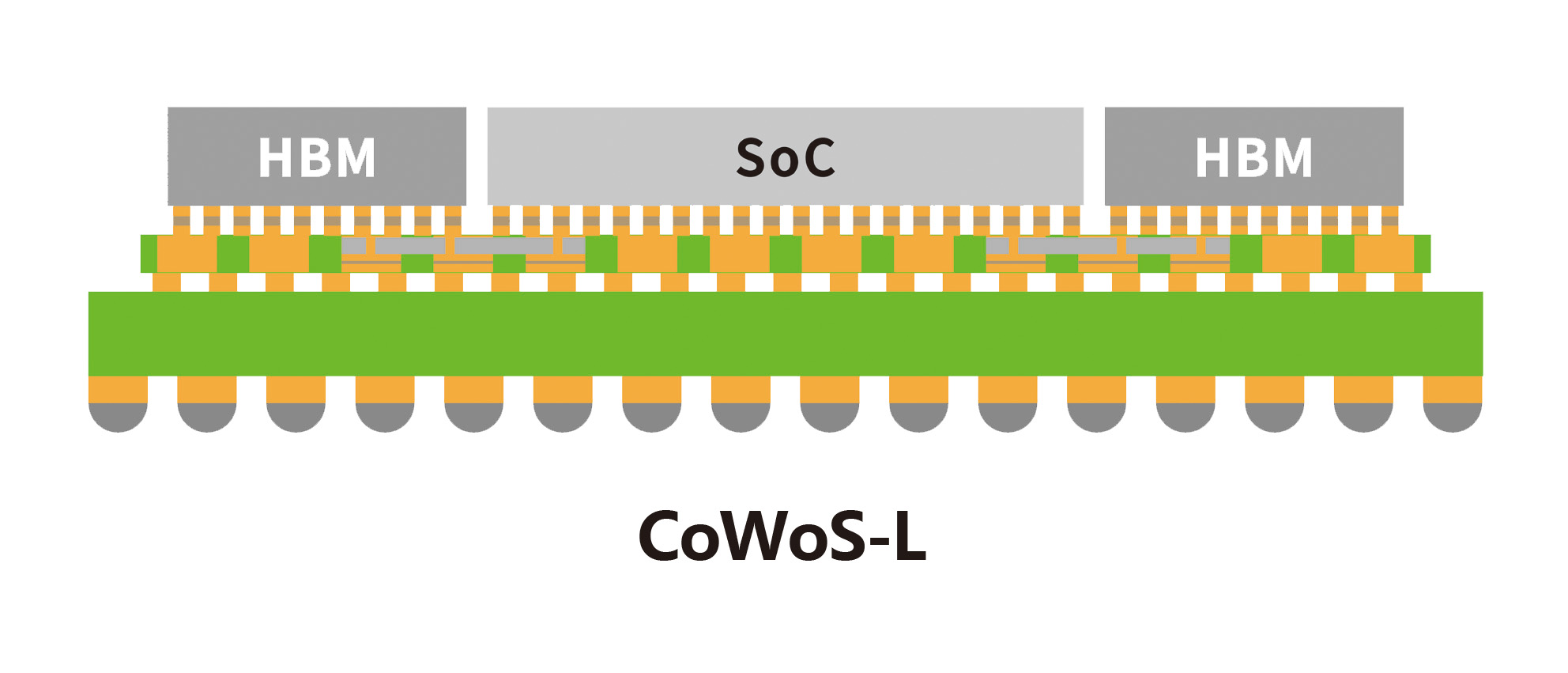
CoWoS封裝——AI芯片高密度集成的基石
隨著AI大模型、自動駕駛、高性能計算(HPC)的爆發式增長,傳統芯片封裝技術已無法滿足算力密度和能效比的需求。臺積電推出的CoWoS(Chip-on-Wafer-on-Substrate)技術,通過將邏輯芯片、高帶寬內存(HBM)、硅中介層等異構元件三維堆疊集成,成為AI芯片的“終極封裝方案”。其核心優勢在于:
1、超高密度互聯:利用硅中介層實現微米級TSV(硅通孔)互連,布線密度較傳統2D
封裝提升10倍以上,突破數據傳輸瓶頸;
2、極致能效比:HBM與GPU/ASIC芯片的“近存計算”架構,將數據傳輸功耗降低50%,顯著提升能效比;
3、卓越異構集成能力:突破傳統封裝限制,支持多芯片、多工藝節點(如7nm邏輯芯片+40nm硅中介層)混合封裝,為芯片設計提供更大自由度。
TCB設備——CoWoS封裝的心臟與技術制高點
在CoWoS封裝流程中,熱壓鍵合(Thermal Compression Bonding, TCB)是決定良率與性能的核心環節。其作用包括:
1、精準連接:以微米級精度將芯片與中介層或基板對準,通過熱壓實現銅柱凸點(Cu Pillar)的共晶鍵合;
2、熱應力控制:在高溫高壓下平衡芯片翹曲,避免微裂紋或界面分層;
3、多層堆疊:支持HBM與邏輯芯片的多次鍵合,確保信號完整性。
應用于CoWoS封裝的熱壓鍵合(TCB)設備,精度要求極高,通常不低于±1.5μm,甚至新一代的TCB設備,精度要求達到亞微米,要在這種對溫度、壓力嚴格控制環境下,實現穩定的精度和力控,全球現在只有國際少數幾家半導體設備巨頭能生產TCB設備,如新加坡ASM Pacific、美國Kulicke & Soffa,韓國Hanmi等。同時,隨著AI芯片尺寸增大(如英偉達GB200芯片達130×90mm),設備需支持更大鍵合面積、更高精度及多芯片同步對準,及對無助焊劑封裝的要求,Fluxless的鍵合與自適應翹曲補償技術成為未來趨勢。
全球CoWoS市場爆發式增長,中國需求激增與產能瓶頸并存
據Yole Développement預測,2023年全球CoWoS封裝市場規模已突破35億美元,未來三年將以年均42%的復合增長率快速擴張,預計2026年市場規模將超100億美元。其中,AI芯片貢獻超70%需求——僅英偉達H100/H200、AMD MI300X等旗艦產品,單顆芯片即需1-2片CoWoS中介層,而2024年全球AI芯片出貨量預計達150萬顆,拉動CoWoS產能缺口持續擴大。

中國作為全球AI芯片第二大市場,CoWoS封裝需求正急速攀升:華為昇騰910B、寒武紀思元590、壁仞BR100等國產AI芯片已進入CoWoS量產階段,單顆芯片中介層需求達2-4片;互聯網巨頭(如百度、阿里)自研AI芯片亦加速導入CoWoS。
據測算,2024年中國大陸CoWoS封裝市場規模將達8億美元,2026年有望突破25億美元,年增長率超70%。但核心瓶頸在于包括TCB設備在內的關鍵設備100%依賴進口,且美國可能將高端TCB設備納入對華半導體設備禁令,導致產能擴張計劃面臨“無米之炊”風險。

美國禁令倒逼國產化,TCB設備成AI芯片制造破局關鍵
美國商務部工業與安全局(BIS)已將CoWoS相關技術列為“重點關注領域”,若對TCB設備實施出口管制,中國大陸先進封裝產線或將陷入停滯。例如:ASM Pacific已暫停向部分中國客戶供應TCB系列設備;Besi的LAB設備對中國客戶實施“逐案審查”。在此背景下,TCB設備國產化不僅是商業需求,更是AI芯片供應鏈安全的生死線。
3月26-28日,SEMICON China展會期間,普萊信(展位號:N1-1285)將攜TCB熱壓鍵合機Loong(國產唯一HBM/CoWoS鍵合設備)、巨量轉移式板級封裝設備XBonder Pro、高速夾焊系統Clip Bonder、多功能超高精度機DA403等亮相。
審核編輯 黃宇
-
封裝
+關注
關注
128文章
8618瀏覽量
145124 -
CoWoS
+關注
關注
0文章
154瀏覽量
11019 -
AI芯片
+關注
關注
17文章
1978瀏覽量
35781
發布評論請先 登錄
國產劃片機崛起:打破COB封裝技術壟斷的破局之路
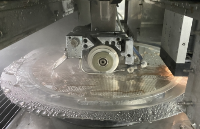
國產SiC碳化硅MOSFET廠商柵氧可靠性危機與破局分析

芯片封裝工藝詳解
8002D音頻功放芯片:國產芯片的破局之選
【新品發布】國產實力破局!算力 “卷王” HZHY-AI210G,體積小巧,讓智能無人設備輕裝上陣

國產汽車芯片現狀解讀:高端少、占比低,該如何破局?
功率模塊封裝工藝






 國產AI芯片破局:國產TCB設備首次完成CoWoS封裝工藝測試
國產AI芯片破局:國產TCB設備首次完成CoWoS封裝工藝測試



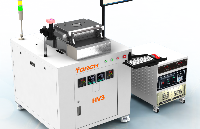










評論