源漏區(qū)嵌入SiC 應(yīng)變技術(shù)被廣泛用于提高90nm 及以下工藝制程 NMOS 的速度,它是通過(guò)外延生長(zhǎng)技術(shù)在源漏嵌入 SiC 應(yīng)變材料,利用硅和碳晶格常數(shù)不同,從而對(duì)溝道和襯底硅產(chǎn)生應(yīng)力,改變硅導(dǎo)帶的能帶結(jié)構(gòu),從而降低電子的電導(dǎo)有效質(zhì)量和散射概率。
硅的晶格常數(shù)是5.431A,碳的晶格常數(shù)是3.57A,硅與碳的不匹配率是34.27%,從而使得 SiC 的晶格常數(shù)小于純硅,并且碳的晶格常數(shù)遠(yuǎn)小于硅的晶格常數(shù),SiC只需很少的碳原子就可得到很高的應(yīng)力。圖2-7所示為在硅襯底上外延生長(zhǎng)SiC應(yīng)變材料外延。SiC會(huì)對(duì)橫向的溝道產(chǎn)生張應(yīng)力,從而使溝道的晶格發(fā)生形變,晶格變大。
在 NMOS 的源漏嵌入SiC 應(yīng)變材料,如圖2-8所示,NMOS的溝道制造在[100] 方向上,SiC應(yīng)變材料會(huì)在該方向產(chǎn)生單軸的張應(yīng)力,得到的主能谷的等能面的軸向都是垂直于溝道分向,沿溝道方向單軸張應(yīng)力會(huì)減小溝道方向的電子電導(dǎo)有效質(zhì)量和散射概率,源漏嵌入SiC應(yīng)變材料可以有效地提高NMOS 的速度。
源漏嵌入 SiC 應(yīng)變材料是選擇外延(Se-lective Epitaxial Growth,SEG)技術(shù)。選擇外延技術(shù)是利用外延生長(zhǎng)的基本原理,以及硅在絕緣體上很難核化成膜的特性,在硅表面的特定區(qū)域生長(zhǎng)外延層而其他區(qū)域不生長(zhǎng)的技術(shù)。外延生長(zhǎng)的基本原理是根據(jù)硅在SiO2上核化的可能性最小,在Si3N4上比在SiO2上大一點(diǎn),在硅上可能性最大的特性完成的。這是因?yàn)樵诠枰r底上外延生長(zhǎng)硅層是同質(zhì)外延,而在SiO2和Si3N4上是異質(zhì)外延,所以落在絕緣體上的原子因不易成核而遷移到更易成核的硅單晶區(qū)內(nèi)。
實(shí)現(xiàn)源漏嵌入 SiC 應(yīng)變材料工藝具有一定的難度,因?yàn)镾iC 應(yīng)變材料外延生長(zhǎng)工藝的選擇性比較差,它在源漏凹槽襯底生長(zhǎng)的同時(shí),也會(huì)在氧化物等非單晶區(qū)域上生長(zhǎng),例如在側(cè)壁和STI上生長(zhǎng) 。可以通過(guò)CVD淀積和濕法刻蝕技術(shù),進(jìn)行多次淀積和多次刻蝕的方式來(lái)改善外延生長(zhǎng)SiC 應(yīng)變材料,因?yàn)槔肅VD工藝可以在單晶硅襯底獲得單晶態(tài)的SiC 薄膜,而在氧化物等非單晶區(qū)域上得到非晶態(tài)的SiC 薄膜,由于非晶態(tài)的SiC 薄膜具有較高的刻蝕率,所以可以通過(guò)多次淀積和多次刻蝕循環(huán)在源漏單晶硅襯底上選擇性生長(zhǎng)出一定厚度的單晶態(tài)SiC薄膜。
另外,SiC 應(yīng)變材料在高溫?zé)嵬嘶鸬臒岱€(wěn)定性比較差,在大于900°C的高溫?zé)嵬嘶鹬校琒iC 應(yīng)變材料中的部分碳原子會(huì)離開(kāi)替位晶格的位置,一旦替位碳原子離開(kāi)替位晶格,應(yīng)力就會(huì)失去,離開(kāi)的碳原子的數(shù)量與高溫?zé)嵬嘶鸬臅r(shí)間成正比。所以在 SiC 應(yīng)變材料薄膜形成后,必須嚴(yán)格控制高溫退火的時(shí)間,而先進(jìn)的毫秒退火工藝可以改善這一問(wèn)題。
圖2-9所示為 NMOS 的源漏嵌入SiC 應(yīng)變材料的工藝流程。

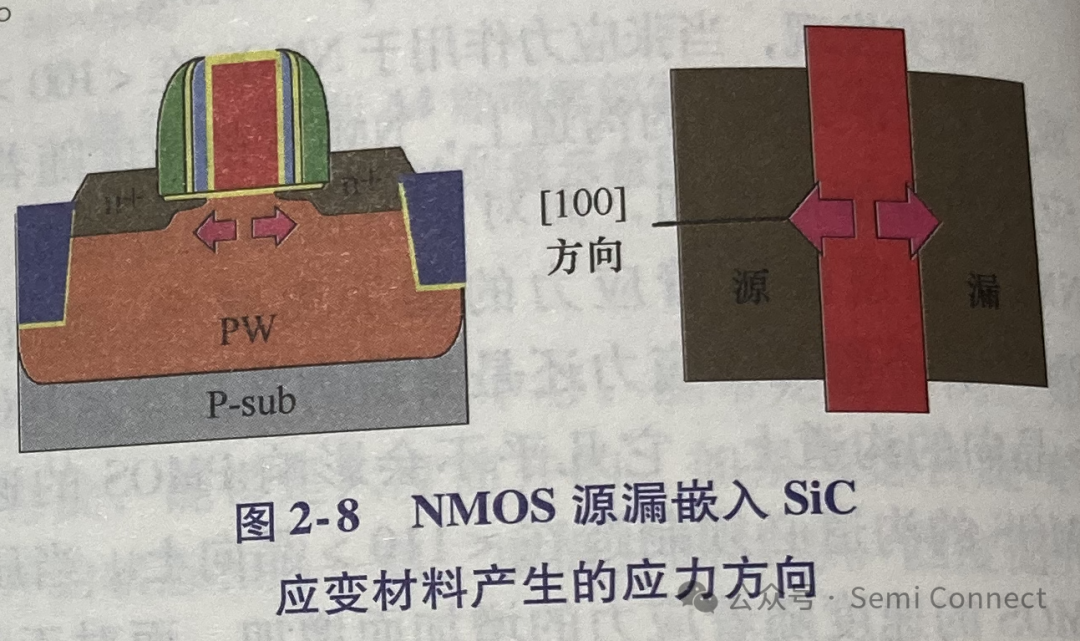
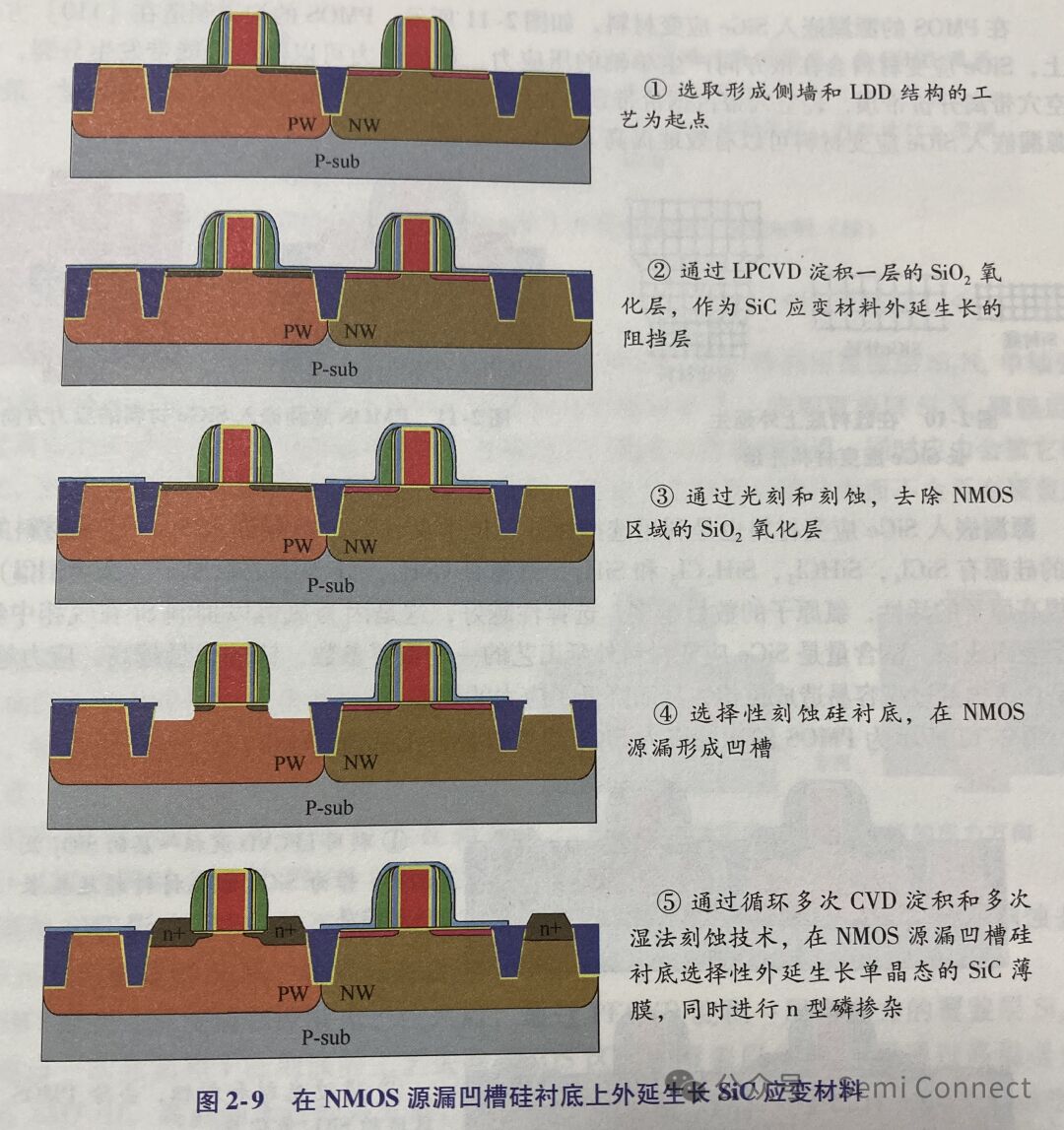
-
NMOS
+關(guān)注
關(guān)注
3文章
356瀏覽量
35379 -
SiC
+關(guān)注
關(guān)注
31文章
3157瀏覽量
64455 -
晶格
+關(guān)注
關(guān)注
0文章
95瀏覽量
9444
原文標(biāo)題:源漏嵌入 SiC 應(yīng)變技術(shù)
文章出處:【微信號(hào):Semi Connect,微信公眾號(hào):Semi Connect】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
金屬電阻應(yīng)變片工作原理簡(jiǎn)介
麥科信光隔離探頭在碳化硅(SiC)MOSFET動(dòng)態(tài)測(cè)試中的應(yīng)用
海飛樂(lè)技術(shù)現(xiàn)貨替換IXFN50N120SIC場(chǎng)效應(yīng)管
基于分布式光纖應(yīng)變傳感器技術(shù)的山體滑坡在線監(jiān)測(cè)預(yù)警方案
漏源電壓VDS相關(guān)資料下載
SiC MOSFET的器件演變與技術(shù)優(yōu)勢(shì)
PNP與NPN哪個(gè)是“源”與”漏“的渾水
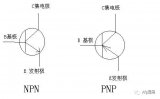
三菱PLC源型和漏型的區(qū)別

嵌入式源漏選擇性外延(Embedded Source and Drain Selective Epitaxy)
R課堂 | 漏極和源極之間產(chǎn)生的浪涌
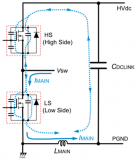
源極和漏極的區(qū)別
mos芯片源極漏極柵極在哪 mos管怎么判斷漏柵源極
源漏擴(kuò)展結(jié)構(gòu)概述






 源漏嵌入SiC應(yīng)變技術(shù)簡(jiǎn)介
源漏嵌入SiC應(yīng)變技術(shù)簡(jiǎn)介












評(píng)論