/ 摘要 /
400V SiC MOSFET技術(shù)商用化彌補(bǔ)了長(zhǎng)期存在的200V中壓MOSFET與600V超級(jí)結(jié)MOSFET之間產(chǎn)品和技術(shù)空缺。400 V SiC MOSFET技術(shù)開(kāi)關(guān)損耗低、導(dǎo)通電阻小,非常適合三電平拓?fù)浣Y(jié)構(gòu)。本文簡(jiǎn)要介紹了該器件的設(shè)計(jì)理念,并研究了其在ANPC拓?fù)涞娜嘟涣魍ㄓ霉I(yè)驅(qū)動(dòng)器中的性能,該驅(qū)動(dòng)器工作在高達(dá)750 VDC的輸入電壓下。
簡(jiǎn) 介
目前400V市場(chǎng)還沒(méi)有有競(jìng)爭(zhēng)力的解決方案。現(xiàn)有的 200 V中壓MOSFET通過(guò)隔離的埋入式場(chǎng)板進(jìn)行橫向電荷補(bǔ)償,但將其耐壓進(jìn)一步提升的效果并不理想。同樣,將現(xiàn)有采用超級(jí)結(jié)技術(shù)的600V MOSFET的耐壓降低也存在問(wèn)題。在這兩種情況下,應(yīng)用性能都會(huì)因特定的器件設(shè)計(jì)而受到影響,即輸入、輸出和反向恢復(fù)電荷較大,輸出電容和米勒電容隨漏極電壓而明顯下降。這些特性阻礙了這些器件在硬開(kāi)關(guān)半橋或全橋拓?fù)浣Y(jié)構(gòu)中的普遍應(yīng)用。
400 V SiC MOSFET器件的總體結(jié)構(gòu)沿用了之前介紹的設(shè)計(jì)方法[1][2]。圖1給出了元胞的橫截面示意圖。有源溝道沿α晶面排列,以提供最佳的溝道遷移率和最低的界面陷阱密度。柵極氧化物由深 p 阱保護(hù),深 p 阱與半導(dǎo)體表面的源電極相連。由于第二溝道側(cè)壁與 α 晶面不重合,因此不用作有源溝道。相反,掩埋 p 區(qū)沿著非活動(dòng)側(cè)壁與源電極相連。這使得元胞設(shè)計(jì)非常緊湊,再加上 α 晶面的高溝道遷移率,使得單位面積的導(dǎo)通電阻很低。
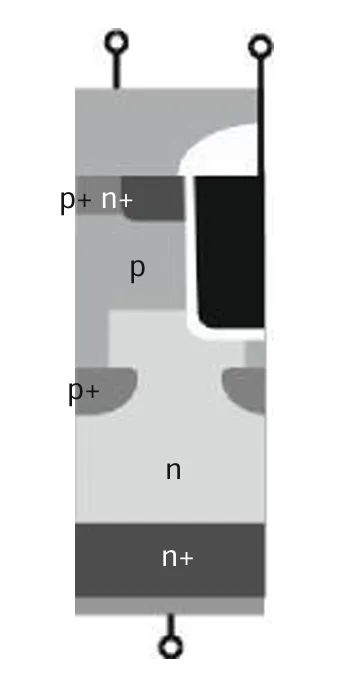
圖1. SiC MOSFET結(jié)構(gòu)橫截面示意圖
雖然新型400 V MOSFET與之前推出的第一代器件[2]、[3]的設(shè)計(jì)相似,但它得益于技術(shù)的不斷改進(jìn),使晶胞間距明顯縮小,溝道特性得到改善,漂移區(qū)特性得到更好的控制。此外,還對(duì)芯片設(shè)計(jì)進(jìn)行了精心優(yōu)化,以避免不必要的有效面積損失,例如通過(guò)優(yōu)化結(jié)端設(shè)計(jì)。圖2比較了新型400 V和650 V CoolSiC技術(shù)的一些關(guān)鍵器件參數(shù)。
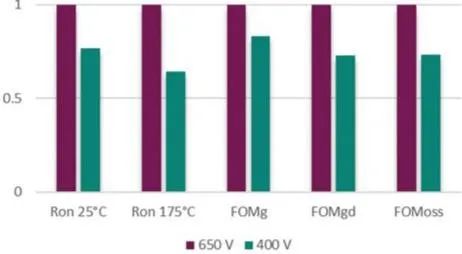
圖2. 400 V和650 V MOSFET的性能參數(shù)比較
新的400V SiC MOSFET 特別適合那些前級(jí)為三相/400Vac整流轉(zhuǎn)換為560V直流母線電壓的應(yīng)用。目前,由于沒(méi)有其他選擇,這些應(yīng)用通常采用兩電平拓?fù)浣Y(jié)構(gòu)中的1200 V半導(dǎo)體。圖3所示的三電平有源中性點(diǎn)鉗位(3L ANPC)拓?fù)浣Y(jié)構(gòu)[4]特別適合使用400 V器件,因?yàn)橹绷?a target="_blank">電容器將母線電壓一分為二。這樣就能實(shí)現(xiàn)800 V的阻斷能力,此外還能帶來(lái)雙向能量轉(zhuǎn)移的好處。

圖3. 三相3L ANPC逆變器基本示意圖
如圖4所示,在一個(gè)3相3電平ANPC逆變器中對(duì)器件性能進(jìn)行了研究。該逆變器采用18個(gè)11 mΩ 400 V TOLL封裝的SiC-MOSFET。理想情況下,柵極驅(qū)動(dòng)器可為三相系統(tǒng)提供18個(gè)隔離的柵極驅(qū)動(dòng)電壓,因此采用了一種基于平面變壓器正激轉(zhuǎn)換器的可靠、低成本解決方案,只需一個(gè)輸入即可驅(qū)動(dòng)18個(gè)隔離輸出。

圖4. 帶有柵極驅(qū)動(dòng)器的 3 相 3L ANPC測(cè)試板
逆變器的開(kāi)關(guān)頻率為10 kHz,每個(gè)開(kāi)關(guān)的dv/dt限制在5 V/ns。它采用SPWM調(diào)制。在VDC=600 V、相電流為15 A,9.74千伏安負(fù)載的條件下,逆變器的效率為 n = 99.57 %。圖5和圖6顯示了測(cè)量到的電壓和電流波形,表明開(kāi)關(guān)行為平穩(wěn)。
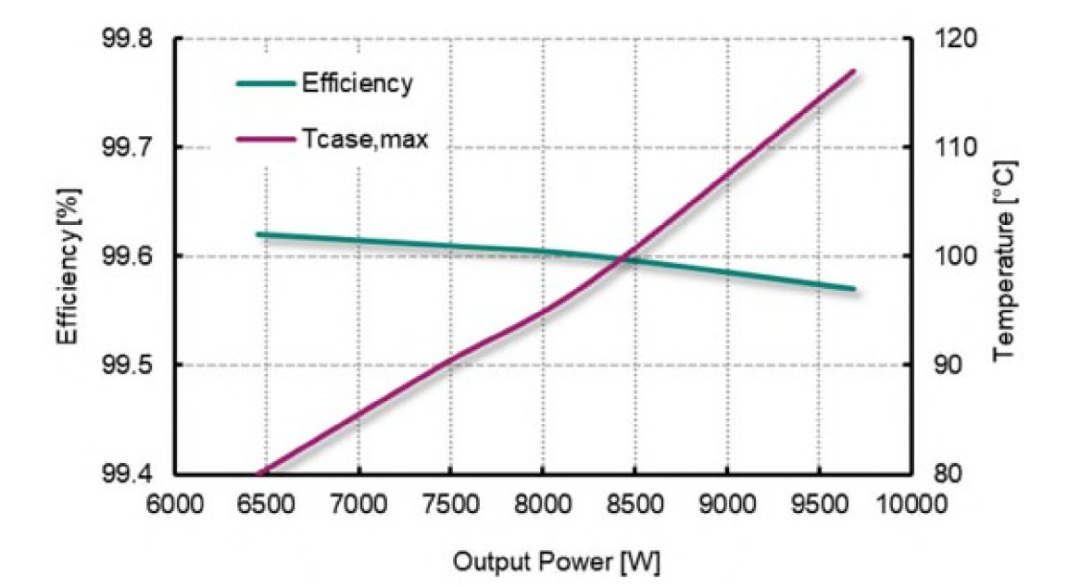
圖5. 無(wú)散熱器運(yùn)行時(shí)的效率和最高外殼溫度測(cè)量值

圖6. 高壓側(cè)開(kāi)關(guān)的導(dǎo)通和關(guān)斷波形 [VDS = 300 V,ILOAD = 30 A,di/dt = 750 A/μs]
論文全文將提供有關(guān)器件特性的更多細(xì)節(jié),對(duì)測(cè)試環(huán)境的更詳細(xì)描述,并包括進(jìn)一步的測(cè)量結(jié)果和對(duì)結(jié)果的解釋。
參考文獻(xiàn)
[1] D.Peters、T.Basler、B.Zippelius、T.Aichinger、W.Bergner、R.Esteve、D.Kueck 和 R.Siemieniec:面向低柵極氧化應(yīng)力和高性能的新型 CoolSiCTM 溝槽 MOSFET 技術(shù),Proc.PCIM,紐倫堡,2017
[2] R.Siemieniec、D. Peters、R. Esteve、W. Bergner、D. Kück、T. Aichinger、T. Basler 和 B. Zippelius:提供改進(jìn)溝道遷移率和高可靠性的碳化硅溝道 MOSFET 概念,Proc.EPE,波蘭華沙,2017 年
[3] R.Siemieniec、R. Mente、W. Jantscher、D. Kammerlander、U. Wenzel 和 T. Aichinger:用于高效電源的 650 V SiC 溝槽 MOSFET,Proc.意大利熱那亞 EPE,2019 年
[4] T.Brückner 和 S. Bernet:有源 NPC 開(kāi)關(guān)在三電平電壓源逆變器中的損耗平衡》,Proc.PESC,加拿大溫哥華,2001 年
-
MOSFET
+關(guān)注
關(guān)注
150文章
8338瀏覽量
218795 -
電機(jī)驅(qū)動(dòng)
+關(guān)注
關(guān)注
60文章
1298瀏覽量
87577 -
SiC
+關(guān)注
關(guān)注
31文章
3170瀏覽量
64527
發(fā)布評(píng)論請(qǐng)先 登錄
三菱電機(jī)1200V級(jí)SiC MOSFET技術(shù)解析
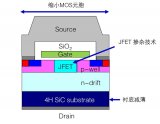
PCIM 2010上海展
Microsem美高森美用于SiC MOSFET技術(shù)的極低電感SP6LI封裝
SiC功率器件SiC-MOSFET的特點(diǎn)
SiC MOSFET:經(jīng)濟(jì)高效且可靠的高功率解決方案
【羅姆SiC-MOSFET 試用體驗(yàn)連載】基于Sic MOSFET的直流微網(wǎng)雙向DC-DC變換器
ROHM的SiC MOSFET和SiC SBD成功應(yīng)用于Apex Microtechnology的工業(yè)設(shè)備功率模塊系列
為SiC mosfet選擇柵極驅(qū)動(dòng)IC時(shí)的關(guān)鍵參數(shù)
《電子設(shè)計(jì)工程》英文摘要寫(xiě)作要求
畢業(yè)論文摘要格式范例
SiC MOSFET學(xué)習(xí)筆記(三)SiC驅(qū)動(dòng)方案

聯(lián)合電子400V SiC(碳化硅)電橋在太倉(cāng)工廠迎來(lái)首次批產(chǎn)
三菱電機(jī)推出兩款新型SBD嵌入式SiC-MOSFET模塊
PCIM2024論文摘要|并聯(lián)SiC MOSFET的均流研究






 PCIM2024論文摘要|新型400V SiC MOSFET用于高效三電平工業(yè)電機(jī)驅(qū)動(dòng)
PCIM2024論文摘要|新型400V SiC MOSFET用于高效三電平工業(yè)電機(jī)驅(qū)動(dòng)










評(píng)論