半導體封裝已從傳統的 1D PCB 設計發展到晶圓級的尖端 3D 混合鍵合。這一進步允許互連間距在個位數微米范圍內,帶寬高達 1000 GB/s,同時保持高能效。先進半導體封裝技術的核心是 2.5D 封裝(其中組件并排放置在中介層上)和 3D 封裝(涉及垂直堆疊有源芯片)。這些技術對于 HPC 系統的未來至關重要。
2.5D 封裝技術涉及各種中介層材料,每種材料都有各自的優點和缺點。硅 (Si) 中介層包括全無源硅晶圓和局部硅橋,以提供最精細的布線功能而聞名,是高性能計算的理想選擇。然而,它們在材料和制造方面成本高昂,并且面臨封裝面積的限制。為了緩解這些問題,局部硅橋的使用正在增加,在精細功能至關重要的地方戰略性地使用硅并解決面積限制問題。
有機中介層采用扇出型模塑料,是一種比硅更具成本效益的替代品。它們的介電常數較低,從而減少了封裝中的 RC 延遲。盡管有這些優勢,但有機中介層難以實現與硅基封裝相同的互連特征減少水平,這限制了它們在高性能計算應用中的采用。
玻璃中介層引起了人們的極大興趣,尤其是在英特爾最近推出基于玻璃的測試載體封裝之后。玻璃具有多種優勢,例如可調節的熱膨脹系數 (CTE)、高尺寸穩定性、光滑且平坦的表面以及支持面板制造的能力,使其成為具有可與硅媲美的布線功能的中介層的有希望的候選者。然而,除了技術挑戰之外,玻璃中介層的主要缺點是生態系統不成熟和目前缺乏大規模生產能力。隨著生態系統的成熟和生產能力的提高,半導體封裝中的基于玻璃的技術可能會進一步增長和采用。
在 3D 封裝技術方面,Cu-Cu 無凸塊混合鍵合正成為一項領先的創新技術。這種先進技術通過將介電材料(如 SiO2)與嵌入式金屬(Cu)相結合,實現永久互連。Cu-Cu 混合鍵合可實現 10 微米以下的間距,通常在個位數微米范圍內,這比傳統的微凸塊技術有了顯著的改進,后者的凸塊間距約為 40-50 微米。混合鍵合的優勢包括增加 I/O、提高帶寬、改善 3D 垂直堆疊、提高功率效率,以及由于沒有底部填充而降低寄生效應和熱阻。然而,這種技術制造復雜,成本較高。
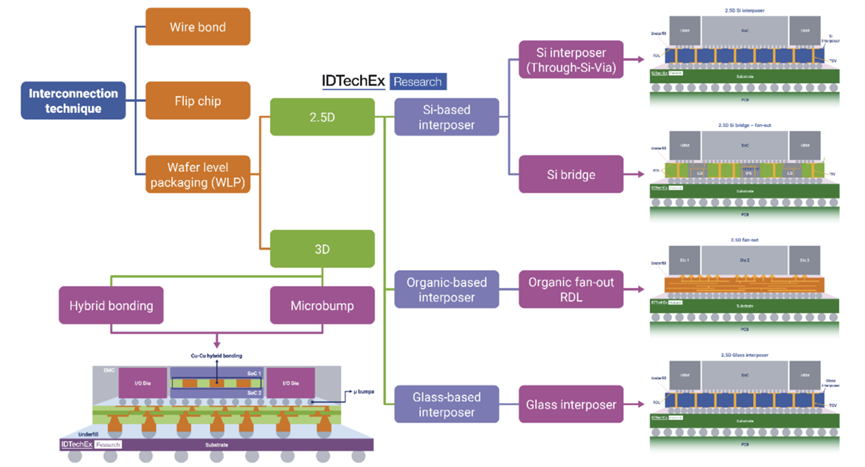
2.5D與3D封裝技術包含各種封裝技術,2.5D封裝中,根據中介層材料的選擇,可分為硅基、有機基、玻璃基中介層,如上圖所示。而3D封裝中,微凸塊技術的發展,目的在于縮小間距尺寸,但如今通過采用混合鍵合技術(一種直接連接Cu-Cu的方法),已可實現個位數間距尺寸,這標志著該領域取得了重大進展。
值得關注的技術趨勢
1更大的中介層面積
IDTechEx 此前曾預測,由于硅中介層難以超過 3 倍光罩尺寸的限制,2.5D 硅橋解決方案將很快取代硅中介層,成為封裝 HPC 芯片的主要選擇。臺積電是 NVIDIA 和谷歌、亞馬遜等其他主要 HPC 開發商 2.5D 硅中介層的主要供應商,該公司最近宣布大批量生產其第一代 3.5 倍光罩尺寸的 CoWoS_L。IDTechEx 預計這一趨勢將持續下去,其涵蓋主要參與者的報告中將探討進一步的進展。
2面板級封裝
面板級封裝已成為一個重要焦點,正如 2024 年臺灣國際半導體展所強調的那樣。這種封裝方法允許使用更大的中介層,并通過同時生產更多封裝來幫助降低成本。盡管它具有潛力,但仍需解決翹曲管理等挑戰。它日益突出反映了對更大、更具成本效益的中介層的需求日益增長。
3玻璃中介層
玻璃正成為實現精細布線的有力候選材料,堪比硅,并具有可調節的熱膨脹系數 (CTE) 和更高的可靠性等額外優勢。玻璃中介層還與面板級封裝兼容,具有以更易于管理的成本實現高密度布線的潛力,使其成為未來封裝技術的一個有前途的解決方案。
4HBM 混合鍵合
3D 銅-銅 (Cu-Cu) 混合鍵合是實現芯片間超細間距垂直互連的關鍵技術。該技術已用于多種高端服務器產品,包括用于堆疊 SRAM 和 CPU 的 AMD EPYC,以及用于在 I/O 塊上堆疊 CPU/GPU 塊的 MI300 系列。混合鍵合預計將在未來 HBM 進步中發揮關鍵作用,尤其是對于超過 16-Hi 或 20-Hi 層的 DRAM 堆棧。
5共封裝光學元件 (CPO )
隨著對更高數據吞吐量和更高功率效率的需求不斷增長,光互連技術已獲得相當大的關注。共封裝光學器件 (CPO) 正在成為增強 I/O 帶寬和降低能耗的關鍵解決方案。與傳統電氣傳輸相比,光通信具有多種優勢,包括遠距離信號衰減更低、串擾敏感性更低以及帶寬顯著提高。這些優勢使 CPO 成為數據密集型、節能 HPC 系統的理想選擇。
值得關注的關鍵市場
推動 2.5D 和 3D 封裝技術發展的主要市場無疑是高性能計算 (HPC) 領域。這些先進的封裝方法對于克服摩爾定律的局限性至關重要,可以在單個封裝內實現更多的晶體管、內存和互連。芯片的分解還可以實現不同功能塊之間工藝節點的最佳利用,例如將 I/O 塊與處理塊分開,從而進一步提高效率。
除了高性能計算 (HPC),其他市場也有望通過采用先進的封裝技術實現增長。在 5G 和 6G 領域,封裝天線和尖端芯片解決方案等創新將塑造無線接入網絡 (RAN) 架構的未來。自動駕駛汽車也將受益,因為這些技術支持傳感器套件和計算單元的集成,以處理大量數據,同時確保安全性、可靠性、緊湊性、電源和熱管理以及成本效益。
消費電子產品(包括智能手機、智能手表、AR/VR 設備、PC 和工作站)雖然更注重成本,但也越來越注重在更小的空間內處理更多數據。先進的半導體封裝將在這一趨勢中發揮關鍵作用,盡管封裝方法與 HPC 中使用的方法不同。
-
半導體
+關注
關注
335文章
28778瀏覽量
235294 -
封裝技術
+關注
關注
12文章
578瀏覽量
68519 -
3D封裝
+關注
關注
8文章
140瀏覽量
27710 -
先進封裝
+關注
關注
2文章
467瀏覽量
576
原文標題:先進封裝的技術趨勢
文章出處:【微信號:深圳市賽姆烯金科技有限公司,微信公眾號:深圳市賽姆烯金科技有限公司】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄

先進封裝技術的發展趨勢
先進封裝技術的發展與機遇
什么是先進封裝?先進封裝技術包括哪些技術

先進封裝技術趨勢分析






 先進封裝的技術趨勢
先進封裝的技術趨勢




















評論