在本篇文章中,我們主要介紹刻蝕工藝評價的工藝參數以及如何做好刻蝕工藝。
一、刻蝕工藝質量評價 1)刻蝕速率 刻蝕速率是指在蝕刻過程中被去除的材料的速率,通常以單位時間內的厚度減少量來表示,單位通常是納米/秒(nm/s)或埃/秒(?/s)。厚度可用膜厚儀、臺階儀或SEM等表征。 刻蝕速率=△d/t (?/min) △d=去掉的材料厚度(?或um) t=刻蝕所用的時間 (min)
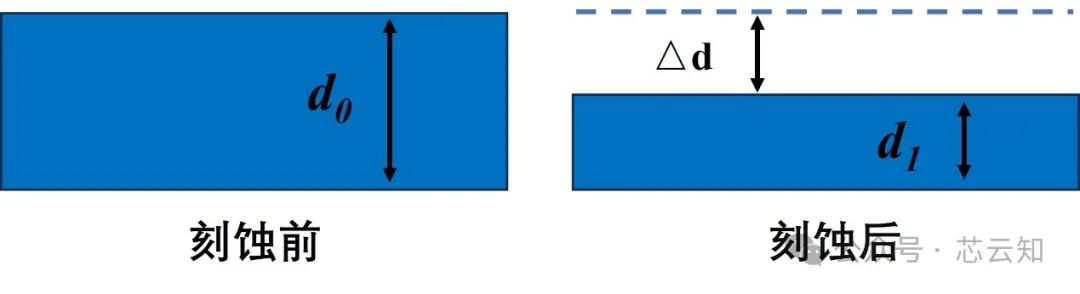
2)刻蝕選擇比 在刻蝕過程中,被刻蝕物質上層的抗蝕劑(如光刻膠)或下層的物質這些本來不需要被刻蝕的膜層會同時遭到刻蝕,那么在抗蝕劑和刻蝕材料間需要有一個定義,即刻蝕選擇比。 刻蝕選擇比=被刻蝕材料的速率/掩膜材料的速率 在微納加工中,刻蝕選擇比是一個重要的參數,它決定了在蝕刻過程中目標材料相對于掩模材料的去除速率。通常情況下,刻蝕選擇比越高,表示目標材料相對于掩模材料的去除速率越快,蝕刻過程更具有選擇性。高刻蝕選擇比對于制造微納米結構和器件至關重要,因為它可以確保所需的結構只在特定的區域進行蝕刻,而不影響其他區域。

用于刻蝕的掩膜材料對比參考下表,對于常規工藝,通常采用光刻膠即可,但是圍繞一些耐刻蝕材料,如碳化硅、石英、藍寶石等則需要硬掩模才能實現。

3)均勻性 均勻性通常用于刻蝕速率在整個晶片上的一致性情況。衡量刻蝕工藝在整個晶片上,或整個一批,或批與批之間刻蝕能力的參數。(片內、片間及批間)。Emax為最大值,Emin為最小值,Eave為平均值。


4)刻蝕偏差 刻蝕以后線寬或關鍵尺寸間距的變化。刻蝕工藝之后線寬、圖形高度、深度等尺寸的變化。只要涉及化學反應就一定或多或少存在側蝕,有效利用側蝕可以實現一些特殊結構。 刻蝕偏差=Wb - Wa Wb=刻蝕前掩膜的線寬 Wa=掩膜去掉后被刻蝕材料的線寬
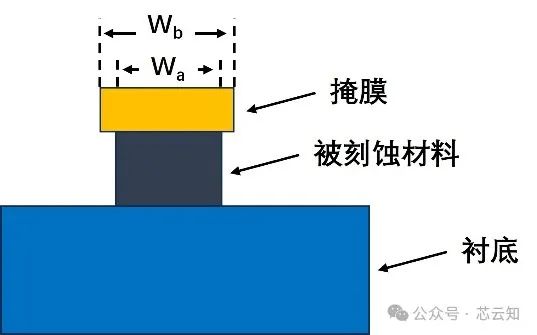
5)刻蝕角度 刻蝕角度通常是指刻蝕過程中垂直于表面的刻蝕方向與表面水平線之間的夾角。刻蝕角度可以通過控制刻蝕速率的比例來實現。假設 Vh表示垂直方向的刻蝕速率,Vv表示水平方向的刻蝕速率,則刻蝕角度θ可以通過以下公式進行估算:  ? ?
? ?
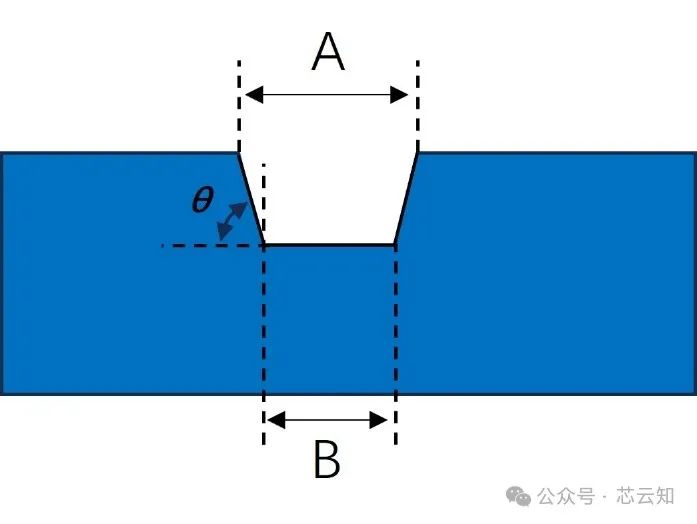
在刻蝕過程中,刻蝕角度的控制對于制備特定形狀或結構的器件非常重要。通過調整刻蝕角度,可以控制材料在特定方向上的刻蝕速率,從而實現所需的形狀或結構。例如,如果需要制備具有斜面的器件或結構,可以通過調整刻蝕角度來實現。 二、如何做好刻蝕工藝 那么如何能夠得到希望的刻蝕效果呢?可以參照如下流程進行設計,再通過刻蝕后形成的工藝質量評價后再進行進一步的優化和調節。
-
光刻膠
+關注
關注
10文章
337瀏覽量
30871 -
刻蝕工藝
+關注
關注
2文章
40瀏覽量
8586
原文標題:想要做好刻蝕工藝需要評價哪些指標?
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導體所】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
芯片制造的刻蝕工藝科普
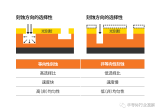
【新加坡】知名半導體晶圓代工廠招聘資深刻蝕工藝工程師和刻蝕設備主管!
干刻清洗工藝在金屬刻蝕去膠腔上的評價及應用
GaN材料干法刻蝕工藝在器件工藝中有著廣泛的應用

關于刻蝕的重要參數報告
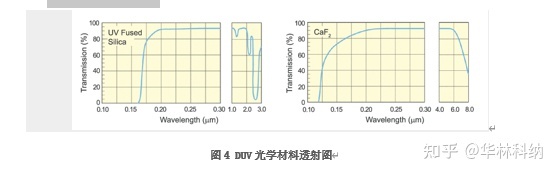
半導體行業之刻蝕工藝技術
半導體前端工藝:刻蝕——有選擇性地刻蝕材料,以創建所需圖形






 刻蝕工藝評價的工藝參數以及如何做好刻蝕工藝
刻蝕工藝評價的工藝參數以及如何做好刻蝕工藝



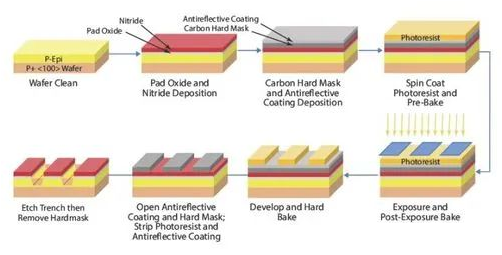
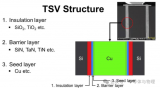











評論