碳化硅(SiC)是制作高溫、高頻、大功率電子器件的理想電子材料之一,近20年來隨著SiC材料加工技術的不斷提升,其應用領域不斷擴大。目前SiC芯片的制備仍然以6英寸(1英寸=25.4 mm)晶圓為主,但是行業(yè)龍頭企業(yè)已經(jīng)開始研發(fā)基于8英寸SiC晶圓的下一代器件和芯片。
近日,廣東天域半導體股份有限公司丁雄杰博士團隊聯(lián)合廣州南砂晶圓半導體技術有限公司、清純半導體(寧波)有限公司、芯三代半導體科技(蘇州)股份有限公司在《人工晶體學報》2024年第10期發(fā)表了題為《8英寸SiC晶圓制備與外延應用》的研究論文(第一作者:韓景瑞;通信作者:丁雄杰)。該論文采用擴徑生長法制備了8英寸導電型4H-SiC襯底晶圓,其平均基平面位錯(BPD)密度低至251 cm-2,平均螺位錯(TSD)密度小于1 cm-2,實現(xiàn)了近“零TSD”和低BPD密度的8英寸導電型4H-SiC襯底晶圓的制備,可以滿足生產(chǎn)需要。研究團隊采用國產(chǎn)8英寸外延設備和開發(fā)工藝包,在8英寸晶圓上實現(xiàn)了速率為68.66 μm/h的快速外延生長,獲得的外延層厚度不均勻性為0.89%,摻雜不均勻性為2.05%,這兩個指標已經(jīng)達到了優(yōu)良6英寸外延膜的水平,完全可以滿足生產(chǎn)需要。與國外已發(fā)布的8英寸外延結(jié)果對比,厚度和摻雜均勻性均優(yōu)于國外數(shù)據(jù),而缺陷密度只有國外數(shù)據(jù)的1/4。本文設計和實施了多片重復性試驗,驗證了8英寸外延的穩(wěn)定性。
論文題錄●●
韓景瑞, 李錫光, 李詠梅, 王垚浩, 張清純, 李達, 施建新, 閆鴻磊, 韓躍斌, 丁雄杰. 8英寸SiC晶圓制備與外延應用[J]. 人工晶體學報, 2024, 53(10): 1712-1719.
HAN Jingrui, LI Xiguang, LI Yongmei, WANG Yaohao, ZHANG Qingchun, LI Da, SHI Jianxin, YAN Honglei, HAN Yuebin, TING Hungkit. Preparation and Epitaxy Application of 8 Inch SiC Wafers[J]. Journal of Synthetic Crystals, 2024, 53(10): 1712-1719.
//文章導讀
在國內(nèi)8英寸SiC晶圓開發(fā)上,從2021年開始截至2023年底,山東大學、北京天科合達半導體股份有限公司(簡稱“天科合達”)、山西爍科晶體有限公司(簡稱“山西爍科”)、廣州南砂晶圓半導體技術有限公司(簡稱“南砂晶圓”)等超過10家公司和研究機構(gòu)先后發(fā)布了8英寸導電型4H-SiC襯底晶圓,也對8英寸長晶爐熱場進行了分區(qū)模擬研究,從表1的對比中可以看出,盡管比國外研發(fā)起步時間較晚,但是國內(nèi)在8英寸晶圓研發(fā)的速度和研發(fā)單位數(shù)量上已經(jīng)快速趕超國外。
表1國內(nèi)外8英寸SiC晶圓開發(fā)對比

在8英寸SiC外延環(huán)節(jié),國內(nèi)也發(fā)展迅速。廈門大學于2023年3月發(fā)布了8英寸4H-SiC外延成果,厚度不均勻性和摻雜濃度不均勻性分別為2.3%和小于7.5%,表面缺陷密度小于0.5 cm-2。從表2中數(shù)據(jù)(截至2024年1月1日)同樣可以看出,國內(nèi)在8英寸SiC外延這個環(huán)節(jié)也在迅速發(fā)展。
表28英寸SiC外延片發(fā)布數(shù)據(jù)對比

8英寸SiC的制造難點之一在于晶錠生長,由6英寸擴徑到8英寸,晶錠生長的難度會成倍增加。8英寸籽晶質(zhì)量要求更高,同時需要解決大尺寸帶來的溫場不均勻、氣相原料分布和輸運效率問題,以及應力增大導致晶體開裂等問題。本文的8英寸4H-SiC襯底晶圓由南砂晶圓制造。SiC單晶生長采用主流的物理氣相傳輸(physical vapor transport, PVT)法,生長系統(tǒng)包括加熱系統(tǒng)、冷卻系統(tǒng)及石墨材料組成的熱場區(qū),典型的生長示意圖如圖1所示。
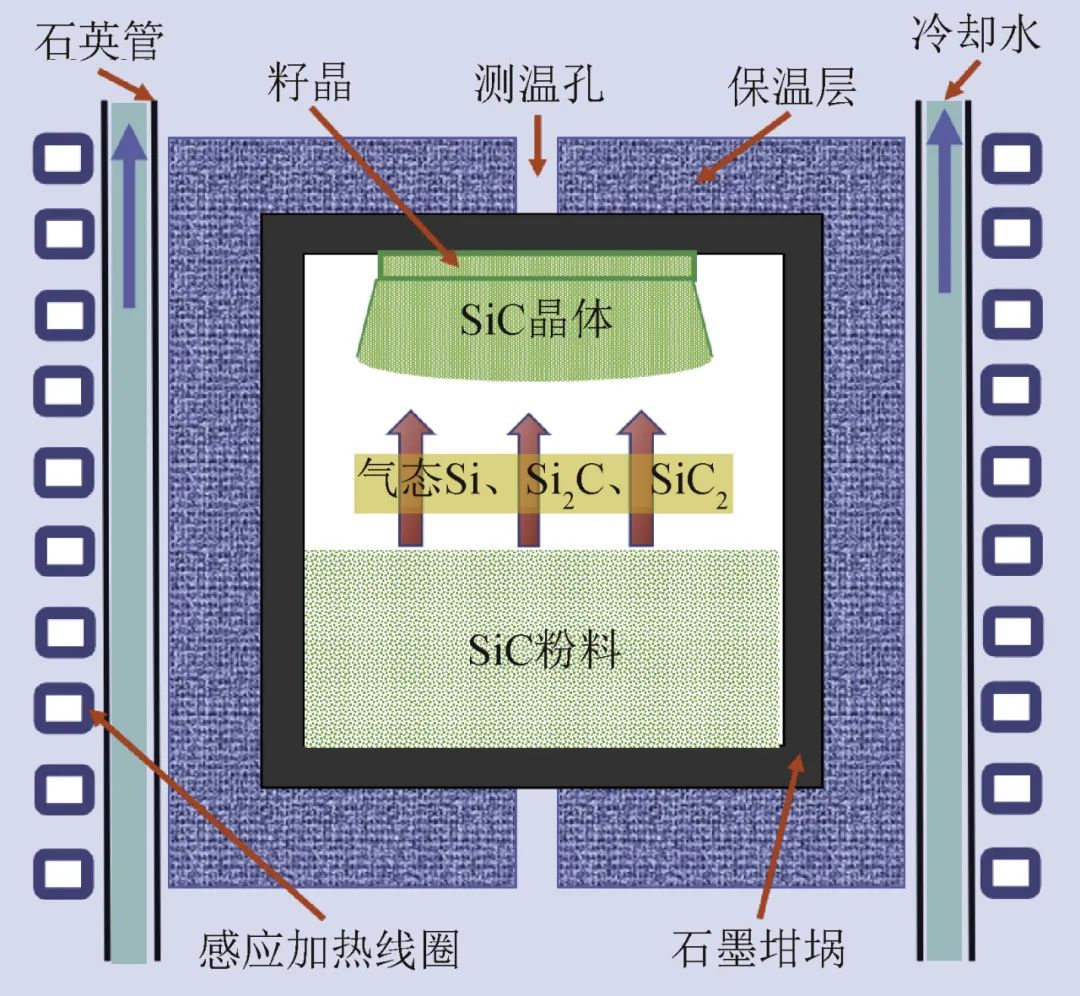
圖1典型SiC PVT生長示意圖
生長得到的晶體經(jīng)過滾圓、磨平面整形后,獲得標準直徑的8英寸導電型4H-SiC晶錠,之后采用多線切割機進行切片,得到原始晶圓。然后對原始晶圓進行機械拋光和化學機械拋光,獲得厚度為500 μm的低粗糙度8英寸導電型4H-SiC襯底晶圓,如圖2所示。從圖中可以看出,8英寸導電型4H-SiC襯底晶圓呈均一的棕黃色,結(jié)合拉曼測試,表明襯底晶圓中無6H和15R-SiC等多型夾雜,4H晶型比例100%。

圖28英寸導電型4H-SiC襯底晶圓(a)及其拉曼光譜(b)
在合適的腐蝕條件下,SiC晶圓Si面的位錯缺陷腐蝕坑形狀清晰、尺寸適中、完全顯露且沒有交疊。將腐蝕后的晶圓用沸騰的酒精和蒸餾水反復清洗,擦干后進行測試。采用位錯瑕疵檢測儀自動識別統(tǒng)計不同類型位錯對應的特征腐蝕坑數(shù)量。設備可以準確地識別各類型位錯,經(jīng)過人工對視覺識別系統(tǒng)的結(jié)果進行復核,確保目前方法結(jié)果的可靠性,得到8英寸導電型4H-SiC襯底晶圓的TSD和BPD密度及分布情況,如圖3所示,平均BPD密度為251 cm-2,平均TSD密度小于1 cm-2。實現(xiàn)了近“零TSD”和低BPD密度的8英寸導電型4H-SiC襯底晶圓制備。

圖38英寸導電型4H-SiC襯底晶圓的螺位錯和基平面位錯密度及分布
本研究在8英寸晶圓上實現(xiàn)了速率為68.66 μm/h的外延生長,獲得了標稱厚度為11.44 μm、摻雜濃度為10.50×1015 cm-3的外延層。圖4和圖5分別為8英寸導電型4H-SiC晶圓上生長的外延層的厚度和摻雜濃度沿徑向分布圖。外延層厚度的平均值為11.44 μm,標準偏差為0.10 μm,用標準偏差和平均值之比評估的厚度不均勻性為0.89%。外延層摻雜濃度的平均值為10.50×1015 cm-3,標準偏差為0.22×1015 cm-3,摻雜不均勻性為2.05%。

圖44H-SiC外延層的片內(nèi)膜厚分布圖

圖5同一片4H-SiC外延層的片內(nèi)摻雜濃度徑向分布圖
為了進一步考察8英寸晶圓上外延生長的重復性和穩(wěn)定性,本研究采用同一個工藝菜單,進行了另外2次外延生長,完成了重復性實驗,結(jié)果如表3和表4所示。從表3中可以看出,膜厚和摻雜濃度片間不均勻性分別為4.25%和4.11%。從表4可以看出,三角形和掉落物缺陷密度的3片平均值為0.12 cm-2,完全滿足6英寸外延片的三角形和掉落物缺陷密度不大于0.5 cm-2的通用出貨要求。因此可以初步得出結(jié)論,本研究的8英寸外延片重復性良好,具有良好的穩(wěn)定性,可以進行大批量試生產(chǎn)和進一步量產(chǎn)研究優(yōu)化。
表3膜厚和摻雜濃度重復性結(jié)果

表4缺陷率重復性結(jié)果

結(jié)論
實現(xiàn)高質(zhì)量8英寸SiC晶圓制造和外延生長是推進下一代大尺寸功率器件生產(chǎn)的基礎性一步,本文概述了在廣東天域的協(xié)調(diào)下,8英寸SiC晶圓工業(yè)試驗線的建立和進展。用新型PVD長晶爐擴徑生長得到晶錠,經(jīng)過切磨拋得到8英寸導電型4H-SiC襯底晶圓。測量結(jié)果證明,8英寸導電型4H-SiC襯底晶圓平均BPD密度低至251 cm-2,平均TSD密度小于1 cm-2,實現(xiàn)了近“零TSD”和低BPD密度的8英寸襯底晶圓制備,已經(jīng)可以滿足外延和芯片加工生產(chǎn)要求。采用垂直式SiC國產(chǎn)外延設備,在廣東天域?qū)嶒炇抑袑δ仙熬A公司研發(fā)的國產(chǎn)8英寸導電型4H-SiC襯底晶圓進行了外延生長,實現(xiàn)了速率為68.66 μm/h的快速外延生長,厚度不均勻性為0.89%,摻雜不均勻性為2.05%,這兩個指標和缺陷密度優(yōu)于國外水平,已經(jīng)達到了優(yōu)良6英寸外延膜的水平,完全可以滿足生產(chǎn)需要。重復性實驗的結(jié)果發(fā)現(xiàn),本研究下8英寸外延生長可以很好地重復,具有良好的穩(wěn)定性,可以進行大批量試生產(chǎn)和進一步量產(chǎn)研究優(yōu)化,本研究為8英寸芯片生產(chǎn)線生產(chǎn)工具使用8英寸晶圓進行了測試和優(yōu)化,實現(xiàn)了8英寸兼容性。這項研究工作為推動8英寸SiC晶圓大規(guī)模芯片制造提供了有益的參考。本研究證明了SiC全產(chǎn)業(yè)鏈的設備和材料國產(chǎn)化已經(jīng)取得了很大的成就,在6英寸產(chǎn)業(yè)化數(shù)年的追趕之后,國內(nèi)企業(yè)在8英寸SiC產(chǎn)業(yè)化上迎頭趕上,在晶圓制備和外延環(huán)節(jié)已經(jīng)比國外做得更好。
-
晶圓
+關注
關注
52文章
5129瀏覽量
129245 -
SiC
+關注
關注
31文章
3171瀏覽量
64543
原文標題:天域半導體 · 8英寸SiC晶圓制備與外延應用
文章出處:【微信號:wc_ysj,微信公眾號:旺材芯片】歡迎添加關注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
8英寸SiC投產(chǎn)進展加速,2025年上量

12英寸SiC,再添新玩家
簡單認識晶圓減薄技術
碳化硅襯底,進化到12英寸!

ASM推出全新PE2O8碳化硅外延機臺

ASM推出全新PE2O8碳化硅外延機臺

又一企業(yè)官宣已成功制備8英寸SiC晶圓
信越化學推出12英寸GaN晶圓,加速半導體技術創(chuàng)新
萬年芯:三代半企業(yè)提速,碳化硅跑步進入8英寸時代






 天域半導體8英寸SiC晶圓制備與外延應用
天域半導體8英寸SiC晶圓制備與外延應用















評論