離子轟擊的不均勻性
干法刻蝕通常是物理作用和化學作用相結合的過程,其中離子轟擊是重要的物理刻蝕手段。在刻蝕過程中,離子的入射角和能量分布可能不均勻. 如果離子入射角在側壁的不同位置存在差異,那么離子對側壁的刻蝕效果也會不同。在離子入射角較大的區域,離子對側壁的刻蝕作用更強,會導致該區域的側壁被刻蝕得更多,從而使側壁產生彎曲。此外,離子能量的不均勻分布也會產生類似的效果,能量較高的離子能夠更有效地去除材料,造成側壁在不同位置的刻蝕程度不一致,進而引起側壁彎曲 。
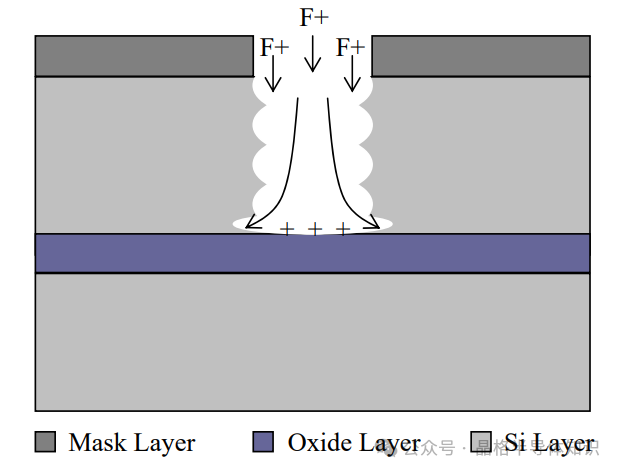
光刻膠的影響光刻膠在干法刻蝕中起著掩膜的作用,保護不需要被刻蝕的區域。然而,光刻膠在刻蝕過程中也會受到等離子體的轟擊和化學反應的影響,其性能可能會發生變化. 如果光刻膠的厚度不均勻、在刻蝕過程中的消耗速率不一致,或者光刻膠與襯底之間的附著力在不同位置有所不同,都可能導致刻蝕過程中對側壁的保護作用不均勻。例如,光刻膠較薄或附著力較弱的區域,可能會使下方的材料更容易被刻蝕,從而導致側壁在這些位置出現彎曲 。
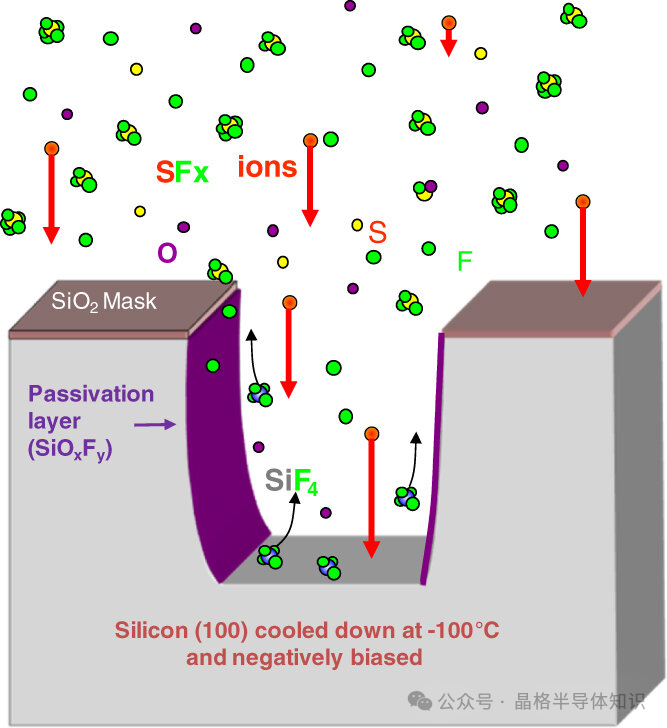
襯底材料特性的差異被刻蝕的襯底材料本身可能存在特性差異,如不同區域的晶體取向、摻雜濃度等可能不完全相同。這些差異會影響刻蝕速率和刻蝕選擇性. 以晶體硅為例,不同晶向的硅原子排列方式不同,其與刻蝕氣體的反應活性和刻蝕速率也會有所差異。在刻蝕過程中,這種由于材料特性差異導致的刻蝕速率不同,會使得側壁在不同位置的刻蝕深度不一致,最終導致側壁彎曲 。設備相關因素刻蝕設備的性能和狀態對刻蝕結果也有重要影響。例如,反應腔內的等離子體分布不均勻、電極的不均勻磨損等問題,都可能導致刻蝕過程中離子密度、能量等參數在晶圓表面的分布不均勻. 此外,設備的溫度控制不均勻、氣體流量的微小波動等,也可能會影響刻蝕的均勻性,進而導致側壁彎曲 。
-
光刻膠
+關注
關注
10文章
335瀏覽量
30838 -
刻蝕
+關注
關注
2文章
203瀏覽量
13346
原文標題:干法刻蝕時側壁為什么會彎曲
文章出處:【微信號:wc_ysj,微信公眾號:旺材芯片】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
干法刻蝕的概念、碳硅反應離子刻蝕以及ICP的應用

上海伯東IBE離子束刻蝕機介紹
半導體濕法和干法刻蝕
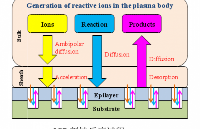
射頻電源的功率與頻率對刻蝕結果的影響
芯片制造中的濕法刻蝕和干法刻蝕

晶圓表面溫度對干法刻蝕的影響

干法刻蝕工藝的不同參數
一文看懂刻蝕角度與ICP-RIE射頻功率的關系
為什么干法刻蝕又叫低溫等離子體刻蝕

半導體干法刻蝕技術解析






 干法刻蝕時側壁為什么會彎曲
干法刻蝕時側壁為什么會彎曲



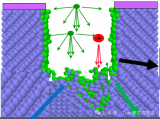
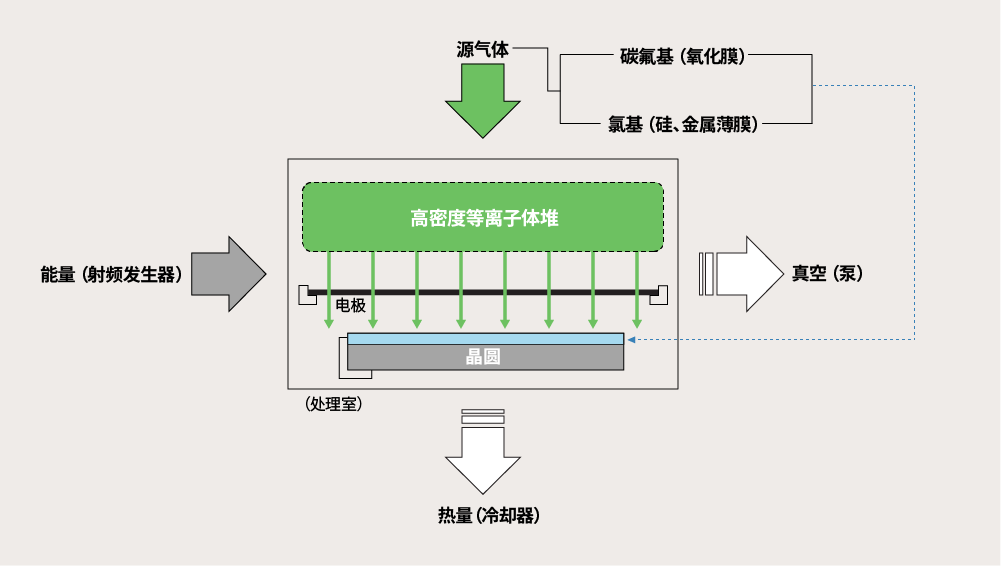










評論