一、術語
1、SiP:System-in-Package
SiP是一種先進的封裝技術,它將多個半導體器件、集成電路(IC)或其他電子組件,以及必要的輔助零件,集成并封裝在一個相對獨立的殼體內,形成一個完整的系統或子系統。與片上系統(SoC)不同,SiP不追求所有功能組件的單片集成,而是通過先進的封裝技術,將來自不同工藝節點的獨立芯片、傳感器、天線等組件封裝在一起,從而實現系統級別的集成。SiP的實現方式多種多樣,包括但不限于倒裝芯片(Flip-Chip)、引線鍵合(Wire Bonding)、凸塊技術(Bump Technology)以及晶圓級封裝(WLP)等。
2、QFN :Quad Flat No-Lead Package
QFN是方形扁平無引腳封裝的縮寫,它是一種表面貼裝技術,用于集成電路的封裝。QFN封裝有一個由引線框架包圍的模具(由銅合金與亞光錫涂層制成)。芯片和框架通常通過線鍵連接在一起。銅/金是焊絲粘合的首選材料。一些制造商使用倒裝芯片技術來實現這種互連。與傳統技術相比,倒裝芯片技術提供了更好的電氣性能。底部是金屬化的端子墊,它們沿著底部的四個邊緣存在,并為PCB提供電氣互連。QFN封裝底部的外露襯墊提供與PCB的電路連接,同時提供有效的傳熱。連接引腳將芯片牢牢地固定在襯墊上的環氧樹脂材料中。
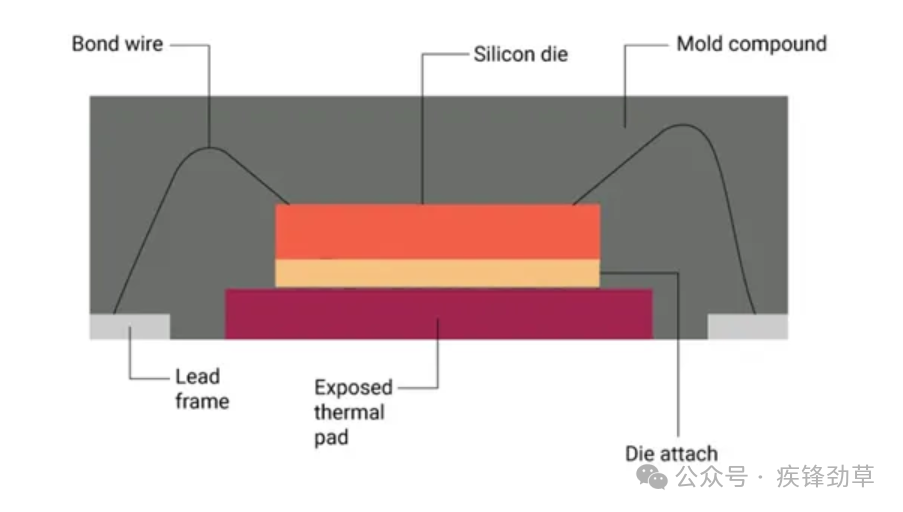
https://mp.weixin.qq.com/s/ZdlWYaLuDELtMe_45cutUA
3、SiC:silicon carbide
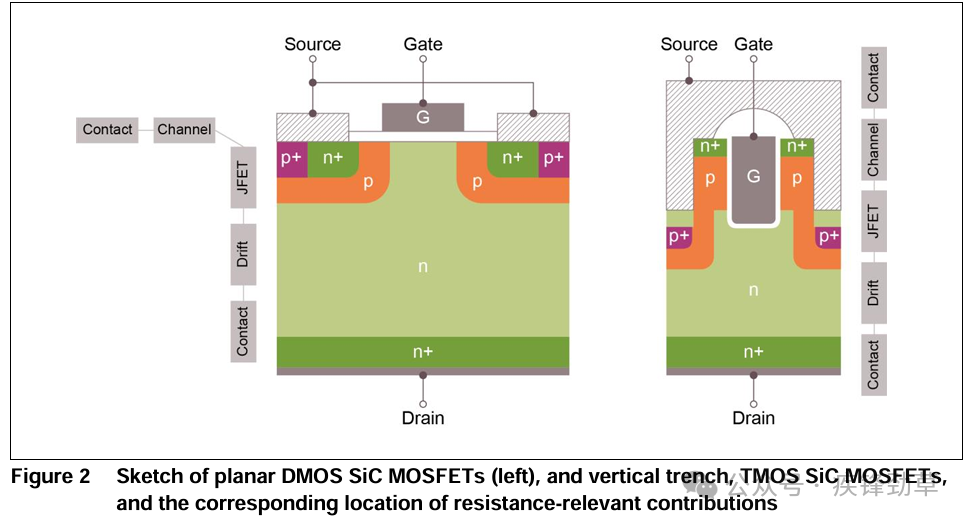
SiC晶體有以下優點:
(1)力學性質:SiC晶體具有極高的硬度與良好的耐磨性質,是目前已發現的材料中僅次 于金剛石的晶體。由于SiC力學上的優秀性質,粉晶SiC常被用于切割或磨拋工業,一些工件上的耐磨涂層也會采用SiC涂層,山東艦甲板上的耐磨涂層就是由SiC構成的。
(2) 熱學性質:SiC的導熱系數是傳統半導體Si的3倍, GaAs的8倍。采用SiC制備的器件產熱可以快速被傳導出去,由此SiC器件對散熱條件的要求相對較寬松,更適合制備大功率器件。SiC具有穩定的熱力學性質。在常壓條件下,SiC會在較高溫度下直接分解為Si與C的蒸氣,而不會發生熔化。
(3)化學性質:SiC具有穩定的化學性質,耐腐蝕性能良好,室溫條件下不與任何已知的酸發生反應。SiC長時間置于空氣中會緩慢的形成一層致密SiO2薄層,阻止進一步的氧化反應。
(4)電學性質:SiC作為寬禁帶半導體的代表材料,6H-SiC和4H-SiC的禁帶寬度分別為 3.0 eV和3.2 eV,是Si的3倍,GaAs 的 2 倍。采用 SiC 制備的半導體器件具有較小的漏電電流,較大的擊穿電場,所以 SiC 被認為是大功率器件的理想材料。SiC的飽和電子遷移率也比Si要高2倍,在制備高頻器件上也具有明顯優勢。通過晶體中雜質原子的摻雜可以獲得p型 SiC 晶體或者 N 型 SiC 晶體。
(5)光學性質:由于具有較寬帶隙,無摻雜的SiC晶體呈無色透明。摻雜后的SiC晶體由于其性質的不同表現出不同顏色,例如:摻雜N后,6H-SiC呈現綠色;4H-SiC呈現棕色;15R-SiC呈現黃色。摻雜Al后,4H-SiC呈現藍色。通過觀察顏色的不同來確定晶型,是一種較直觀的分辨 SiC 晶型的方法。
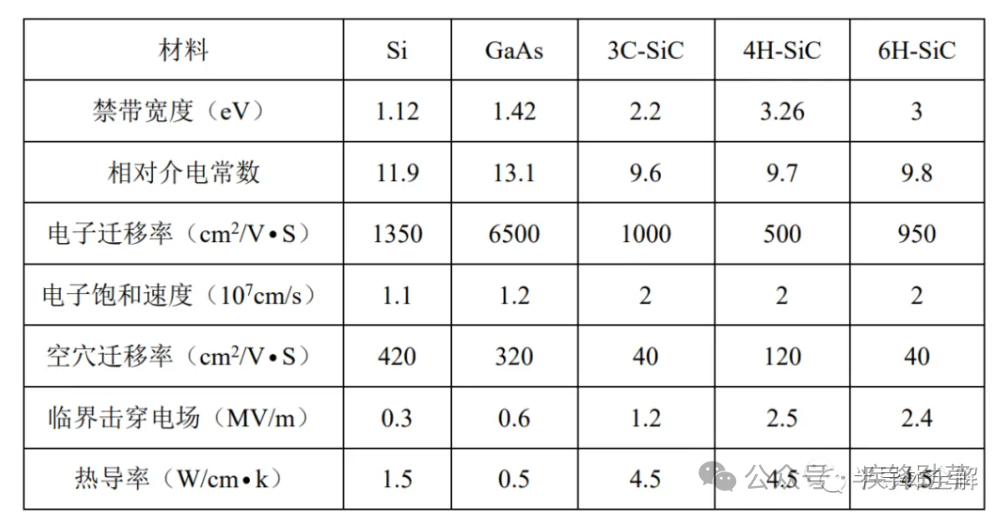
4、GaN:gallium nitride
氮化鎵(GaN)的晶體結構為六方晶系,與石墨相似,具有層狀結構。它的禁帶寬度為3.4eV,大于GaAs(1.424eV)和SiC(3.3eV),這使得GaN具有更高的擊穿電壓和熱穩定性。此外,GaN的導熱性差,但它的熱穩定性非常好,可以在高溫下保持其電學性能。
下面來解釋什么是禁帶寬度。
禁帶寬度(Band gap)是指一個帶隙寬度,單位是電子伏特(eV),用于描述半導體的能帶結構。在固體中,電子的能量是不連續的,這些能量不同的電子的能帶間存在一個最小能量差,稱為禁帶寬度。如果想要導電,就要有自由電子或者空穴存在。自由電子存在的能帶稱為導帶(能導電),而自由空穴存在的能帶稱為價帶(亦能導電)。被束縛的電子要成為自由電子或者空穴,就必須獲得足夠能量從而躍遷到導帶,這個能量的最小值就是禁帶寬度。
GaN HEMT是基于AlGaN/GaN異質結,目前市面上還未出現GaN的MOSFET,主要是因為同質GaN成本太高,一般采用Si或者SiC作為異質襯底,異質襯底就需要在襯底上生長一層緩沖層(AlN),而緩沖層是絕緣的,因此目前的GaN器件還沒有MOSFET結構。
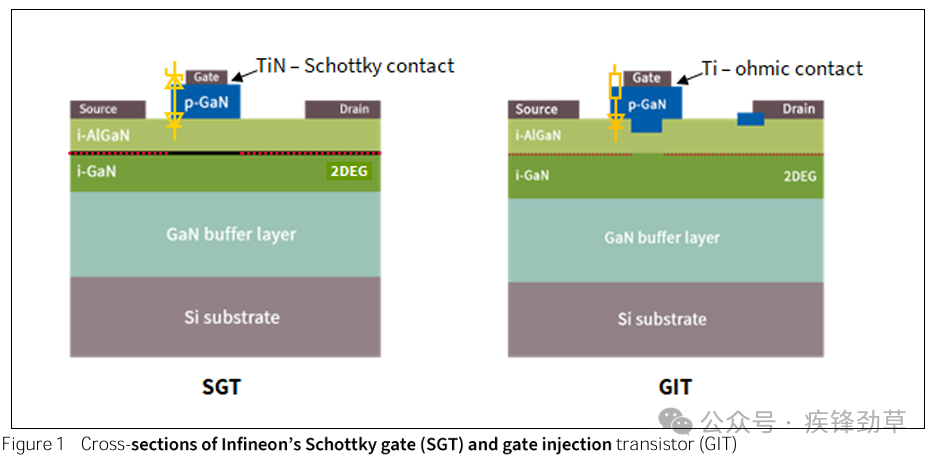
漲知識!氮化鎵(GaN)器件結構與制造工藝
定義
5、HEMT:high-electron-mobility transistors
高電子遷移率晶體管(High Electron Mobility Transistors,HEMT)作為功率半導體器件的代表,在高頻應用領域有著巨大的市場潛力。氮化鎵相比于硅和碳化硅具有更高的電子遷移率(Electron Mobility)、飽和電子漂移速率(Saturated Electron Veloctity)和擊穿場強(Breakdown Field)。 什么是電子遷移率?
電流的導通依靠的是材料內部載流子的定向移動。當存在著外加電壓時,材料內部的自由電子受到外加電壓中電場力的作用,會沿著電場的反方向做定向運動產生電流,我們稱其為漂移運動。而將這種定向運動的速度稱為漂移速度。根據推導可知,當電場增大時電子的運動速度也會隨之增大,兩者呈線性關系,而這個比例系數就被稱作遷移率。

由于材料上的優勢,在相同耐壓等級下,氮化鎵材料更適合制作高效的功率器件,特別是橫向結構HEMT,其導通電阻比硅器件的導通電阻低1~2個數量級,與同為寬禁帶半導體材料的碳化硅器件相比,其導通電阻減小1/2~1/3。
氮化鎵HEMT與普通晶體管的區別就在于高電子遷移率,因此更適合于高頻應用場合,對提升轉換器的效率和功率密度非常有利,這也是它被大規模應用的原因與前提。比如氮化鎵HEMT可將充電器的尺寸縮小一半,同時將功率提高3倍。目前氮化鎵功率器件主要應用于電源適配器、車載充電器、數據中心等領域,也逐漸成為5G基站電源的最佳解決方案。
從HEMT器件結構看,可分為橫向和縱向結構。縱向結構器件需要用到氮化鎵自支撐襯底,而且從目前來看,氮化鎵襯底的成本較高,尺寸較小,這就使得單個器件的成本更高。氮化鎵縱向結構器件尚未在市場上出售,目前處于大量研究以使器件商業化的階段。同時縱向結構的器件并沒有利用到氮化鎵最大的優勢——二維電子氣(2 Dimensional Electron Gas,2DEG),而橫向結構的器件則能很好地利用到這一特點。
獨特的 2DEG
氮化鎵外延的異質結結構,典型如AlGaN/GaN界面,由于沿鎵面方向外延生長的結構存在較強的自發極化和壓電極化效應,這導致在AlGaN/GaN異質結界面處會產生高濃度的2DEG。
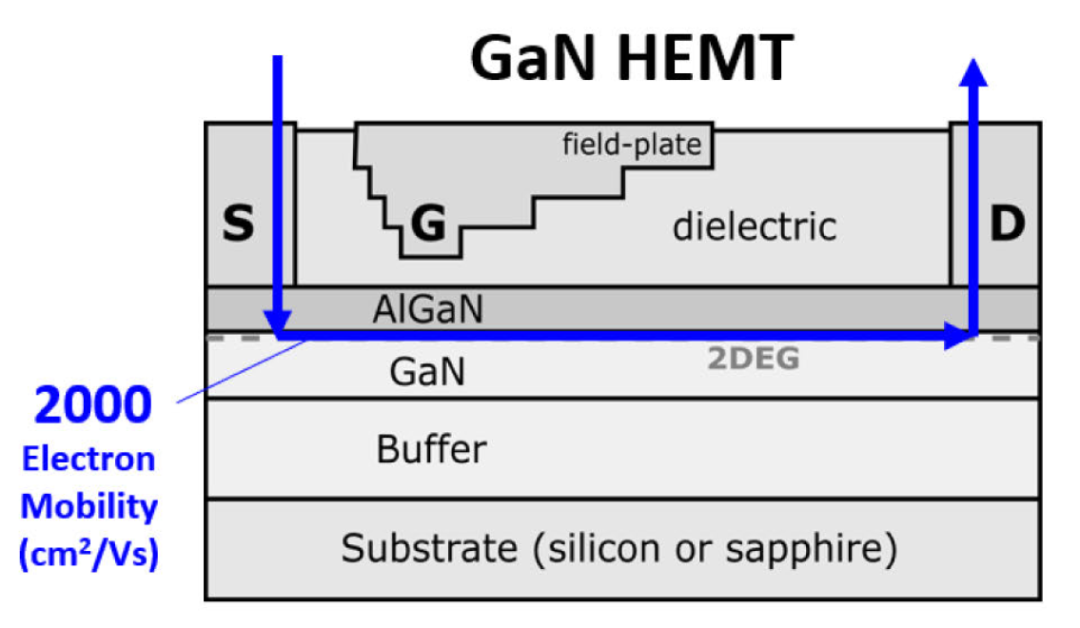
首先,由于GaN與AlGaN的晶格常數不同,而且它們的晶格常數又有變為數值一致的趨勢,因此在異質結界面處會出現對上層材料的擠壓或拉伸,產生應力。
在沒有外加應力時,由于氮化物材料自身的結構特點,其自身內部的正負電中心并不對稱,電子會向著N原子一側偏移,在材料內部產生電場,這就是自發極化。
與此同時,由于AlGaN材料的晶格常數小于GaN,上層的AlGaN材料會受到壓應力。就像等腰三角形來做一個類比,當我們在拉伸三角形的兩個等邊時,第三個頂點會向著其所對的邊移動,這就是壓電極化。
在自發極化與壓電極化的一同作用下,在AlGaN與GaN之間會產生一層極薄的電子層。由于這些電子被限制在幾個原子厚度的薄層中,不可以在Z軸方向運動,但可以在X與Y方向自由運動,所以電子近似位于一個平面內。在這個平面中的電子運動模式與自由空間中的氣體類似,故稱之為2DEG。
在極薄的平面中,電子的運動不會受到阻擋,所以電子的漂移速度就會相對較高,這也是高電子遷移率的由來。
6、MOSFET:metal-oxide-semiconductor field-effect transistors
金屬氧化物半導體場效應晶體管是一種電壓控制元件,以金屬層的柵極隔著氧化層利用電場的效應來控制半導體的場效應晶體管。
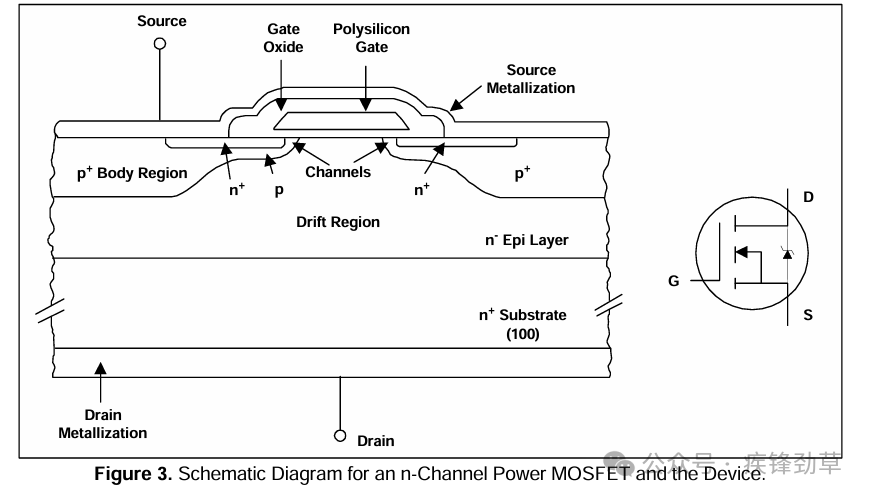
Power MOSFET Basics:https://www.infineon.com/dgdl/Infineon-power_mosfet_basics-Article-v01_00-EN.pdf?fileId=8ac78c8c8d2fe47b018e625961741a0e
7、IGBT:insulated-gate bipolar transistors
絕緣柵雙極型晶體管,是由雙極型三極管(BJT)和絕緣柵型場效應管(MOS)組成的復合全控型電壓驅動式功率半導體器件。下圖顯示了一種N溝道增強型絕緣柵雙極晶體管結構。IGBT是一個三端器件,正面有兩個電極,分別為發射極(Emitter)和柵極(Gate)背面為集電極(Collector)。IGBT的開關作用是通過加正向柵極電壓形成溝道,給PNP晶體管提供基極電流,使IGBT導通;反之,加反向門極電壓消除溝道,流過反向基極電流,使IGBT關斷。
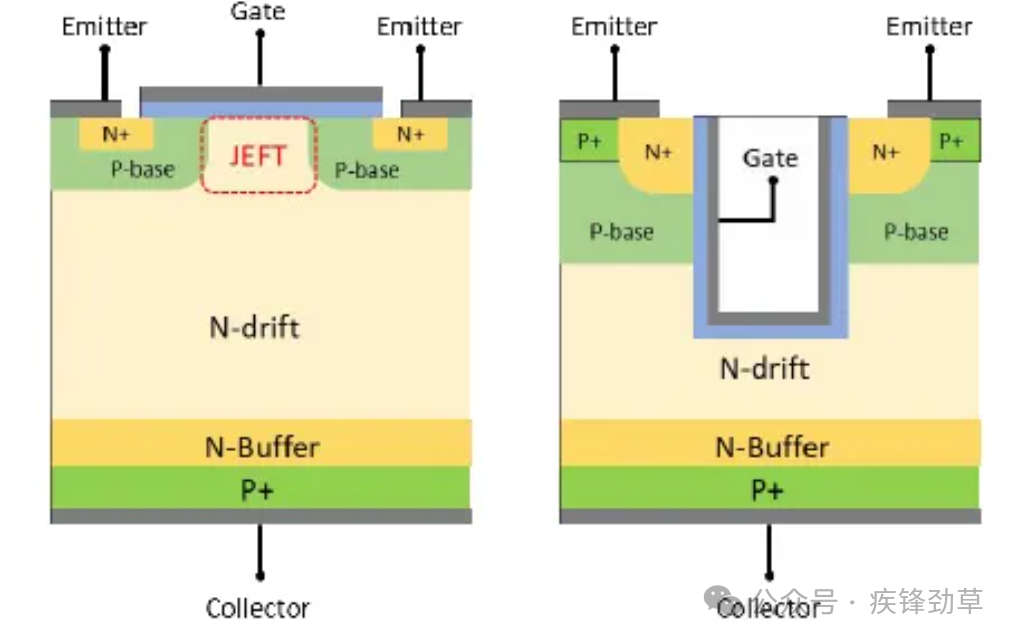
各種功率器件的應用場景
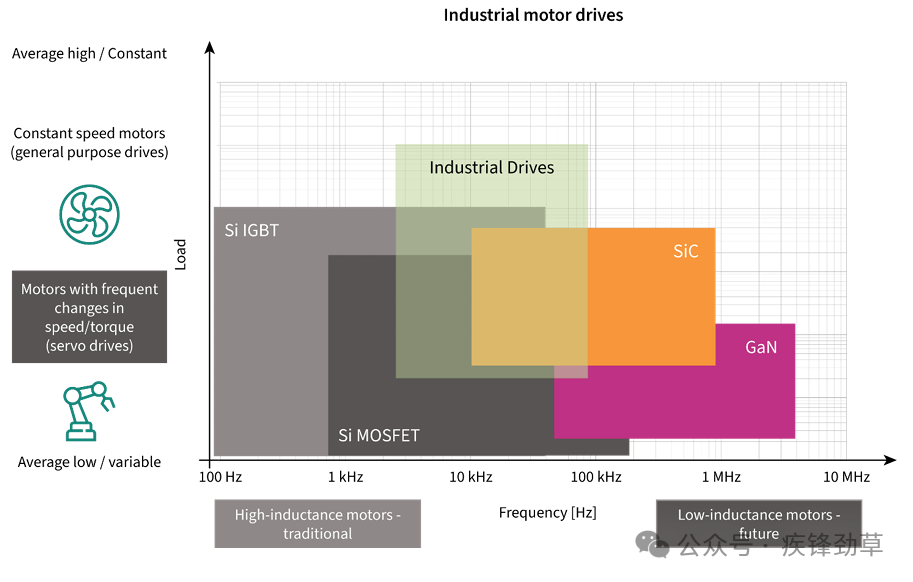
8、IMS:insulated metal substrate
絕緣金屬基板,其制造方法是:在鋁基板表面壓合絕緣層,并在絕緣層表面壓合并刻蝕出具有特定走線形狀的銅箔,在銅箔上貼裝控制IC、功率元件和引腳并綁定金屬線,然后一體模制成型。
9、DCB:direct copper bonded
銅直接粘合,其制造方法是:在陶瓷基板兩面壓合銅箔,其中一面形成特定形狀,并在該面裝配具有特定走線形狀的銅框架,再在銅框架上貼裝控制IC、功率元件,然后一體模制成型。
10、FR4:a glass fiber fabric, pre-impregnated with partially cured resin, known as FR4 in PCB industry
常常提到的FR-4是對一類玻璃纖維增強環氧樹脂材料的簡稱。但嚴格來講FR-4不是一種材料名稱,而是材料的防火等級。
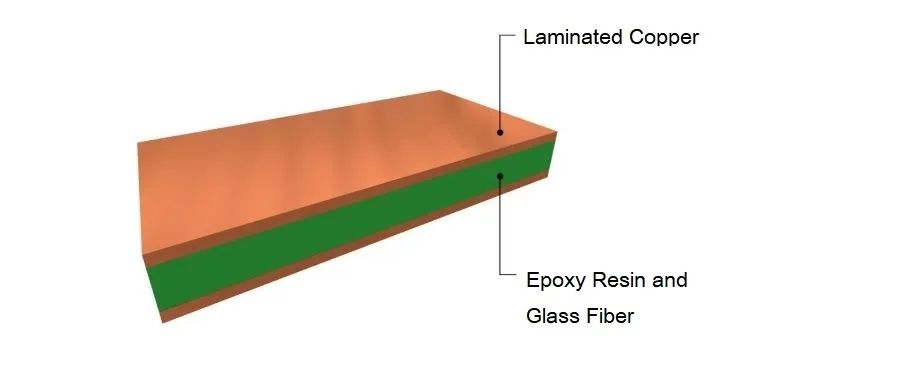
FR-4的規格標準是由NEMA(美國電器制造商協會)制定,NEMA分類標準中的FR表示Flame-Retardant (阻燃的) 。FR-4表示樹脂為環氧樹脂,增強材料為玻璃纖維布,阻燃等級為UL94 V-0的板材。
目前電路板所用的FR-4等級材料的種類非常多,但多數都是以四功能(Tera-Function)的環氧樹脂加上填充劑(Filler)以及玻璃纖維所做出的復合材料。
PCB的基材不同,阻燃等級也不相同,劃分如下:
基板種類等級材料是否阻燃
紙基板XPC酚醛樹脂
纖維紙否
UL94 HB
XXPC改性酚醛樹脂
纖維紙否
UL94 HB
FR-1阻燃酚醛樹脂
纖維紙是
UL94 V-1
FR-2阻燃酚醛樹脂
纖維紙是
UL94 V-1
玻璃布
基板FR-4環氧樹脂
玻璃布是
UL94 V-0
FR-5環氧樹脂
玻璃布是
UL94 V-0
復合基板CEM-1環氧樹脂
纖維紙
玻璃布是
UL94 V-0
CEM-3環氧樹脂
玻璃布
玻璃氈是
UL94 V-0
FR4定義
FR-4的導熱率一般在0.3~0.4 W/m·K范圍內,熱導性能較差。
11、Tg:glass transition temperature
Tg值,指的是材料從一個相對剛性“玻璃”狀態轉變為易變形狀態的溫度點。只要沒達到熱分解溫度(Td),這種熱力學變化是可逆的,當冷卻至Tg值以下時,材料可以變回剛性狀態。當超過熱分解溫度時,FR-4會發生分解失效。
業界通常根據Tg值,把FR-4板材劃分為高、中、低三檔:
低 Tg FR-4:Tg值在135℃左右;
中 Tg FR-4:Tg值在150℃左右;
高 Tg FR-4:Tg值在170℃左右。
如果PCB加工時壓合次數多、PCB層數多、焊接溫度高(≥230℃)、工作溫度高(超過100℃)、焊接熱應力大(如波峰焊接),時應選擇高Tg板材。
12、CTI:Comparative Tracking Index
相對漏電起痕指數,用來度量絕緣材料的電擊穿(電痕破壞)性能。漏電起痕發生在絕緣材料表面,由于介質損耗的存在,電介質發熱升溫,引起電介質分解碳化,最終延伸至電極導致短路。
CTI是絕緣材料表面能經受住50滴電解液(0.1%氯化銨水溶液)而沒有形成漏電痕跡的最高電壓值,單位為V。換句話說,CTI是絕緣塑料在通電情況下,其表面滴加50滴導電液體而沒有產生碳化短路的最高電壓值。
材料的CTI值與其絕緣性能正相關。高CTI值意味著要求的爬電距離更低,兩個導體間的距離會更近。
漏電起痕指數 (V)性能等級類別(PLC)
CTI≥600 0
400≤CTI《6001
250≤CTI《4002
175≤CTI《2503
100≤CTI《175 4
CTI《100 5
13、CAF:Conductive Anodic Filamentation)
導電性陽極絲,指的是PCB內部銅離子從陽極(高電壓)沿著玻纖絲間的微裂通道,向陰極(低電壓)遷移過程中發生的銅與銅鹽的漏電行為。
如下圖片,對兩個相鄰的兩個過孔進行縱向研磨,置于電子顯微鏡下放大100倍,板材呈黯淡顏色,亮金色部分則為銅,可以看到在兩個過孔間,有銅點、銅絲存在。
14、Young′s modulus
楊氏模量就是彈性模量,這是材料力學里的一個概念。彈性模量是指材料在彈性變形范圍內(即在比例極限內),作用于材料上的縱向應力與縱向應變的比例常數。也常指材料所受應力如拉伸,壓縮,彎曲,扭曲,剪切等)與材料產生的相應應變之比。
彈性模量是表征晶體中原子間結合力強弱的物理量,故是組織結構不敏感參數。在工程上,彈性模量則是材料剛度的度量,是物體變形難易程度的表征。
15、IPM:intelligent power module
智能功率模塊,不僅把功率開關器件和驅動電路集成在一起。而且還內部集成有過電壓,過電流和過熱等故障檢測電路,并可將檢測信號送到CPU。它由高速低功耗的管芯和優化的門極驅動電路以及快速保護電路構成。即使發生負載事故或使用不當,也可以保證IPM自身不受損壞。IPM一般使用IGBT作為功率開關元件,內部集成電流傳感器及驅動電路的集成結構。IPM以其高可靠性,使用方便贏得越來越大的市場,尤其適合于驅動電機的變頻器和各種逆變電源,是變頻調速,冶金機械,電力牽引,伺服驅動,變頻家電的一種非常理想的電力電子器件
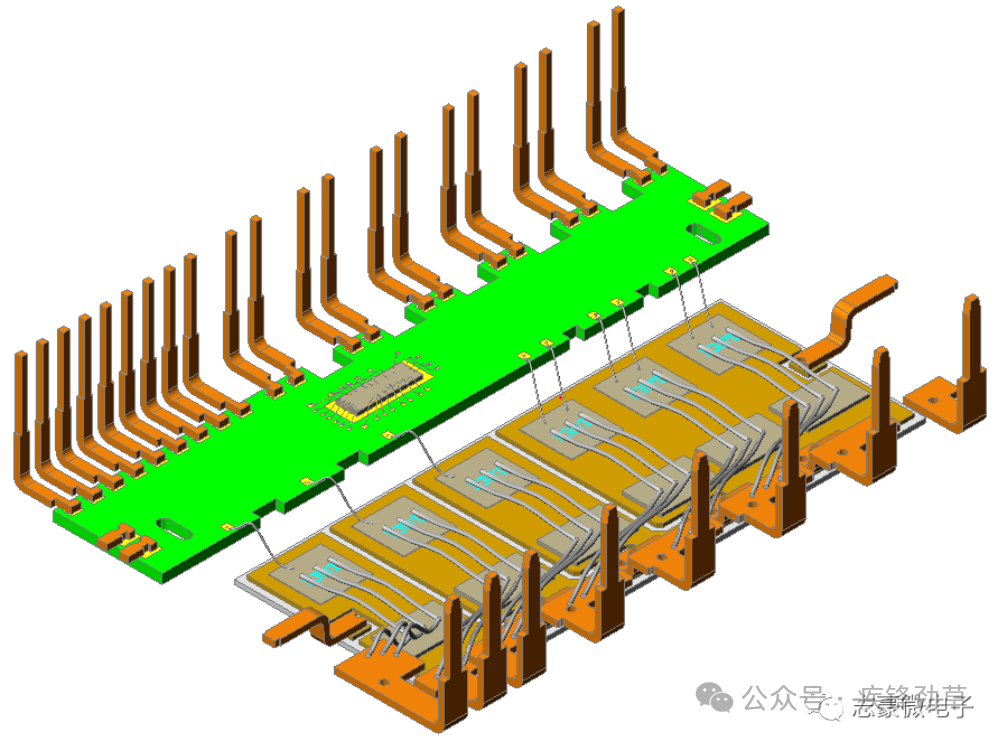
16、coefficient of thermal expansion (CTE)
熱膨脹系數,英文簡稱CTE,是指物質在熱脹冷縮效應作用之下,幾何特性隨著溫度的變化而發生變化的規律性系數。熱膨脹系數有三個指標,線膨脹系數(α),面膨脹系數(β),和體膨脹系數(γ)。實際應用中,α最常用,γ次之,β較少使用。
計算公式:α=ΔL/(L*ΔT)
如下是半導體器件常用材料的熱膨脹系數
材料熱膨脹系數(10^-6/°C)
硅(Si)2.6
鎵砷化物(GaAs)5.9
氮化硅(Si3N4)2.4~3.2
碳化硅(SiC)4.0~4.4
氮化鎵(GaN)5.59(a軸),6.57(c軸)
- 氧化鋁陶瓷7~9
- 氮化硅陶瓷3.2~4.5
FR-46~14
銅(Cu)16~17
銀(Ag)18.9~19
環氧樹脂10~70
17、PVD:physical vapor deposition
物理氣相沉積(Physical vapor deposition,PVD)是一種在真空條件下采用物理方法,將固體或液體材料表面氣化成氣態原子、分子或部分電離成離子,并通過低壓氣體(或等離子體)過程,在基體表面沉積具有某種特殊功能薄膜的技術。
物理氣相沉積技術基本原理可分三個工藝步驟:(1)鍍料的氣化:即使鍍料蒸發,升華或被濺射,也就是通過鍍料的氣化源;(2)鍍料原子、分子或離子的遷移:由氣化源供出原子、分子或離子經過碰撞后,產生多種反應;(3)鍍料原子、分子或離子在基體上沉積。
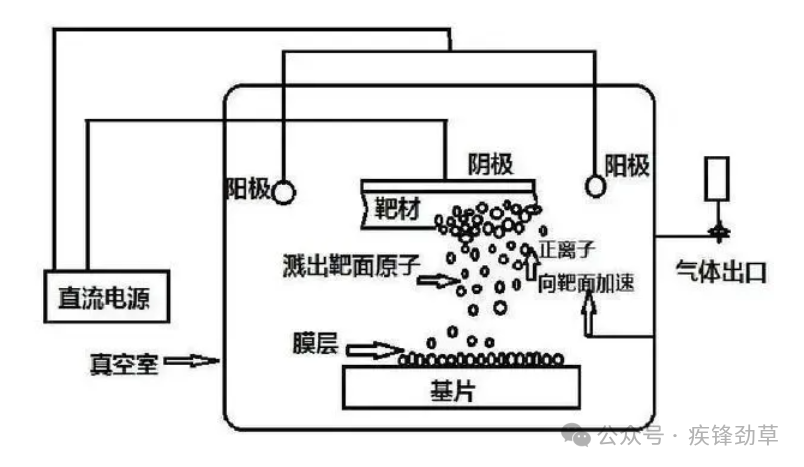
18、PDEV:partial discharge extinction voltage
局部放電是由于在絕緣材料層或屏蔽表面界面上的空隙的空氣分解。這個放電導致聚合物最終退化和擊穿。這一過程涉及的電子和離子的撞擊是電纜中絕緣擊穿的主要原因。空隙存在可能是由于雜質導致的界面接觸不好,老化引發的退化也許與制造過程相關。該部分包括聚合物絕緣電性能基本原理。在這里指出局部放電方面沒有直接關系的絕緣材料現象,但在本章中不包括:這些包括沿著導體和屏蔽傳輸的高頻信號,周圍區域輻射的電磁波,以及發射的光波和聲波。應該查閱參考文獻來研究放電類型或脈沖幅值的重要性。
?1.空隙里發生了什么
擠出電纜絕緣里可能會存在小的空隙,由于老化引起的改變導致它們的發展。符合工業規范要求的擠出電纜中不應存在超過一定尺寸的空隙。在新制作電纜上進行局部放電測試能防止帶有一定尺寸(和數量)空隙的電纜到達用戶的手上。
必須知道空氣(在空隙里)的介電強度。絕緣的介電強度越大,在放電條件下的電阻就越大。因此,當(聚乙烯或XLPE)絕緣薄膜的介電強度本身很高時 (也許高達16000V/mil),而空氣的介電強度則低2~3個數量級,這是最容易受加速電子老化的。
對已發生的放電,空隙的尺寸(直徑)、形狀、壓強和溫度都有顯著影響。當遭遇帶電的電子時不同的絕緣材料會有不同的響應,但是空氣的基本老化響應是不變的。
空氣的老化過程會導致形成額外的電子和離子,如圖6-11所示。
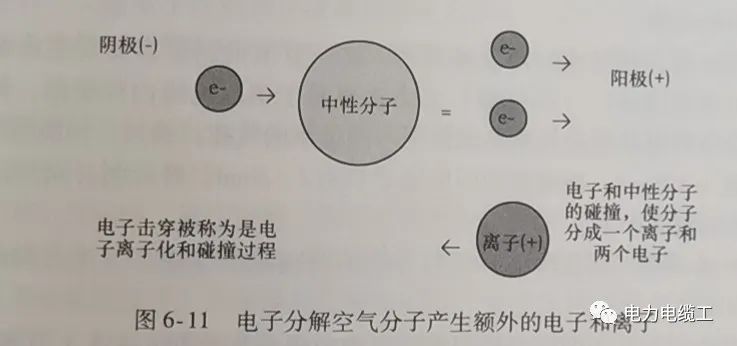
約含有80%氮氣的空氣的降解可能會導致形成離子和其他有氮的(例如氮氧化物)降解產生物一旦產生新形成的離子和電子,它們會繼續這個過程;攻擊空隙中剩余的空氣,如圖6-12所示。

在某一時刻,臨界值一過就會發生擊穿;這個擊穿被稱為是局部放電起始電壓 (PDIV)。在擊穿之后,穿過空隙的電壓立即降為0 (或接近 0)。這就是局部放電熄滅電壓(PDEV)。如要繼續放電過程和發生額外的擊穿, 電壓必須再次建立起來。空隙中空氣的降解就是重復這一過程,是非常有害的。因 此,放電導致空隙的擊穿,引起空氣降解。
2.局部放電過程
在雪崩過程發生時,絕緣層的固/氣界面會受到大量電子轟擊。這會導致絕緣分子鏈斷裂并產生解離副產物,如一氧化碳、二氧化碳、甲烷以及其他低分子量碳氫化合物,同時也會生成無機碳酸鹽。這些生成物會與氣體解離產物混雜在一起。解離出來的電子、離子以及其他產物將沉積在絕緣表面(這將大大增強絕緣表面的極性)。電子可能被束縛在表面上一段時間,然后再釋放出來。如果這一過程持續發生,解離過程將會導致從絕緣/氣孔界面向絕緣內部發展,而不僅限于初始放電的氣孔。部分本來完好的聚合物絕緣將被解離后的聚合物取代。解離產生的高氧化性炭黑會破壞聚合物的連續性,形成電樹。在電樹發展的路徑里,充斥著放電產生的各種氣體。如果局部放電一直存在,電樹最終會延展到絕緣表面形成放電通道,導致材料的擊穿。
19、IPC-TM-650
IPC-TM-650是國際電子工業聯接協會(IPC,Association Connecting Electronics Industries)制定的一套標準試驗方法手冊,主要用于測試印刷電路板及其相關產品的性能和可靠性。全稱為《印刷電路板(PCB)和模塊的測試方法》。
IPC-TM-650手冊涵蓋了大量的試驗方法,包括物理性能測試、電氣性能測試、可靠性測試等多個方面,用于評估和測試電子產品的各種性能和可靠性指標。具體包括:
焊接試驗:IPC-TM-650包括了多種焊接試驗方法,用于評估焊接接頭的質量和可靠性。其中包括焊接性能評估、焊接強度測試和焊接可靠性測試等試驗方法。
環境試驗:提供了多種環境試驗方法,用于評估電子產品在不同環境條件下的性能和可靠性。包括高溫試驗、低溫試驗、濕熱試驗、鹽霧試驗、溫度循環測試和濕度測試等。
電氣性能測試:包括了多種電氣性能測試方法,用于評估電子產品的電氣性能和可靠性。包括電阻測試、電容測試、電感測試和絕緣電阻測試等方法。
可靠性試驗:提供了多種可靠性試驗方法,用于評估電子產品在長時間使用過程中的可靠性和穩定性。包括熱沖擊試驗、振動試驗(如正弦振動試驗)、冷卻試驗和封裝試驗等方法。
材料測試:包括了多種材料測試方法,用于評估電子產品中使用的材料的性能和可靠性。包括焊料測試、膠粘劑測試和材料耐久性測試等方法。
此外,對于金相切片而言,IPC-TM-650標準下的測試非常關鍵,可幫助分析和評估印刷電路板(PCB)內部結構的完整性和質量,包括內層連接質量的檢查、材料分析以及損壞評估等。
-
pcb
+關注
關注
4357文章
23438瀏覽量
407198 -
SiP
+關注
關注
5文章
523瀏覽量
106190 -
qfn
+關注
關注
3文章
208瀏覽量
56917 -
GaN
+關注
關注
19文章
2184瀏覽量
76269
原文標題:嵌入PCB綜述:術語拓展
文章出處:【微信號:深圳市賽姆烯金科技有限公司,微信公眾號:深圳市賽姆烯金科技有限公司】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄





 嵌入PCB術語拓展
嵌入PCB術語拓展











評論