垂直和橫向氮化鎵(GaN)器件的集成可以成為功率電子學領域的一次革命性進展。這種集成能夠使驅動和控制橫向GaN器件與垂直功率器件緊密相鄰。在本文中,我們將總結一種解決橫向和垂直器件隔離問題的方法。這項技術為橫向和垂直GaN(vGaN)器件的單片集成提供了一種簡單且可靠的潛在方法。
垂直GaN器件
橫向GaN HEMT器件已廣泛應用于許多領域,包括電源適配器和數據中心電源。其寬帶隙、高通道遷移率、高飽和速度以及低寄生電容,使得該器件在導通和開關性能方面相較傳統硅器件具有顯著優勢。目前,多家公司正在利用6英寸和8英寸Si(111)襯底大規模生產橫向GaN功率器件。市面上常見商用HEMT器件的最大額定電壓為650V或以下,但一些制造商已經開始生產900V額定電壓的器件。
相比橫向器件,垂直功率器件具有內在優勢,并且在硅和碳化硅(SiC)器件中占主導地位。對于GaN來說,使用垂直功率器件的好處包括以下幾點:
1.更高的抗陷阱退化能力
在橫向器件中,通道是通過極化誘導的二維電子氣形成的。此類通道容易受到陷阱相關退化的影響,從而導致導通態電阻(RDS(on))動態增加,甚至可能引發電流崩潰。盡管大多數制造商已經理解并解決了這一問題,但仍會對器件的操作條件產生一定限制。而垂直器件則對基于電荷陷阱的退化更具免疫力。
2.更高的電壓額定值
垂直器件的最大電壓額定值主要通過增加漂移層的厚度來提高。在橫向器件中,由于漂移區是橫向的,增大器件尺寸會導致電壓額定值的提升難以實現。而對于垂直器件,即使芯片尺寸增加很少,也可以實現更高的電壓額定值。例如,超過900V額定值的HEMT器件制造難度較高,而垂直器件可以更輕松地實現這一目標。
3.更高的閾值電壓(Vth)
橫向HEMT本質上是耗盡型器件。通過在柵極添加p-GaN層,可以形成增強型器件,但其閾值電壓通常低于2V。這會對驅動電路、封裝及過電壓約束提出更高要求,以避免誤導通。盡管一些制造商通過兩芯片級聯的方式解決了這一問題,但多家研究團隊已展示出基于垂直MOS架構的GaN器件,其閾值電壓通常高于3V,更適合功率器件的應用。
4.雪崩擊穿能力
垂直器件在漏-源結超過擊穿電壓時通常會發生雪崩擊穿。這種可逆機制允許器件承受由系統故障(如負載中的線圈短路)引起的浪涌和瞬態電流。垂直器件中的能量耗散均勻地分布在漂移區,而橫向HEMT器件缺乏雪崩能力。此外,橫向器件的表面可能會形成更高的電場,從而需要場板來改善擊穿性能。
5.更高的功率密度和更好熱穩定性
垂直器件由于其體積導通特性,更容易設計用于高功率密度的應用。同時,使用同質外延的垂直器件不會像橫向GaN-on-Si器件那樣受到晶格失配和熱膨脹差異的限制。
盡管如此,vGaN器件的大規模生產仍面臨許多挑戰,例如缺陷問題、晶圓翹曲以及緩慢的外延生長速度。目前,多數GaN襯底的尺寸仍限制在4英寸或以下,相關研發多集中在2英寸襯底上。一些工程化襯底(如Qromis的QST)顯示出潛在的解決路徑。此外,低摻雜n型漂移區和p型摻雜區的制造難題也需要進一步解決。
垂直和橫向GaN器件的隔離問題
在垂直器件中,襯底通常形成器件的漏極端子。施加高電壓時,會對表面層產生耗盡效應,從而影響橫向HEMT器件。實際上,襯底端子會起到背柵的作用,調節器件的閾值電壓(Vth)和導通電阻(RDS(on))。最近,Zaidan等人提出了一種通過n+摻雜GaN層有效隔離表面HEMT器件的方法,避免其受到vGaN器件襯底漏極電位的影響。該方法的截面示意圖如圖1所示。
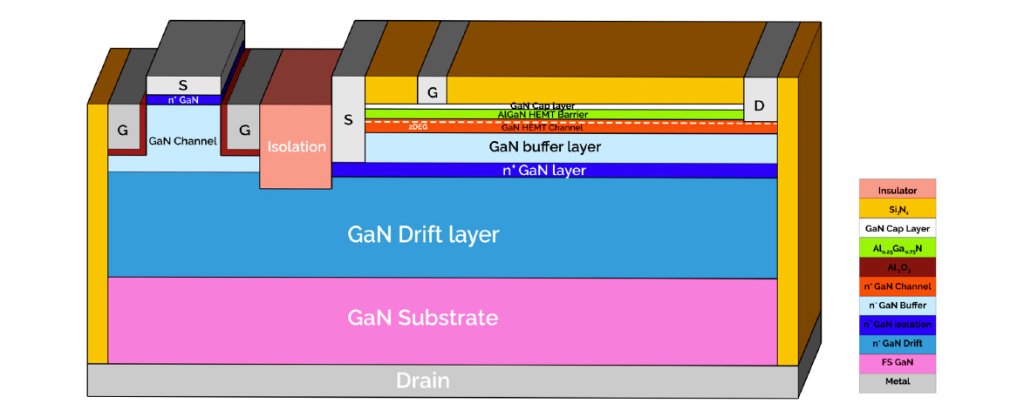 圖1
圖1所示的vGaN器件是一種垂直FinFET,與Zhang等人展示的器件類似。研究團隊曾展示出一種具有200nm鰭寬、1.2kV擊穿電壓和0.8V閾值電壓的器件。在本例中,集成的HEMT器件可作為垂直功率器件的柵極驅動器。HEMT器件的制造過程包括對vGaN漂移層的刻蝕,以及在刻蝕區域內選擇性外延HEMT層,包括底部的n+摻雜GaN隔離層、500nm厚的緩沖層、50nm GaN通道、20nm AlGaN勢壘層和2nm GaN保護層。研究人員使用TCAD-Sentaurus對這種結構進行了模擬,并通過已制造HEMT器件的實測數據校準了模擬結果。
圖2顯示了在無隔離情況下,襯底背偏電壓從-50V變化到100V時,HEMT輸出特性的模擬結果。正如預期,隨著正背偏電壓的增加,背柵效應增強了通道反轉和電子濃度,顯著降低了RDS(on)。
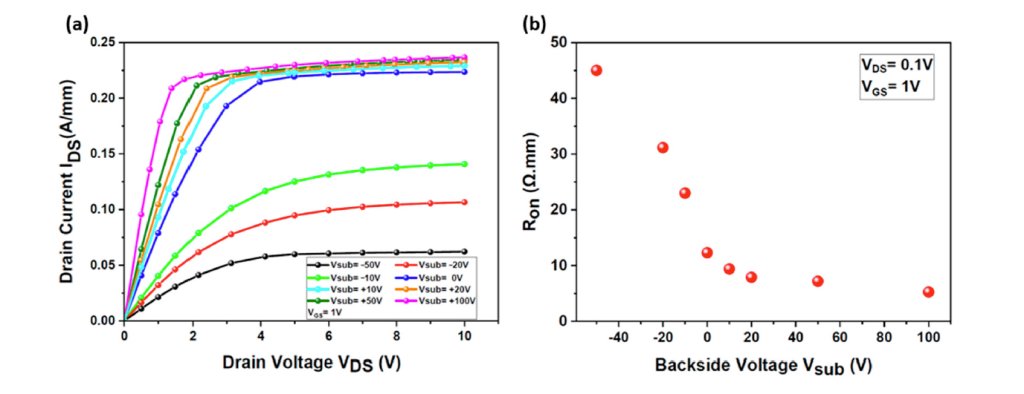 圖2
圖2器件的閾值電壓隨著襯底電壓從0V變化到100V,從-1.7V下降到-2.95V,而在-50V時則移動到-0.2V。這種閾值電壓的變化會導致柵極驅動電路的嚴重不穩定。
圖3詳細展示了提出的垂直隔離方法。通過調整n+ GaN層的摻雜密度和厚度進行模擬。
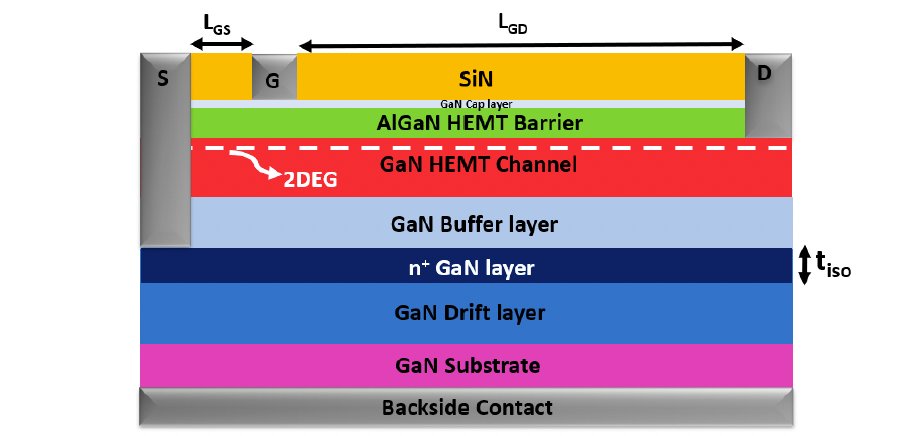 圖3
圖3n+隔離層連接到HEMT的源極端子,并充當場屏蔽層。TCAD實驗表明,n+ GaN層的最小厚度需達到10nm,且摻雜濃度需要高于1×10^18/cm3才能實現有效隔離。在這些最優條件下,即使施加100V背偏電壓,HEMT的閾值電壓也保持不變。圖4展示了在10nm、1×10^19/cm3隔離層條件下,HEMT的輸出特性。可以看出,帶隔離層且施加100V偏置的曲線與無偏置情況下的曲線完全重疊。
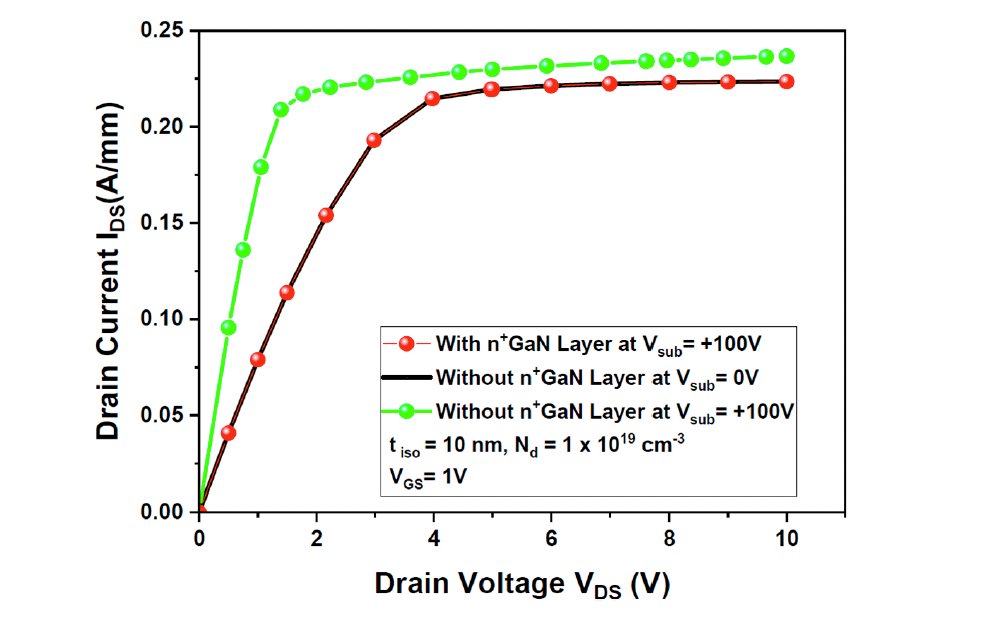 圖4
圖4這種簡單且高效的方法可以用于垂直和橫向GaN器件的單片集成,并進一步推動GaN集成功率芯片技術的發展。
浮思特科技深耕功率器件領域,為客戶提供IGBT、IPM模塊等功率器件以及單片機(MCU)、觸摸芯片,是一家擁有核心技術的電子元器件供應商和解決方案商。
-
MOS
+關注
關注
32文章
1346瀏覽量
96340 -
功率器件
+關注
關注
42文章
1919瀏覽量
92270 -
GaN
+關注
關注
19文章
2184瀏覽量
76267
發布評論請先 登錄
垂直GaN 器件:電力電子的下一個層次

浙大首次報道垂直GaN功率整流器
GaN組件的單片集成提升了功率集成電路?
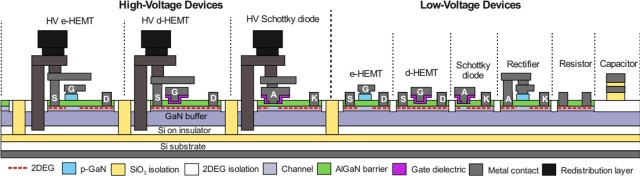
集成汽車 GaN 功率器件
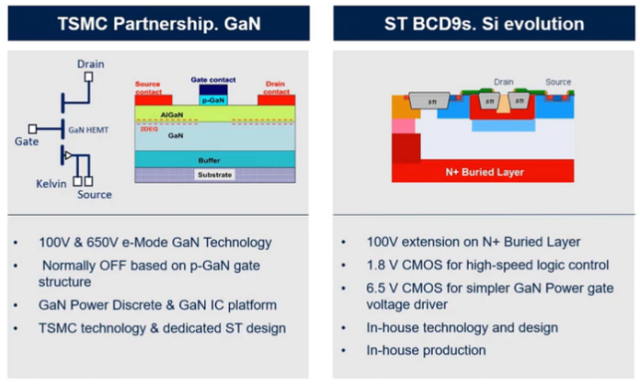
低成本垂直GaN(氮化鎵)功率器件的優勢
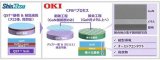





 垂直與橫向GaN功率器件單片集成的高效隔離技術
垂直與橫向GaN功率器件單片集成的高效隔離技術
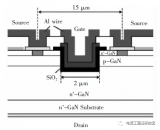

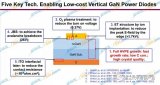
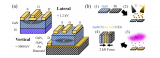










評論