為了應(yīng)用在光纖通訊上有效提升訊號(hào)傳輸距離,對于發(fā)光波長1310nm與1550nm的面射型雷射需求也相當(dāng)迫切,傳統(tǒng)半導(dǎo)體雷射二極體在長波長紅外光雷射大多采用磷化銦系列材料,但是磷化銦系列材料成長雷射二極體結(jié)構(gòu)時(shí)經(jīng)常遭遇到特性溫度較低的問題,往往需要額外的主動(dòng)散熱裝置來協(xié)助雷射二極體維持在恒溫狀態(tài)避免操作特性劣化,主要原因在于磷化銦/磷砷化銦鎵系列材料所形成的異質(zhì)接面結(jié)構(gòu)中導(dǎo)帶能障差異較小(△Ec=0.4Eg),與砷化鎵系列材料(△Ec=0.7Eg) 相較之下低不少,因此注入電子經(jīng)常因?yàn)樵用鏈囟壬仙@得額外動(dòng)能因此溢流到活性層外,這個(gè)載子溢流(carrieroverflow)現(xiàn)象讓元件量子效率變差,注入的載子還沒機(jī)會(huì)在活性區(qū)復(fù)合形成光子就流失掉,原本獲得的能量以熱的形式逸散,又進(jìn)一步提高接面溫度,導(dǎo)致惡性循環(huán)讓雷射操作特性變差,此外活性層中常見的歐杰復(fù)合(Auger recombination)也會(huì)讓元件發(fā)光效率低落,如圖6-2所示。
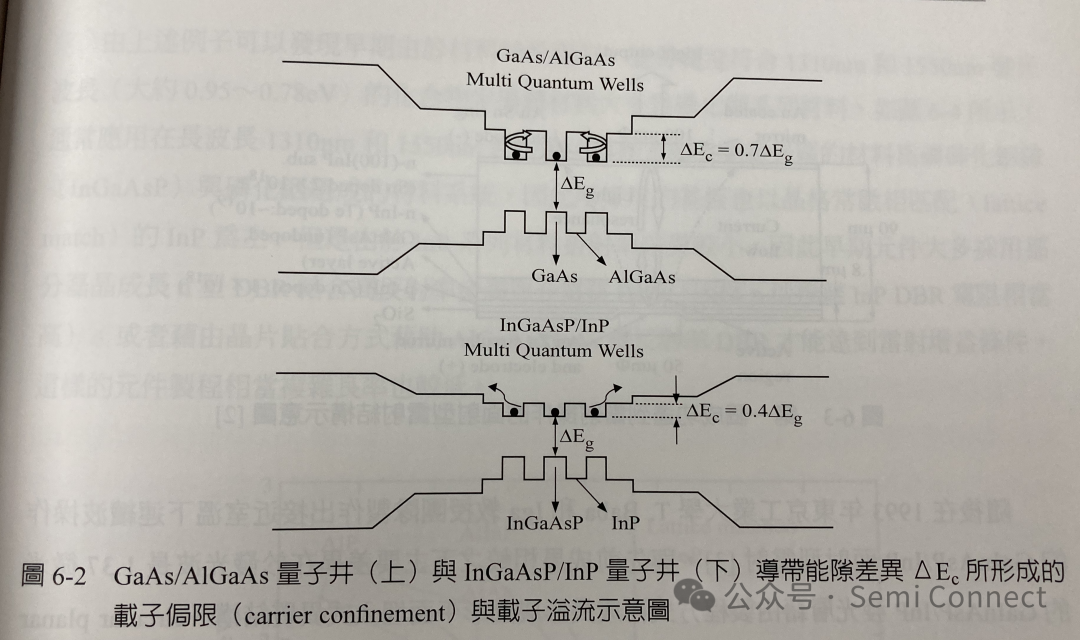
除了載子局限能力較差之外,磷化銦系列材料折射率差異也不顯著,如第三章表3-1所示,要獲得足夠雷射增益所需的DBR層數(shù)高達(dá)50對以上,不但會(huì)造成較高串聯(lián)電阻與所需的磊晶成長時(shí)間,這么多對摻雜的DBR也會(huì)造成顯著的雜質(zhì)吸收效應(yīng),讓元件達(dá)到雷射增益的條件更加嚴(yán)苛;此外與矽基板或砷化鎵基板相較之下,磷化銦基板較昂貴,而且機(jī)械特性較差,在磊晶或制程中容易因?yàn)槭軣崧N曲或破裂,因此制程良率較低,成本也相對昂貴。
如同第一章所述由Iga教授團(tuán)隊(duì)最早成功制作出來的面射型雷射元件采用n-InP/undoped GaInAsP/p-InP(n型磷化銦/未摻雜磷砷化銦鎵活性層/p型磷化銦)雙異質(zhì)接面結(jié)構(gòu)所組成,發(fā)光波長在1.2微米范圍(λ=1.18μm)。由于載子局限效果較差且上下反射鏡反射率較低,因此元件必須固定在鍍金銅座上加強(qiáng)散熱效果,即使如此也只能在液態(tài)氮冷卻下在77K以脈沖操作,閾值電流值為900mA,以基板側(cè)陰極直徑100μm計(jì)算,雷射操作閾值電流密度為11kA/cm2,成功驗(yàn)證面射型雷射的可行性是其最重大的貢獻(xiàn),該實(shí)驗(yàn)采用液相磊晶LPE法成長的結(jié)構(gòu)與元件示意圖如下圖6-3所示。
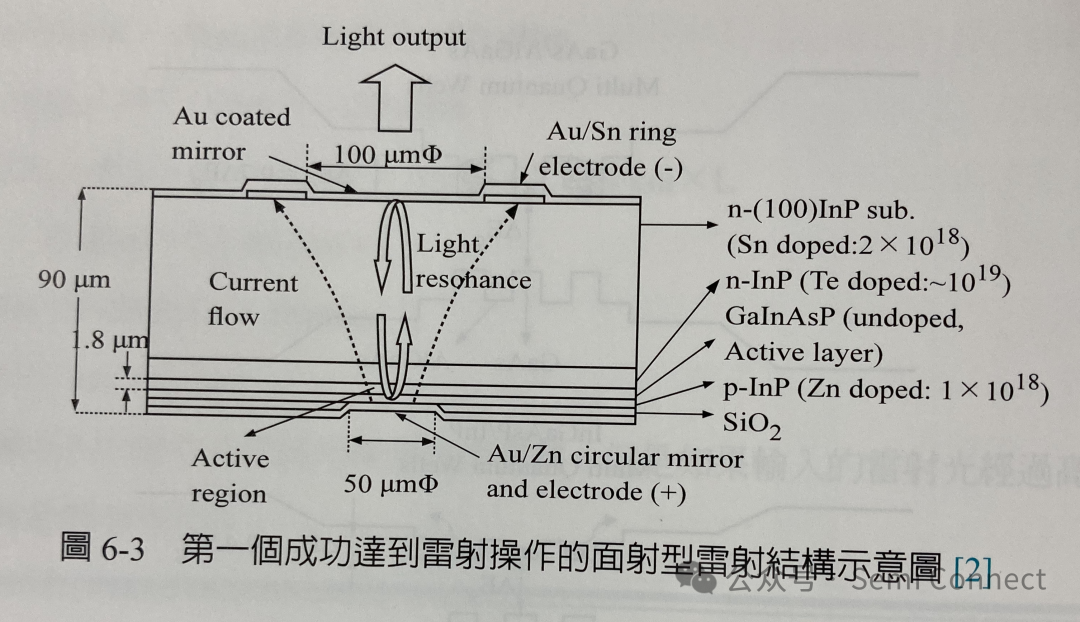
隨后在1993年東京工業(yè)大學(xué)T.Baba和Iga教授團(tuán)隊(duì)制作出接近室溫下連續(xù)波操作的GaInAsP/InP面射型雷射,與先前成果相較之下主要差異在于發(fā)光波長1.37微米的GaInAsP/InP發(fā)光層借由制程方式再成長形成圓形平面埋入式異質(zhì)結(jié)構(gòu)(circular planarburied heterostructure, CPBH),p側(cè)鏡面由8.5對MgO/Si DBR與Au/Ni/Au所組成,n側(cè)鏡面則由6對SiO2/Si介電質(zhì)DBR構(gòu)成。元件p側(cè)采用鎵焊料(Ga solder)貼合到鍍金的鉆石導(dǎo)熱板,借助于MgO/Si較高的熱傳導(dǎo)系數(shù)以及散熱片來移除元件電激發(fā)光操作過程中產(chǎn)生的熱,使元件可以在接近室溫環(huán)境下連續(xù)波操作。在77K溫度下元件可以連續(xù)波操作且大多數(shù)元件閾值電流值約為10mA,最低可達(dá)0.42mA。在20°C下可以脈沖電激發(fā)光操作,閾值電流為18mA。最高可以維持連續(xù)波操作的溫度為14°C,此時(shí)閾值電流值為22mA,遠(yuǎn)場發(fā)散角為4.2°。直到在1995年加州大學(xué)圣塔芭芭拉分校胡玲院士團(tuán)隊(duì)在GaAs基板上以MBE分別成長28對n型AIAs/GaAs DBR,另外成長30對p型Al0.67Ga0.33As-GaAS DBR,再與MOVPE成長的7層應(yīng)變補(bǔ)償InGaAsP量子井發(fā)光層在630°C下通氫氣持溫20分鐘進(jìn)行第一次晶片貼合,移除InP基板后再與n型DBR進(jìn)行第二次晶片貼合。由于采用應(yīng)變補(bǔ)償InGaAsP量子井結(jié)構(gòu),與原先的雙異質(zhì)接面結(jié)構(gòu)相較之下可以稍微改善載子溢流問題,因此所制作的元件首次成功在室溫下電激發(fā)光連續(xù)波操作,最低臨界電流為2.3mA,發(fā)光波長1542nm,符合玻璃光纖最低損耗的波段,但是砷化鎵材料與磷化銦材料熱膨脹系數(shù)差異顯著,在高溫環(huán)境或長時(shí)間操作下元件壽命與可靠度可能有疑慮。
由上述例子可以發(fā)現(xiàn)早期由于材料特性限制,能帶寬度符合1310nm和1550nm發(fā)光波長(大約0.95~0.78eV)的化合物半導(dǎo)體材料大多為磷化銦系列材料,如圖6-4所示,通常應(yīng)用在長波長1310nm和1550nm波段的半導(dǎo)體雷射主動(dòng)發(fā)光區(qū)的材料為磷砷化銦鎵(InGaAsP)與磷化銦組成的材料系統(tǒng),因此所采用的基板也以晶格常數(shù)相匹配(lattice match)的InP為主。但是由于InP系列材料折射率差異較小,因此早期元件大多采用部分磊晶成長n型DBR結(jié)合高反射率金屬與介電質(zhì)DBR(因?yàn)閜型摻雜InP DBR電阻相當(dāng)高);或者借由晶片貼合方式借助AIGaAs/GaAs高反射率DBR才能達(dá)到雷射增益條件,這樣的元件制程相當(dāng)復(fù)雜良率也較低。
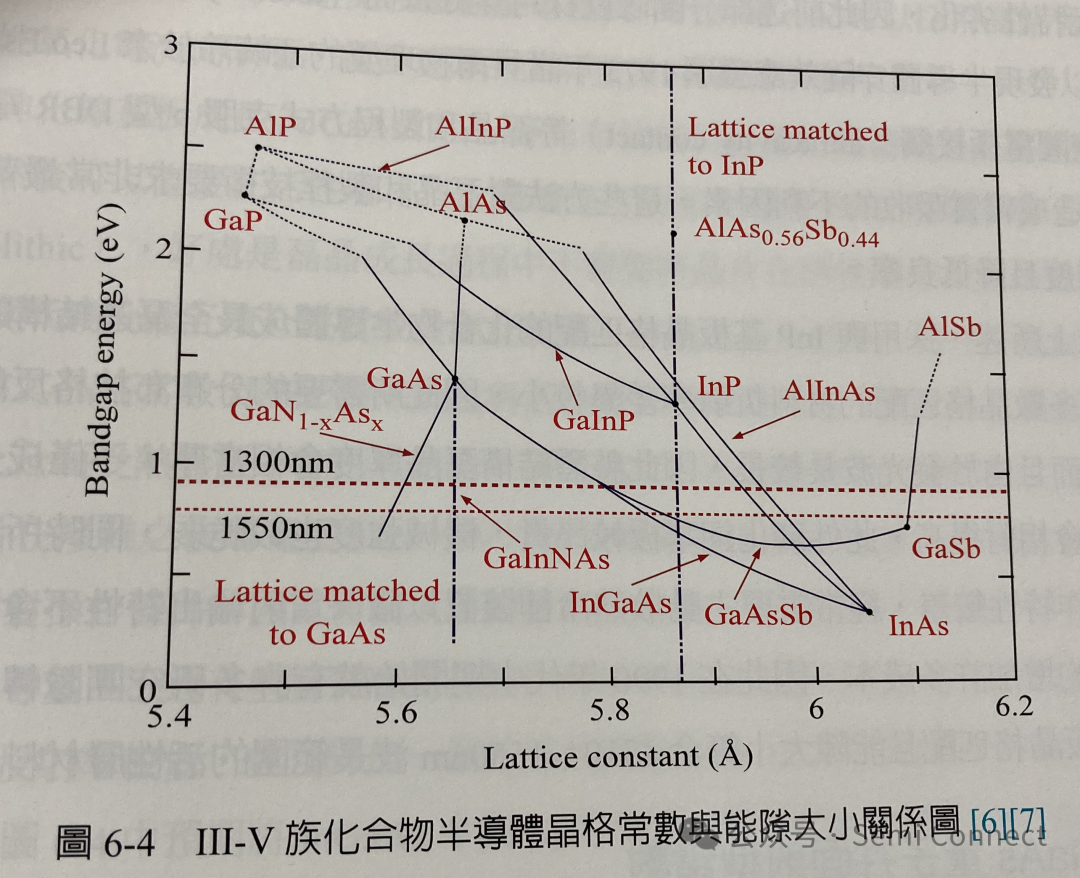
由圖6-4中可以觀察到一個(gè)大致的趨勢,通常能隙愈小的III-V族化合物半導(dǎo)體其晶格常數(shù)會(huì)愈大;相反的能隙愈大的III-V族化合物半導(dǎo)體其晶格常數(shù)愈小,比較特殊的例外是GaN1-xAsx這個(gè)材料,會(huì)在稍后另外介紹。從圖6-4中可以發(fā)現(xiàn)除了InP以外,還有一些材料組合借由調(diào)整成分元素莫耳分率后其晶格常數(shù)也有機(jī)會(huì)和InP相匹配,包括AlInAs、GaAsSb、InGaAs、AIAsSb、AIGaAsSb其他還有較不常見且與InP基板晶格不匹配約4%的AlGaSb,當(dāng)然還有最常見的GalnAsP。因此除了InGaAsP/InP以外,AlInGaAs/InP和AlInGaAs/AlInAs也被用來作為InP基板成長長波長面射型雷射的發(fā)光層增益材料,其中InP基板成長InGaAIAs/IAIAs全磊晶DBR夾著中央3/2λ的InGaAlAs活性層面射型雷射可以在55°C溫度下還能脈沖操作,并在2006年時(shí)由韓國電子通信研究院團(tuán)隊(duì)獲得連續(xù)波操作溫度達(dá)80°C的成果,不過采用這個(gè)材料系統(tǒng)雖然可以改善導(dǎo)帶能隙差異所造成的載子溢流問題,但是同樣的要成長高對數(shù)的DBR仍然會(huì)造成元件串聯(lián)電阻太高,特別是p-型DBR由于價(jià)帶能帶差異較大注入電洞需要更高能量才能順利克服這么多對的異質(zhì)接面所形成的能障,因此InP基板成長的全磊晶結(jié)構(gòu)普遍遭遇p-型DBR電阻過大問題,導(dǎo)致注入電流造成元件溫度上升更進(jìn)一步造成發(fā)光特性劣化,因此前述部分團(tuán)隊(duì)就采用穿隧接面(tunnel junction,又稱為Esakijunction,以發(fā)現(xiàn)半導(dǎo)體穿隧效應(yīng)獲頒1973年諾貝爾物理獎(jiǎng)的江崎玲于奈Leo Esaki命名)以及共振腔間電極接觸 (intracavity contact) 等磊晶和制程方式克服p型DBR電阻過高或摻雜DBR造成雜質(zhì)吸收的不利因素,這些方法對磊晶和制程技術(shù)要求非常嚴(yán)苛,因而提高制程復(fù)雜度且降低良率。
綜合以上所述,采用與InP基板晶格匹配的化合物半導(dǎo)體成長全磊晶結(jié)構(gòu)的面射型雷射,由于大多數(shù)晶格匹配的材料折射率差異較小,因此所需要的分布布拉格反射器對數(shù)也會(huì)非常多,而且由于發(fā)光波長較長,因此整體結(jié)構(gòu)磊晶厚度會(huì)相當(dāng)厚,不僅成長耗時(shí)而且材料成本也會(huì)相對提高,此外磷化銦基板較昂貴,機(jī)械強(qiáng)度也較脆弱,同時(shí)所制作的雷射元件高溫操作特性較差,經(jīng)常需要主動(dòng)散熱冷卻裝置以確保雷射輸出特性不會(huì)劣化,所以也無可避免的增加許多成本,因此在1990年代中期開始就有許多研究團(tuán)隊(duì)轉(zhuǎn)而尋求其他與砷化鎵基板晶格匹配且能隙大小符合1310~1550nm波長范圍的活性層材料。
-
量子
+關(guān)注
關(guān)注
0文章
489瀏覽量
25779 -
雷射
+關(guān)注
關(guān)注
0文章
25瀏覽量
10314 -
光纖通訊
+關(guān)注
關(guān)注
1文章
22瀏覽量
7808
原文標(biāo)題:InP 異質(zhì)接面/ 量子井面射型雷射
文章出處:【微信號(hào):Semi Connect,微信公眾號(hào):Semi Connect】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
InAs量子點(diǎn)面發(fā)射激光器的概述
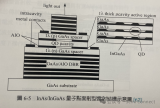
InGaAs量子井面射型雷射介紹
典型的氧化局限面射型雷射結(jié)構(gòu)
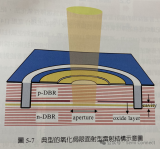
半導(dǎo)體雷射相對強(qiáng)度雜訊

半導(dǎo)體雷射之發(fā)光線寬

半導(dǎo)體雷射震蕩條件

雙異質(zhì)接面介紹

面射型雷射初期的研發(fā)進(jìn)展
雷射的發(fā)展歷史
半導(dǎo)體研究所在量子點(diǎn)異質(zhì)外延技術(shù)上取得重大突破






 InP異質(zhì)接面/量子井面射型雷射
InP異質(zhì)接面/量子井面射型雷射















評論