SiC芯片可以高溫工作,與之對應的連接材料和封裝材料都需要相應的變更。三菱電機高壓SiC模塊支持175℃工作結溫,其封裝技術相對傳統(tǒng)IGBT模塊封裝技術做了很大改進,本文帶你詳細了解內部的封裝技術。
為了實現低碳社會,能夠高效電能變換的電力電子技術正在擴展到消費、工業(yè)、電氣化鐵路、汽車、太陽能發(fā)電和風力發(fā)電等各個領域。其中,功率模塊在控制電流方面發(fā)揮著重要作用,需要減少運行過程中的損耗,減小封裝尺寸,并提高功率密度。近年來備受關注的SiC(碳化硅)與以往的Si(硅)相比具有高速開關且低損耗的特點,能夠飛躍性地提高性能,因此被期待為下一代的功率器件。此外,由于SiC能夠高溫工作,因此可以通過減小封裝尺寸來促進功率單元的小型化,但為此,需要開發(fā)能夠應對高溫工作的封裝材料和結構。
在封裝開發(fā)過程中,我們提高了鍵合材料和灌封材料等各部件的耐熱性,并開發(fā)了對應的工藝技術,特別是提高了對溫度循環(huán)壽命有影響的鍵合部位的可靠性,實現了高質量和高可靠性。通過應用這些技術,我們開發(fā)了一種支持芯片工作溫度(Tjop)175℃高溫運行的封裝。
圖1顯示了開發(fā)的高溫工作全SiC功率模塊(FMF185/375/750DC-66A)的封裝外觀,圖2顯示了主要結構(示意圖)。作為支持175℃高溫運行的封裝結構,在底板上使用耐高溫焊錫來連接耐高溫絕緣基板,在絕緣基板上使用Ag燒結技術鍵合芯片。芯片上面的電極和絕緣基板金屬層用Al線連接,與外部電氣連接的電極與絕緣基板金屬層進行US鍵合。外殼安裝在底板上,內部填充了耐高溫灌封材料。

圖1:適用于高溫工作的封裝外觀
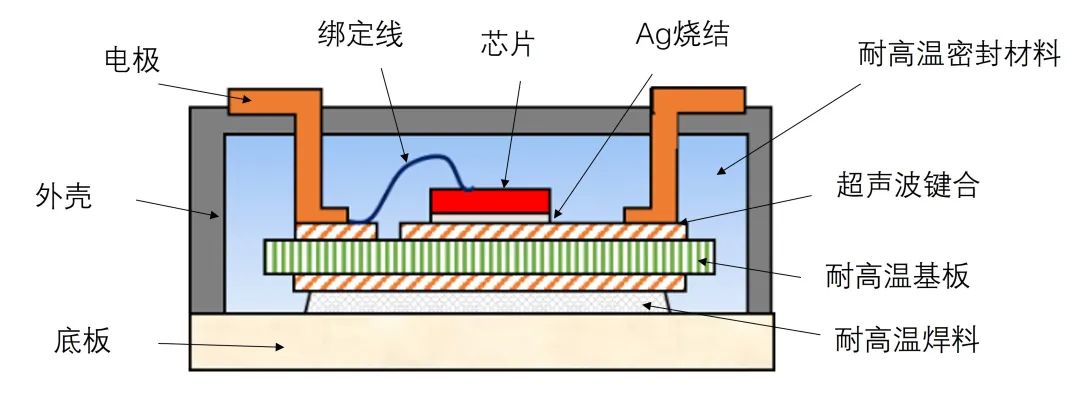
圖2:高溫運行封裝截面圖
當考慮芯片的高溫運行時,由于傳統(tǒng)焊料在芯片鍵合時的物理限制,因此需要新的鍵合材料和合適的工藝。本公司開發(fā)了使用Ag粒子燒結鍵合工藝,實現了耐高溫、高品質化。
Ag燒結連接工藝進行多個芯片的批量鍵合。因此,在高溫工作封裝中,相對于以往封裝,芯片尺寸縮小,研究了在4×3的芯片排列中高密度化統(tǒng)一鍵合。圖3顯示了通過Ag燒結進行批量鍵合后的SAT(Scanning Acoustic Tomography)圖像,圖4顯示了鍵合截面圖像。從SAT圖像和截面圖像的結果來看,鍵合處沒有空隙或龜裂等,可以確認鍵合狀態(tài)良好。因此,在高溫工作封裝中,通過Ag燒結實現了芯片的高密度化和高質量的鍵合。
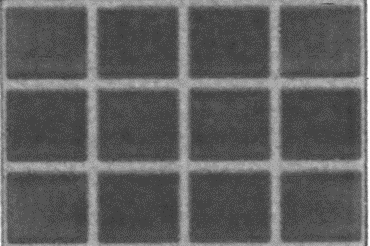
圖3:Ag燒結批量鍵合后的SAT圖像

圖4:Ag燒結后的橫截面圖像
過去一直使用AlN(氮化鋁)陶瓷的絕緣基板,此次研究了采用Si3N4(氮化硅)陶瓷的耐高溫絕緣基板作為新材料。為了評價耐高溫性能,對AlN絕緣基板和Si3N4絕緣基板實施溫度循環(huán)試驗,使溫度變化為-40~175℃(ΔT=215K),對陶瓷部分和基板金屬層的鍵合部裂紋變化進行檢測、確認。結果,如圖5所示,AlN絕緣基板的陶瓷部分出現龜裂,而Si3N4絕緣基板在600個循環(huán)后也未發(fā)生龜裂,實現了耐高溫、高可靠性。

圖5(a):溫度循環(huán)測試后的絕緣基板截面圖-AlN基板
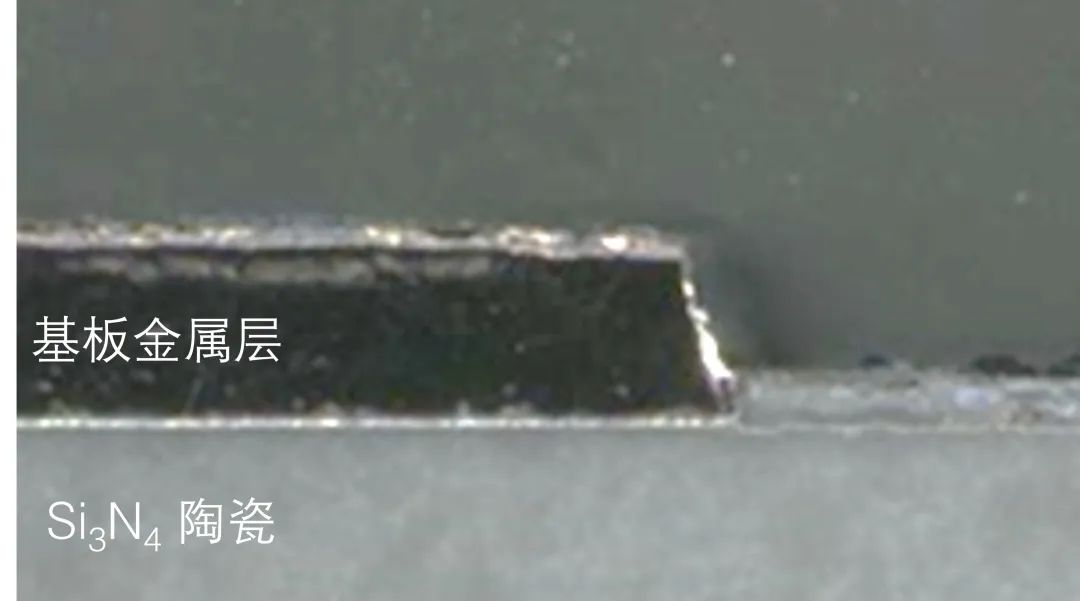
圖5(b):溫度循環(huán)測試后的絕緣基板截面圖-Si3N4基板
連接絕緣基板和底板的焊料必須保持鍵合處無裂紋,以保證對基板的散熱,防止芯片過熱。因此,我們研究選擇了耐久性、耐熱性的RoHS焊錫材料。對于耐高溫焊料,在表1所示的混合元素基礎上添加了多種元素,以提高鍵合壽命,使其符合絕緣基板和底板的機械物理性能。使用選定的焊料,將Si3N4絕緣基板和底板連接起來,并進行了溫度循環(huán)試驗,其中溫度變化為-40~175℃(ΔT=215K)。結果,即使在600次循環(huán)后,也沒有觀察到鍵合處出現裂紋,并驗證了它可以作為耐高溫焊料使用(圖6)。

表1:耐高溫焊錫材料的主要混合元素和效果
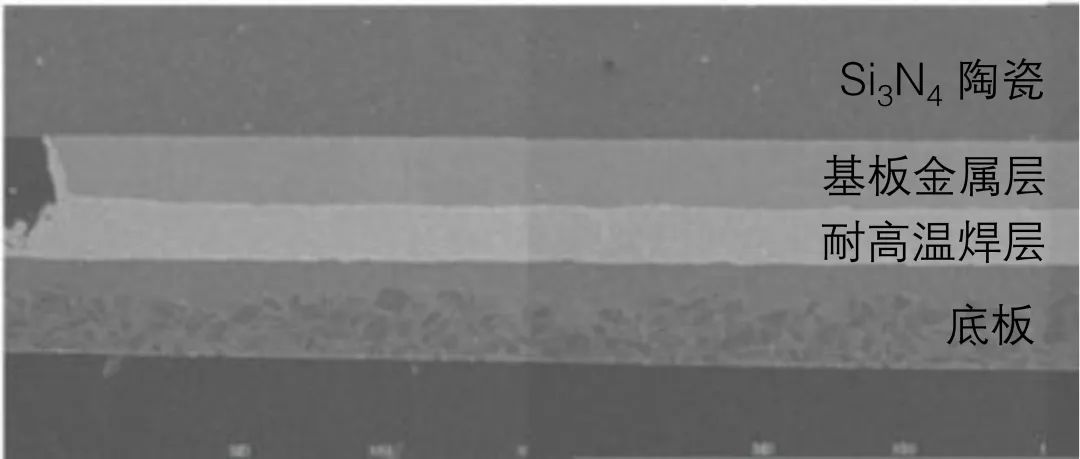
圖6:溫度循環(huán)測試后的焊接層截面圖
傳統(tǒng)用于電氣連接到外部的電極是使用焊料鍵合到絕緣基板金屬層。然而,隨著功率密度的增加,由于電極電阻成分引起的發(fā)熱和電極與基板金屬的鍵合部分溫度上升成為問題,因此需要提高高溫循環(huán)下的鍵合壽命。因此,我們利用US(超聲波)焊接技術將電極與基板金屬直接鍵合在一起,并通過去除焊料提高了鍵合強度,從而在高溫循環(huán)中提高了電極與絕緣基板的鍵合壽命。
為了實現功率模塊的更高工作溫度,我們不斷開發(fā)器件封裝技術。表2顯示了從傳統(tǒng)封裝到高溫運行封裝的技術。除了引進Ag燒結鍵合、耐高溫絕緣基板、耐高溫焊錫材料、電極US鍵合相關技術外,為支持高溫運行功率模塊的商業(yè)化,創(chuàng)新的封裝設計、材料及制造工藝的開發(fā)是至關重要的。

表2:傳統(tǒng)封裝與高溫運行封裝的區(qū)別
今后,本公司將以多年積累的功率模塊封裝技術及量產技術為基礎,加速開發(fā)新一代高溫運行且高品質的功率模塊,同時繼續(xù)推進商業(yè)化,為實現環(huán)保及節(jié)能社會做出貢獻。
正文完
<關于三菱電機>
三菱電機創(chuàng)立于1921年,是全球知名的綜合性企業(yè)。截止2024年3月31日的財年,集團營收52579億日元(約合美元348億)。作為一家技術主導型企業(yè),三菱電機擁有多項專利技術,并憑借強大的技術實力和良好的企業(yè)信譽在全球的電力設備、通信設備、工業(yè)自動化、電子元器件、家電等市場占據重要地位。尤其在電子元器件市場,三菱電機從事開發(fā)和生產半導體已有68年。其半導體產品更是在變頻家電、軌道牽引、工業(yè)與新能源、電動汽車、模擬/數字通訊以及有線/無線通訊等領域得到了廣泛的應用。
-
封裝技術
+關注
關注
12文章
578瀏覽量
68605 -
三菱電機
+關注
關注
0文章
197瀏覽量
21148 -
SiC
+關注
關注
31文章
3226瀏覽量
65285 -
碳化硅
+關注
關注
25文章
3066瀏覽量
50484
原文標題:第15講:高壓SiC模塊封裝技術
文章出處:【微信號:三菱電機半導體,微信公眾號:三菱電機半導體】歡迎添加關注!文章轉載請注明出處。
發(fā)布評論請先 登錄
三菱電機SiC DIPIPM在變頻家電中的應用(1)

三菱電機SiC DIPIPM在變頻家電中的應用(2)
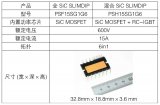
三菱電機1200V級SiC MOSFET技術解析
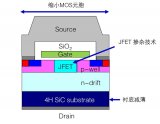
一文了解三菱電機高壓SiC芯片技術
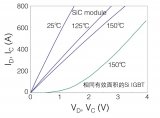
三菱電機提供SiC功率半導體模塊樣
三菱電機SiC功率模塊的發(fā)展里程碑
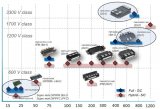
三菱電機開始提供工業(yè)設備用NX封裝全SiC功率半導體模塊樣品
三菱電機將投資Coherent的SiC業(yè)務 發(fā)展SiC功率器件業(yè)務
三菱電機提供SiC MOSFET裸片樣品
三菱電機開始提供全SiC和混合SiC SLIMDIP樣品






 三菱電機高壓SiC模塊封裝技術解析
三菱電機高壓SiC模塊封裝技術解析




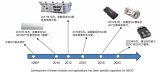










評論