系統(tǒng)構(gòu)成與工作原理
FIB-SEM雙束系統(tǒng)是一種集微區(qū)成像、加工、分析、操縱于一體的綜合型分析與表征設(shè)備。
其基本構(gòu)成是將單束聚焦離子束系統(tǒng)與掃描電子顯微鏡(SEM)耦合而成。在常見(jiàn)的雙束設(shè)備中,電子束垂直安裝,離子束與電子束成一定夾角安裝,兩者的焦平面交點(diǎn)被稱為共心高度位置。當(dāng)樣品處于共心高度時(shí),可同時(shí)實(shí)現(xiàn)電子束成像和離子束加工,并可通過(guò)樣品臺(tái)的傾轉(zhuǎn)使樣品表面與電子束或離子束垂直。
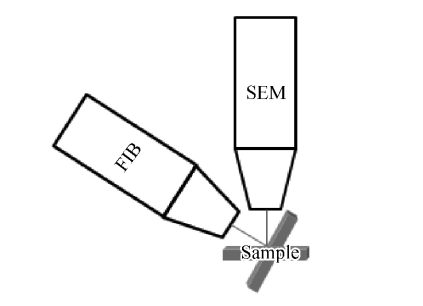
此外,雙束系統(tǒng)還可配備多種附屬設(shè)備,如氣體注入系統(tǒng)(GIS),用于物理濺射與化學(xué)氣體反應(yīng),實(shí)現(xiàn)材料的選擇性去除或沉積;能譜或電子背散射衍射系統(tǒng),用于材料成分、結(jié)構(gòu)、取向的表征和分析;納米操縱儀,用于微納米尺度的操控;以及可控的樣品臺(tái),如控溫、加電、加力等,用于多場(chǎng)耦合條件下的原位分析和測(cè)試試驗(yàn)。
離子源與離子束特性
液態(tài)金屬鎵離子源是目前應(yīng)用最廣泛的離子源。鎵元素具有低熔點(diǎn)、低蒸汽壓和良好的抗氧化性,使得鎵離子源具備發(fā)射穩(wěn)定、使用壽命長(zhǎng)的特點(diǎn)。一顆離子源激活后可穩(wěn)定工作上千小時(shí),且源尺寸較小,束斑尺寸可達(dá)5納米,束流范圍為1皮安至幾十納安,能夠兼顧加工精度和速度。

液態(tài)金屬鎵離子源的實(shí)物照片
當(dāng)高能離子束入射到固體材料表面時(shí),會(huì)產(chǎn)生一系列相互作用,包括二次電子、二次離子的發(fā)射,可用于成像;X射線的發(fā)射,可用于分析材料化學(xué)成分;以及材料表面原子被離子轟擊濺射脫離基體的過(guò)程,這是離子束加工的主要機(jī)制。金鑒實(shí)驗(yàn)室利用離子束特性,能夠?yàn)榭蛻籼峁└哔|(zhì)量的測(cè)試,幫助客戶深入了解材料的微觀結(jié)構(gòu)和性能。
三種基本工作模式
成像模式下,聚焦離子束與材料表層原子交互作用,激發(fā)出的二次電子和二次離子被探測(cè)器收集后可用于成像。與電子束成像相比,離子束在掃描多晶材料時(shí),不同晶向的穿透能力差異較大,可用于分析多晶材料的晶粒取向、晶界分布和晶粒尺寸分布等。
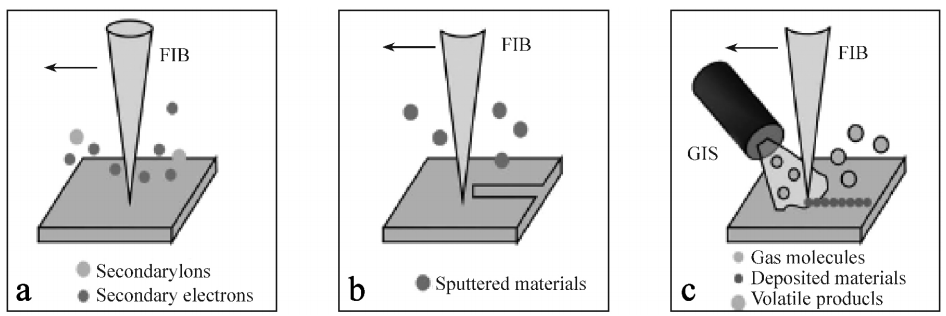
加工模式是聚焦離子束最重要的應(yīng)用之一。通過(guò)高能離子束與樣品表面原子撞擊,使表層原子濺射,可加工簡(jiǎn)單的規(guī)則圖形以及復(fù)雜的圖形,如通過(guò)位圖、流文件等方式實(shí)現(xiàn)。沉積模式則是在離子束照射區(qū)通入特定氣體,在離子束誘導(dǎo)下,氣體可在固體材料表面沉積。通過(guò)調(diào)整離子束束斑尺寸、束流大小、掃描路徑和時(shí)間等參數(shù),可在材料表面沉積出期望的圖案或功能元器件。
應(yīng)用案例
1.透射電鏡樣品制備
透射電鏡(TEM)樣品的制備分為非提取法和提取法。非提取法是在預(yù)減薄樣品上,對(duì)感興趣區(qū)域進(jìn)行定點(diǎn)FIB加工,制取電子透明的觀測(cè)區(qū)。提取法中,最后的減薄工藝流程對(duì)獲得高質(zhì)量TEM照片至關(guān)重要。金鑒實(shí)驗(yàn)室配備了專業(yè)的TEM設(shè)備并配備了能譜儀,能夠進(jìn)行無(wú)機(jī)材料的微結(jié)構(gòu)和微區(qū)組成的深入分析。
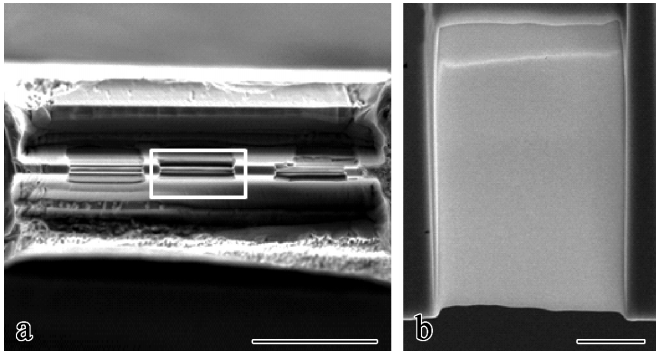
非提取法制備 TEM 樣品。a樣品俯視圖( Bar=20 μm) ; b樣品側(cè)視圖( Bar=5 μm)
2.微納尺度材料力學(xué)性能測(cè)試樣品制備
以力學(xué)性能研究為例,F(xiàn)IB可加工各種幾何形狀的力學(xué)測(cè)試樣品。采用該方法,對(duì)金屬非晶試樣進(jìn)行研究,成功實(shí)現(xiàn)了高精度的應(yīng)力應(yīng)變關(guān)系測(cè)量,發(fā)現(xiàn)非晶態(tài)金屬的實(shí)測(cè)彈性極限是大塊非晶態(tài)金屬?gòu)椥詰?yīng)變的兩倍多,與理論預(yù)測(cè)的理想彈性極限一致
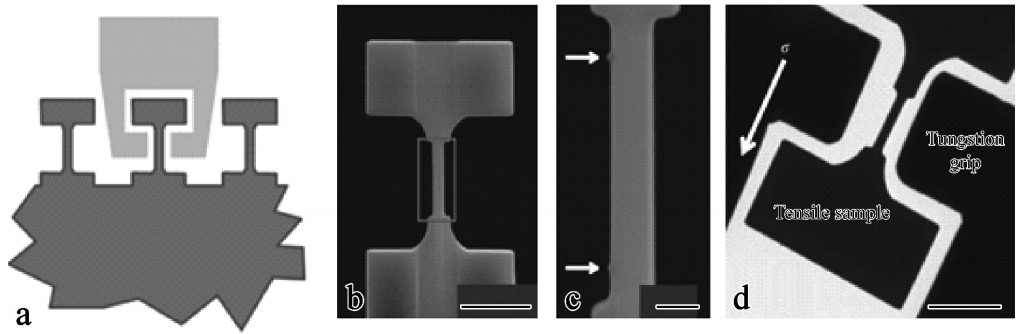
a.微拉伸試驗(yàn)的示意圖; b、c.拉伸試樣; d.在透射電鏡中進(jìn)行拉伸試驗(yàn)。b,c,d: Bar=1μm,200nm,1μm
展示了用于原位疲勞測(cè)試的金屬非晶彎曲測(cè)試樣品。在屈服強(qiáng)度以下進(jìn)行固定應(yīng)變的循環(huán)加載,發(fā)現(xiàn)非晶材料會(huì)經(jīng)歷塑性損傷、微裂紋形成,甚至在裂尖區(qū)域形成微小晶粒。部分微小晶粒會(huì)演化成大晶粒,阻止微裂紋生長(zhǎng),增加材料的抗損傷能力。

非晶態(tài)金屬的原位透射電鏡疲勞測(cè)試 。a.原位疲勞測(cè)試的試驗(yàn)裝置圖; b. FIB 加工的彎曲試樣;c.測(cè)試前缺口根部的 TEM 明場(chǎng)像。b,c:Bar=2μm,50nm
未來(lái)展望
目前,F(xiàn)IB-SEM雙束系統(tǒng)在國(guó)內(nèi)的裝機(jī)量快速增長(zhǎng),其在科研工作中的重要性日益凸顯。雙束設(shè)備本身也在不斷發(fā)展,例如開(kāi)發(fā)性能更優(yōu)異的離子源和離子光學(xué)鏡筒,擴(kuò)展離子束的束流范圍,兼顧高加工效率和小加工損傷,以及開(kāi)發(fā)特殊用途的樣品臺(tái)以開(kāi)展有趣的原位試驗(yàn)。隨著技術(shù)的不斷發(fā)展與創(chuàng)新,F(xiàn)IB-SEM系統(tǒng)將在更多領(lǐng)域發(fā)揮重要作用,助力材料科學(xué)的進(jìn)一步發(fā)展。
-
SEM
+關(guān)注
關(guān)注
0文章
257瀏覽量
14869 -
fib
+關(guān)注
關(guān)注
1文章
98瀏覽量
11383 -
電子束
+關(guān)注
關(guān)注
2文章
112瀏覽量
13585
發(fā)布評(píng)論請(qǐng)先 登錄
聚焦離子束顯微鏡(FIB-SEM)
FIB-SEM雙束系統(tǒng)在材料科學(xué)領(lǐng)域的應(yīng)用
聚焦離子束顯微鏡(FIB-SEM)材料分析

微電子制造中的FIB-SEM雙束系統(tǒng):技術(shù)應(yīng)用與進(jìn)展
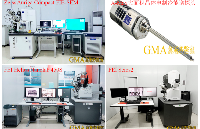
聚焦離子束掃描電鏡(FIB-SEM)技術(shù)原理、樣品制備要點(diǎn)及常見(jiàn)問(wèn)題解答

雙束FIB-SEM系統(tǒng)在材料科學(xué)中的應(yīng)用
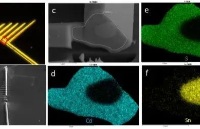
FIB-SEM技術(shù)全解析:原理與應(yīng)用指南
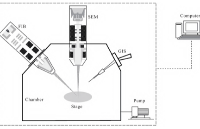
案例展示||FIB-SEM在材料科學(xué)領(lǐng)域的應(yīng)用
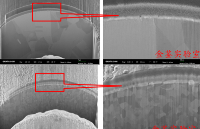
聚焦離子束顯微鏡(FIB-SEM)的應(yīng)用領(lǐng)域
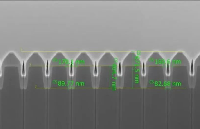
聚焦離子束雙束系統(tǒng) FIB - SEM 的技術(shù)剖析與應(yīng)用拓展
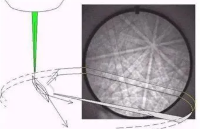





 FIB-SEM雙束系統(tǒng):多領(lǐng)域應(yīng)用的前沿技術(shù)
FIB-SEM雙束系統(tǒng):多領(lǐng)域應(yīng)用的前沿技術(shù)

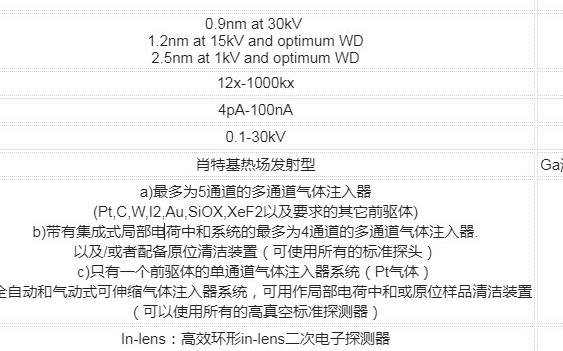
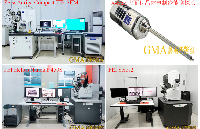
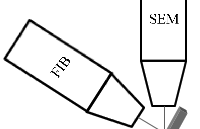

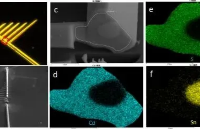










評(píng)論