聚焦離子束(FIB)技術是一種極為精細的樣品制備與加工手段,它能夠對金屬、合金、陶瓷等多種材料進行加工,制備出尺寸極小的薄片。這些薄片的寬度通常在10~20微米,高度在10~15微米,厚度僅為100~150納米。它不僅可以對納米材料的指定位置進行截面處理,以供掃描電子顯微鏡(SEM)進行形貌分析,還能高效制備透射電子顯微鏡(TEM)所需的指定位置樣品,從而成為連接SEM與TEM的重要橋梁。
FIB的工作原理
FIB的基本工作原理是利用加速的重離子轟擊目標材料,使原子從目標材料中濺射出來。
在FIB的操作過程中,固體鎵(Ga)被加熱至熔點,液體鎵通過表面張力流動至探針針尖,從而潤濕鎢針。當在鎢尖端施加強電場后,液態鎵會形成直徑約2-5納米的尖端,尖端處的電場強度可高達101?伏每米。在如此高的電場下,液尖表面的金屬離子會以場蒸發的形式逸出表面,從而產生鎵離子束流。
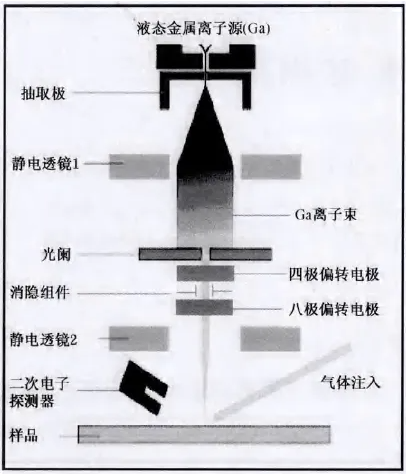
鎵離子與目標材料接觸時,會發生一系列復雜的相互作用。當鎵離子與材料原子核碰撞時,會傳遞能量,導致原子移位或脫離表面,產生濺射現象,這是FIB刻蝕功能的基本原理。此外,鎵離子還可能通過級聯碰撞釋放動能并在材料內部靜止,這一過程稱為離子注入。同時,非彈性散射會產生二次電子、聲子、等離子激元和X射線。其中,二次電子在單束FIB儀器中被用于成像,可通過二次電子探測器(CDEM)收集。
FIB-SEM聯用系統
將離子柱和電子柱組裝在同一臺儀器中,就形成了一種集FIB和SEM所有功能于一體的儀器,通常被稱為聚焦離子束顯微鏡或者雙束電鏡。這種聯用系統的主要作用可以分為兩大部分:
1. FIB的刻蝕和沉積功能
可用于材料微加工、TEM樣品制備以及金屬沉積等。通過精確控制離子束的能量和劑量,可以在材料表面進行高精度的刻蝕,形成所需的微納結構。同時,利用離子束誘導沉積技術,還可以在材料表面沉積各種材料,實現微納尺度的材料合成與改性。
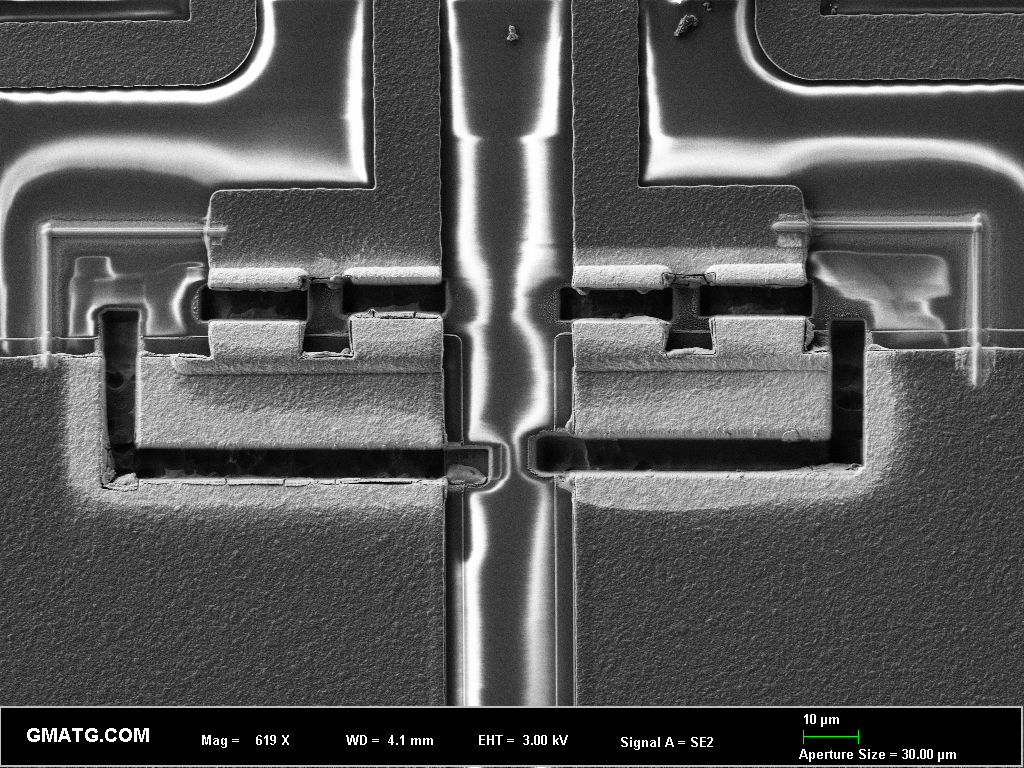
2. 微區成分形貌分析功能
兼容常規SEM的二次電子成像、背散射成像、電子背散射衍射(EBSD)、能量色散X射線光譜(EDX)分析等。
FIB-TEM制樣
透射電子顯微鏡(TEM)樣品需要非常薄,以便電子能夠穿透材料形成衍射圖像。FIB憑借其高效的濺射能力,常用于優化超TEM薄樣品的制備。
FIB的應用
1.TEM樣品制備優化
制備TEM樣品是FIB的一個極具特色的重要應用。與傳統TEM樣品制備方法相比,
FIB制樣方法具有以下顯著特點:定點、定向精度高,幾乎不需要樣品預處理,制樣時間短,制樣成功率高,對加工材料不敏感,可對同一塊材料的不同區域進行特性分析。
這些優點使得FIB在TEM樣品制備領域具有不可替代的地位。
2.3D SEM成像
在研究礦物的生成反應過程時,不僅要識別相結構和化學成分,還需獲取不同相的分布、形狀和體積量等三維數據。利用FIB-SEM的逐層切片刻蝕和圖像采集形成3D成像可以很好地實現這一目的。通過精確控制離子束的刻蝕深度和圖像采集參數,可以獲得礦物內部微觀結構的三維圖像,為礦物學研究提供了重要的技術支持。
應用案例展示
在實際應用中,FIB技術已經廣泛應用于多個領域。例如,在電鍍鍍層分析中,FIB可以精確地切取鍍層截面,通過SEM觀察可以清晰地看到鍍層的厚度、均勻性和微觀結構。在半導體器件截面觀察中,FIB能夠快速制備出高質量的截面樣品,為器件的結構和性能分析提供支持。此外,FIB還被用于PCB電路截面分析、電鍍缺陷分析、錫球截面分析等,為電子材料和器件的研究與開發提供了重要的技術支持。
-
fib
+關注
關注
1文章
94瀏覽量
11339 -
TEM
+關注
關注
0文章
101瀏覽量
10707 -
離子束
+關注
關注
0文章
85瀏覽量
7735
發布評論請先 登錄
如何找到專業做FIB技術的?
聚焦離子束(FIB)技術:芯片調試的利器






 聚焦離子束(FIB)技術的應用原理
聚焦離子束(FIB)技術的應用原理
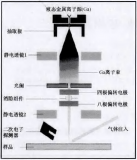
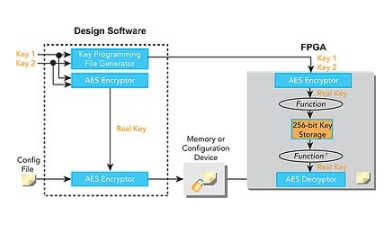


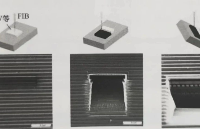

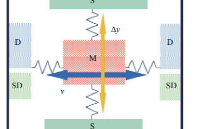




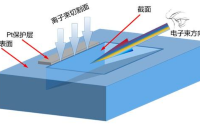











評論