來源:星際浮塵
注入增強型IGBT
1、結構特點與典型工藝
1.1結構提出與發展
為了協調IGBT通態特性與關斷特性及短路特性之間的矛盾,提高器件的綜合性能和可靠性,在IGBT中引入了一種電子注入增強效應(Injection Enhancement Effect,IE),既可加強IGBT導通時的電導調制效應,又可限制陽極空穴的注入,于是形成了注入增強型IGBT(Injection Enhanced Insulated Gate Bipolar Transistor,IE-IGBT)。
盡管出現了很多結構,所采取的措施也不同,但目的都是提高通態時IGBT內部發射極側的載流子濃度,即引入IE效應,以增強電導調制作用,從而解決IGBT通態特性和開關特性之間的矛盾,降低器件功耗。
1.2結構類型與特點
按柵極結構分:平面寬柵、溝槽寬柵、平面-溝槽柵(Trench-Planar Gate,TP)結構
按是否有虛擬元胞分:普通元胞和虛擬元胞結構
按輔助層的位置分:溝槽柵結構(如CST-BT)和平面柵結構(如EP-IGBT和HiGT)
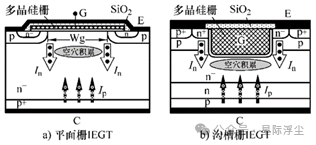
圖1 IEGT結構
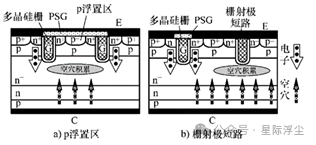
圖2 含虛擬元胞的窄槽柵IEGT結構
(1)寬柵IEGT結構
集電極注入的空穴在寬柵形成積累,引起發射極向漂移區注入的電子增強。
由于這兩種結構的柵極尺寸較大,使得元胞密度和溝道密度減小,從而會影響器件的電流容量。
(2)虛擬元胞窄槽柵IEGT結構
部分元胞的p基區沒有歐姆接觸,成為p浮置區。導通期間,集電區注入的空穴將無法經過p浮置區到達發射極,于是會在p浮置區下方的n-漂移區內形成積累。
部分元胞的多晶硅柵極與發射極短路,導通期間,柵極兩側的p基區則不會形成導電溝道,于是從集電區注入的空穴無法與電子復合,也會在柵極下方的n-漂移區內形成堆積。
(3)n輔助層平面柵結構
HiGT結構通過離子注入工藝在n-漂移區和p基區之間形成一個n空穴勢壘(HB)層,其摻雜濃度略高于n-漂移區的摻雜濃度,使得p基區與n輔助層間的內電位差增加了約0.2V,相當于增加了一個空穴勢壘。導通期間大量空穴會積累在空穴勢壘層下方,迫使n+發射區注入增強。該結構不需要像P-IEGT那樣增加柵極寬度,就可獲得較強的IE效應,但對n HB的摻雜濃度要求極為嚴格,設計不當會嚴重影響器件的阻斷能力。
EP-IGBT結構是在普通平面柵P-IGBT的p基區側面和底部分別增加了一個n增強層。與HiGT結構相比,EP-IGBT除了具有IE效應外,阻斷電壓較高;同時p基區側面的n增強層會縮短溝道長度,有利于提高器件跨導和集電極電流,降低MOS溝道的壓降。通過優化n增強層的參數,可增大其反偏安全工作區(RBSOA)。
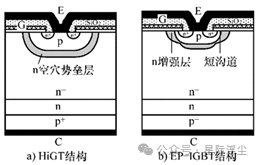
圖3 平面柵結構
(4)n輔助層溝槽柵結構
CSTBT結構是在p基區與n-漂移區之間增加一個n載流子存儲(CS)層, 類似于HiGT結構中的n HB層。導通期間在n CS層下方會形成空穴積累層。如將n CS層和虛擬元胞相結合,可形成CSTBT結構,導通期間的IE效應會更強,從而獲得更低的導通損耗和開關損耗。
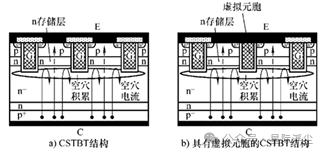
圖4 溝槽柵結構
圖5a為東芝公司4.5kV P-IEGT芯片,尺寸為15mm×15mm,柵極壓焊點均位于芯片角處。圖5b為日立公司3.3kV/50A平面柵HiGT芯片,柵極壓焊點位于芯片中央。圖5c為三菱公司1.2kV/150A溝槽柵CSTBT芯片,柵極壓焊點位于芯片的側邊和角上。
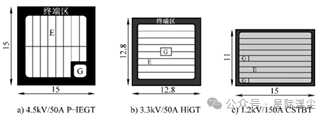
圖5 各種不同IE-IGBT結構的芯片圖形
1.3典型工藝
IE-IGBT關鍵工藝在于深而窄的溝槽刻蝕、n輔助層的注入技術及少子壽命控制技術。
(1)溝槽刻蝕工藝
在溝槽柵IEGT結構中,溝槽越深(約12μm),IE效應越強。為了消除柵氧化層不均勻引起的閾值電壓變化,并提高MOS溝道電子的遷移率,需采用精細的RIE刻蝕工藝先形成溝槽,再生長犧牲氧化層來獲得光滑的槽壁。對于寬槽柵(槽寬為8~12μm)結構,通常在氮氧化硅(SiON)掩蔽下進行溝槽刻蝕之后,再采用局部氧化(LOCOS)工藝來圓化溝槽底部拐角,并消除頂部的“鳥嘴”效應。
(2)n輔助層工藝
若采用常規摻雜工藝,由于存在雜質的補償作用,會使溝道的凈摻雜濃度降低,導致閾值電壓下降,并影響溝道電子的遷移率,同時也很難形成摻雜濃度和厚度均合適的n輔助層。采用倒摻雜(Retro Grade Doping)工藝,可有效避免CS層對溝道摻雜濃度的補償,有利于獲得更高的溝道電子遷移率,并提高器件的均勻性,增大短路安全工作區(SCSOA)。
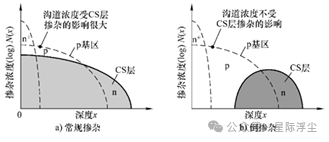
圖6 載流子存儲層的摻雜濃度分布
(3)載流子壽命控制技術
壽命控制技術改善IEGT開關特性,也會影響器件IE效應的強弱。與傳統的均勻壽命控制相比,采用局部壽命控制,如質子輻照和H+、He2+等輕離子輻照,可將低壽命區控制在靠近n緩沖層的n-漂移區中,從而使器件的開關特性和通態特性同時得到改善。
2、工作原理與注入增強效應
2.1工作原理
無論是采用寬柵結構,還是虛擬元胞,或者增加n輔助層,都增強了發射極側的載流子注入,使得器件內部的電導調制區域由局部的n-漂移區擴展到整個n-漂移區甚至n型輔助層中。所以,IE-IGBT具有比普通IGBT更好的通態特性。在采用n輔助層和虛擬元胞的復合結構中,IE效應會更加明顯,電導調制區域更大,器件的特性會進一步改善。
2.2等效電路
IGBT可等效為MOSFET和pnp晶體管的級聯,在導通狀態下,IGBT可簡化地等效為MOSFET和pin二極管的串聯。
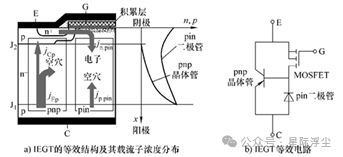
圖7 IEGT導通狀態下的等效結構及其載流子濃度分布與等效電路
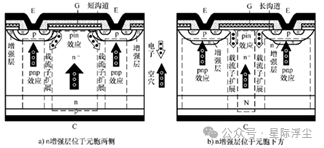
圖8 EP-IEGT結構中的pin二極管與pnp晶體管效應
如圖8a所示,當n增強層位于元胞兩側時,溝道縮短,n+發射區的電子通過溝道后向元胞下方擴展,在柵極正下方的n-漂移區形成空穴積累,使pin二極管的效應加強。圖8b當n增強層集中在元胞底部時,此時溝道長度不變,n+發射區的電子通過溝道后向柵極下方擴展,同時空穴會在元胞正下方的n增強層處形成積累,使pnp晶體管效應加強。
為了獲得優良的導通特性,應加強P-IEGT內部的pin二極管效應。 但如果發射區附近的pin二極管效應增強,飽和電流特性變差。所以,為了獲得優良的FBSOA,pin二極管效應需遠離溝道和發射區。如圖9所示的溝槽-平面柵TP-IEGT結構,在發射極元胞之間插入了溝槽(類似于TPMOS),于是沿溝槽側壁會形成電子積累層,同時因溝槽和元胞之間的n-漂移區很窄,空穴只能在元胞下方的n-漂移區形成積累,產生電子注入增強效應,使pin二極管效應增強,并且pin二極管效應僅壓縮在遠離發射區的n-漂移區內,故TP-IEGT具有比P-IEGT更好的導通特性。
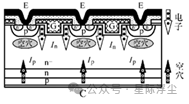
圖9 溝槽平面柵IEGT
2.3注入增強效應及其表征
但IE效應起因于n-漂移區存在空穴積累,從集電區注入到n-漂移區的空穴數目并沒有增加。可見,IE效應能方便地增加IE-IGBT發射極側的電子積累,同時有效地控制集電極側的空穴注入,因此很好地解決了IGBT耐壓提高時關斷特性與通態特性之間的矛盾。
可用發射極電子注入效率γn來表征IE效應的強弱。γn越大,IE效應越強,器件的通態特性越好。γn值不僅與MOSFET表面遷移率有關,還與柵極結構、集電極注入效率及發射極面積等因素有關。
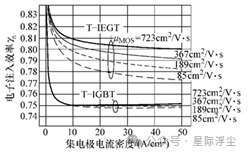
圖10 T-IGBT和T-IEGT的注入效率比較
溝槽柵IEGT和IGBT的電子注入效率比較如圖10。兩者的電子注入效率都隨集電極電流密度的增加而減小,隨溝道電子遷移率μns的增加而增加。T-IEGT的電子注入效率明顯高于T-IGBT,并且隨溝道電子遷移率的變化更加明顯,這說明要提高T-IEGT的電子注入效率γn,必須提高MOS溝道的電子遷移率。
圖11給出了P-IEGT和T-IEGT的電子注入效率與結構參數的變化關系。T-IEGT電子注入效率(γn≈0.75~0.83)明顯高于P-IEGT(γn≈0.73~0.77),并且γn除了與MOS溝道電子的遷移率有關外,還與元胞寬度和溝槽柵尺寸有關。P-IEGT的γn隨元胞半寬度W的增大呈線性增加,T-IEGT的γn隨深度T和元胞半寬度W乘積的平方根增大呈非線性增加。
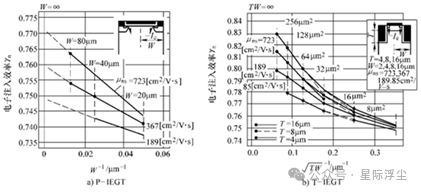
圖11 P-IEGT和T-IEGT的電子注入效率γn與結構參數的關系曲線
3、靜態與動態特性
3.1通態特性
P-IEGT的飽和電壓主要由漂移區的壓降Un-和集電結的壓降Up+n決定。

式中JC為集電極電流密度;Wn-為n-漂移區厚度;ρc和ρe分別為集電極和發射極側載流子濃度。
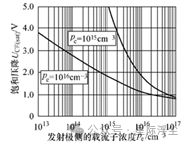
圖12 T-IEGT的UCEsat隨ρe和ρc變化曲線
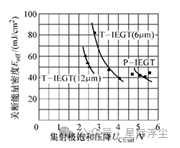
圖13 P-IEGT與T-IEGT特性比較
當集電極側載流子濃度ρc一定時,UCEsat隨ρe的增加而下降;當ρe一定時,ρc越高,UCEsat越低。適當提高IEGT集電極側與發射極側的載流子濃度,有助于實現理想的低飽和電壓,但集電極側的載流子濃度增加會導致關斷特性變差。
3.2特性比較
圖13所示為采用局部少子壽命控制的P-IEGT與T-IEGT關斷能耗密度與飽和電壓UCEsat的關系。P-IEGT的UCEsat明顯比T-IEGT的要高,并且溝槽越深,對改善T-IEGT關斷特性與飽和電壓越有利。
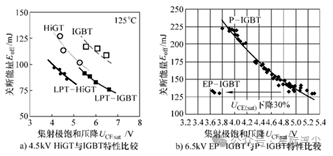
圖14 幾種不同結構的IE-IGBT特性的比較
采用LPT型耐壓結構可進一步改善平面柵IE-IGBT的綜合特性。圖14a對4.5kV器件而言,當關斷能量Eoff一定時,LPT-HiGT的飽和電壓更低,而普通IGBT特性最差。圖14b對6.5kV器件而言,當Eoff一定時,EP-IGBT的UCEsat比普通IGBT低30%。如果將溝槽柵n輔助層及LPT型結構相結合,可以獲得更好的綜合特性。如LPT-CSTBT結構的飽和電壓比傳統P-IGBT結構的下降約40%,并且耐壓越高,CSTBT與傳統P-IGBT結構的特性差異越大。
-
工藝
+關注
關注
4文章
680瀏覽量
29408 -
IGBT
+關注
關注
1278文章
4064瀏覽量
254320 -
功率器件
+關注
關注
42文章
1928瀏覽量
92601 -
動態特性
+關注
關注
0文章
22瀏覽量
8831
原文標題:功率器件工程師筆記——注入增強型IGBT
文章出處:【微信號:芯長征科技,微信公眾號:芯長征科技】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄





 注入增強型IGBT學習筆記
注入增強型IGBT學習筆記

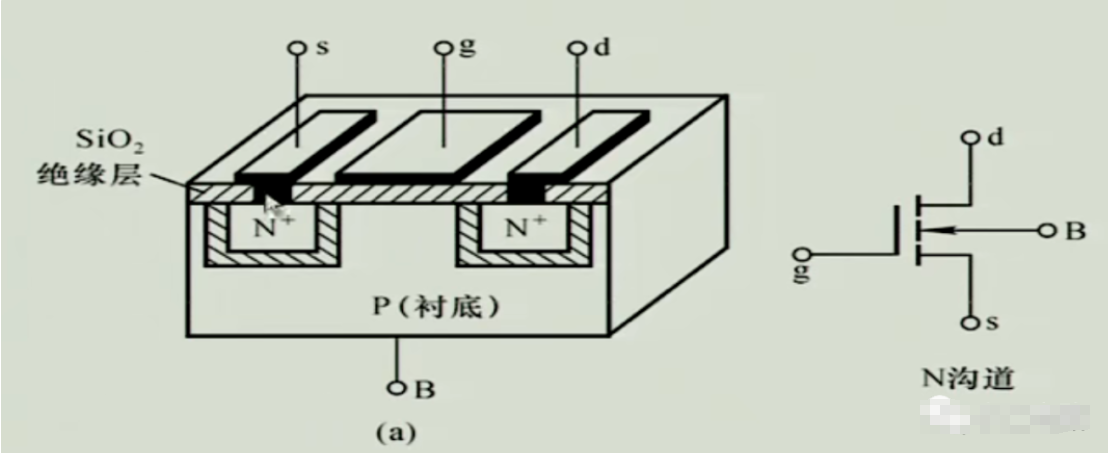












評論