晶圓是半導(dǎo)體制造的核心基材,所有集成電路(IC)均構(gòu)建于晶圓之上,其質(zhì)量直接決定芯片性能、功耗和可靠性,是摩爾定律持續(xù)推進(jìn)的物質(zhì)基礎(chǔ)。其中晶圓的厚度(THK)、翹曲度(Warp) 和彎曲度(Bow) 是直接影響工藝穩(wěn)定性和芯片良率的關(guān)鍵參數(shù):
1、厚度(THK) 是工藝兼容性的基礎(chǔ),需通過精密切割與研磨實(shí)現(xiàn)全局均勻性。
2、翹曲度(Warp) 反映晶圓整體應(yīng)力分布,直接影響光刻和工藝穩(wěn)定性,需通過退火優(yōu)化和應(yīng)力平衡技術(shù)控制。
3、彎曲度(Bow) 源于材料與工藝的對(duì)稱性缺陷,對(duì)多層堆疊和封裝尤為敏感,需在晶體生長(zhǎng)和鍍膜工藝中嚴(yán)格調(diào)控。
在先進(jìn)制程中,三者共同決定了晶圓的幾何完整性,是良率提升和成本控制的核心參數(shù)。通過WD4000晶圓幾何形貌測(cè)量系統(tǒng)在線檢測(cè),可減少其對(duì)芯片性能的影響。
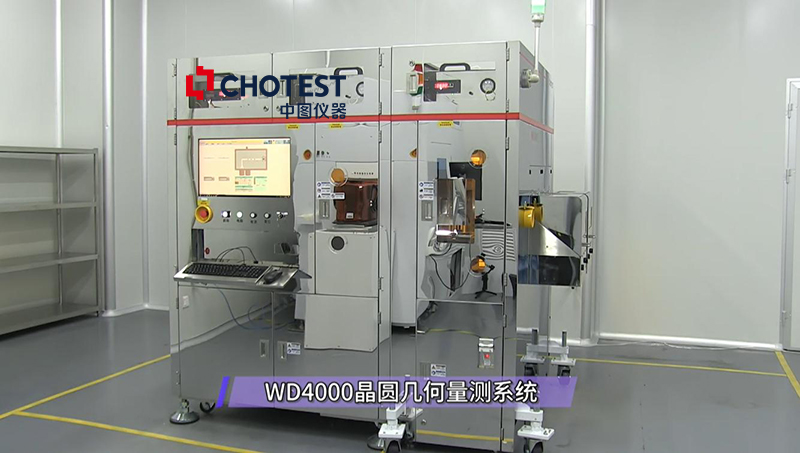
WD4000晶圓幾何量測(cè)系統(tǒng)適用于裸晶圓、圖案晶圓、鍵合晶圓、貼膜晶圓、超薄晶圓等復(fù)雜結(jié)構(gòu)晶圓的量測(cè)應(yīng)用。
(1)搭配中圖全自主研發(fā)的EFEM系統(tǒng),可以適配loadport、smifport、carrier等多種形式,實(shí)現(xiàn)全自動(dòng)上下料,實(shí)現(xiàn)在單系統(tǒng)內(nèi)完成晶圓厚度、平坦度、粗糙度、膜厚等面型參數(shù)的高精度測(cè)量。
(2)系統(tǒng)覆蓋襯底切磨拋,光刻/蝕刻后翹曲度檢測(cè),背面減薄厚度監(jiān)測(cè)等關(guān)鍵工藝環(huán)節(jié)。
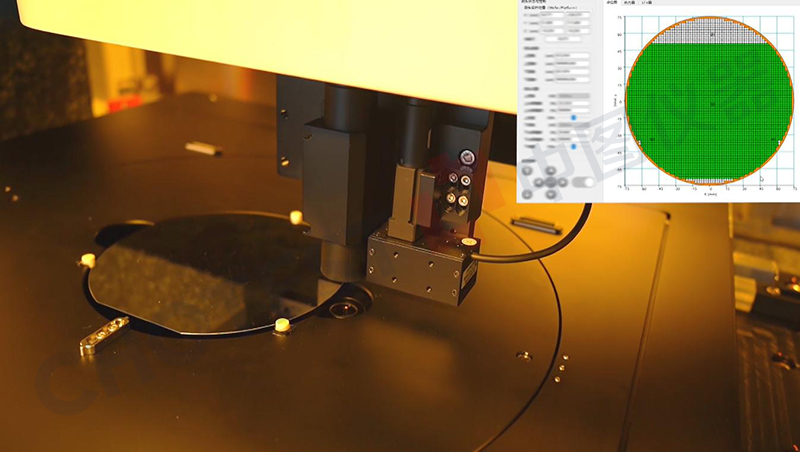

晶圓作為半導(dǎo)體工業(yè)的“地基”,其高純度、單晶結(jié)構(gòu)和大尺寸等特點(diǎn),支撐了芯片的高性能與低成本制造。其戰(zhàn)略價(jià)值不僅體現(xiàn)在技術(shù)壁壘和產(chǎn)業(yè)核心地位,更在于推動(dòng)全球電子設(shè)備小型化、智能化及新興領(lǐng)域(如AI、自動(dòng)駕駛)的發(fā)展。晶圓技術(shù)的持續(xù)創(chuàng)新,是半導(dǎo)體行業(yè)進(jìn)步的核心驅(qū)動(dòng)力之一。
-
翹曲度
+關(guān)注
關(guān)注
0文章
6瀏覽量
6059 -
厚度測(cè)量
+關(guān)注
關(guān)注
0文章
11瀏覽量
6839 -
數(shù)據(jù)測(cè)量
+關(guān)注
關(guān)注
0文章
8瀏覽量
7396 -
晶圓制造
+關(guān)注
關(guān)注
7文章
292瀏覽量
24584
發(fā)布評(píng)論請(qǐng)先 登錄
wafer晶圓厚度(THK)翹曲度(Warp)彎曲度(Bow)等數(shù)據(jù)測(cè)量的設(shè)備
PCB板的翹曲度介紹
半導(dǎo)體晶圓翹曲度測(cè)試方法
半導(dǎo)體晶圓翹曲度測(cè)試方法
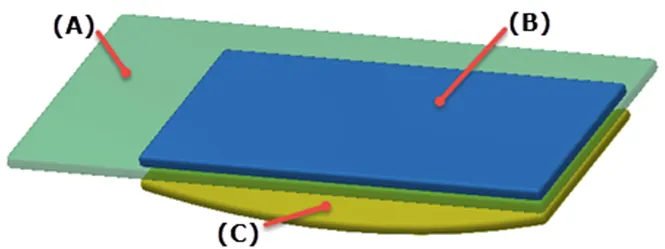
“芯”動(dòng)未來,無圖晶圓幾何量測(cè)系統(tǒng)提升半導(dǎo)體競(jìng)爭(zhēng)力

WD4000無圖晶圓幾何量測(cè)系統(tǒng)
晶圓的環(huán)吸方案相比其他吸附方案,對(duì)于測(cè)量晶圓 BOW/WARP 的影響






 wafer晶圓幾何形貌測(cè)量系統(tǒng):厚度(THK)翹曲度(Warp)彎曲度(Bow)等數(shù)據(jù)測(cè)量
wafer晶圓幾何形貌測(cè)量系統(tǒng):厚度(THK)翹曲度(Warp)彎曲度(Bow)等數(shù)據(jù)測(cè)量


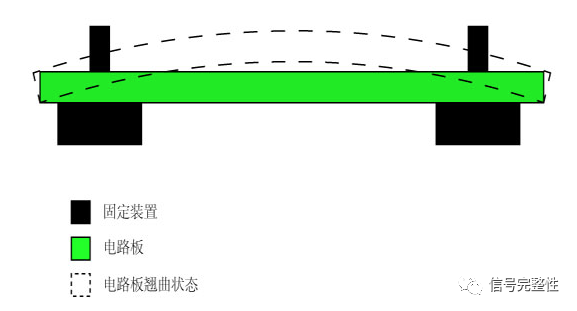











評(píng)論