來源:半導體小馬
前面分享了先進封裝的四要素一分鐘讓你明白什么是先進封裝,今天分享一下先進封裝中先進性最高的TSV。
TSV(Through - Silicon Via,硅通孔)是先進封裝技術中的一種關鍵垂直互連技術。它通過在芯片內部打通通道,實現電氣信號的垂直傳輸,可顯著提高芯片之間的數據傳輸效率,減少信號延遲,降低功耗,并提升封裝的集成密度。

一、工作原理
基于硅片中的深孔刻蝕技術,先在硅片中打孔,再填充銅等導電材料形成電氣連接。這些通孔貫穿整個芯片厚度,可將不同芯片層或同一芯片內的不同電路相互連接,作為芯片與芯片、芯片與封裝基板、以及芯片內部不同電路層之間的高效電氣通道。
二、分類
2.5D封裝中的TSV:通常用于中介層(Interposer)。中介層是帶有 TSV 的載體,可承載多個芯片,如處理器和內存等,芯片通過 TSV 在中介層上互連,而非直接堆疊,主要應用于高性能計算和數據中心芯片等需要高度互連和高帶寬的系統。
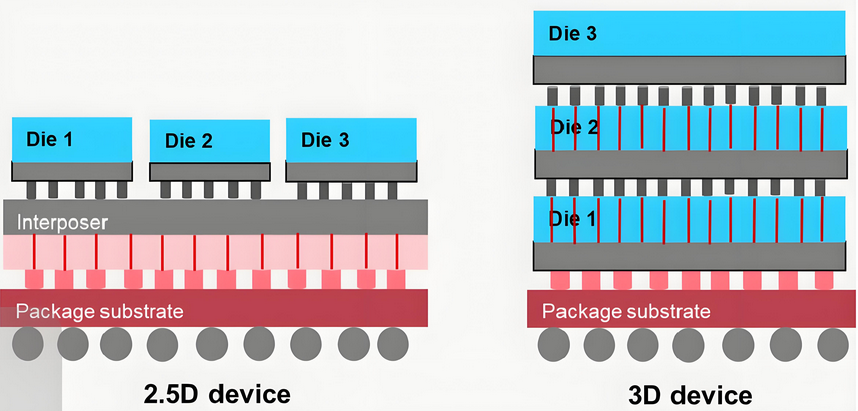
3D 封裝中的 TSV:實現了芯片的垂直堆疊,每個芯片層通過 TSV 直接相互連接,形成一個整體,能讓不同功能模塊,如處理器和內存高度集成在同一個封裝中,提高芯片集成密度和性能,同時減小封裝尺寸。
Via-last TSV:TSV制作可以集成到生產工藝的不同階段,通常放在晶圓制造階段為Via-first,封裝階段為Via-last(該方案可以不改變現有集成電路流程和設計,目前業界已開始在高端的Flash和DRAM領域采用Via-last技術,即在芯片周末進行硅通孔的TSV制作,然后進行芯片或晶圓層疊。
Via-middle(中通孔)封裝工藝:首先在晶圓制造過程中形成通孔,隨后在封裝過程中,于晶圓正面形成焊接凸點。之后將晶圓貼附在晶圓載片上并進行背面研磨,在晶圓背面形成凸點后,將晶圓切割成獨立芯片單元,并進行堆疊。
三、工藝流程
中通孔基本工序:首先在晶圓上制作晶體管,隨后使用硬掩模在硅通孔形成區域繪制電路圖案,之后利用干刻蝕工藝去除未覆蓋硬掩膜的區域,形成深槽;再利用CVD工藝制備絕緣膜(用于隔絕填入槽中的銅等金屬物質,防止硅片被金屬物質污染);此外絕緣層上還將制備一層金屬薄層(將被用于電鍍銅層)作為屏障;電鍍完成后,采用CMP技術使晶圓表面保持平滑,同時清除其表面銅基材,確保銅基材只留在溝槽中。
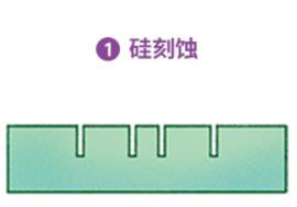
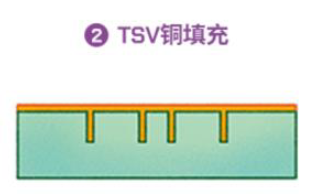
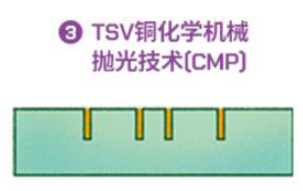
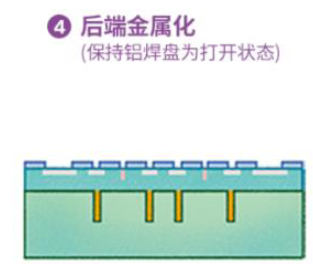
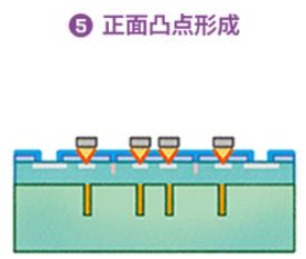
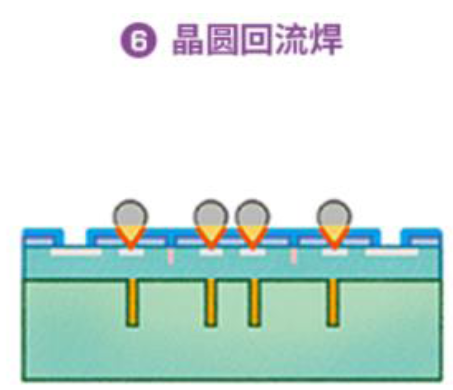
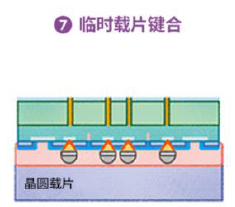
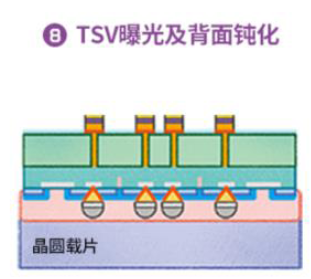
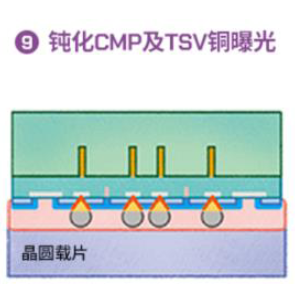
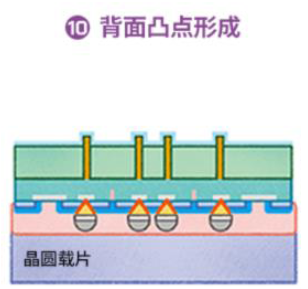
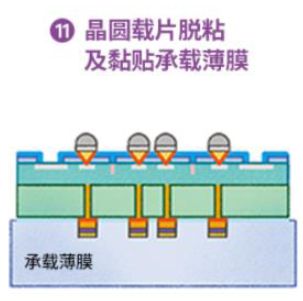
-
半導體
+關注
關注
335文章
28847瀏覽量
236565 -
TSV
+關注
關注
4文章
123瀏覽量
81913 -
封裝工藝
+關注
關注
3文章
65瀏覽量
8146 -
先進封裝
+關注
關注
2文章
470瀏覽量
607
原文標題:先進封裝四要素中先進性最高的TSV分類及工藝流程介紹
文章出處:【微信號:深圳市賽姆烯金科技有限公司,微信公眾號:深圳市賽姆烯金科技有限公司】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
TSV工藝流程與電學特性研究






 先進封裝中的TSV分類及工藝流程
先進封裝中的TSV分類及工藝流程




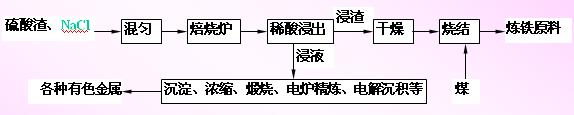













評論