本文介紹了TSV工藝流程是什么。
用于2.5D與3D封裝的TSV工藝流程是什么?有哪些需要注意的問題?
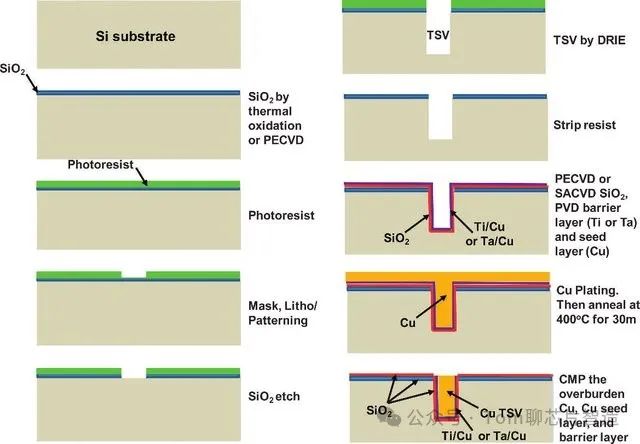
上圖是TSV工藝的一般流程。TSV,全名Through-Silicon Via,又叫硅通孔工藝。
硅基底準備:流程以一塊覆蓋有二氧化硅(SiO?)層的硅基底開始。這層SiO?可以通過熱氧化或等離子體增強化學氣相沉積(PECVD)方法形成。
光刻:光刻膠(Photoresist)被涂布在SiO?層上,然后通過曝光和顯影步驟進行圖案化,以得到后面工序要進行硅蝕刻的區域。 硅蝕刻:使用光刻圖案作為掩模,采用DRIE在硅基底中蝕刻出通孔。
去除光刻膠:在蝕刻完成后,去除光刻膠以準備接下來的層沉積步驟。
沉積絕緣層和阻擋層:通過PVD,PECVD或原子層沉積(ALD)技術在孔壁上沉積一層二氧化硅來作為絕緣層,防止電子竄擾;然后沉積一層導電的阻擋層,如鈦/銅(Ti/Cu)或鉭/銅(Ta/Cu),以便后續的銅鍍層能更好地附著,且能防止電子遷移。
銅電鍍:在絕緣層和阻擋層上進行銅鍍層,以填充TSV孔洞。一般通過電鍍方式完成。電鍍完成后,進行退火工序,釋放應力。
化學機械拋光(CMP):最后,進行CMP步驟來平整表面,去除多余的銅和阻擋層,留下一個與硅基底表面平齊的銅TSV。
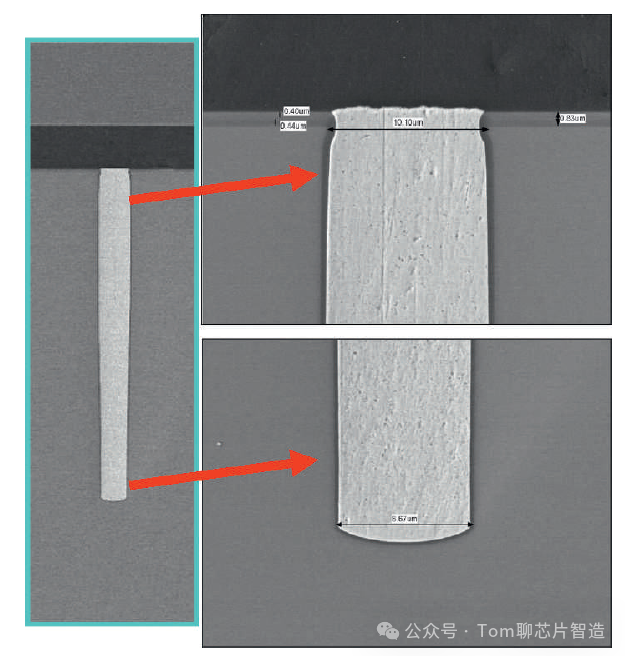
審核編輯:劉清
-
CMP
+關注
關注
6文章
157瀏覽量
26717 -
TSV
+關注
關注
4文章
123瀏覽量
81957 -
光刻膠
+關注
關注
10文章
339瀏覽量
30967 -
3D封裝
+關注
關注
9文章
141瀏覽量
27811
原文標題:TSV工藝流程介紹
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導體所】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
研發的銅混合鍵合工藝正推動下一代2.5D和3D封裝技術

2.5D/3D芯片-封裝-系統協同仿真技術研究
3D封裝結構與2.5D封裝有何不同?3D IC封裝主流產品介紹






 用于2.5D與3D封裝的TSV工藝流程是什么?有哪些需要注意的問題?
用于2.5D與3D封裝的TSV工藝流程是什么?有哪些需要注意的問題?


















評論