創(chuàng)建真正的 3D 設計被證明比 2.5D 復雜和困難得多,需要在技術和工具方面進行重大創(chuàng)新。
雖然已經(jīng)有很多關于 3D 設計的討論,但對于 3D 的含義有多種解釋。然而,這不僅僅是語義,因為每個封裝選項都需要不同的設計方法和技術。隨著芯片進入真正的3D-IC領域,在邏輯之上堆疊邏輯或存儲器,它們的設計、制造以及最終的成品率和測試變得更具挑戰(zhàn)性。
“一開始,代工廠開始提供多芯片封裝,他們開始使用 3D-IC 這個術語,”Cadence 定制 IC 和 PCB 部門產(chǎn)品管理組總監(jiān) John Park說。“但它指的不僅僅是硅堆疊和中介層。它還包括高密度 RDL 扇出。這是一個術語,用于對許多多芯片、主要是基于代工廠的封裝技術進行分組。”
已經(jīng)有幾次嘗試來整理這個術語。“我們正在與 imec 保持一致,后者將 3D 分為四個部分,”EV Group 業(yè)務發(fā)展總監(jiān) Thomas Uhrmann 說。“真正的 3D 是晶圓以高度集成的方式堆疊在一起。第二組是 3D 片上系統(tǒng) (SoC) 集成,其中您可能有一個背面配電層,或一個晶圓到晶圓的存儲器堆棧。第三組包括 2.5D 和硅中介層。最后一個是 3D 系統(tǒng)級封裝 (SiP),其中接觸間距約為 700 微米,包括扇出晶圓級封裝。差異化很有趣,因為他們定義了觸點間距或集成密度的差異化。”
這提供了物理差異,但差異也可以從其他方面來看。“有趣的 3D 類型要么是邏輯對邏輯,要么是顯著的內存對邏輯,”Synopsys研究員 Rob Aitken 說。“這兩個都是起點,但是你可以開始堆疊其他隨機的東西。我會說 HBM 是 3D 堆棧,但它們是非常具體的 3D 堆棧。”
這些打包方法中的每一種的流程都是不同的。“多年來,2.5D 和 3D 一直被用于支持傳感器應用之類的東西,”西門子 EDA 高級封裝解決方案總監(jiān) Tony Mastroianni說。“但他們不使用自動布局布線流程,這就是為什么我喜歡使用‘真正的 3D’這個詞。”今天的堆疊芯片技術依賴于人們手動進行規(guī)劃。您正在設計每個芯片,以便它們對接在一起,但工具并沒有這樣做。分區(qū)和詳細的引腳規(guī)劃是手動過程。”
真正的 3D 需要重新考慮整個流程。“為了將 SoC 有效地實現(xiàn)為 2.5D 系統(tǒng),例如避免良率問題或實現(xiàn)具有更多晶體管的更大系統(tǒng),可以使用現(xiàn)有架構,” Fraunhofer IIS 工程高效電子部門負責人 Andy Heinig 說自適應系統(tǒng)部門。“只需要實現(xiàn)一個芯片到芯片的接口。但只有使用新概念和架構,才能發(fā)揮真正 3D 集成的優(yōu)勢。”
為什么選擇 3D 3D
的最大好處之一是縮短了距離。Synopsys 的 Aitken 說:“你可以證明存在二的平方根效應。”“對于這個堆疊物體中的所有距離,它們變成了 2D 變體中的 0.7。結果,它們在布線部分消耗的功率現(xiàn)在是以前的 0.7 左右,因為電容減小了。”
影響可能比這更大。“信號傳輸過程中會產(chǎn)生大量熱量,”EV Group 的 Uhrmann 說。“對于 CMOS,你對某些東西進行充電和放電以存儲然后傳遞信息。縮小和堆疊模具將使您能夠使其更小,因此可以在三維空間中傳遞信息。但在 3D 中,它們之間可能只有一個緩沖區(qū),而不是大型 PHY 和通信協(xié)議。”
尺寸有兩個優(yōu)勢——產(chǎn)量和占地面積。“假設類似數(shù)量的邏輯分布在多個芯片上,較小對象的產(chǎn)量將高于一個較大對象的產(chǎn)量,”Aitken 說。“因此,您可以降低一定程度的成本。當然,你正在增加其他成本,但這些成本會隨著時間的推移而下降。”
從 2D 封裝的角度來看,堆疊芯片可以顯著減少面積。“通過堆疊,我可以在同一區(qū)域獲得三倍的邏輯數(shù)量,”西門子的 Mastroianni 說。“你最終會得到更小的足跡和更多的邏輯。所以你可以在那個區(qū)域安裝更多的馬力,如果你有區(qū)域限制,它可能會降低系統(tǒng)成本。”
異質性可能是另一個好處。“3D 集成的異構技術架構已經(jīng)成熟,”Lightelligence 工程副總裁 Maurice Steinman 說。“考慮混合技術組件,例如光子 IC 及其配套電子 IC。對于其中一些集成,沒有其他方法可以在不犧牲大量功率或性能的情況下提供所需的數(shù)千個芯片到芯片互連。”
混合技術仍然主要是未知領域。“如果您的設計不適合十字線尺寸,那么為了能夠構建更多的門,您需要使用真正的 3D,而這可能會保留在相同的技術中,”Mastroianni 說。“但在某些情況下,你可能想要混合搭配。也許你有一個你真正想要的前沿技術計算引擎,但其余的東西有很多控制,你可以在一個不那么激進的過程節(jié)點上做。”
這變成了一個集成挑戰(zhàn)。Cadence 數(shù)字與簽核部產(chǎn)品管理組總監(jiān) Vinay Patwardhan 表示:“我們最近發(fā)現(xiàn),純邏輯內存配置適用于某些類型的客戶,他們正試圖解決片上內存墻問題。”“但是很多客戶希望在兩層都有邏輯。例如,即使您在頂層裸片上只有內存,內存 BiST 邏輯或與內存一起使用的測試邏輯也需要在該裸片上。頂層裸片需要一些邏輯。”
物理層次結構
將芯片集成到 3D 堆棧中,以及對該堆棧的封裝,涉及多種技術,如圖 1 所示。
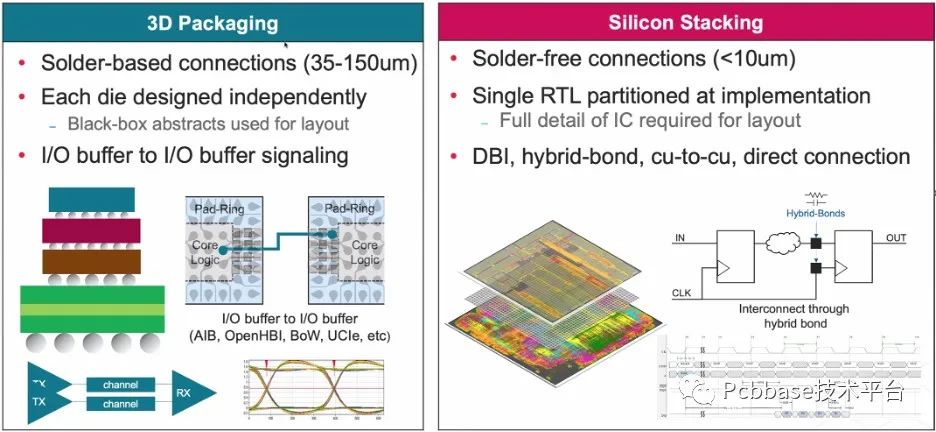 ?
?
圖 1:3D 封裝與硅堆疊
物理尺寸很重要。“對于最終的 3D 集成,你談論的是 14 納米間距,基本上就是今天的晶體管,”Uhrmann 說。“如果你談論的是小芯片,它們是功能性 IP 塊,那么你就在微米間距的范圍內。晶體管堆疊和小芯片集成之間存在接近一個數(shù)量級。當您使用 3D 小芯片、高度集成的具有微米間距的裸片形成 3D 封裝時,您無法將微米間距連接到外部世界。你仍然需要擁有封裝技術才能使布線越來越粗,所以你最終會在板級上達到 400 多微米。”
間距定義了集成過程。“當我們封裝多個芯片或多個小芯片時,封裝存在一些很大的差異,”Cadence 的 Park 說。“小芯片通常使用所謂的基于焊料的連接。它們與微凸塊和 C4 連接,我們使用通常約 45 微米或更大的連接來連接它們。這也創(chuàng)建了一個封裝層次結構,因為我們經(jīng)常使用黑盒、每個芯片或小芯片的抽象表示,而封裝設計師負責將它們正確連接起來。”
這通常需要不同的工具。“這是一個多尺度問題,也意味著多物理問題,”Ansys產(chǎn)品營銷總監(jiān) Marc Swinnen 說。“當你從芯片上的納米到封裝上的毫米再到 3D-IC 內插器上的厘米時,你跨越了六個數(shù)量級。傳統(tǒng)上,這些由三組不同的工具處理。現(xiàn)在對于 3D-IC,這些都需要整合成一個。”
團隊分裂也會導致問題。“大多數(shù)公司都有 ASIC 設計的設計團隊,以及獨立的內部封裝設計團隊,”Park 補充道。“硅堆疊和 3D 模糊了封裝工程師負責的工作與芯片設計團隊之間的界限。我們比以往任何時候都更多地看到,兩個團隊在一個房間里從早期階段就開始規(guī)劃項目。封裝和芯片領域之間的協(xié)同設計有很多要求。”
在一些公司中,內插器也被視為封裝內的 PCB,并由另一個團隊處理。“3D 芯片將執(zhí)行一些非常先進的類型功能,但您不一定能夠通過堆疊芯片來構建整個系統(tǒng)和封裝,”Mastroianni 說。“你將把它與中介層上的其他裸片結合起來。也許那里會有一個標準處理器,或者可能有多個 3D-IC 集成在一個中介層上。我認為 3D 不會取代 2.5D。它們將是互補的。一些應用程序將是真正的 3D,但最終會有一些小芯片的生態(tài)系統(tǒng),你將能夠混合和匹配,并在 2.5D 封裝中做到這一點。”
只要存在層次結構,就可以將事物分開,只要存在覆蓋邊界的工具。“我們必須以層次結構形式表示事物,因為您不再設計單個單片芯片,”Park 說。“你正在設計一個系統(tǒng),所以有一些新的東西開始發(fā)揮作用,比如系統(tǒng) LVS(布局與原理圖)。混合債券是否全部對齊?從頂部裸片到底部裸片,連接是否如您所愿?有一個層次結構只是因為你有一個層次結構代表芯片,你有一個層次結構代表系統(tǒng)級設計。設計本質上是分層的,因為它是一個系統(tǒng)級設計,其中嵌入了芯片級設計。”
邏輯層次
層次結構在任何復雜的設計中都是必不可少的,但 3D 為其添加了一個有趣的轉折。“當您為大型設計進行傳統(tǒng)的布局布線時,您使用的是分層設計方法,”Mastroianni 說。“你將設計分解成塊,這些塊通過布局布線,然后你進行頂層集成。
對于 3D,我們基本上可以使用相同的過程,但我們要添加另一個層次結構。考慮一個 90 億門的設計,我們將其分成三個芯片,每個芯片有 30 億個門。本質上,您只需要指定哪些塊將放在芯片 1 上,哪些塊將放在芯片 2 上,以及哪些塊將放在芯片 3 上。至少在短期內,工具無法自動找出將哪個邏輯放在哪里,并在該級別進行真正的 3D 全局布局布線。
需要一些新工具來驗證芯片到芯片的連接性。“我們通常會使用標準的觸發(fā)器到觸發(fā)器連接,”Park 說。“所以我們需要 STA 工具、時序驅動的布線、時序驅動的布局,而不是分隔設備的緩沖區(qū),它只是一個混合鍵。這只是一個小的寄生值發(fā)揮作用。為此,我們不能像傳統(tǒng)包裝那樣在抽象層面上工作,將它們視為黑盒。我們必須在完整的細節(jié)級別表示每個芯片或小芯片——如果是模擬設計,則為完整的晶體管級別,如果是數(shù)字設計,則為標準單元宏級別——因為我們必須能夠對所有內容進行建模。不是從 2D 角度對所有事物進行建模,而是必須通過這種新的垂直方向整合來完成。”
這可能需要妥協(xié)。“您可以對邏輯堆疊對象進行真正的 3D 簽核,或者您可以直接說,我將只運行芯片之間兩個反相器長度的路徑,”Aitken 說。“然后無論他們在哪個角落,他們都會排成一行,我不必擔心。”
人們普遍認為,扁平化不是一種選擇。“就數(shù)據(jù)量而言,這對任何 EDA 工具來說都是一個重大挑戰(zhàn),”Cadence 的 Patwardhan 說。“需要一些有效的抽象技術,而層次結構定義是第一個流行且有效的東西。我們已經(jīng)弄清楚,使用設計層次結構以及對設計進行分區(qū),如何在分區(qū)設計上運行分析。可以做出哪些假設并且仍然具有與簽核一樣好的準確性。它會發(fā)生,就像在 2D SoC 中發(fā)生的那樣。較小的設計將首先建立完整的平坦運行和所需的精度水平(測量與建模)。隨著我們的前進,隨著更大的芯片以硅堆棧格式完成,EDA、OSAT、代工廠必須在分層方法和扁平方法之間進行驗證,以保持一定的裕度。如果可用,那么您可以輕松地說您的完整平坦跑步看起來是一樣的。這是 3D-IC 設計中非常重要的方法,它不會一成不變。”
當全 3D 布局布線成為可能時,這會變得更加困難。“今天最安全的回答是,‘我們不要分塊。讓我們將每個塊保留在一個模具上,我們將跨越模具邊界與他們交談。這樣做,你仍然有一個必須解決的 3D 布局分區(qū)問題,但你的簽核問題更簡單,因為至少你的塊簽核被限制在 2D 空間內,”Aitken 說。“學術著作表明,移動方塊并將它們散布在邊界上可以為您帶來額外的好處。但在大多數(shù)情況下,這些論文都忽略了諸如時鐘同步、芯片匹配以及當您嘗試執(zhí)行此類操作時會出現(xiàn)的其他問題。如果你把單獨的塊放在一個芯片上,你仍然有很多問題要解決,
審核編輯:劉清
-
pcb
+關注
關注
4369文章
23496瀏覽量
409962 -
EDA工具
+關注
關注
4文章
273瀏覽量
32890 -
片上系統(tǒng)
+關注
關注
0文章
188瀏覽量
27301 -
3D封裝
+關注
關注
9文章
141瀏覽量
27816 -
sip封裝
+關注
關注
4文章
68瀏覽量
15733 -
2.5D封裝
+關注
關注
0文章
24瀏覽量
346
發(fā)布評論請先 登錄
多芯粒2.5D/3D集成技術研究現(xiàn)狀

2.5D封裝為何成為AI芯片的“寵兒”?

3D封裝與系統(tǒng)級封裝的背景體系解析介紹

2.5D集成電路的Chiplet布局設計

一文詳解2.5D封裝工藝

最全對比!2.5D vs 3D封裝技術
2.5D封裝的熱力挑戰(zhàn)

深入剖析2.5D封裝技術優(yōu)勢及應用






 3D封裝與2.5D封裝比較
3D封裝與2.5D封裝比較
















評論