隨著制程技術的不斷逼近極限,進一步提升晶體管密度和性能變得愈發艱難,成本也日益高昂。在此背景下,先進封裝技術,特別是2.5D封裝,成為了半導體領域的重要突破口。2.5D封裝技術作為半導體領域的一項重要創新,不僅提高了芯片的性能和集成度,還為未來的芯片設計提供了更多的可能性。本文將深入剖析2.5D封裝技術的內涵、優勢及其在現代半導體工業中的應用。
一、芯片封裝的重要性
封裝作為半導體制造流程中的關鍵環節,其核心作用在于為電子晶片提供一個安全、穩定的外部環境,防止其受到溫度、濕度、灰塵等不利因素的影響。隨著制程技術的不斷進步,封裝技術同樣經歷了從簡單到復雜、從低級到高級的演變。在制程技術遭遇瓶頸,新工藝研發成本急劇上升的背景下,先進封裝技術成為了提升芯片性能、降低成本的重要途徑。
半導體行業的決策往往不僅僅基于技術的先進性,成本效益、商業模式及企業利益同樣占據著舉足輕重的地位。因此,在封裝技術的選擇上,企業往往需要綜合考慮多種因素,以實現最優化的資源配置。封裝技術的改進,本質上是在確保成本可控的前提下,不斷提升芯片間互聯的密度與速度,從而滿足日益增長的性能需求。
二、多芯片集成的革命——2.5D封裝
2.5D封裝技術是一種介于傳統2D封裝與未來3D封裝之間的過渡性技術。它通過將多個芯片并排堆疊,并通過中介層實現高速互聯,從而大幅提升了數據傳輸速度和電源效率。這一技術的首次亮相,是在AMD發布Fury顯卡之時,隨后,各種基于2.5D封裝的解決方案如雨后春筍般涌現,包括CoWoS(Chip-on-Wafer-on-Substrate)、EMIB(Embedded Multi-die Interconnect Bridge)、FoCoS(Fan-out Chip-on-Chip Substrate)等。
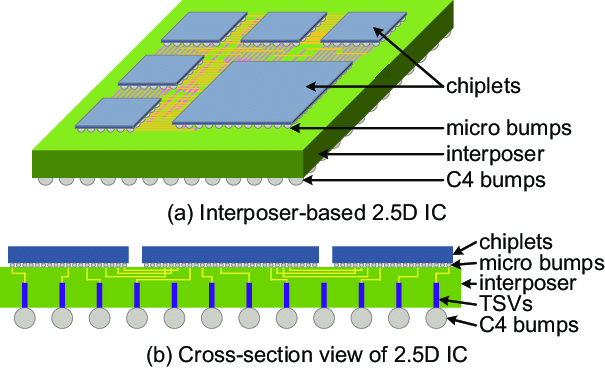
2.5D封裝的核心在于多芯片集成,并通過引入高密度I/O(輸入/輸出)接口,取代了傳統載板上的走線方式。這種設計不僅提高了數據傳輸速度,還使得內存、GPU和I/O等組件能夠更緊密地集成在一塊基板上,從而顯著提升了傳輸帶寬。目前,2.5D封裝技術并沒有嚴格的定義,其應用往往與HBM(High Bandwidth Memory,高帶寬內存)顯存緊密相連,但并非必須使用TSV(Through Silicon Via,硅通孔)技術,中介層的材質也沒有統一規定。
三、2.5D封裝的四大優勢
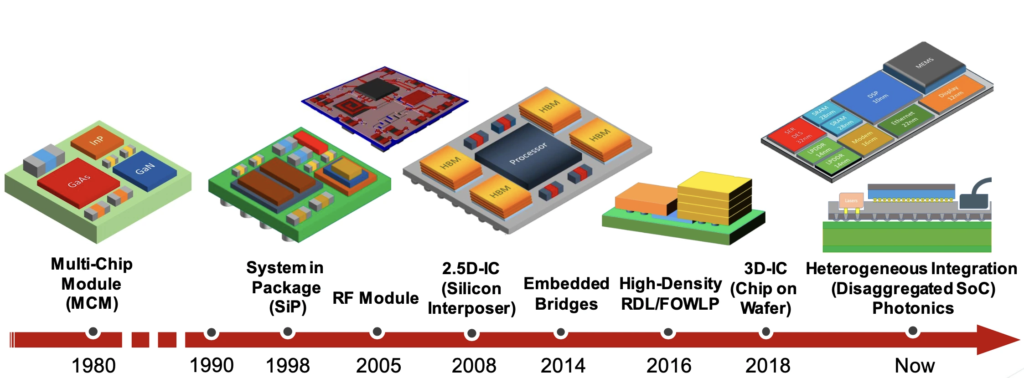
提高傳輸速率
借助2.5D先進封裝技術,可以將內存、GPU和I/O等組件集成在一塊基板上,顯著拉近它們與處理器的距離,從而大幅提升數據傳輸速度。這種設計不僅提高了系統的整體性能,還降低了數據傳輸過程中的延遲和功耗。
提高連接密度
相比傳統的2D封裝技術,2.5D/3D封裝技術可以封裝7-8倍以上的I/O數增量,同時實現更高密度的芯片/模組整合。這不僅有助于提升芯片的性能和功耗表現,還為未來的芯片設計提供了更多的可能性。
提高集成度
使用2.5D封裝技術,可以將應用處理器和存儲器芯片等組件以更高的集成度封裝在一起,從而顯著減少芯片面積。據估計,這種技術可以使得芯片面積減少約30%至40%,這對于提升設備的便攜性和降低成本具有重要意義。
降低功耗
硅中間層作為2.5D封裝技術的重要組成部分,具有出色的散熱性能。通過優化熱設計,可以使得芯片在運行過程中產生的熱量更有效地散發出去,從而降低功耗。據估計,這種技術可以節省高達40%或更高的功耗,這對于提升設備的續航能力和減少能源浪費具有重要意義。
四、2.5D封裝技術的市場應用
目前,2.5D封裝技術已經廣泛應用于高性能計算、數據中心、人工智能、消費電子等領域。隨著技術的不斷進步和成本的逐漸降低,這一技術有望在未來幾年內實現更廣泛的應用。特別是在5G、物聯網等新興技術的推動下,對于高性能、低功耗芯片的需求將不斷增長,為2.5D封裝技術的發展提供了廣闊的市場空間。
然而,2.5D封裝技術也面臨著一些挑戰。例如,如何進一步提高中介層的性能和可靠性、如何降低生產成本、如何優化芯片間的互聯結構等。為了解決這些問題,科研人員正在不斷探索新的材料、工藝和設計方法,以推動2.5D封裝技術的持續進步。
-
封裝
+關注
關注
128文章
8598瀏覽量
144990 -
芯片封裝
+關注
關注
11文章
576瀏覽量
31313 -
2.5D封裝
+關注
關注
0文章
24瀏覽量
324
原文標題:【芯片封裝】2.5D封裝如何提高芯片的性能?
文章出處:【微信號:深圳市賽姆烯金科技有限公司,微信公眾號:深圳市賽姆烯金科技有限公司】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
2.5D/3D芯片-封裝-系統協同仿真技術研究
2.5D封裝應力翹曲設計過程






 深入剖析2.5D封裝技術優勢及應用
深入剖析2.5D封裝技術優勢及應用
















評論