橫向氮化鎵高電子遷移率晶體管(HEMT)在中低功率轉換應用領域正呈現強勁增長態勢。將這一材料體系擴展至更高電壓等級需要器件設計和襯底技術的創新。本文總結了臺灣研究團隊在工程襯底上開發1500V擊穿電壓(BV)GaN HEMT器件的研究成果。
Qromis襯底技術(QST?)
硅基氮化鎵(GaN-on-Si)是目前商用功率HEMT器件的首選技術,其主流最高工作電壓范圍目前為650V及以下。當嘗試將該技術擴展到更高電壓范圍時,會面臨諸多挑戰:GaN與Si之間顯著的熱膨脹系數(CTE)差異會導致高缺陷密度、晶圓翹曲和薄膜開裂,進而影響器件可靠性和良率,且晶圓直徑越大問題越嚴重。
業界已提出碳化硅基氮化鎵(GaN-on-SiC)和藍寶石基氮化鎵(GaN-on-sapphire)等替代方案。雖然GaN-on-SiC已商業應用于射頻和微波領域,但SiC的高成本使其難以在消費級和工業級功率器件市場實現商業化。高性價比藍寶石襯底上雖已實現高壓HEMT演示,但其較低的熱導率在高功率應用中存在局限。而理想的原生GaN-on-GaN技術則受限于大尺寸GaN襯底的匱乏。
Qromis開發的GaN-on-QST?平臺提供了一種無應力、可擴展的解決方案。QST?襯底采用類似絕緣體上硅(SOI)的結構設計:以多晶氮化鋁陶瓷為核心,外覆經過特殊設計的復合層及晶體硅(111)氧化層(BOX),該結構能有效促進GaN/AlGaN外延生長。
該襯底符合SEMI標準且兼容CMOS工藝線。其核心優勢在于熱膨脹系數與GaN在寬溫域內(包括高溫外延生長及后續冷卻過程)完美匹配,這使得器件既能通過增加外延層厚度提升耐壓,又可實現大尺寸晶圓制造。正如硅基CMOS技術發展中代工模式對Fabless設計公司的關鍵作用,晶圓代工同樣推動著GaN技術的普及。世界先進(VIS)已成為首家提供200mm QST?襯底650V增強型GaN HEMT代工服務的廠商。此外,Qromis已將襯底技術授權給信越化學,任何擁有產線的GaN企業均可采購。
1500V耐壓GaN-on-QST?器件
本研究在QST?襯底的氮化鋁成核層上方采用了超晶格(SL)緩沖層結構(圖1)。與傳統硅襯底相比,QST?襯底允許使用更薄且質量更優的緩沖層,從而提升器件熱電性能。
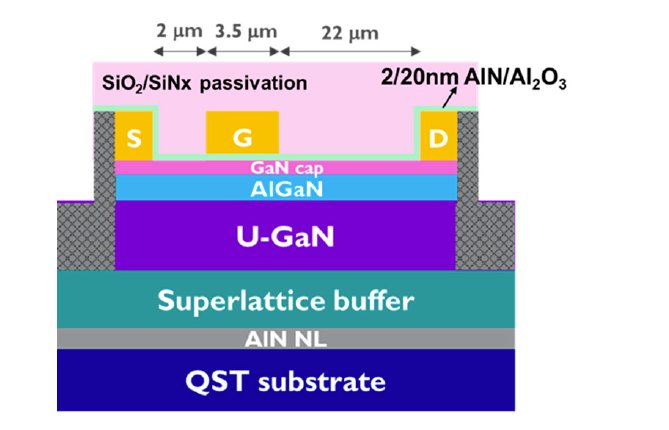 圖1
圖1實驗采用2μm厚的標準AlN/GaN超晶格層。超晶格上方的高阻碳摻雜GaN層(GaN:C)作為緩沖層組成部分,其厚度在1-3μm間調整以研究對擊穿電壓的影響。
制備的耗盡型(d-mode)MIS-HEMT器件閾值電壓為-12.7V。圖2對比了器件關態特性與傳統硅基GaN器件的差異,可得出以下結論:
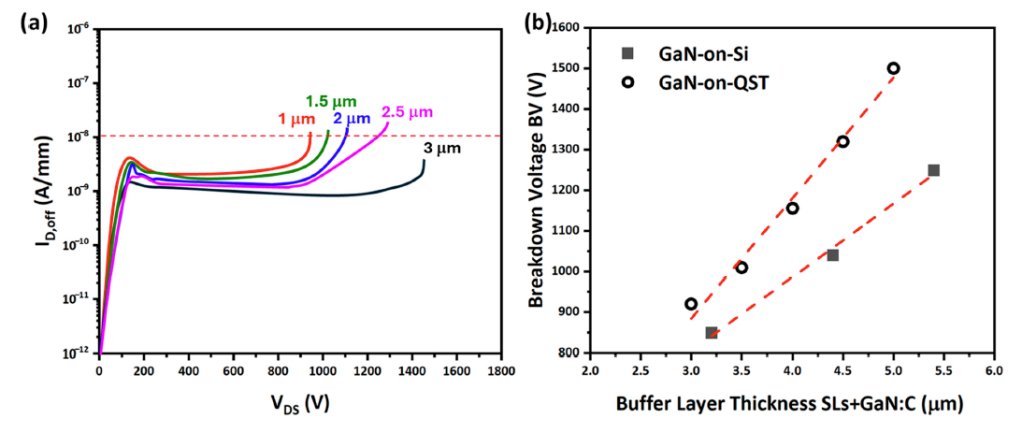 圖2
圖2? GaN:C層增厚可提升擊穿電壓,3μm樣品實現1500V耐壓(總緩沖層厚度5μm=SL+GaN:C)
? 相同耐壓下QST?襯底緩沖層可減薄1μm以上(以1200V為例)
? QST?襯底能增強GaN:C層效能,同等厚度下尤其在高壓段可獲得更高耐壓
為深入分析機理,研究者進行了TCAD仿真。已知陷阱輔助熱場發射(TA-TFE)會在關態高電場(特別是高負柵壓)下引發HEMT源漏泄漏:柵極下方橫向能帶抬升導致電子-空穴對產生——空穴通過緩沖層位錯陷阱形成,電子則從漏極抽取。當緩沖層空穴生成率較低時,高場下源漏泄漏增量較小;但當空穴濃度因復合增強達到碳摻雜濃度時,碳摻雜抑制泄漏的效果將失效。實驗數據校準后的TCAD TA-TFE模型仿真結果見圖3-4。
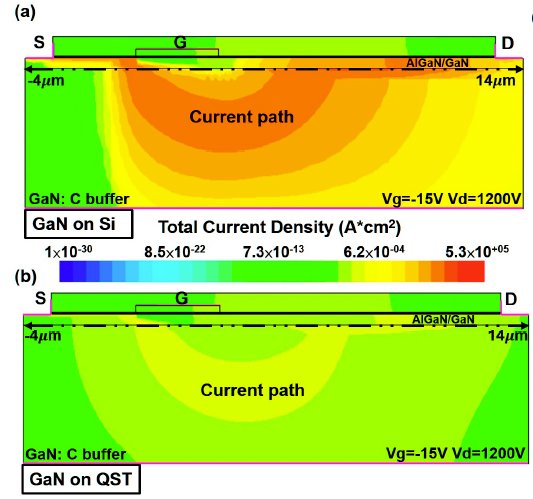 圖3
圖3圖4顯示QST?器件的泄漏電流隨漏壓增加幾乎無變化。研究者認為這是由于QST?襯底位錯密度更低、GaN晶體質量更優,使碳摻雜緩沖層效能提升,從而降低陷阱密度和泄漏電流。
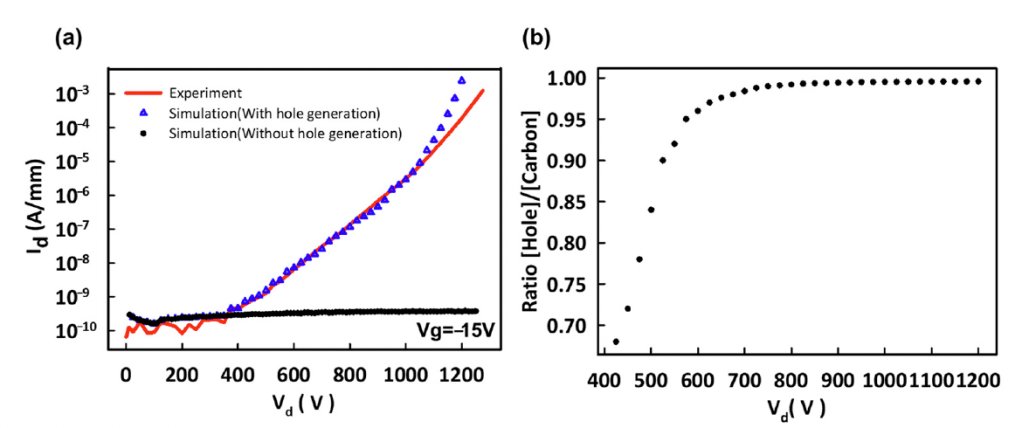 圖4
圖45K低溫光致發光(PL)光譜分析驗證了仿真與電性能結果:QST?樣品在360nm GaN特征峰表現出更窄更強的信號,表明其更優的結晶質量;而硅基GaN在可見光波段的強峰可能源于襯底材料的高密度深能級陷阱。
QST?襯底將持續升級:計劃2025年推出的第二代產品將采用SiC替代Si作為籽晶層以降低外延晶格失配,涵蓋6/8英寸晶圓規格;后續還將采用GaN籽晶層實現終極晶格匹配。信越化學近期宣布開發的300mm專用襯底更彰顯QST?技術對大尺寸GaN制造的支撐能力。
-
晶體管
+關注
關注
77文章
10029瀏覽量
142111 -
功率器件
+關注
關注
42文章
1947瀏覽量
92959 -
GaN
+關注
關注
19文章
2217瀏覽量
77081
發布評論請先 登錄
同是功率器件,為什么SiC主要是MOSFET,GaN卻是HEMT
基于德州儀器GaN產品實現更高功率密度
GaN器件在Class D上的應用優勢
低成本垂直GaN(氮化鎵)功率器件的優勢
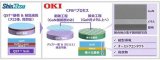
首個在6英寸藍寶石襯底上的1700V GaN HEMTs器件發布






 浮思特 | 在工程襯底上的GaN功率器件實現更高的電壓路徑
浮思特 | 在工程襯底上的GaN功率器件實現更高的電壓路徑


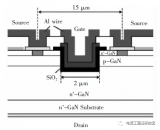
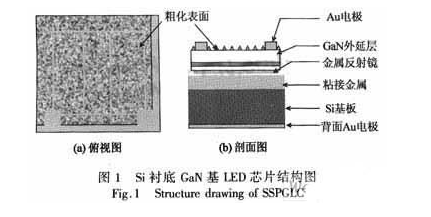
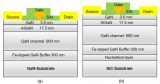











評論