隨著電子設(shè)備向小型化、高性能化方向發(fā)展,集成電路封裝技術(shù)面臨著前所未有的挑戰(zhàn)。QFN(Quad Flat No-lead)封裝因其優(yōu)異的散熱性能、小型化尺寸和良好的電性能,在高端電子產(chǎn)品中得到了廣泛應(yīng)用。然而,隨著封裝尺寸的不斷縮小和功率密度的持續(xù)提高,封裝可靠性問(wèn)題日益突出,特別是銅線鍵合與塑封材料的匹配性問(wèn)題已成為制約QFN封裝可靠性的關(guān)鍵因素。
本文科準(zhǔn)測(cè)控小編將重點(diǎn)從力學(xué)性能角度分析FSF和FSFF兩種鍵合模式對(duì)QFN封裝可靠性的影響,結(jié)合Beta S100推拉力測(cè)試機(jī)等檢測(cè)設(shè)備,系統(tǒng)評(píng)估了鍵合界面的力學(xué)特性及其在可靠性測(cè)試中的表現(xiàn),為高可靠性QFN封裝的設(shè)計(jì)與制造提供了重要參考。
一、力學(xué)性能分析原理
1、鍵合界面力學(xué)原理
銅線鍵合過(guò)程本質(zhì)上是通過(guò)機(jī)械力(壓力)和超聲波能量共同作用,在銅球與鋁焊盤(pán)之間形成可靠的冶金連接。這一過(guò)程中涉及多種力學(xué)現(xiàn)象:
塑性變形:鍵合壓力使銅球和鋁焊盤(pán)發(fā)生塑性變形,增加接觸面積
摩擦焊接:超聲波振動(dòng)產(chǎn)生微觀摩擦,破壞表面氧化層,促進(jìn)金屬間擴(kuò)散
金屬間化合物(IMC)形成:Cu-Al界面在熱力學(xué)驅(qū)動(dòng)下形成多種成分的IMC層
2、鍵合強(qiáng)度評(píng)價(jià)標(biāo)準(zhǔn)
根據(jù)JESD22-B116B和MIL-STD-883K標(biāo)準(zhǔn),鍵合界面的力學(xué)性能主要通過(guò)以下參數(shù)評(píng)價(jià):
焊球推力(Ball Shear):評(píng)估焊球與焊盤(pán)之間的結(jié)合強(qiáng)度
焊線拉力(Wire Pull):評(píng)估鍵合線與焊球/第二鍵合點(diǎn)之間的連接強(qiáng)度
彈坑測(cè)試(Crater Test):評(píng)估鍵合過(guò)程對(duì)下層硅芯片的損傷程度
二、實(shí)驗(yàn)設(shè)備與方法
1、Beta S100推拉力測(cè)試儀

A、設(shè)備介紹
Beta S100推拉力測(cè)試機(jī)是一款專為微電子封裝行業(yè)設(shè)計(jì)的高精度測(cè)試設(shè)備。它能夠滿足多種封裝形式的測(cè)試需求,包括QFN、BGA、CSP、TSOP等,并支持靜態(tài)和動(dòng)態(tài)的拉力、推力及剪切力測(cè)試。其廣泛的應(yīng)用范圍覆蓋了半導(dǎo)體封裝、LED封裝、光電子器件、PCBA電子組裝、汽車(chē)電子以及航空航天等多個(gè)領(lǐng)域。
B、核心優(yōu)勢(shì)
a、高精度測(cè)量
采用先進(jìn)的傳感器技術(shù)和自主研發(fā)的數(shù)據(jù)采集系統(tǒng),Beta S100能夠提供高精度的測(cè)試數(shù)據(jù),確保測(cè)試結(jié)果的可靠性和重復(fù)性。
b、多功能設(shè)計(jì)
設(shè)備支持多種測(cè)試模塊的更換,用戶可根據(jù)具體需求選擇合適的模塊。系統(tǒng)會(huì)自動(dòng)識(shí)別并調(diào)整到最佳量程,極大地提高了設(shè)備的靈活性和適用性。
c、智能化操作
配備專用軟件,操作界面簡(jiǎn)潔直觀,功能強(qiáng)大。設(shè)備自帶SPC(統(tǒng)計(jì)過(guò)程控制)等多種數(shù)據(jù)統(tǒng)計(jì)功能,支持多種數(shù)據(jù)輸出格式,便于用戶進(jìn)行數(shù)據(jù)分析和報(bào)告生成。
d、自動(dòng)化測(cè)試
Beta S100配備智能視覺(jué)系統(tǒng)和深度學(xué)習(xí)技術(shù),可自動(dòng)識(shí)別測(cè)試位置,減少人工誤差,提高測(cè)試效率和準(zhǔn)確性。
2、推刀或鉤針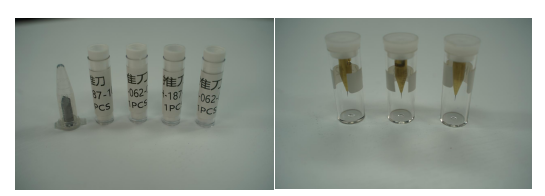

3、常用工裝夾具

四、測(cè)試流程
步驟一、樣品制備
塑封后樣品經(jīng)研磨拋光制備鍵合界面切片
激光開(kāi)蓋露出鍵合點(diǎn)用于拉力測(cè)試
步驟二、焊球推力測(cè)試
根據(jù)JESD22-B116B標(biāo)準(zhǔn)設(shè)置測(cè)試參數(shù)
剪切工具距離芯片表面10μm
剪切速度200μm/s
記錄最大剪切力及失效模式
步驟三、焊線拉力測(cè)試
鉤子置于鍵合線中點(diǎn)位置
拉力方向垂直于芯片表面
拉伸速度200μm/s
記錄最大拉力及斷裂位置
步驟四、彈坑測(cè)試
去除焊球后觀察鋁焊盤(pán)殘留情況
評(píng)估硅基板損傷程度
步驟五、力學(xué)性能測(cè)試結(jié)果與分析
1、鍵合模式對(duì)力學(xué)性能的影響
通過(guò)Beta S100推拉力測(cè)試機(jī)獲得的測(cè)試數(shù)據(jù)顯示:

2、失效模式分析
BHAST測(cè)試中FSF模式失效樣品的力學(xué)分析顯示:
失效位置:全部發(fā)生在Cu-Al界面
IMC形貌:呈現(xiàn)多孔狀腐蝕特征
力學(xué)性能退化:失效樣品推力值下降30-40%
而FSFF模式樣品在所有可靠性測(cè)試中均未出現(xiàn)力學(xué)性能退化,表明其界面具有更好的環(huán)境穩(wěn)定性。
以上就是小編介紹的有關(guān)于銅線鍵合模式和塑封料對(duì)QFN 封裝可靠性的影響相關(guān)內(nèi)容了,希望可以給大家?guī)?lái)幫助!如果您還想了解更多關(guān)于推拉力測(cè)試機(jī)怎么使用視頻和圖解,使用步驟及注意事項(xiàng)、作業(yè)指導(dǎo)書(shū),原理、怎么校準(zhǔn)和使用方法視頻,推拉力測(cè)試儀操作規(guī)范、使用方法和測(cè)試視頻,焊接強(qiáng)度測(cè)試儀使用方法和鍵合拉力測(cè)試儀等問(wèn)題,歡迎您關(guān)注我們,也可以給我們私信和留言,【科準(zhǔn)測(cè)控】小編將持續(xù)為大家分享推拉力測(cè)試機(jī)在鋰電池電阻、晶圓、硅晶片、IC半導(dǎo)體、BGA元件焊點(diǎn)、ALMP封裝、微電子封裝、LED封裝、TO封裝等領(lǐng)域應(yīng)用中可能遇到的問(wèn)題及解決方案。
審核編輯 黃宇
-
封裝
+關(guān)注
關(guān)注
128文章
8583瀏覽量
144960 -
qfn
+關(guān)注
關(guān)注
3文章
209瀏覽量
56939 -
推拉力測(cè)試機(jī)
+關(guān)注
關(guān)注
0文章
145瀏覽量
530
發(fā)布評(píng)論請(qǐng)先 登錄
從檢測(cè)到優(yōu)化:推拉力測(cè)試儀在半導(dǎo)體封裝中的全流程應(yīng)用解析

從理論到實(shí)踐:推拉力測(cè)試機(jī)在微電子封裝失效分析中的關(guān)鍵作用

提升功率半導(dǎo)體可靠性:推拉力測(cè)試機(jī)在封裝工藝優(yōu)化中的應(yīng)用

揭秘推拉力測(cè)試機(jī):如何助力于IGBT功率模塊封裝測(cè)試?

提升QFN封裝可靠性的關(guān)鍵:附推拉力測(cè)試機(jī)檢測(cè)方案
基于推拉力測(cè)試機(jī)的化學(xué)鍍鎳鈀金電路板金絲鍵合可靠性驗(yàn)證

ASTM F1269標(biāo)準(zhǔn)解讀:推拉力測(cè)試機(jī)在BGA焊球可靠性測(cè)試中的應(yīng)用

BGA封裝焊球推力測(cè)試解析:評(píng)估焊點(diǎn)可靠性的原理與實(shí)操指南

你不知道的COB封裝測(cè)試方法,快來(lái)看看推拉力測(cè)試機(jī)的應(yīng)用!
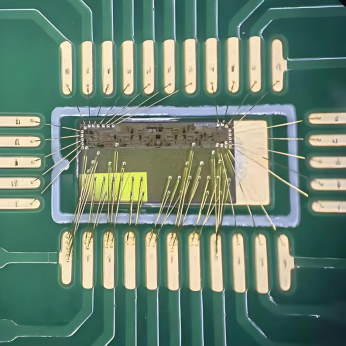
Beta S100推拉力測(cè)試機(jī)助力激光通訊器件封裝質(zhì)量檢測(cè)!

粗鋁線鍵合強(qiáng)度測(cè)試:如何選擇合適的推拉力測(cè)試機(jī)?
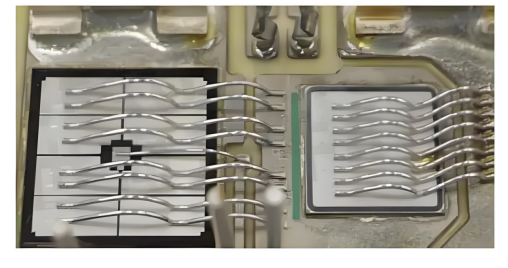
推拉力測(cè)試機(jī)助力于晶圓焊點(diǎn)推力測(cè)試詳解:從原理到實(shí)操

多功能推拉力測(cè)試機(jī):原理及應(yīng)用

多功能推拉力測(cè)試機(jī)測(cè)試費(fèi)用是多少?






 推拉力測(cè)試機(jī)應(yīng)用解析:如何通過(guò)力學(xué)性能評(píng)估提升QFN封裝可靠性
推拉力測(cè)試機(jī)應(yīng)用解析:如何通過(guò)力學(xué)性能評(píng)估提升QFN封裝可靠性











評(píng)論