引言
在半導體制造領域,硅片作為核心基礎材料,其質量參數對芯片性能和生產良率有著重要影響。TTV、Bow、Warp、TIR 等參數是衡量硅片質量與特性的關鍵指標。本文將對這些參數進行詳細定義與闡述,明確其在硅片制造和應用中的重要意義。
TTV(Total Thickness Variation,總厚度變化)
定義
TTV 指的是在硅片同一表面上,硅片最大厚度與最小厚度的差值,用于表征硅片厚度的均勻性。其計算公式為:TTV = T_{max} - T_{min},其中T_{max}為硅片表面的最大厚度值,T_{min}為硅片表面的最小厚度值 。在先進半導體制造工藝中,對硅片 TTV 的要求極為嚴格,通常需控制在幾微米甚至更小的范圍內,以確保后續光刻、刻蝕等工藝的精確性。
測量意義與方法
TTV 值過大,會導致光刻膠涂覆不均勻、光刻圖形轉移精度下降,影響芯片的電學性能和成品率。目前,常用激光掃描技術測量硅片 TTV,通過激光傳感器在硅片表面進行多點掃描,獲取不同位置的厚度數據,進而計算出 TTV 值 。
Bow(彎曲度)
定義
Bow 是指硅片受外力或內部應力作用,導致硅片中心面偏離理想平面,硅片中心到邊緣參考平面的最大距離。它反映了硅片在某一方向上的彎曲程度 。硅片在制造、加工或運輸過程中,因溫度變化、機械應力等因素,容易產生 Bow 現象。
測量意義與方法
Bow 值過大可能造成光刻時曝光不均勻、鍵合工藝中硅片貼合不良等問題。一般采用非接觸式光學測量方法,如激光干涉儀,通過測量硅片表面的干涉條紋,計算出硅片的 Bow 值。
Warp(翹曲度)
定義
Warp 表示硅片整個表面偏離其理想平面的程度,是硅片表面最高點與最低點之間的距離。與 Bow 不同,Warp 考慮的是硅片整體表面的起伏情況,能更全面地反映硅片的形狀畸變 。
測量意義與方法
較大的 Warp 值會影響硅片在設備中的定位精度,導致工藝處理的不一致性。測量 Warp 常用的方法是光學輪廓儀測量,通過對硅片表面進行三維掃描,獲取表面形貌數據,從而確定 Warp 值。
TIR(Total Indicator Reading,總指示讀數)
定義
TIR 指的是在硅片表面上,測量點相對于某一基準平面的高度差的最大值與最小值之差。它綜合反映了硅片表面的平整度和形狀誤差 ,在一定程度上體現了硅片表面的整體質量狀況。
測量意義與方法
TIR 值過大可能影響硅片與其他器件的集成效果。通常使用高精度的表面輪廓測量儀進行 TIR 測量,通過逐點掃描硅片表面,獲取各點高度數據,進而計算出 TIR 值。
TopMap Micro View白光干涉3D輪廓儀
一款可以“實時”動態/靜態 微納級3D輪廓測量的白光干涉儀
1)一改傳統白光干涉操作復雜的問題,實現一鍵智能聚焦掃描,亞納米精度下實現卓越的重復性表現。
2)系統集成CST連續掃描技術,Z向測量范圍高達100mm,不受物鏡放大倍率的影響的高精度垂直分辨率,為復雜形貌測量提供全面解決方案。
3)可搭載多普勒激光測振系統,實現實現“動態”3D輪廓測量。

實際案例

1,優于1nm分辨率,輕松測量硅片表面粗糙度測量,Ra=0.7nm

2,毫米級視野,實現5nm-有機油膜厚度掃描
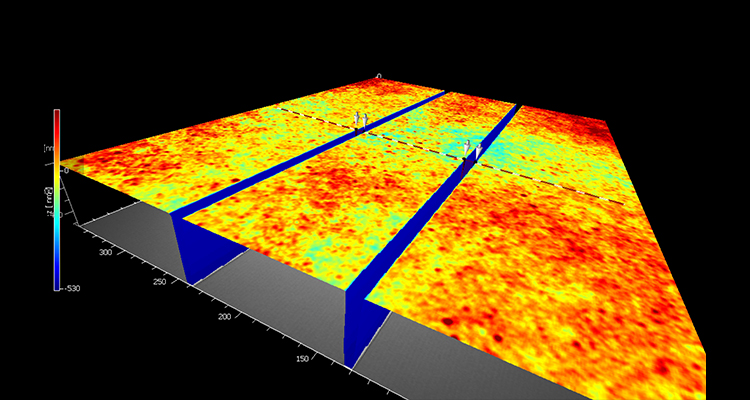
3,卓越的“高深寬比”測量能力,實現光刻圖形凹槽深度和開口寬度測量。
審核編輯 黃宇
-
硅片
+關注
關注
13文章
381瀏覽量
35139 -
干涉儀
+關注
關注
0文章
103瀏覽量
10378
發布評論請先 登錄
晶圓邊緣 TTV 測量的意義和影響

wafer晶圓厚度(THK)翹曲度(Warp)彎曲度(Bow)等數據測量的設備
wafer晶圓幾何形貌測量系統:厚度(THK)翹曲度(Warp)彎曲度(Bow)等數據測量
wafer晶圓幾何形貌測量系統:厚度(THK)翹曲度(Warp)彎曲度(Bow)等數據測量

利用 Bow 與 TTV 差值于再生晶圓制作超平坦芯片的方法

降低晶圓 TTV 的磨片加工方法

碳化硅襯底的特氟龍夾具相比其他吸附方案,對于測量碳化硅襯底 BOW/WARP 的影響

不同的氮化鎵襯底的吸附方案,對測量氮化鎵襯底 BOW/WARP 的影響

氮化鎵襯底的環吸方案相比其他吸附方案,對于測量氮化鎵襯底 BOW/WARP 的影響

不同的碳化硅襯底的吸附方案,對測量碳化硅襯底 BOW/WARP 的影響

碳化硅襯底的環吸方案相比其他吸附方案,對于測量碳化硅襯底 BOW/WARP 的影響

晶圓的環吸方案相比其他吸附方案,對于測量晶圓 BOW/WARP 的影響

硅拋光片的主要技術指標、測試標準及硅片加工參數的測量方法

降低晶圓TTV的磨片加工有哪些方法?






 硅片的 TTV,Bow, Warp,TIR 等參數定義
硅片的 TTV,Bow, Warp,TIR 等參數定義











評論