一、CMP 工藝與拋光材料的核心價值
化學機械拋光(Chemical Mechanical Planarization,CMP) 是半導體制造中實現晶圓表面全局平坦化的關鍵工藝,通過 “化學腐蝕 + 機械研磨” 的協同作用,去除晶圓表面多余材料,確保后續光刻、沉積等制程的精度。在 7nm 及以下先進制程中,單顆芯片需經歷 10-15 次 CMP 步驟,而拋光材料的性能直接決定了晶圓的平整度、缺陷率和良率,是半導體產業鏈中 “卡脖子” 的關鍵材料之一。
二、半導體 CMP 拋光材料的核心組成
CMP 拋光材料是一個 “系統級” 組合,主要包括拋光液(Slurry)、拋光墊(Pad)、拋光墊修整器(Conditioner) 三大核心組件,三者協同作用決定拋光效果:
1. 拋光液(CMP Slurry):化學與機械作用的核心載體
拋光液是 CMP 中最關鍵的耗材,由研磨顆粒、化學添加劑(氧化劑、抑制劑、pH 調節劑等)和去離子水組成,占 CMP 材料成本的 50% 以上。其核心功能是通過化學腐蝕軟化晶圓表面材料,同時通過研磨顆粒的機械作用去除腐蝕層,實現精準平坦化。
按應用場景可分為三大類:
? 硅襯底拋光液:用于晶圓襯底(硅片)的粗拋與精拋,以膠體二氧化硅(SiO?) 為主要研磨顆粒,配合弱堿性溶液(pH 9-11),實現納米級表面粗糙度(Ra<0.1nm)。
? 金屬層拋光液:針對銅、鎢、鋁等金屬互連層,如銅拋光液以氧化鋁(Al?O?) 為研磨顆粒,加入 H?O?作為氧化劑(將 Cu 氧化為 Cu2?),并通過苯并三唑(BTA)抑制過度腐蝕,確保金屬線寬精度。
? 介電層拋光液:用于氧化硅(SiO?)、氮化硅(Si?N?)等絕緣層,以氧化鈰(CeO?) 為核心顆粒(與 SiO?反應性強,選擇性高),適配淺溝槽隔離(STI)、柵極結構等制程。
2. 拋光墊(CMP Pad):機械研磨的 “工作面”
拋光墊是晶圓與拋光液接觸的介質,主要作用是:① 均勻承載研磨顆粒和拋光液;② 提供機械研磨的壓力傳導;③ 及時排出拋光產生的碎屑。其性能由材料、結構和硬度決定:
? 材料類型:主流為聚氨酯(PU)(硬度高、耐磨性強,占市場 80%),其次是無紡布 + 樹脂復合墊(適用于低壓力拋光,減少晶圓損傷)。
? 結構設計:表面多為 “多孔蜂窩狀”,孔隙率(20%-40%)影響拋光液的留存與碎屑排出;硬度(Shore D 60-85)需匹配不同材料(如金屬拋光用高硬度墊,介電層用中低硬度墊)。
3. 拋光墊修整器(Conditioner):維持拋光穩定性的 “校準工具”
拋光墊在使用中會因磨損、碎屑堵塞導致表面狀態變化(如硬度下降、平整度變差),修整器的作用是通過金剛石顆粒(粒徑 50-200μm) 對拋光墊表面進行微量切削,恢復其粗糙度和孔隙結構,確保每片晶圓的拋光一致性。
? 關鍵指標:金剛石顆粒分布均勻性、結合強度(避免顆粒脫落污染晶圓)、使用壽命(通常對應 50-100 片晶圓拋光)。
三、應用場景:覆蓋半導體全制程
CMP 拋光材料的應用貫穿半導體制造的 “前道(FEOL)、中道(MOL)、后道(BEOL)” 全流程,具體場景包括:
? 前道制程:硅片襯底平坦化、淺溝槽隔離(STI)拋光、柵極(Gate)材料拋光(如 polysilicon);
? 中道制程:金屬柵極(Metal Gate)拋光、接觸孔(Contact)平坦化;
? 后道制程:銅互連層(Damascene 結構)拋光、介質層(ILD)拋光;
? 先進封裝:3D IC 堆疊中的晶圓級封裝(WLP)表面平坦化、Chiplet 間的鍵合面拋光。
四、市場格局與發展趨勢
1. 市場規模:隨先進制程升級快速增長
2024 年全球半導體 CMP 材料市場規模約85 億美元,其中拋光液占比 55%(約 47 億美元),拋光墊占 30%(約 25 億美元),修整器占 15%(約 13 億美元)。預計到 2028 年,隨著 3nm/2nm 制程量產、3D NAND 堆疊層數突破 500 層,市場規模將突破 130 億美元,年復合增長率(CAGR)達 11%。
2. 競爭格局:海外壟斷與國產突破并存
? 國際巨頭:長期壟斷高端市場,如:
? 拋光液:美國 Cabot Microelectronics(全球市占率 35%,主打金屬拋光液)、日本 Fujifilm(收購 Hitachi Chemical 后,介電層拋光液領先);
? 拋光墊:美國 Dow(原陶氏化學,市占率 40%,聚氨酯墊技術標桿)、美國 3M(無紡布復合墊龍頭);
? 修整器:美國 Applied Materials(設備 + 修整器一體化方案)、日本 Disco。
? 國產進展:中國企業從中低端切入,逐步突破高端市場,如:
? 拋光液:安集科技(銅拋光液國內市占率超 20%,進入中芯國際、長江存儲供應鏈)、鼎龍股份(硅襯底拋光液替代進口);
? 拋光墊:華海清科(與天津大學合作,拋光墊產品進入 14nm 制程驗證)、天通股份(布局聚氨酯墊量產)。
3. 技術趨勢:更高精度、更低缺陷、更環保
? 高選擇性拋光:開發 “化學機械協同可控” 的拋光液,減少過拋光(Over-polishing),如針對 3D NAND 的氮化硅 / 氧化硅拋光液,選擇性(拋光速率比)需達 100:1 以上;
? 低缺陷化:通過納米級研磨顆粒(粒徑 < 50nm)、無金屬離子添加劑(如無鐵離子拋光液),降低晶圓表面劃痕、金屬污染;
? 環保與循環:開發可降解拋光液(生物基添加劑)、拋光墊再生技術(通過激光修整延長壽命),降低碳排放;
? 智能化集成:將傳感器嵌入拋光墊 / 修整器,實時監測拋光壓力、溫度、研磨顆粒濃度,實現閉環控制(如應用于 TSMC 的 “Smart CMP” 系統)。
五、總結
半導體 CMP 拋光材料是先進制程 “微米級精度、納米級缺陷” 要求的核心保障,其技術壁壘體現在材料配方、微觀結構設計與應用場景適配性上。隨著中國半導體產業鏈自主可控需求升級,CMP 材料國產化將迎來加速期,而 “技術創新 + 產業鏈協同” 是突破海外壟斷的關鍵。未來,適配 EUV 光刻、3D IC 等新技術的 CMP 材料,將成為企業競爭的戰略高地。
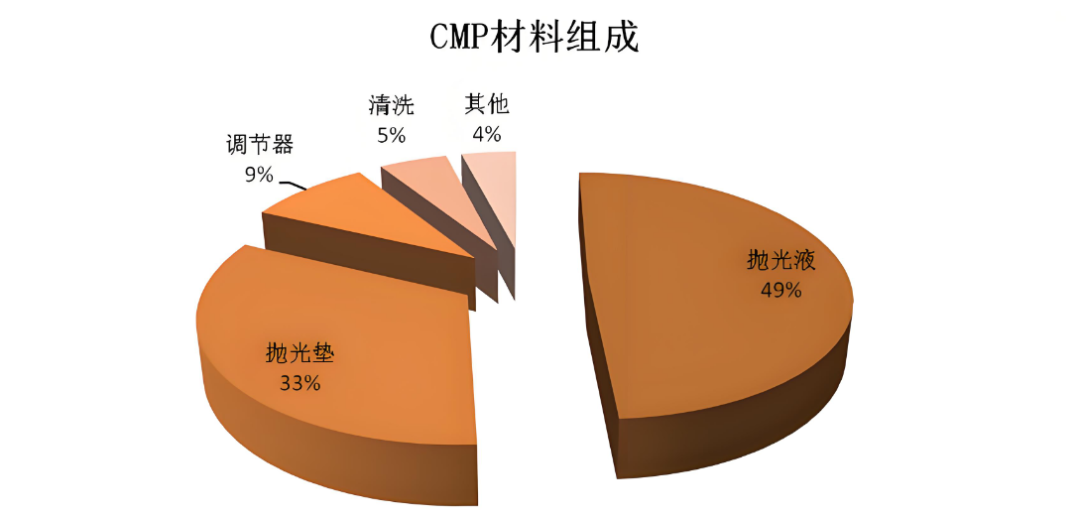


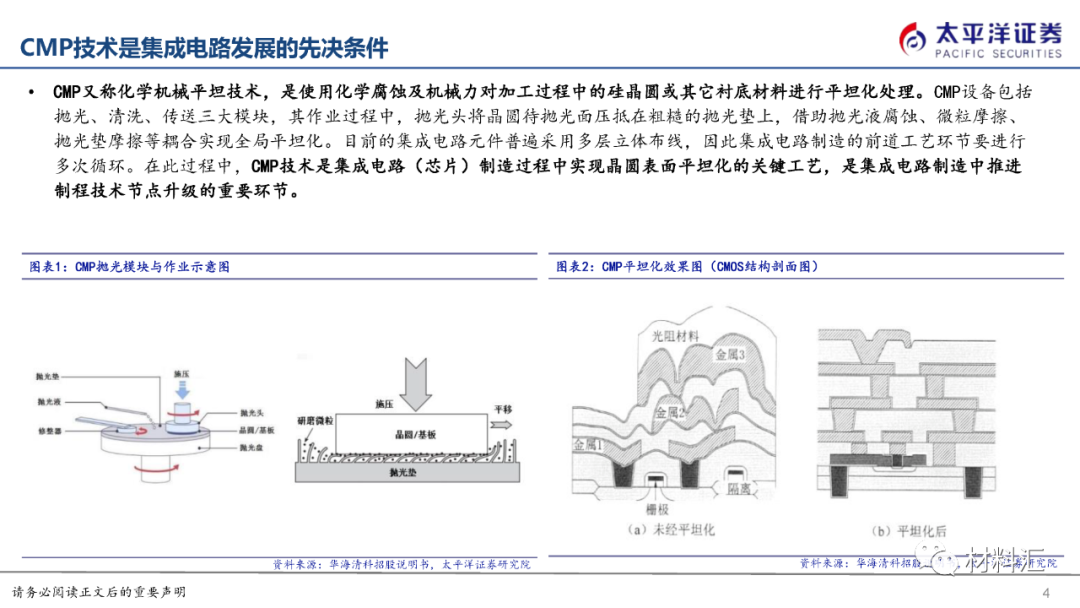
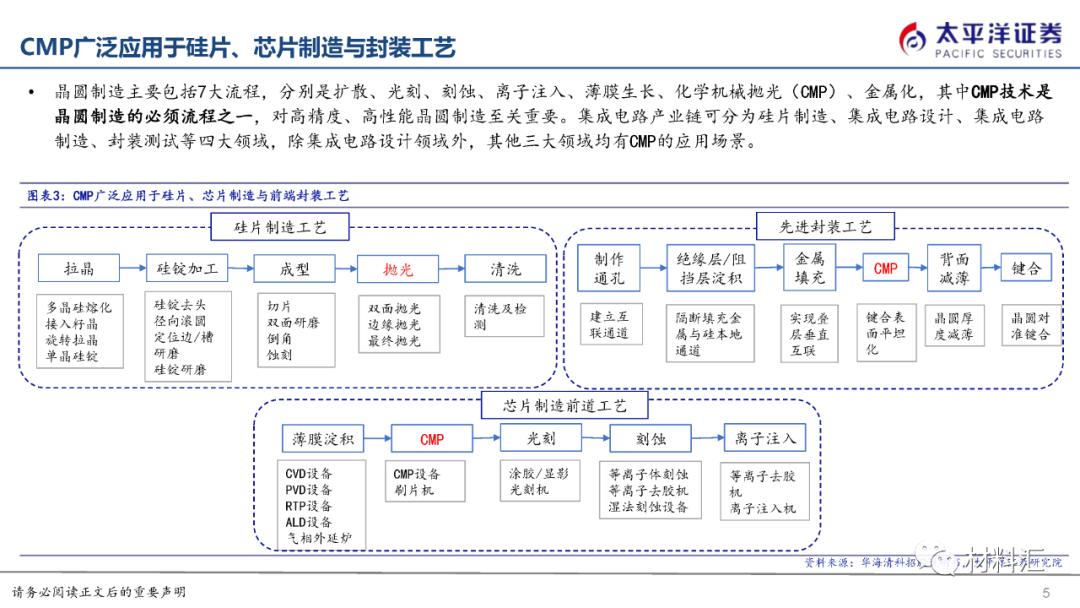










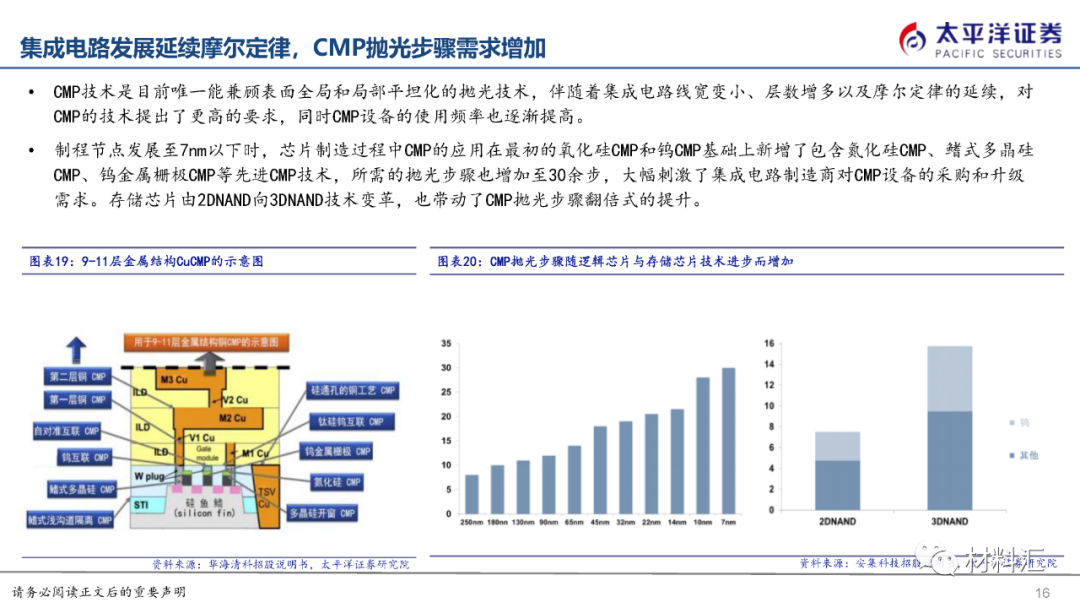




















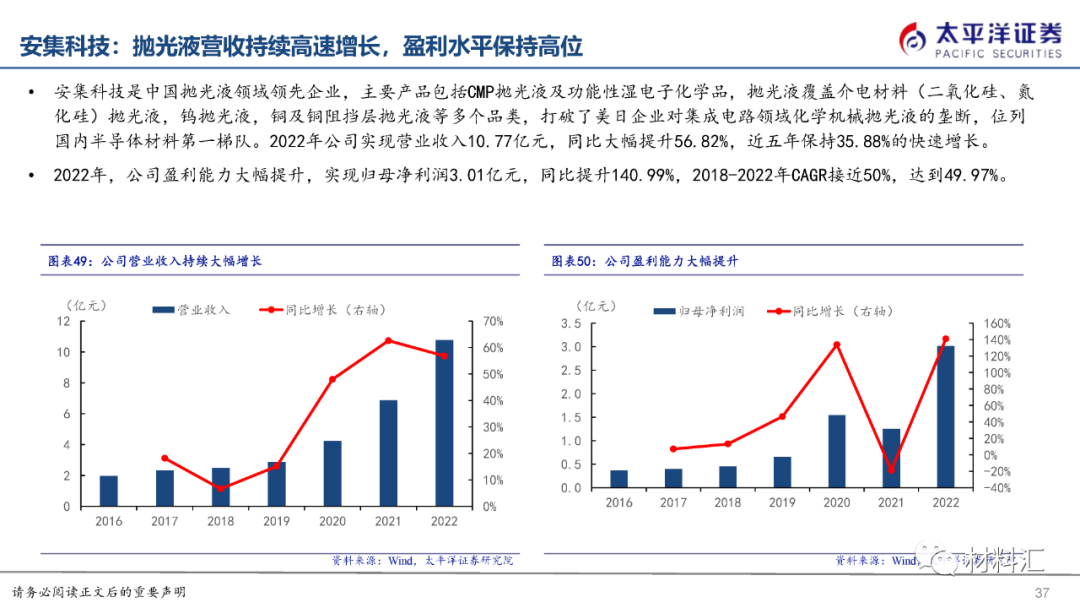








來源:太平洋證券,版權歸原作者所有
以上部分資料轉載“材料匯”網絡平臺,文章僅僅用于交流學習版權歸原作者。如有侵權請告知立刪。
-
半導體
+關注
關注
335文章
28832瀏覽量
236390 -
材料
+關注
關注
3文章
1342瀏覽量
27859 -
CMP
+關注
關注
6文章
156瀏覽量
26639 -
拋光
+關注
關注
0文章
58瀏覽量
11969
發布評論請先 登錄
上游設備和材料企業最新業績公布,傳遞出半導體行業回暖復蘇信號?

全球CMP拋光液大廠突發斷供?附CMP拋光材料企業盤點與投資邏輯(21361字)

精密傳感技術驅動半導體未來:明治傳感器在CMP/量測/減薄機的應用
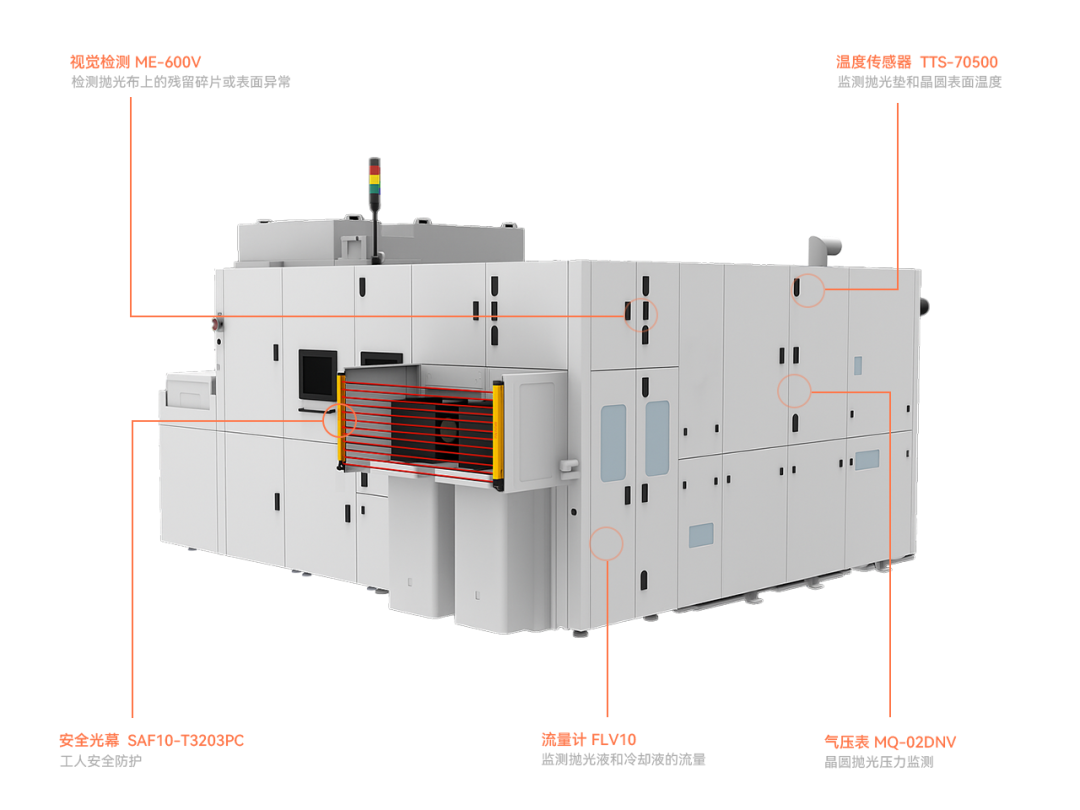





 半導體國產替代材料 | CMP化學機械拋光(Chemical Mechanical Planarization)
半導體國產替代材料 | CMP化學機械拋光(Chemical Mechanical Planarization)

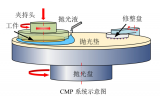
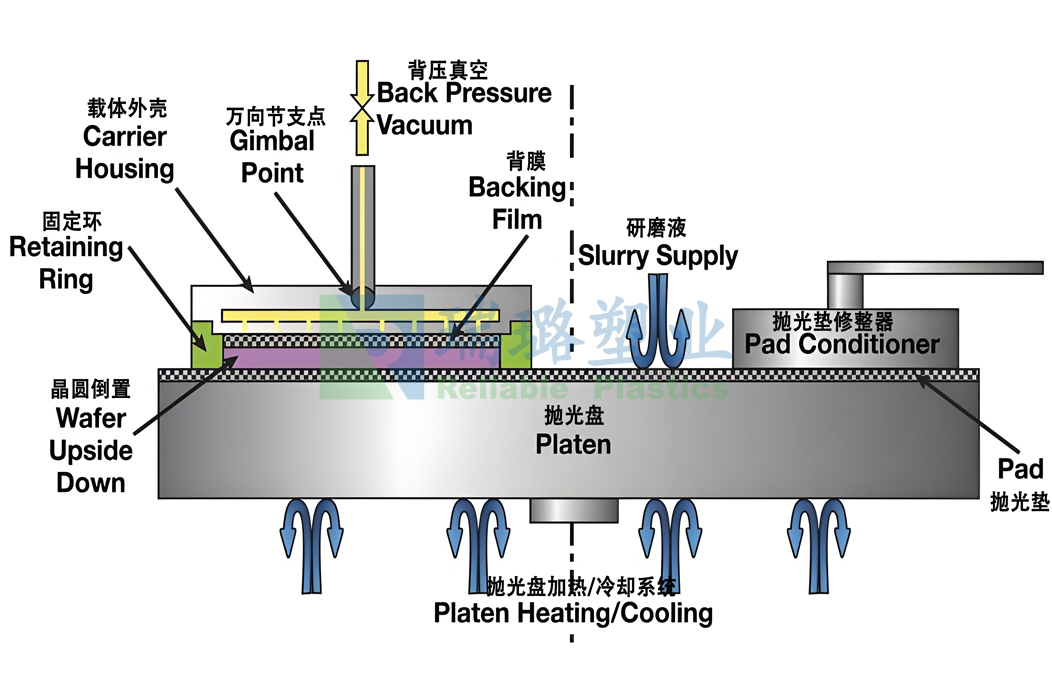
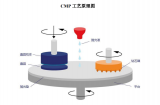













評論